通過觀察偏移、輔助圖形、襯線和其他掩模校正方法對光刻成像的影響,可以建立用作掩模版圖校正的規則。一個簡單的例子如圖4-12所示,如果將左上角的目標圖形或設計目標作為掩模版圖,則會獲得與目標圖形有著顯著偏差的光刻膠輪廓(右上)。與目標圖形相比,光刻膠輪廓的末端縮短了。此外,圖形拐角處的輪廓形狀發生了強烈的變形。采用幾種基于規則的校正方法,獲得新的經光學鄰近效應校正后的掩模版圖(OPC掩模版圖,左下)。校正后掩模版圖的光刻膠輪廓更接近于目標圖形(右下)。
將少數規則應用于給定目標圖形比較簡單,然而,隨著工藝因子K1的不斷降低,光刻工藝會引起更嚴重的鄰近效應。與特征尺寸相比,不同特征圖形之間的相互作用距離會增加。因此,越來越多的相互作用場景需要被考慮進來,并且需要日益復雜的掩模校正方法來補償鄰近效應。如此一來,OPC規則的數量呈指數級增長。對于先進半導體制程而言,完全基于規則的OPC變得越來越難,且不切實際。
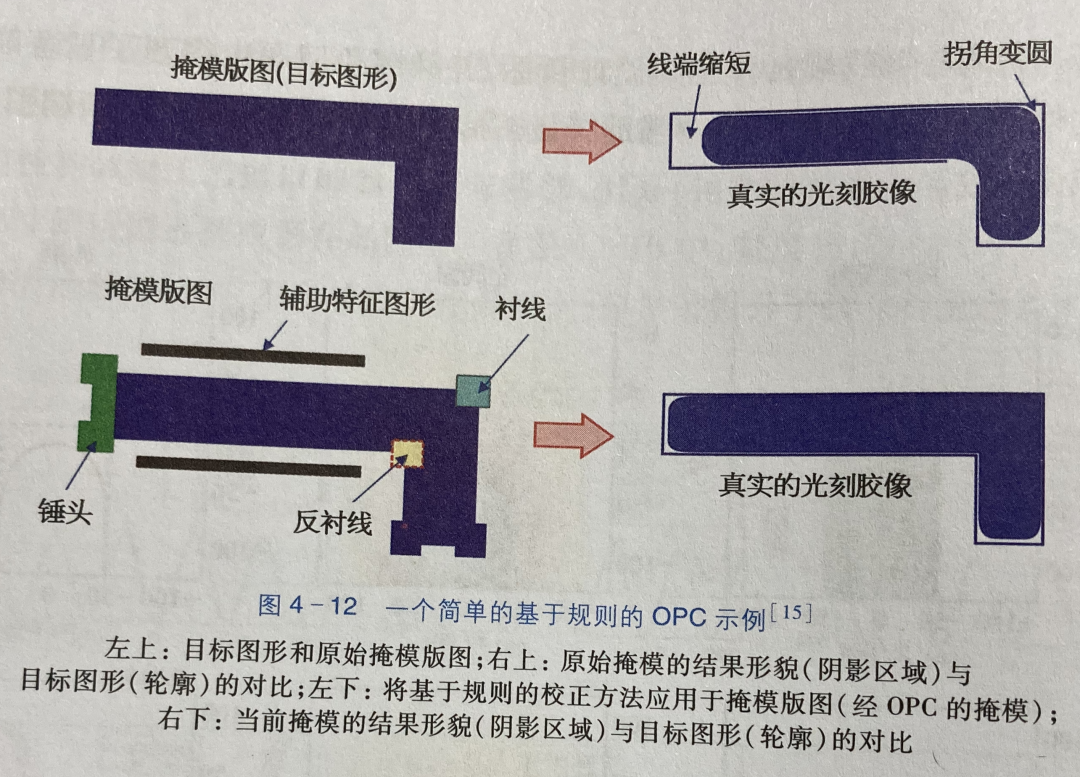
基于模型的OPC采用高效(緊姿)的光刻成像模型和光刻膠反應模型來預測推模版圖的必要修正。其基本思想、概念和方法是由 Rieger 和 Stirniman ,以及 Nick Cobb共同提出并開發的。該方法的基本思想如圖4-13所示。首先,將原始掩模版圖的邊緣分成幾部分,這個過程稱為碎片化:然后,調整各個部分的位置,最大限度地減少每次調整掩模后獲得的成像輪廓與目標圖形之間的差異。在每次迭代中,都會執行一次仿真。Cobb 使用SOCS 成像算法來實現空間像的高效計算(參見2.2.3節)。Rieger 和 Stirniman 使用經驗化的行為模型,這些模型基于適當內核(區域樣本)的卷積。數值化的有效卷積運算的應用以及圖像計算對特征邊緣或邊緣位置誤差的限制,使得基于模型的 OPC能夠應用于掩模上的大塊區域,甚至整個芯片的版圖。

第一個基于模型的OPC得到的掩模幾何形狀是通過已知解的擾動獲得的。在許多情況下,以這種方式獲得的掩模幾何形狀往往不是最佳的解決方案,例如,圖4-13所示原始的基于模型的OPC永遠不會找到亞分辨率輔助圖形,而這些輔助圖形已被證明可用于增加孤立/半密集特征圖形的焦深。因此,各種用于添加輔助圖形的基于規則和模型的策略已經被設計出來,這些策略包括受物理效應啟發的干涉映射技術、在數字網格上專門的“有效”矩陣的計算以及機器學習的應用。
一般而言,當為一個具有已知特征的系統設計輸入圖形(或掩模),以使輸出結果盡可能接近目標圖形時,可以將 OPC視為一個圖像合成問題。最先進的 OPC 算法是從逆向問題的抽象數學公式開始的(圖4-14)。為此,圖像形成過程在數學上可以被表示為

式中,H為將掩模傳輸函數 m(x,y)映射到輸出強度函數I(x,y)的前饋模型。一般來說,H是不可逆的。該優化問題的解是確定一個最合適的掩模版圖m(x,y),其生成的圖像強度分布接近于目標圖形強度分布Z(x,y):

式中,d為一個合適的用于量化圖像和目標之間相似性的距離度量。有關光源掩模協同優化(SMO)和反演光刻技術(ILT)的評價函數的進一步討論,請參見4.5節。出于實際有效性考慮,得到的掩模版圖 m(x,y)應該可以通過合理的方式被制造出來。
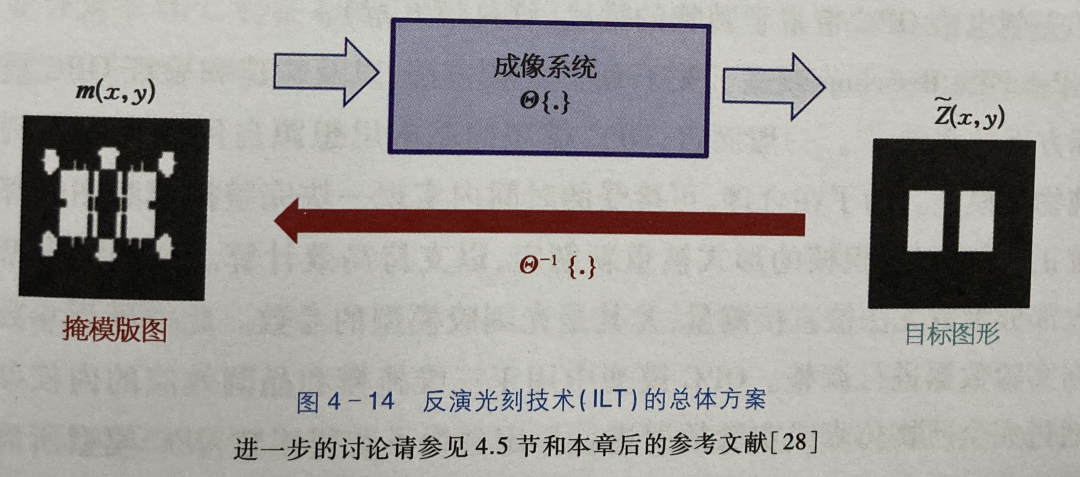
解決上述優化問題的早期嘗試包括采用像素翻轉、模擬退火和交替投影技術等。為了獲得可制造的掩模,在掩模版圖優化中采用了不同的正則化方案。Granik 給出了用于解決反演光刻掩模問題的最新方法的全面概述和分類。最先進的反演光刻技術(ILT) 應用高效的成像(和光刻膠)模型,并結合各種先進的優化技術來確定基于目標設計圖形的最佳掩模版圖。掩模版圖和照明形態的優化采用了類似的技術,這些技術經常在SMO 中被結合使用。4.5節將對此類技術進行概述,并討論其各個重要方面,還將列出相關文獻和所選示例的參考資料。
盡管ILT提供了(理論上)最佳解決方案,但它很少被應用于整個掩模版圖。在實際應用中,ILT經常用于優化熱點( hotspots)區域的掩模版圖,這些是整個掩模版圖中非常容易出現圖形錯誤的位置。此外,ILT 也被用于生成輔助圖形的放置規則。
-
光刻
+關注
關注
8文章
364瀏覽量
31336 -
模型
+關注
關注
1文章
3751瀏覽量
52099 -
掩模
+關注
關注
0文章
14瀏覽量
7747
原文標題:從基于規則到基于模型的OPC和反演光刻技術-------光學光刻和極紫外光刻 安迪?愛德曼 著
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
光刻機工藝的原理及設備
半導體光刻技術基本原理
來幫幫孩子吧,關于磁傳感器測電流反演得出幅值和電位。
AltaRica3.0模型到NuSMVP模型的轉換規則和算法

OPC UA SDK for Java通過OPC基金會認證
計算光刻技術的發展
突破!打破國外壟斷,中國首款自主可控芯片光刻OPC軟件

浙大、微信提出精確反演采樣器新范式,徹底解決擴散模型反演問題




 從基于規則到基于模型的OPC和反演光刻技術
從基于規則到基于模型的OPC和反演光刻技術


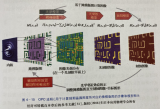



評論