半導體晶圓清洗工藝中,SC-1與SC-2作為RCA標準的核心步驟,分別承擔著去除有機物/顆粒和金屬離子的關鍵任務。二者通過酸堿協同機制實現污染物的分層剝離,其配方設計、反應原理及工藝參數直接影響芯片制造良率與電學性能。本文將深入解析這兩種溶液的作用機理與應用要點。
以下是關于SC-1和SC-2兩種清洗液能去除的雜質的詳細說明:
SC-1(堿性清洗液)
顆粒污染物
去除機制:由氨水(NH?OH)、過氧化氫(H?O?)和去離子水組成,通過H?O?的強氧化性破壞顆粒表面結構,同時NH?OH腐蝕硅片表面的自然氧化層,使附著的顆粒失去支撐而脫落。此外,堿性環境使硅片與顆粒均帶負電,產生靜電排斥力防止再吸附;
適用場景:對粒徑>0.3μm的顆粒去除率可達90%以上,尤其適合去除晶圓表面的大尺寸微粒。
有機物殘留
化學反應原理:H?O?作為強氧化劑分解有機物(如光刻膠、油脂等),將其轉化為二氧化碳和水等可溶性物質;NH?OH則通過溶劑化作用進一步溶解有機分子鏈;
典型應用:常用于清除光刻工藝后的抗蝕劑殘余及加工過程中沾染的有機污染物。
部分金屬雜質
絡合作用:NH?OH可與某些金屬離子形成可溶性絡合物,例如銅、金、銀等過渡金屬,使其從表面脫附進入溶液中;
局限性:對鋁、鐵等易形成不溶性氫氧化物的金屬效果有限,需后續SC-2處理以完全去除。
SC-2(酸性清洗液)
金屬離子污染
核心反應:鹽酸(HCl)提供H?和Cl?,與金屬離子反應生成可溶性氯化物;H?O?將低價態金屬氧化為高價態,增強與Cl?的絡合能力,形成穩定的絡合物;
目標污染物:有效去除鈉、鈣、鎂、鐵等堿金屬及部分重金屬離子,尤其擅長溶解SC-1步驟中未完全清除的金屬氫氧化物沉淀。
堿性殘留物
中和功能:作為酸性溶液,SC-2能中和前序SC-1清洗后殘留的微量氨水或其他堿性物質,避免交叉污染;
工藝銜接意義:在RCA標準流程中,SC-2接在SC-1之后使用,確保表面電中性并消除堿性環境導致的金屬再沉積風險。
特定難溶性化合物
特殊溶解能力:對SC-1可能遺留的金屬氧化物或氫氧化物具有高效溶解作用,例如可將Fe(OH)?轉化為FeCl?等可溶性鹽類。
SC-1側重于顆粒和有機物的去除,同時初步處理部分金屬;SC-2則專門針對金屬離子污染,并與SC-1形成互補。兩者按順序使用時,可實現從有機到無機、從顆粒到離子的全面清洗,是半導體RCA工藝的核心組合。實際生產中需根據污染物類型動態調整配方比例、溫度與處理時間,并結合兆聲波輔助提升清洗效率。
-
半導體
+關注
關注
339文章
30977瀏覽量
265371 -
濕法
+關注
關注
0文章
41瀏覽量
7264
發布評論請先 登錄
SC-1顆粒去除和piranha后漂洗的機理研究
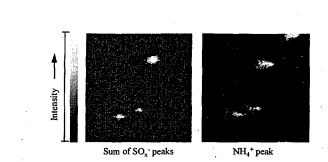
過氧化氫在SC1清潔中的應用
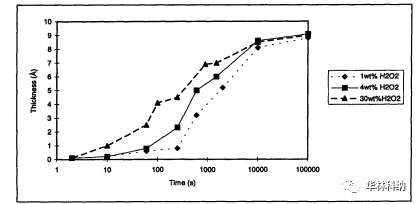
2sc1970.pdf 2SC1971.pdf 2SC197
5G移動技術支持,索尼無人駕駛概念車 Cart SC-1開啟測試
SC-1顆粒去除和piranha后漂洗的機理研究

用于硅晶圓的全新RCA清洗技術
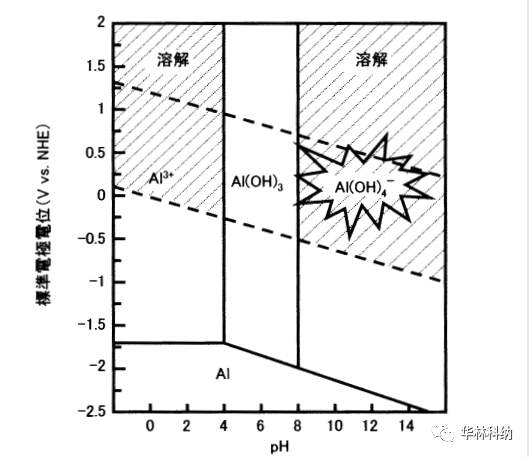
sc-1和sc-2可以一起用嗎




 sc-1和sc-2能洗掉什么雜質
sc-1和sc-2能洗掉什么雜質









評論