介紹
RCA標準清潔,在去除硅表面污染方面非常有效。RCA清潔包括兩個順序步驟:標準清潔1(SC-1)和標準清潔2(SC-2)。SC-1溶液由氫氧化銨、過氧化氫和水的混合物組成,是迄今為止發現的最有效的顆粒去除劑。這種混合物也被稱為氫氧化胺、過氧化氫混合物(APM)。SC-I溶液通過蝕刻顆粒下面的晶片來促進顆粒去除;從而松動顆粒,使機械力可以很容易地從晶圓表面去除顆粒。
本文將討論一個詳細的SC-I清洗的化學模型。了解導致氧化物同時生長和蝕刻的化學性質,為優化顆粒去除,同時盡量減少氣體液體界面的形成提供了基礎。
溶液化學
SC-1中晶片表面氧化物的生長速率由溫度、過氧化氫濃度和pH決定。此外,由于活性物質在與硅反應之前必須通過現有的氧化物擴散,因此該反應是受運輸限制的,因此是氧化物厚度的函數。氧化物的厚度隨同時蝕刻和氧化物的生長而變化。因此,厚度是反應時間的函數。此外,識別最可能的氧化物種對于準確的氧化物溶液中氧化物生長模型是必要的。先前的分析表明,H202可能不是主要的氧化物種。
氧化物生長的濃度依賴性
在SC-1和H202溶液中發現了兩種不同的氧化物質:H202和超氧化氫。這兩種氧化劑的相對濃度在兩種溶液之間存在很大差異。
其中CH202和CNH3是化學物質混合物的正式過氧化氫和氨濃度。實驗結果表明,SC-1溶液的氧化速率遠高于純過氧化物溶液。SC-1中的最終氧化物厚度會在非常短的暴露時間后達到,而在過氧化物溶液中,只有在大約50分鐘后才能獲得類似的氧化物厚度。

圖3:不同濃度下H202溶液中氧化物厚度隨時間的函數
氧化物生長的時間依賴性
事實上,化學氧化物的最大厚度是9A,因為該氧化物是在SC-I或純過氧化物溶液中產生的。由于氧化物在純過氧化氫溶液和SC-1溶液中停止生長,數據表明其他一些運輸限制可能是活躍的。在氧化物和硅之間的界面附近,與局部電荷相關的極化能可以直接影響帶電物質的輸運。界面上局部電荷的存在提供了一種動力,通過近距離擴散影響輸運。
結果表明,A的符號為負的,說明陰離子是氧化膜生長過程中的活性氧化物質。這一證 據再次表明,超氧化氫是主要的氧化劑。
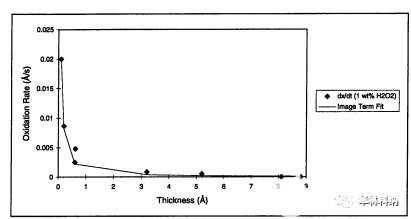
圖6:實驗數據(6)與圖像電荷模型的比較
結論
氧化物的生長發生在純物之間的界面上。硅和現有的氧化物,因此是一個運輸有限的反應。本文對已發表的數據進行的分析表明,負責氧化物生長的主要氧化劑是過氧化物陰離子,超氧化氫”。數據表明,SC-I溶液的生長速度明顯快于過氧化物溶液。在SC-1溶液中,超氧化氫由于氫氧化銨的存在而導致的濃度增加;因此,由于氧化劑濃度較高,生長速度更快。H20 2 在兩種溶液中的濃度大致相同,因此如果H20 2 是主要的活性氧化物種,則預計兩種溶液之間的生長速率不會發生變化。此外,任何一種溶液的增長率都與的濃度也與 成正比。這些比例關系表明,一個簡單的一階反應,或與超氧化氫的運輸有限反應是氧化物生長的主要原因。最后,基于簡單菲克擴散的模型無法擬合數據。相比之下,基于圖像電荷離子輸運的模型與實驗誤差范圍內發表的數據一致。基于圖像電荷輸運的模型預測了經常觀察到的氧化物厚度在8-10a左右的限制。超氧化氫-由圖像電荷產生的離子力傳輸;而H202不受這種靜電效應的影響。
-
晶片
+關注
關注
1文章
413瀏覽量
32983 -
模型
+關注
關注
1文章
3791瀏覽量
52217 -
刻蝕
+關注
關注
2文章
222瀏覽量
13816
發布評論請先 登錄
大模型實戰(SC171開發套件V2-FAS)
濕法清洗機原理:化學溶解與物理作用的協同清潔機制

如何提高RCA清洗的效率
sc-1和sc-2能洗掉什么雜質

濕法清洗尾片效應是什么原理
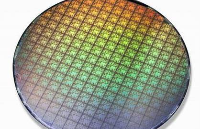
半導體清洗機如何優化清洗效果




 詳解SC-I清洗的化學模型
詳解SC-I清洗的化學模型


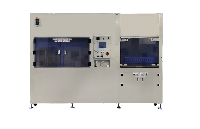



評論