引言
集成設備制造的縮小圖案要求濕化學加工的表面清潔度和表面光滑度,特別是對于常見的清潔技術RCA清潔(SC-1和SC-2)。本文討論了表面制備參數的特性和影響。硅技術中RCA濕式化學處理的性質是基于SC-1和QDR的加工時間、溫度、濃度和超電子功率。提出了一種利用濕式清洗化學工藝的增強變量來改進晶片表面制備的方法。
實驗與討論
我們廣泛研究了SC-1和QDR的加工時間、溫度、濃度和超電子功率的影響。這些研究表明,對粒子去除效率的最大主效應是超電子功率,其次是溫度和濃度,而SC-2的影響較小。在濕式臺式處理器中進行了統計設計的實驗(DOE)。英思特半導體提出了一種基于SC-1、QDR和SC-1溫度的超電子功率,具有最佳顆粒去除效率的晶片表面制備RCA配方。此外,還將詳細討論每個結果。

表1:0.06pm粒徑實驗設計匯總結果
采用篩選DOE(實驗設計)來確定顆粒去除效率的主要影響。在高頻浴和旋轉到干燥干燥機中處理晶片,晶片被故意預先污染。會使晶片表面變成疏水,排斥水,容易吸引顆粒。典型的污染程度在100-2000個顆粒之間有所不同,顆粒閾值分別為0.13和0.16 Pm。由于PRE強烈依賴于初始計數和晶圓的初始條件(污染前清洗),因此為每個DOE條件隨機選擇晶圓。所有對受污染晶片的實驗都是在同一份批次的樣品上進行的。
高溫在一定程度上通過蝕刻晶片表面和顆粒來去除大部分顆粒,從而降低顆粒與晶片的粘附力,促進顆粒離開晶片進入溶液的體積。小顆粒的PRE%高于大顆粒,因為小顆粒的表面接觸高于大顆粒,因此保持小顆粒在表面上的力更高。通過提高溫度,可以迅速變化。

表2:0.13 P M粒徑實驗設計總結結果
結果表明,與SC-2工藝相比,跳躍對0.06um及以上顆粒的顆粒去除效率更高。對于0.13um及以上的顆粒,顆粒去除效率無顯著差異。當溶液的pH降低時,粒子與襯底物之間的zeta勢增大。與SC-2工藝相比,跳躍對0.06um及以上顆粒的顆粒去除效率更高。對于0.13um及以上的顆粒,顆粒去除效率無顯著差異。當溶液的pH降低時,粒子與襯底物之間的勢增大。
結論
巨波能量和化學稀釋有助于去除顆粒,而不增加表面粗糙度。聲能可以用來平衡SC-1化學物質的低濃度和較短的處理時間。根據英思特設計的實驗,在這些實驗中觀察到SC-1溫度是使用SC-1型化學方法去除顆粒的第二個主要因素。這一發展的主要成就是通過SC-1稀釋、高溫、短浸泡時間和適當的超電子功率優化。
江蘇英思特半導體科技有限公司主要從事濕法制程設備,晶圓清潔設備,RCA清洗機,KOH腐殖清洗機等設備的設計、生產和維護。
審核編輯:湯梓紅
-
半導體
+關注
關注
339文章
31024瀏覽量
265564 -
晶圓
+關注
關注
53文章
5433瀏覽量
132507 -
RCA
+關注
關注
0文章
47瀏覽量
9280
發布評論請先 登錄
AWE 2026 | 奧迪威顆粒物感應方案:以粒徑感知賦能智能清潔設備

奧迪威顆粒物感應方案:通過實時顆粒分析實現智能清潔

晶圓檢測過程中產生的異物去除方案
革新半導體清洗工藝:RCA濕法設備助力高良率芯片制造
襯底清洗全攻略:從濕法到干法,解鎖半導體制造的“潔凈密碼”

如何提高RCA清洗的效率
晶圓清洗設備有哪些技術特點
sc-1和sc-2能洗掉什么雜質

汽車零部件“技術清潔度”定義全流程指南

清潔電器開卷,智能MCU是關鍵變量

半導體rca清洗都有什么藥液

半導體封裝清洗工藝有哪些

超聲波除油清洗設備是否可以有效去除難以清潔的油漬?
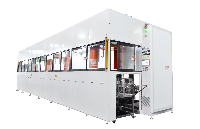



 RCA清潔變量對顆粒去除的影響
RCA清潔變量對顆粒去除的影響





評論