超導(dǎo)薄膜的微觀不均勻性(顆粒度)是影響其宏觀性能的關(guān)鍵因素。在接近臨界溫度(T??)時,傳統(tǒng)四探針法常觀測到異常電阻峰,這一現(xiàn)象長期被誤認為材料本征特性。然而,研究表明,此類異常可能源于超導(dǎo)參數(shù)的局部差異(如T??和ΔT??的非均勻分布)導(dǎo)致的電流重分布效應(yīng)。本文通過構(gòu)建非局域四探針模型,結(jié)合實驗與磁場調(diào)控,系統(tǒng)解析了電阻峰的物理起源,揭示了超導(dǎo)顆粒度的動態(tài)響應(yīng)機制。研究中采用Xfilm埃利四探針方阻儀對NbN薄膜進行全自動多點掃描,其高精度與快速材料表征能力為超導(dǎo)薄膜的精準分析提供了技術(shù)支撐。
四探針非局域測量模型
/Xfilm
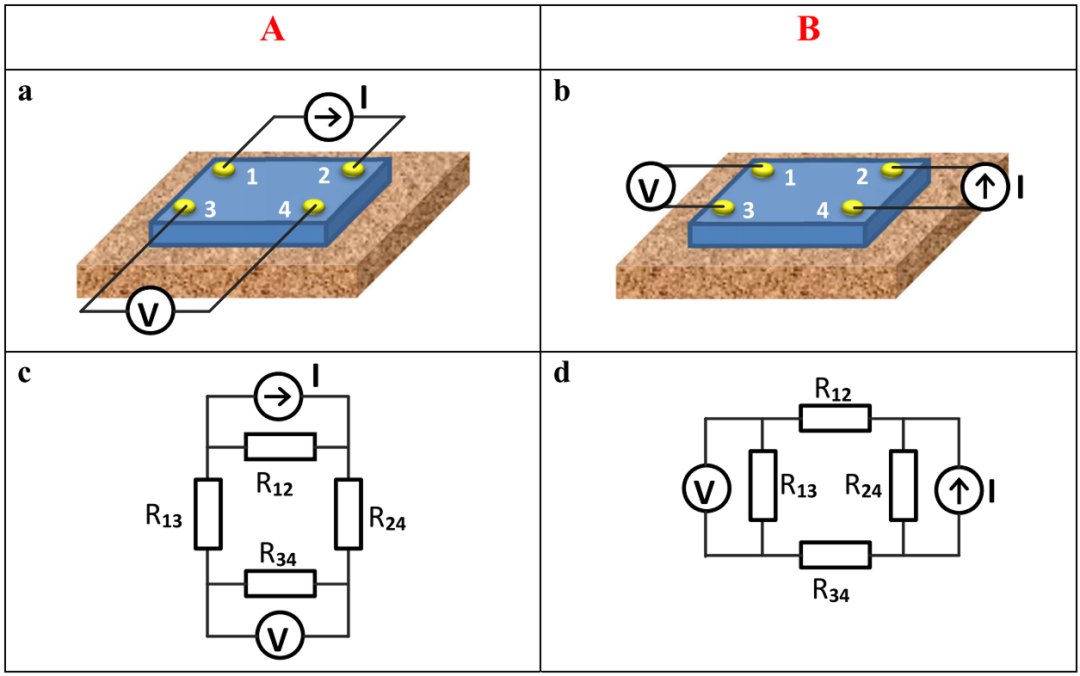
非局域四探針兩種接觸配置(A和B)及其等效電路
等效電路構(gòu)建:
- 區(qū)域劃分:將正方形超導(dǎo)薄膜劃分為四個獨立電阻區(qū)域(編號12、13、24、34),各區(qū)域電阻服從溫度依賴關(guān)系R(T)?=?R???[1?+?tanh((T???T??)/ΔT??)]。
- 非局域電阻計算:通過基爾霍夫定律推導(dǎo)配置A(R??(T))和B(R??(T))的電阻表達式,揭示電流路徑對局部超導(dǎo)參數(shù)的敏感性。
模擬結(jié)果與機制分析:
- 單區(qū)域參數(shù)差異:
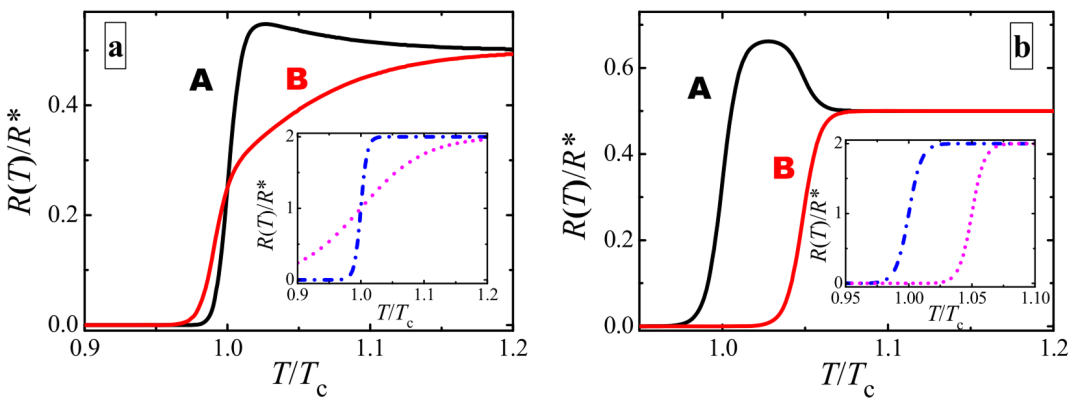 不同場景下計算的電阻-溫度特性曲線(A和B配置)當區(qū)域24的轉(zhuǎn)變寬度(ΔT??2??=?0.1T??)顯著大于其他區(qū)域時(ΔT???=?0.01T??),電流優(yōu)先流經(jīng)低阻路徑,導(dǎo)致T??附近出現(xiàn)電阻峰; 若區(qū)域24的T??偏高(T??2??=?1.05T??),其提前進入超導(dǎo)態(tài)迫使電流繞行,進一步放大電阻峰。
不同場景下計算的電阻-溫度特性曲線(A和B配置)當區(qū)域24的轉(zhuǎn)變寬度(ΔT??2??=?0.1T??)顯著大于其他區(qū)域時(ΔT???=?0.01T??),電流優(yōu)先流經(jīng)低阻路徑,導(dǎo)致T??附近出現(xiàn)電阻峰; 若區(qū)域24的T??偏高(T??2??=?1.05T??),其提前進入超導(dǎo)態(tài)迫使電流繞行,進一步放大電阻峰。
- 多區(qū)域協(xié)同效應(yīng):
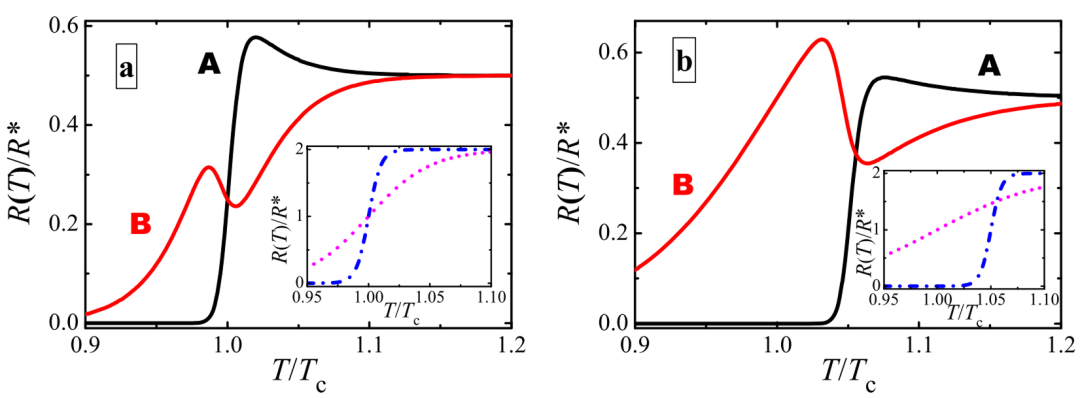 多區(qū)域參數(shù)差異對電阻-溫度曲線的影響多個區(qū)域的T??或ΔT??差異可導(dǎo)致類“再入超導(dǎo)”行為,突顯顆粒度對全局電阻的動態(tài)調(diào)控能力。
多區(qū)域參數(shù)差異對電阻-溫度曲線的影響多個區(qū)域的T??或ΔT??差異可導(dǎo)致類“再入超導(dǎo)”行為,突顯顆粒度對全局電阻的動態(tài)調(diào)控能力。 
NbN薄膜的制備與電阻行為驗證
/Xfilm
- 樣品制備與表征:
工藝細節(jié):采用脈沖激光沉積(PLD)在Al?O?襯底上生長50 nm NbN薄膜,緩沖層為50 nm AlN; 測量系統(tǒng):物理性質(zhì)測量系統(tǒng)(PPMS)在1.9–300 K范圍內(nèi)獲取電阻-溫度曲線。
- 實驗結(jié)果:
 50 nm厚NbN薄膜的實驗數(shù)據(jù)與數(shù)值擬合(零磁場)?
50 nm厚NbN薄膜的實驗數(shù)據(jù)與數(shù)值擬合(零磁場)?
- 零磁場下非局域測量:
配置A/B顯示顯著電阻峰(峰值較正常態(tài)高10–20%),而共線配置(電壓探針位于電流路徑內(nèi))無此現(xiàn)象; 參數(shù)擬合表明,局部T??差異(13.6–14.1 K)與ΔT??波動(0.25–0.35 K)是電阻峰的主因。 
磁場效應(yīng):顆粒度的抑制與調(diào)控
/Xfilm
- 垂直磁場(B?⊥?=?6 T)的作用:
 垂直磁場(B?⊥?=?6 T)下的實驗數(shù)據(jù)與擬合現(xiàn)象:所有區(qū)域T??趨同(11.5 K),電阻峰消失,曲線趨于平滑; 機制:磁場誘導(dǎo)渦旋穿透,破壞大尺度超導(dǎo)疇,抑制顆粒度,實現(xiàn)全局均勻化。
垂直磁場(B?⊥?=?6 T)下的實驗數(shù)據(jù)與擬合現(xiàn)象:所有區(qū)域T??趨同(11.5 K),電阻峰消失,曲線趨于平滑; 機制:磁場誘導(dǎo)渦旋穿透,破壞大尺度超導(dǎo)疇,抑制顆粒度,實現(xiàn)全局均勻化。
- 平行磁場(B?∥?=?6 T)的響應(yīng):
 平行磁場(B?∥?=?6 T)下的實驗數(shù)據(jù)與擬合現(xiàn)象:局部T??差異保留(11.5–11.8 K),電阻峰重現(xiàn); 機制:平行磁場主要影響自旋自由度(Zeeman效應(yīng)),對軌道耦合作用微弱,顆粒度未被完全消除。 非局域四探針法通過電流路徑敏感性,可高效探測超導(dǎo)薄膜的顆粒度,異常電阻峰本質(zhì)為電流重分布的假象;垂直磁場通過渦旋穿透抑制顆粒度,平行磁場則保留局部不均勻性,二者共同揭示超導(dǎo)疇的動態(tài)競爭機制;
平行磁場(B?∥?=?6 T)下的實驗數(shù)據(jù)與擬合現(xiàn)象:局部T??差異保留(11.5–11.8 K),電阻峰重現(xiàn); 機制:平行磁場主要影響自旋自由度(Zeeman效應(yīng)),對軌道耦合作用微弱,顆粒度未被完全消除。 非局域四探針法通過電流路徑敏感性,可高效探測超導(dǎo)薄膜的顆粒度,異常電阻峰本質(zhì)為電流重分布的假象;垂直磁場通過渦旋穿透抑制顆粒度,平行磁場則保留局部不均勻性,二者共同揭示超導(dǎo)疇的動態(tài)競爭機制; 
Xfilm埃利四探針方阻儀
/Xfilm

Xfilm埃利四探針方阻儀用于測量薄層電阻(方阻)或電阻率,可以對最大230mm 樣品進行快速、自動的掃描, 獲得樣品不同位置的方阻/電阻率分布信息。
- 超高測量范圍,測量1mΩ~100MΩ
- 高精密測量,動態(tài)重復(fù)性可達0.2%
- 全自動多點掃描,多種預(yù)設(shè)方案亦可自定義調(diào)節(jié)
- 快速材料表征,可自動執(zhí)行校正因子計算
Xfilm埃利四探針方阻儀憑借其全自動掃描與高動態(tài)重復(fù)性,在超導(dǎo)薄膜的電阻分布表征中展現(xiàn)出顯著優(yōu)勢。本研究通過非局域四探針法揭示了超導(dǎo)顆粒度對電阻峰的調(diào)控機制,并驗證了磁場對超導(dǎo)疇結(jié)構(gòu)的動態(tài)影響。
原文參考:《Probing superconducting granularity using nonlocal four-probe measurements》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時間核實并處理。
-
薄膜
+關(guān)注
關(guān)注
1文章
367瀏覽量
46239 -
測量
+關(guān)注
關(guān)注
10文章
5673瀏覽量
116856 -
電阻特性
+關(guān)注
關(guān)注
0文章
4瀏覽量
7445
發(fā)布評論請先 登錄
吉時利四探針法測試系統(tǒng)實現(xiàn)材料電阻率的測量

高溫電阻測試儀的四探針法中,探針的間距對測量結(jié)果是否有影響

四探針法丨導(dǎo)電薄膜薄層電阻的精確測量、性能驗證與創(chuàng)新應(yīng)用

四探針法精準表征電阻率與接觸電阻 | 實現(xiàn)Mo/NbN低溫超導(dǎo)薄膜電阻器

四探針法 | 測量射頻(RF)技術(shù)制備的SnO2:F薄膜的表面電阻

非接觸式發(fā)射極片電阻測量:與四探針法的對比驗證

四探針法校正因子的全面綜述:基于實驗與數(shù)值模擬的電阻率測量誤差修正

四探針法測電阻的原理與常見問題解答

四探針法在薄膜電阻率測量中的優(yōu)勢

二探針與四探針電阻測量法的區(qū)別

四探針法測量半導(dǎo)體薄層電阻的原理解析
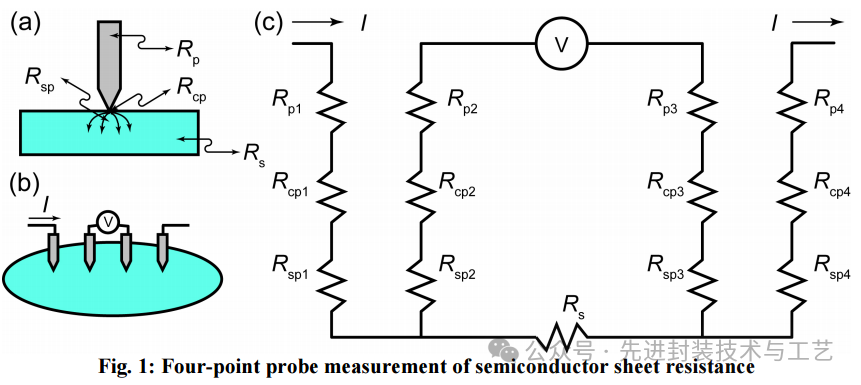
源表應(yīng)用拓展:四探針法測電阻率

四探針法測量電阻率:原理與不確定度分析




 非局域四探針法:超導(dǎo)薄膜顆粒度對電阻特性的影響機制解析
非局域四探針法:超導(dǎo)薄膜顆粒度對電阻特性的影響機制解析





評論