四探針法(4PP)作為一種非破壞性評估技術(shù),廣泛應(yīng)用于半導(dǎo)體和導(dǎo)電材料的電阻率和電導(dǎo)率測量。其非破壞性特點(diǎn)使其適用于從宏觀到納米尺度的多種材料。然而,傳統(tǒng)解析模型在校正因子的計算中存在近似誤差,尤其是在樣品幾何尺寸與探針間距相當(dāng)時。本文通過數(shù)值模擬和實(shí)驗(yàn)交叉驗(yàn)證并結(jié)合Xfilm埃利四探針方阻儀提供的準(zhǔn)確測量數(shù)據(jù)優(yōu)化這些校正因子,提升測量準(zhǔn)確性。
四探針法的基本原理
/Xfilm

四探針理想配置
在四探針的標(biāo)準(zhǔn)線性配置中,電流通過外側(cè)兩個探針注入樣品,電壓則由內(nèi)側(cè)兩個探針測量。對于無限厚的均勻材料,電阻率(ρ?)的計算公式為: 其中,(s)為探針間距,(V/I)為電壓-電流比值。該方法的顯著優(yōu)勢包括:
其中,(s)為探針間距,(V/I)為電壓-電流比值。該方法的顯著優(yōu)勢包括:
- 非破壞性測量(NDE)
- 可測量電阻率范圍廣(10-4 - 104 Ω·cm)
- 適用于各向異性材料
當(dāng)樣品厚度有限或直徑較小時,需引入幾何校正因子以修正電阻率計算。
幾何校正因子的分析
/Xfilm
- 厚度校正因子G(w/s)
對于有限厚度的樣品,電阻率計算需引入: 當(dāng)(w/su≈1)時,G的表達(dá)式為:
當(dāng)(w/su≈1)時,G的表達(dá)式為:
- 直徑校正因子CF(d/s)

圓形樣品四探針配置
對于圓形樣品,當(dāng)電極位于中心時,CF的表達(dá)式為: 當(dāng)直徑(d > 30s)時,CF趨近于1,校正可忽略。
當(dāng)直徑(d > 30s)時,CF趨近于1,校正可忽略。
實(shí)驗(yàn)與數(shù)值模擬
/Xfilm
實(shí)驗(yàn)設(shè)置
實(shí)驗(yàn)采用間距為1.118 mm的探頭,通過自動化測量系統(tǒng),對兩種不同尺寸的N型鍺樣品(GeR2和GeR3)進(jìn)行測量。樣品參數(shù)及校正因子: 測量結(jié)果顯示,未經(jīng)修正的模型在GeR3樣品上產(chǎn)生7.2%的系統(tǒng)偏差,驗(yàn)證了理論誤差分析的結(jié)論。
測量結(jié)果顯示,未經(jīng)修正的模型在GeR3樣品上產(chǎn)生7.2%的系統(tǒng)偏差,驗(yàn)證了理論誤差分析的結(jié)論。
- 數(shù)值模擬

樣品GeR2的COMSOL模擬結(jié)果 樣品GeR3的COMSOL模擬結(jié)果 虛構(gòu)樣品GeF2的COMSOL模擬結(jié)果通過COMSOL有限元模擬(FEM)分析電勢分布和電流密度,發(fā)現(xiàn)GeR2和GeR3的模擬電阻率與實(shí)驗(yàn)值存在偏差:
虛構(gòu)樣品GeF2的COMSOL模擬結(jié)果通過COMSOL有限元模擬(FEM)分析電勢分布和電流密度,發(fā)現(xiàn)GeR2和GeR3的模擬電阻率與實(shí)驗(yàn)值存在偏差: 模擬表明,GeR3的電流密度和電場線更接近邊緣,導(dǎo)致電勢等高線平行于邊緣,而GeR2的場分布更均勻。
模擬表明,GeR3的電流密度和電場線更接近邊緣,導(dǎo)致電勢等高線平行于邊緣,而GeR2的場分布更均勻。
誤差分析與修正模型
/Xfilm
- 厚度校正因子G的誤差

厚度校正因子G的相對近似誤差
對GeR3(w/s=1.34),原始G模型的相對誤差達(dá)6.92%。通過擬合四次多項式修正G: 顯著降低誤差。
顯著降低誤差。
- 直徑校正因子CF的誤差

直徑校正因子CF的解析值與修正值相對偏差(ΔCF/CF’)

修正后的直徑校正因子CF’與解析CF的關(guān)系通過線性擬合修正CF: 修正后,GeR2和GeR3的電阻率誤差分別降至1.1%和2.0%,修正后結(jié)果:
修正后,GeR2和GeR3的電阻率誤差分別降至1.1%和2.0%,修正后結(jié)果: 本研究通過整合數(shù)值模擬、實(shí)驗(yàn)測量與理論分析,提出了一種改進(jìn)的四探針法電阻率計算模型。主要創(chuàng)新點(diǎn)包括:
本研究通過整合數(shù)值模擬、實(shí)驗(yàn)測量與理論分析,提出了一種改進(jìn)的四探針法電阻率計算模型。主要創(chuàng)新點(diǎn)包括:
- 建立了厚度-直徑校正因子的耦合修正模型
- 驗(yàn)證了數(shù)值模擬指導(dǎo)實(shí)驗(yàn)測量的方法論
- 開發(fā)了適用于1特殊工況的測量規(guī)范
通過數(shù)值模擬和實(shí)驗(yàn)驗(yàn)證,修正后的模型將測量誤差從7.4%降低至2%以內(nèi),顯著提高了電阻率測量的精度。優(yōu)化了四探針法中的幾何校正因子,為半導(dǎo)體和納米材料的電學(xué)表征提供了更可靠的工具。
Xfilm埃利四探針方阻儀
/Xfilm

Xfilm埃利四探針方阻儀用于測量薄層電阻(方阻)或電阻率,可以對最大230mm 樣品進(jìn)行快速、自動的掃描, 獲得樣品不同位置的方阻/電阻率分布信息。
- 超高測量范圍,測量1mΩ~100MΩ
- 高精密測量,動態(tài)重復(fù)性可達(dá)0.2%
- 全自動多點(diǎn)掃描,多種預(yù)設(shè)方案亦可自定義調(diào)節(jié)
- 快速材料表征,可自動執(zhí)行校正因子計算
Xfilm埃利四探針方阻儀提供的高精度測量功能,極大地增強(qiáng)了實(shí)驗(yàn)數(shù)據(jù)的準(zhǔn)確性和可信度,為各類材料的電學(xué)特性表征提供了強(qiáng)有力的支持。
原文出處:《Broad review of four-point probe correction factors: Enhanced analytical model using advanced numerical and experimental cross-examination》
*特別聲明:本公眾號所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請聯(lián)系,我們將在第一時間核實(shí)并處理。
-
測量
+關(guān)注
關(guān)注
10文章
5693瀏覽量
116934 -
電阻率
+關(guān)注
關(guān)注
0文章
165瀏覽量
11350
發(fā)布評論請先 登錄
半導(dǎo)體電阻率測試方案解析
吉時利四探針法測試系統(tǒng)實(shí)現(xiàn)材料電阻率的測量

高溫電阻測試儀的四探針法中,探針的間距對測量結(jié)果是否有影響

基于四點(diǎn)探針和擴(kuò)展電阻模型的接觸電阻率快速表征方法

四探針法測電阻的原理與常見問題解答

四探針法在薄膜電阻率測量中的優(yōu)勢

二探針與四探針電阻測量法的區(qū)別

四探針法測量半導(dǎo)體薄層電阻的原理解析
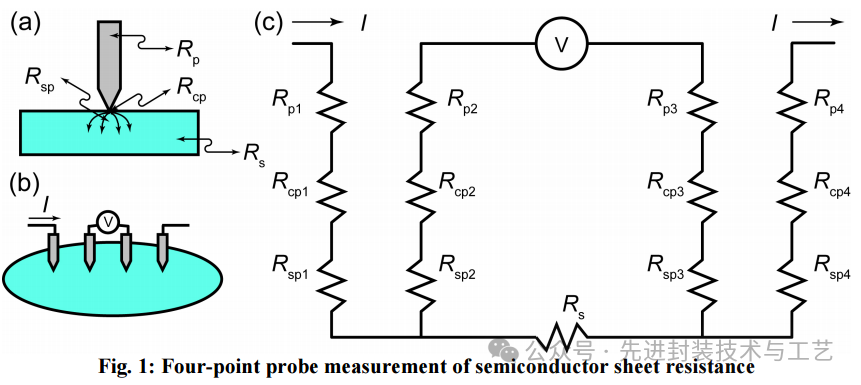
源表應(yīng)用拓展:四探針法測電阻率

金屬小樣品電阻率的四探針高精度測量方法




 四探針法校正因子的全面綜述:基于實(shí)驗(yàn)與數(shù)值模擬的電阻率測量誤差修正
四探針法校正因子的全面綜述:基于實(shí)驗(yàn)與數(shù)值模擬的電阻率測量誤差修正






評論