發(fā)射極片電阻(Remitter)是硅太陽能電池性能的核心參數(shù)之一,直接影響串聯(lián)電阻與填充因子。傳統(tǒng)方法依賴物理接觸或受體電阻率干擾,難以滿足在線檢測(cè)需求。本文提出一種結(jié)合渦流電導(dǎo)與光致發(fā)光(PL)成像的非接觸式測(cè)量技術(shù),通過分離Remitter與體電阻(Rbulk),實(shí)現(xiàn)高精度、無損檢測(cè)。實(shí)驗(yàn)驗(yàn)證表明,該方法與基于四點(diǎn)探針法(4pp)的Xfilm埃利在線四探針方阻儀測(cè)量結(jié)果偏差小于15%,且對(duì)體電阻率波動(dòng)具有高容忍度,而且其非接觸特性適合進(jìn)行在線檢測(cè)。
非接觸式測(cè)量方法的原理
/Xfilm
該方法建立于兩個(gè)物理效應(yīng)耦合:
- 渦流電導(dǎo)測(cè)量:渦流技術(shù)通過交變磁場(chǎng)在硅片中感應(yīng)出環(huán)形電流,其總電導(dǎo)(Gtotal)由發(fā)射極與體電導(dǎo)并聯(lián)構(gòu)成:

- PL空間分布特征:非均勻光照下,PL圖像亮度分布與橫向載流子流動(dòng)相關(guān)。PL最大-最小強(qiáng)度比(MMPL)與(Remitter+ Rbulk) × JL(光生電流密度)相關(guān):
 通過聯(lián)立渦流電導(dǎo)方程與PL強(qiáng)度方程,可解析出Remitter與Rbulk。
通過聯(lián)立渦流電導(dǎo)方程與PL強(qiáng)度方程,可解析出Remitter與Rbulk。
模擬非均勻光照下的PL分布
/Xfilm

仿真幾何結(jié)構(gòu)示意圖及典型歸一化PL強(qiáng)度分布通過構(gòu)建二維對(duì)稱幾何模型,并對(duì)體壽命(τbulk)及摻雜濃度(Ndop)進(jìn)行參數(shù)化掃描,最終提取歸一化PL分布及最大/最小PL強(qiáng)度比(MMPL)。仿真結(jié)果表明,非均勻光照下MMPL與(Remitter+ Rbulk)和光生電流密度(JL)的乘積呈強(qiáng)相關(guān)性。
實(shí)驗(yàn)與四探針法4pp測(cè)量結(jié)果對(duì)比
/Xfilm

本文方法提取的Remitter與四探針(4pp)測(cè)量結(jié)果的對(duì)比研究使用渦流-PL法和四探針法(4pp)對(duì)九組具有不同發(fā)射極片電阻(Remitter)和體電阻(Rbulk)的樣品進(jìn)行了測(cè)量。硅片的體電阻(Rbulk)通過基于渦流的暗電導(dǎo)測(cè)量確定,體電阻率(ρbulk)則通過硅片厚度和Rbulk計(jì)算得出。

實(shí)驗(yàn)用樣品參數(shù)(厚度、Remitter、Rbulk及體電阻率ρbulk)實(shí)驗(yàn)結(jié)果表明,使用新型非接觸式測(cè)量方法提取的發(fā)射極片電阻數(shù)據(jù)與四探針法測(cè)量結(jié)果高度一致,最大相對(duì)偏差僅為15%。這一結(jié)果不僅驗(yàn)證了新方法的準(zhǔn)確性,也為其在大規(guī)模生產(chǎn)中的應(yīng)用提供了有力支持。
不確定性分析
/Xfilm

蒙特卡洛模擬估算的Remitter不確定性與Remitter及Rbulk的關(guān)系通過蒙特卡洛模擬評(píng)估測(cè)量誤差對(duì)提取發(fā)射極電阻(Remitter)的影響。假設(shè)暗電導(dǎo)、光生電流密度(JL)和PL強(qiáng)度比(MMPL)的變異系數(shù)均為1%,對(duì)每組Remitter與體電阻(Rbulk)組合進(jìn)行5000次模擬,計(jì)算其相對(duì)誤差(均方根誤差/真實(shí)值)。結(jié)果顯示:誤差傳遞規(guī)律:當(dāng)Remitter≈Rbulk時(shí),原始誤差被放大;當(dāng)兩者差異顯著時(shí),誤差被抑制。工業(yè)參數(shù)影響:當(dāng)前典型參數(shù)(體電阻率0.5–2 Ω·cm、發(fā)射極電阻100–130 Ω/□)下誤差輕微放大,但隨輕摻雜趨勢(shì)(Remitter進(jìn)一步升高),不確定性將降低。

不同表面復(fù)合速率(SRVrear)下模擬橫向PL剖面

考慮光子散射模糊效應(yīng)前后的PL分布對(duì)比抗干擾能力:高表面復(fù)合速度(>5000 cm/s)下,體壽命、表面粗糙度對(duì) PL 分布的影響可忽略,且光散射引起的 “涂抹效應(yīng)” 對(duì) MMPL 的影響小于 1%。本研究開發(fā)了一種用于測(cè)定擴(kuò)散硅片發(fā)射極片電阻(Remitter)的方法。該方法結(jié)合了渦流電導(dǎo)測(cè)量與非均勻光照光致發(fā)光(PL)成像,其核心優(yōu)勢(shì)在于能夠?qū)w電阻率(Rbulk)可變的樣品進(jìn)行定量分析,并同步分離Remitter與Rbulk。通過與四探針(4pp)法對(duì)比驗(yàn)證,該方法在寬范圍Remitter(100–314 Ω/□)與Rbulk(16–111 Ω/□)內(nèi)表現(xiàn)出良好一致性(最大偏差15%)。
Xfilm埃利在線四探針方阻儀
/Xfilm

Xfilm埃利在線四探針方阻儀是專為光伏工藝監(jiān)控設(shè)計(jì)的在線四探針方阻儀,可以對(duì)最大 230mm ×230mm的樣品進(jìn)行快速、自動(dòng)的掃描,獲得樣品不同位置的方阻/電阻率分布信息。
- 最大樣品滿足230mm×230mm
- 測(cè)量范圍:1mΩ~100MΩ
- 測(cè)量點(diǎn)數(shù)支持5點(diǎn)、9點(diǎn)測(cè)量,同時(shí)測(cè)試5點(diǎn)滿足≤5秒,同時(shí)測(cè)試9點(diǎn)滿足≤10秒
- 測(cè)量精度:保證同種型號(hào)測(cè)量的精準(zhǔn)度不同測(cè)試儀器間測(cè)試誤差在±1%
本文中渦流-PL法通過結(jié)合Xfilm埃利在線四探針方阻儀驗(yàn)證突破傳統(tǒng)方法的接觸限制和體電阻干擾難題,為光伏制造過程提供了可靠的在線檢測(cè)方案。
原文參考:《A contactless method of emitter sheet resistance measurement for silicon wafers》
*特別聲明:本公眾號(hào)所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號(hào)相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請(qǐng)聯(lián)系,我們將在第一時(shí)間核實(shí)并處理。
-
電阻測(cè)溫
+關(guān)注
關(guān)注
0文章
4瀏覽量
5849 -
電阻率
+關(guān)注
關(guān)注
0文章
165瀏覽量
11344
發(fā)布評(píng)論請(qǐng)先 登錄
吉時(shí)利四探針法測(cè)試系統(tǒng)實(shí)現(xiàn)材料電阻率的測(cè)量

測(cè)量薄層電阻的四探針法

高溫電阻測(cè)試儀的四探針法中,探針的間距對(duì)測(cè)量結(jié)果是否有影響

四探針法丨導(dǎo)電薄膜薄層電阻的精確測(cè)量、性能驗(yàn)證與創(chuàng)新應(yīng)用

四探針法精準(zhǔn)表征電阻率與接觸電阻 | 實(shí)現(xiàn)Mo/NbN低溫超導(dǎo)薄膜電阻器

探針式與非接觸式碳化硅 TTV 厚度測(cè)量方法對(duì)比評(píng)測(cè)

四探針法 | 測(cè)量射頻(RF)技術(shù)制備的SnO2:F薄膜的表面電阻

基于四點(diǎn)探針和擴(kuò)展電阻模型的接觸電阻率快速表征方法

四探針法校正因子的全面綜述:基于實(shí)驗(yàn)與數(shù)值模擬的電阻率測(cè)量誤差修正

四探針法測(cè)電阻的原理與常見問題解答

四探針法在薄膜電阻率測(cè)量中的優(yōu)勢(shì)

二探針與四探針電阻測(cè)量法的區(qū)別

四探針法測(cè)量半導(dǎo)體薄層電阻的原理解析
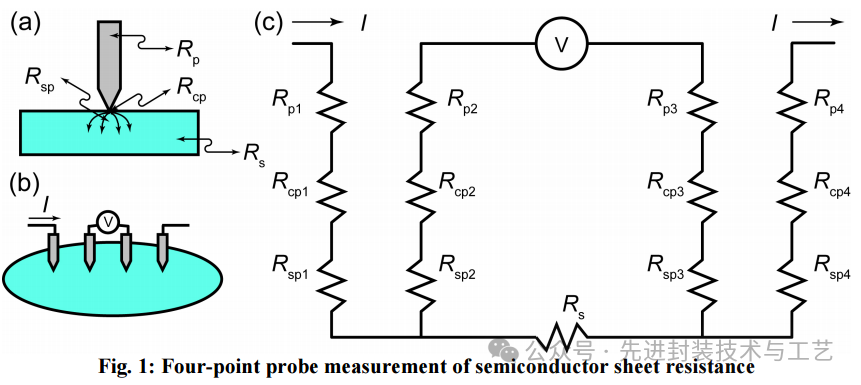
源表應(yīng)用拓展:四探針法測(cè)電阻率

四探針法測(cè)量電阻率:原理與不確定度分析




 非接觸式發(fā)射極片電阻測(cè)量:與四探針法的對(duì)比驗(yàn)證
非接觸式發(fā)射極片電阻測(cè)量:與四探針法的對(duì)比驗(yàn)證




評(píng)論