2024年11月19日,日本電氣硝子株式會社(Nippon Electric Glass Co.,Ltd.,NEG)宣布與 Via Mechanics,Ltd. 簽署了聯(lián)合開發(fā)協(xié)議,旨在加速開發(fā)用于半導體封裝的玻璃或玻璃陶瓷制成的基板。
目前的半導體封裝中,以玻璃環(huán)氧基板等有機材料為基材的封裝基板仍占主流,但在未來需求量更大的生成型AI等高端半導體封裝中,核心層基板和微加工孔(通孔)需要具有電氣特性,以實現(xiàn)進一步小型化、更高密度和高速傳輸。由于基于有機材料的基板難以滿足這些需求,因此玻璃作為替代材料引起了人們的關(guān)注。
另一方面,普通玻璃基板在使用CO?激光打孔時容易產(chǎn)生裂紋,增加了基板損壞的可能性,因此使用激光改性和蝕刻形成通孔的難度較高且加工時間較長。為了能夠使用CO?激光器形成通孔,日本電氣硝子與Via Mechanics簽訂了聯(lián)合開發(fā)協(xié)議,將日本電氣硝子多年來積累的玻璃和玻璃陶瓷專業(yè)知識與Via Mechanics的激光器相結(jié)合,同時引進Via Mechanics的激光加工設(shè)備,旨在快速開發(fā)半導體封裝玻璃基板。
審核編輯 黃宇
-
半導體封裝
+關(guān)注
關(guān)注
4文章
319瀏覽量
15239 -
基板
+關(guān)注
關(guān)注
2文章
321瀏覽量
24053
發(fā)布評論請先 登錄
氮化硅陶瓷封裝基板:抗蠕變性能保障半導體長效可靠

鍵合玻璃載板:半導體先進封裝的核心支撐材料

玻璃芯片基板成功實現(xiàn)激光植球技術(shù)新突破

玻璃基板技術(shù)的現(xiàn)狀和優(yōu)勢

第三代半導體崛起催生封裝材料革命:五大陶瓷基板誰主沉浮?

請問RT-Thread與stm32cubemx聯(lián)合開發(fā)的原理是什么?
用于高性能半導體封裝的玻璃通孔技術(shù)

TGV技術(shù):推動半導體封裝創(chuàng)新的關(guān)鍵技術(shù)

DPC陶瓷基板:高精密電子封裝的核心材料


精密劃片機在切割陶瓷基板中有哪些應(yīng)用場景
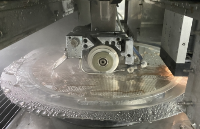
震驚!半導體玻璃芯片基板實現(xiàn)自動激光植球突破




 這一聯(lián)合開發(fā)涉及半導體封裝玻璃陶瓷基板
這一聯(lián)合開發(fā)涉及半導體封裝玻璃陶瓷基板





評論