根據(jù)Canalys預(yù)測(cè),兼容AI的個(gè)人電腦將從2025年開(kāi)始快速普及,預(yù)計(jì)至2027年約占所有個(gè)人電腦出貨量的60%,AI 有望提振消費(fèi)者需求。在高性能AI處理器的加持以及消費(fèi)者需求下,消費(fèi)電子終端產(chǎn)品持續(xù)向高集成、輕薄化方向發(fā)展的大趨勢(shì)下,芯片和元器件體積不斷縮小,功率密度卻在快速增加,消費(fèi)電子產(chǎn)品的散熱方案需要不斷升級(jí)。
封裝材料成本通常會(huì)占到整體封裝成本的 40%~60%,其中多種封裝材料決定了芯片散熱性能的優(yōu)劣,如固晶膠/膜、熱界面材料(TIM)、均熱片及散熱器以及底部填充料(Underfill)等。
特此分享方正證券《半導(dǎo)體材料行業(yè)專(zhuān)題報(bào)告—芯片功耗提升,散熱重要性凸顯》,供大家了解市場(chǎng)需求、主要封裝材料及其發(fā)展趨勢(shì)。
內(nèi)容大綱:
1 芯片性能提升催生散熱需求,封裝材料市場(chǎng)穩(wěn)健增長(zhǎng)
2 黏接材料:由 DAP 向 DAF 升級(jí)
3 散熱材料:芯片功率提升的重要防線
3.1 熱界面材料(TIMs)
3.2 均熱片
3.3 散熱器
4 Underfill:倒裝芯片封裝的關(guān)鍵材料





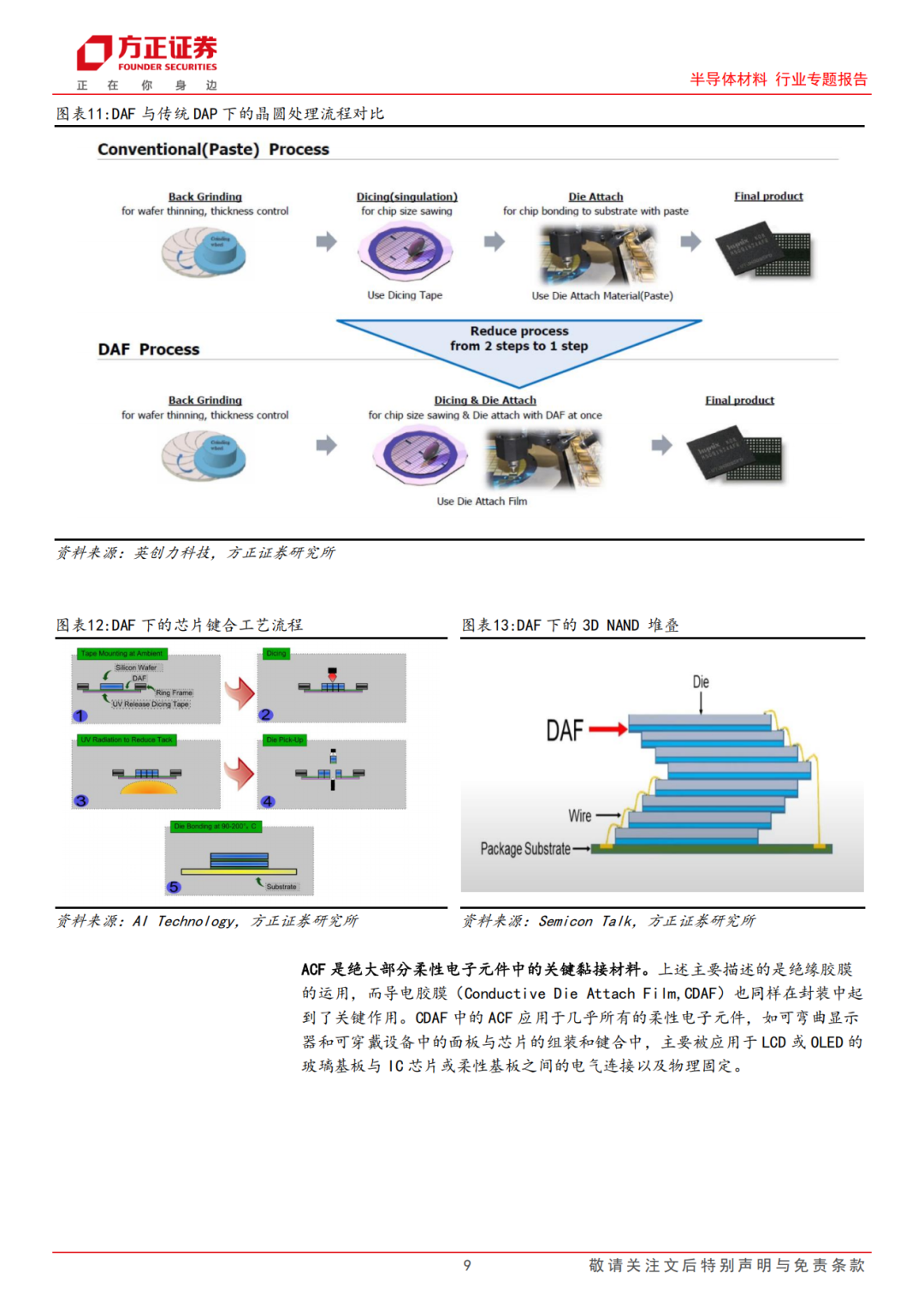






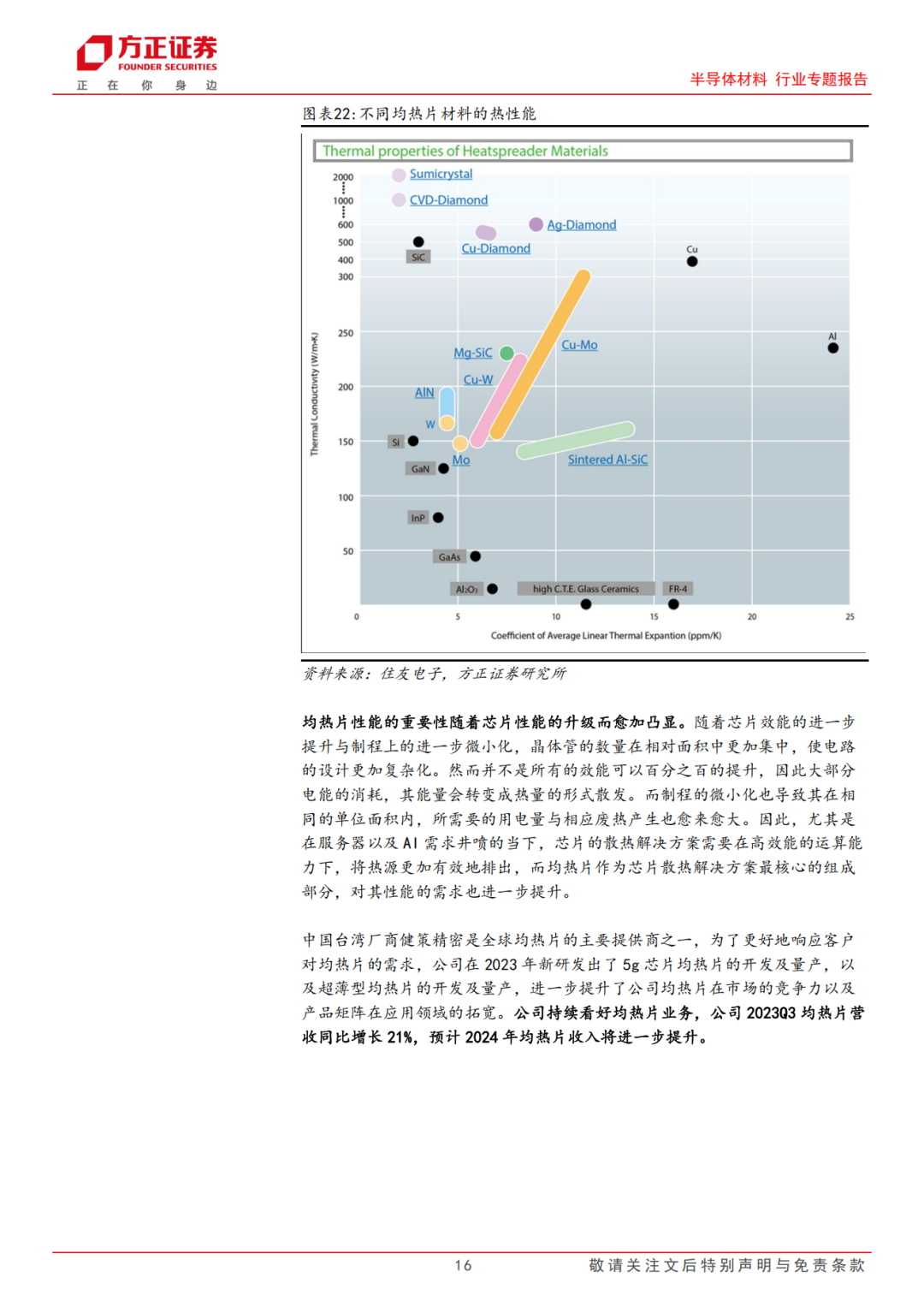
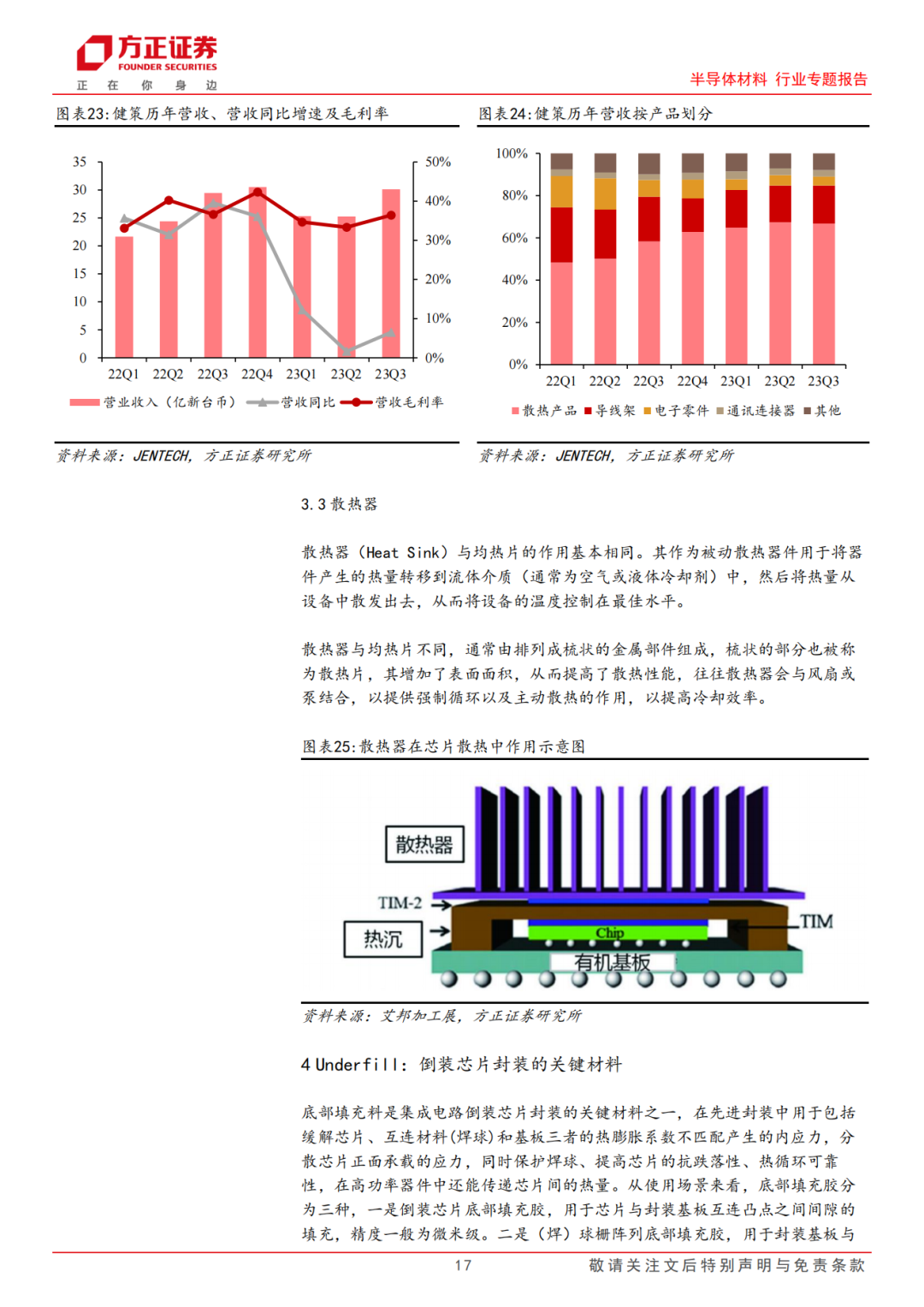



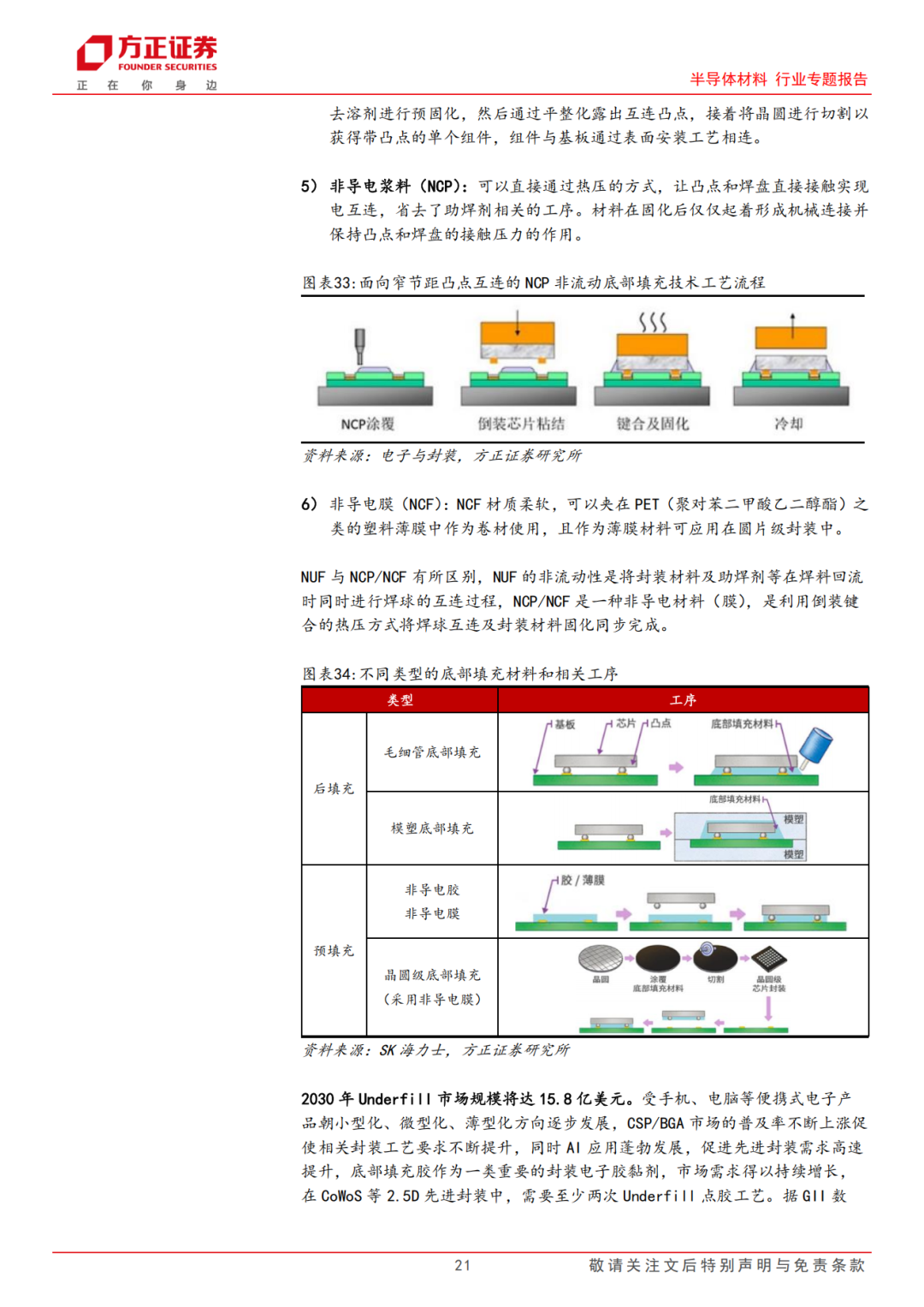

來(lái)源:天通智造、新材料在線、方正證券
以上部分資料轉(zhuǎn)載“車(chē)乾6G”網(wǎng)絡(luò)平臺(tái),文章僅用于交流學(xué)習(xí)版權(quán)歸原作者。如有侵權(quán)請(qǐng)告知立刪。
-
芯片
+關(guān)注
關(guān)注
463文章
54007瀏覽量
465935 -
散熱材料
+關(guān)注
關(guān)注
0文章
36瀏覽量
7793 -
AI算力
+關(guān)注
關(guān)注
1文章
143瀏覽量
9857
發(fā)布評(píng)論請(qǐng)先 登錄

將AI算力送上太空,是終極方案還是瘋狂幻想?評(píng)論區(qū)說(shuō)出你的陣營(yíng)!
賦能電源芯片國(guó)產(chǎn)替代,智芯谷助力AI算力穩(wěn)定前行


國(guó)產(chǎn)AI芯片真能扛住“算力內(nèi)卷”?海思昇騰的這波操作藏了多少細(xì)節(jié)?
算力需求狂飆下的“效率競(jìng)賽”,國(guó)產(chǎn)AI芯片有何破局之道?

AI安防選什么主板?杰和IB3-761靠“算力精準(zhǔn)+多接口”出圈

什么是AI算力模組?

什么是AI算力模組?

一文看懂AI算力集群

大算力芯片的生態(tài)突圍與算力革命
智能算力最具潛力的行業(yè)領(lǐng)域

RAKsmart服務(wù)器如何重塑AI高并發(fā)算力格局
DeepSeek推動(dòng)AI算力需求:800G光模塊的關(guān)鍵作用
存力接棒算力,慧榮科技以主控技術(shù)突破AI存儲(chǔ)極限




 AI算力需求激增,芯片散熱材料如何選?
AI算力需求激增,芯片散熱材料如何選?





評(píng)論