針對BGA(球柵陣列)底部填充膠(Underfill)固化異常延遲或不固化的問題,需從材料、工藝、設備及環境等多方面進行綜合分析。以下為常見原因及解決方案
一、原因分析
1.材料問題
膠水過期或儲存不當:未按供應商要求儲存(如溫度、濕度、避光等),導致膠水性能劣化。
材料受潮:吸濕性膠水因濕氣干擾固化反應。
2.固化條件不達標
溫度不足或時間過短:未達到膠水固化所需的溫度曲線(如未達到推薦的120℃或時間不足)。
溫度分布不均:回流焊爐或固化爐溫度均勻性差,局部區域未達固化溫度。
UV固化膠的光照不足:UV燈強度衰減或照射時間不足。
3.工藝操作問題
點膠不均勻:膠水未充分填充BGA底部間隙,導致局部固化不良。
膠水滲透性差:膠水未完全覆蓋焊點,存在氣泡或空隙。
-固化前預固化不足:未完成預固化(如低溫預固化)直接進入主固化階段。
4.環境因素
濕度過高:濕氣干擾固化反應(尤其對濕氣敏感型膠水)。
氧氣抑制(自由基固化膠水):氧氣阻聚導致表面發粘或不固化。
5.設計兼容性問題
BGA間隙過小:膠水無法充分流動,導致填充不良。
材料與基板不匹配:膠水與PCB基板或焊球材料的熱膨脹系數(CTE)差異過大。

二、解決方案
1.材料優化
嚴格管控材料:檢查膠水有效期及儲存條件(如低溫干燥環境),避免使用過期或劣化材料。
選擇低吸濕性膠水:改用對濕氣不敏感的材料(如陽離子固化膠)。
2.固化條件調整
驗證溫度曲線:使用溫度曲線測試儀(如KIC測溫儀)確認固化爐實際溫度與設定值一致,確保達到膠水TDS(技術數據表)要求。
優化固化設備:調整爐內熱風循環或增加均溫板,改善溫度均勻性。
UV固化參數優化:定期檢測UV燈強度,必要時更換燈管;延長照射時間或增加照射角度。
3.工藝改進
優化點膠參數:調整點膠速度、壓力及路徑,確保膠水均勻覆蓋BGA底部間隙。
提高膠水流動性:預熱基板(如60~80℃)或選擇低粘度膠水,改善填充效果。
分階段固化:按膠水要求進行預固化(如80℃/30min)+主固化(如150℃/60min)。
4.環境控制
濕度管控:生產環境濕度控制在40%~60%(視膠水類型而定),必要時使用除濕機。
隔絕氧氣:對自由基固化膠水,可在氮氣環境下固化或選用厭氧型膠水。
5.設計與兼容性驗證
優化BGA設計:與PCB設計團隊協作,確保BGA與基板間隙合理(推薦50~100μm)。
材料兼容性測試:通過熱循環試驗(-40℃~125℃)驗證膠水與基板的CTE匹配性。
三、測試與監控
1.固化過程監控:
使用示蹤劑(如DSC分析)檢測固化度,確保達到90%以上。
通過紅外熱成像儀檢查固化溫度均勻性。
2.固化后檢測:
切片分析:觀察膠水填充是否完全,是否存在氣泡或空洞。
推力測試:驗證BGA焊點與膠水的結合強度。
電性能測試:檢查電氣連接可靠性(如菊花鏈測試)。
四、總結
固化異常的根本原因通常是材料、工藝、設備或環境的綜合作用。建議通過以下步驟系統排查:
1.確認膠水型號與工藝要求匹配;
2.驗證固化設備參數與膠水TDS一致性;
3.優化點膠工藝及環境條件;
4.必要時與膠水供應商聯合分析,提供失效樣品進行FTIR或DSC測試。
通過以上措施,可顯著提升BGA底部填充膠的固化可靠性,避免因固化不良導致的焊點開裂或器件失效。
-
BGA
+關注
關注
5文章
585瀏覽量
51723 -
芯片封裝
+關注
關注
13文章
619瀏覽量
32354
發布評論請先 登錄
BGA/VGA四角邦定UV膠(替代傳統底部填充膠)
導熱灌封膠固化后表面不均勻的原因
UVLED固化機在光學鏡片UV膠固化的應用
手機SIM卡和銀行卡芯片封裝和bga底部填充膠方案
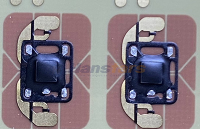
工業計算機電腦主板CPU,BGA芯片底部填充膠應用
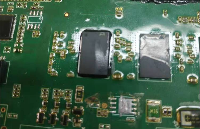



 BGA底部填充膠固化異常延遲或不固化原因分析及解決方案
BGA底部填充膠固化異常延遲或不固化原因分析及解決方案



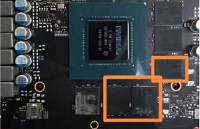

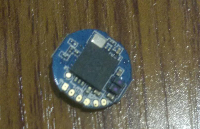






評論