一、玻璃基板為何有望成為封裝領域的新寵?
玻璃基板在先進封裝領域備受關注,主要源于其相較于傳統硅和有機物材料具有諸多顯著優勢。
從成本角度看,玻璃轉接板的制作成本約為硅基轉接板的 1/8 ,這得益于大尺寸超薄面板玻璃易于獲取且無需沉積絕緣層。在電學性能方面,玻璃材料介電常數僅約為硅材料的 1/3,損耗因子比硅低 2 - 3 個數量級,可有效減小襯底損耗和寄生效應,提升信號傳輸完整性。同時,玻璃基板具備大尺寸超薄特性,康寧等廠商可量產大于 2m×2m 的超大尺寸和小于 50μm 的超薄面板玻璃。此外,其工藝流程簡單,無需在襯底表面及 TGV 內壁沉積絕緣層,超薄轉接板也無需二次減薄,且機械穩定性強,當轉接板厚度小于 100μm 時翹曲較小 。
英特爾持續加碼玻璃基板領域,早在十年前就開始探索,計劃于 2030 年批量生產玻璃基板封裝芯片,認為玻璃基板有望成為下一代主流基板材質,這也推動了玻璃基板在行業內的關注度提升。
二、TGV 在玻璃基板應用中起到什么關鍵作用?
TGV(Through Glass Via,玻璃通孔)技術是玻璃基板應用于先進封裝的關鍵工藝。它是 TSV 技術的延續,主要區別在于基板種類,TGV 采用高品質硼硅玻璃、石英玻璃作為中介層基板,以獲得比硅中介層更好的封裝表現。
在 3D 封裝中,以 HBM 工藝為例,TSV 是關鍵技術之一,而對于玻璃基板的 3D 封裝,TGV、銅孔的填充及其 RDL 成為關鍵工藝。TGV 技術的優勢在于可降低信號傳輸距離,增加帶寬并實現封裝小型化。同時,TGV 作為 TSV 的低成本替代方案,逐漸受到廣泛關注,因為硅基轉接板存在成本高和電學性能差的問題,而 TGV 省去了沉積隔離層、絕緣層的過程。然而,TGV 目前面臨通孔成孔工藝以及高質量填充兩方面的挑戰。
三、玻璃通孔成孔技術有哪些?各有何特點?
噴砂法:加工前需在玻璃基板制作復合掩模,然后進行干粉噴砂蝕刻,需兩側蝕刻且保證中心點對稱。該方法制作的通孔粗糙、孔徑大且一致性差,只能制作孔徑大于 200μm、間距較大的玻璃通孔,沙粒碰撞還會對玻璃表面及孔側壁造成損傷,在先進封裝工藝中應用較少。
聚焦放電法:將玻璃放在兩電極間,通過放電熔融和內部應力形成通孔,可制備多種玻璃通孔,均勻性好、無裂紋,但單次單孔制作,生產效率低,通孔形狀不垂直,可能影響后續填充。
等離子體刻蝕法:先在石英玻璃蒸發鋁層作硬掩模,光刻后用氯氣等腐蝕鋁層,再用氧氣等離子體去光刻膠,最后蝕刻石英形成 TGV。該方法可大面積刻蝕多個 TGV,生產效率較高,側壁粗糙度小、無損傷,可靠性好,但工藝復雜、成本高且刻蝕速率慢。
激光燒蝕法:利用激光能量燒蝕玻璃形成通孔,如激光形成的 TGV 側壁裂紋多,準分子激光形成的 TGV 孔壁粗糙度大且成孔效率低。
電化學放電加工法:結合電火花和電解加工,通過電解液的電化學放電和化學腐蝕去除材料。工藝簡單、設備要求低,但只能加工孔徑大于 300μm 的錐形玻璃通孔,應用范圍受限。
光敏玻璃法:通過紫外曝光、熱處理、濕法刻蝕等加工,可實現各向異性刻蝕,獲得高密度、高深寬比通孔,但光敏玻璃材料和工藝成本高,不同尺寸圖形刻蝕精度差別大,高溫處理易導致結構偏移。
激光誘導刻蝕法:通過脈沖激光誘導玻璃產生變性區,再用氫氟酸刻蝕形成通孔。可形成孔徑大于 20μm 的玻璃通孔,成孔質量均勻、一致性好、無裂紋,成孔速率快且形貌可調,但存在激光誘導速度慢、制備過程復雜等缺點,不過該方法具有低成本優勢,有大規模應用前景。
四、玻璃通孔填孔技術如何實現高質量金屬填充?
高質量的金屬填充是玻璃通孔應用的另一技術難點。一方面,TGV 孔徑大、形狀多樣(盲孔、垂直通孔、X 型通孔、V 型通孔),對銅沉積挑戰大,易堵塞;另一方面,玻璃與常用金屬粘附性差,易分層、卷曲、脫落。目前主要填充工藝如下:
Bottom-up 填充:用于 TGV 盲孔填充,通過在孔口側壁及表面添加抑制劑,底部添加加速劑,使銅自下而上填充,確保盲孔無孔洞和縫隙。
蝶形填充:適用于垂直 TGV 通孔。先在通孔壁按 “兩邊多,中間少” 涂抹抑制劑,使銅在孔中心優先沉積形成蝶形,隨后轉變為 Bottom - up 填充實現完全填充。Dimitrov 課題組提出的改良方案,使用酒精預潤濕、特定鍍液和添加劑,可在一定時間內實現不同深寬比 TGV 的完整填充,但工藝復雜,工業化生產難度大。
Conformal 填充:通過添加劑使孔內銅沉積速率與孔側壁及表面相當,適用于 X 和 V 型通孔。X 形、V 形通孔特殊形狀可避免中央孔洞缺陷,相比垂直通孔的 BFT 電鍍模式,可在更大電流密度下實現快速完整填充。
TGV 孔內電鍍薄層:在保證電學性能前提下,可減小電鍍時間和成本,孔深和孔徑適用范圍更大。通常需先沉積金屬粘附層,近年來研發人員開發化鍍 Cu 種子層低成本填充方案,如美國安美特公司通過形成金屬氧化物黏附層,喬治亞理工學院采用環氧聚合物干膜增強 Cu 與玻璃的結合力。
五、玻璃基板產業鏈上有哪些重點公司?
玻璃基板供應商:
海外方面,美國康寧是全球龍頭,可提供 4 - 12 英寸、厚度 100 - 700μm 的玻璃晶圓基板,TGV 孔徑 20 - 100μm,深寬比可達 10:1。德國肖特公司的 Hermes 玻璃晶圓基板可用于多種器件封裝;Mosaic Microsystems 公司能提供全流程玻璃晶圓加工服務;日本印刷株式會社開發出玻璃芯基板產品。
國內廠商也在快速發展,云天半導體突破 4 - 12 寸晶圓級系統封裝能力,TGV 關鍵指標達國際領先;沃格光電掌握多項核心技術,玻璃基 Mini LED 背光產品量產,TGV 載板通過客戶驗證;森丸電子專注于無源互連特殊工藝,可提供多種尺寸玻璃晶圓;三疊紀突破亞 10 微米通孔和填充技術;賽微電子旗下瑞典代工廠掌握領先的 TGV 工藝;五方光電的玻璃基板用于光學墊片和車載領域;藍特光學的 TGV 玻璃晶圓應用于多個領域。
TGV 設備廠商:
激光開孔設備廠商中,LPKF 的 Vitrion S 5000 系統適用于多種玻璃基板加工,TGV 孔徑最小 10 微米,深寬比可達 10:1(部分材料 50:1);4JET Microtech 的 VLIS 工藝可高效制備高精度 TGV。國內帝爾激光推出 TGV 激光微孔設備,大族激光研制出激光誘導蝕刻快速成型技術設備,德龍激光研發出玻璃通孔等激光精細微加工設備。
電鍍設備方面,美國泛林公司推出 Kallisto 和 Phoenix 兩款 TGV 電鍍解決方案;盛美上海是國內前道電鍍設備領先企業,其電鍍設備可應用于多通道先進封裝關鍵電鍍步驟。
-
封裝
+關注
關注
128文章
9248瀏覽量
148614 -
玻璃基板
+關注
關注
1文章
104瀏覽量
11069
原文標題:玻璃基板:先進封裝領域的變革力量與投資洞察
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
IPC-6921有機封裝基板國際標準即將落地

鍵合玻璃載板:半導體先進封裝的核心支撐材料
TGV產業發展:玻璃通孔技術如何突破力學瓶頸?
用于高性能半導體封裝的玻璃通孔技術

PEEK注塑電子封裝基板的創新應用方案
2.5D封裝為何成為AI芯片的“寵兒”?

震驚!半導體玻璃芯片基板實現自動激光植球突破




 玻璃基板為何有望成為封裝領域的新寵
玻璃基板為何有望成為封裝領域的新寵





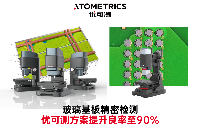



評論