電鍍一個(gè)關(guān)鍵部分是利用電流將所需材料沉積到基材表面,但玻璃基板是非導(dǎo)電材料,必須使其表面導(dǎo)電,這就需要先鍍一層電鍍銅。當(dāng)然,還需要更好的粘合劑,由于玻璃表面平滑,與常用金屬(如Cu)的黏附性較差,容易造成玻璃襯底與金屬層卷曲甚至脫落等現(xiàn)象。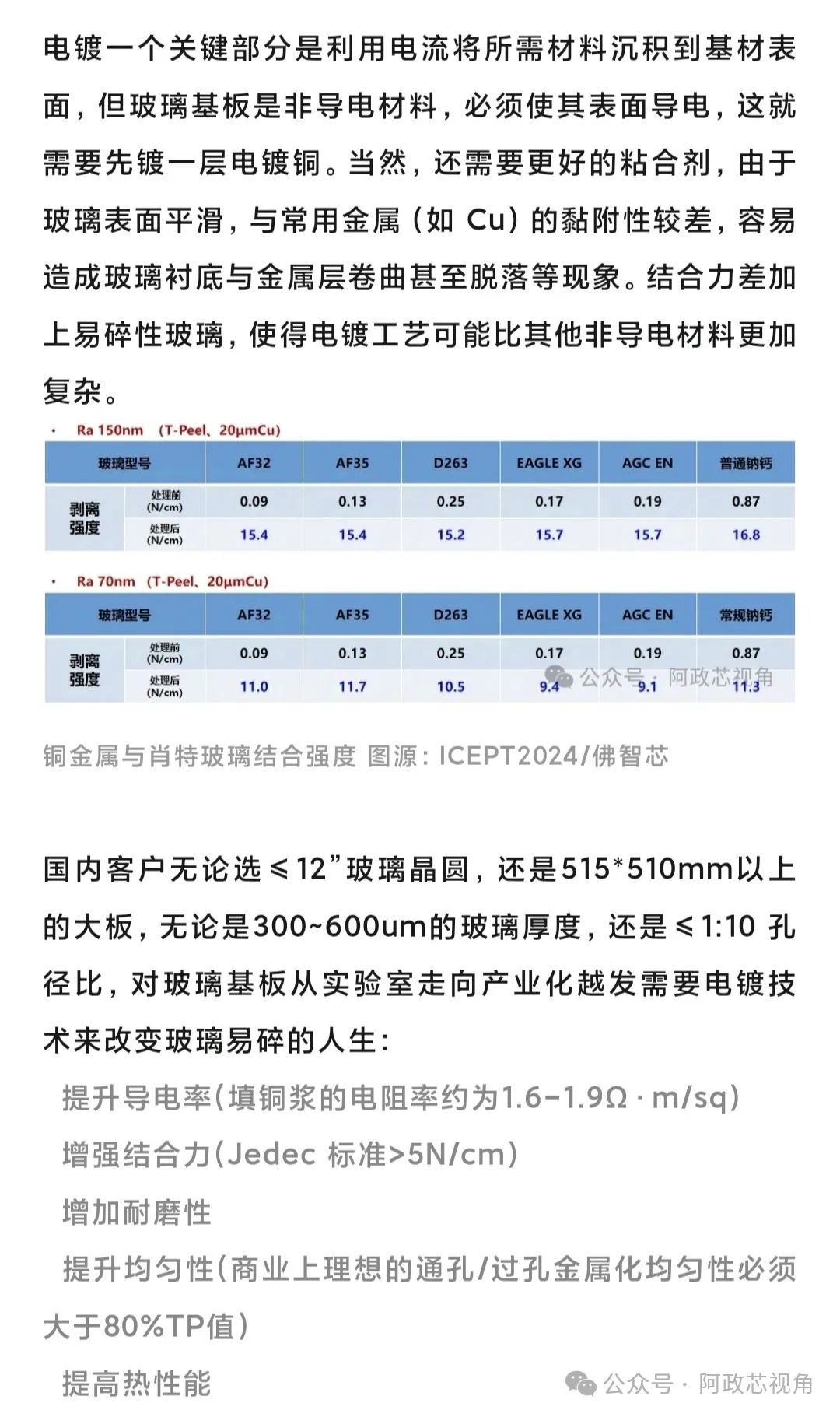





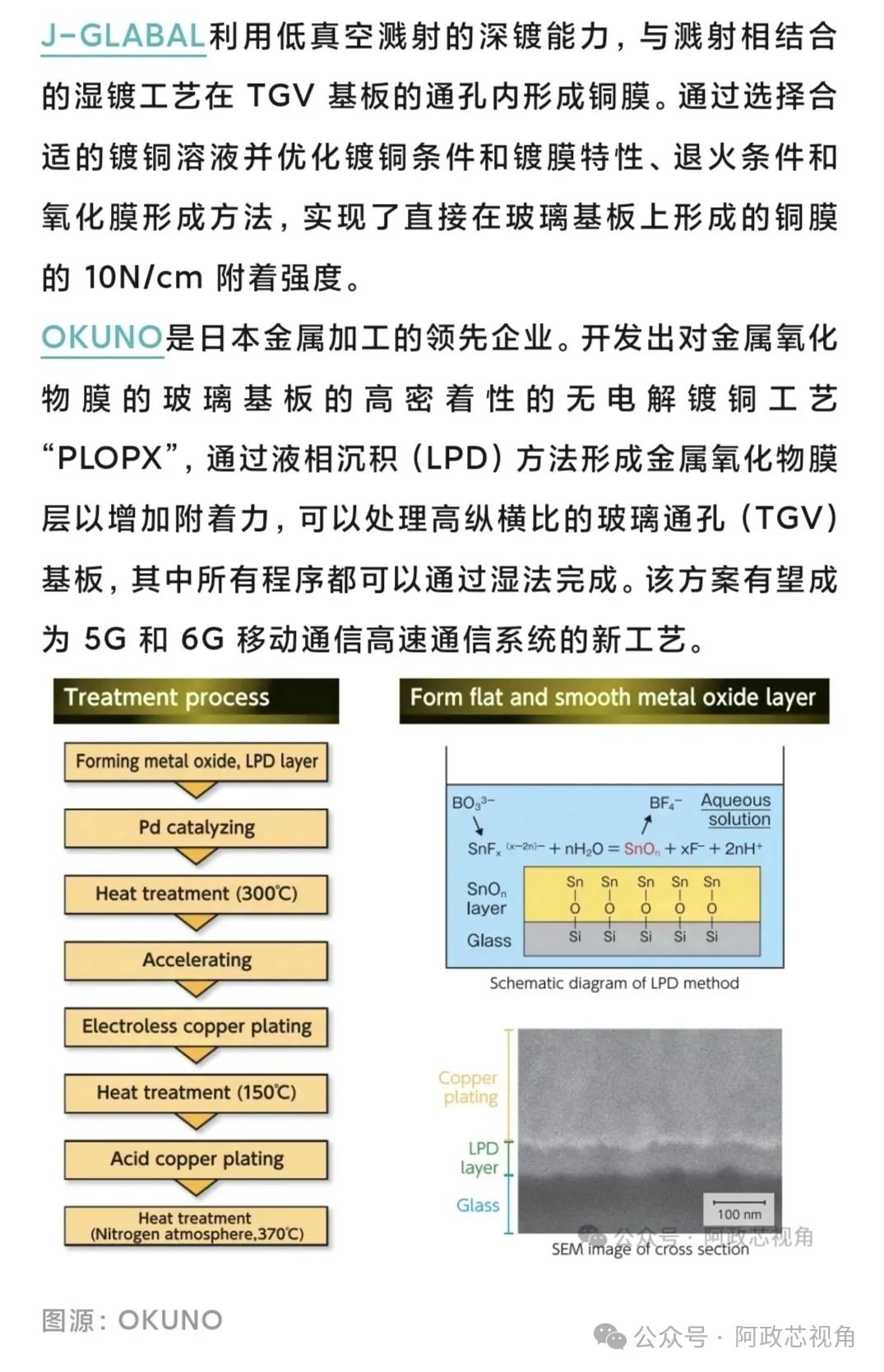



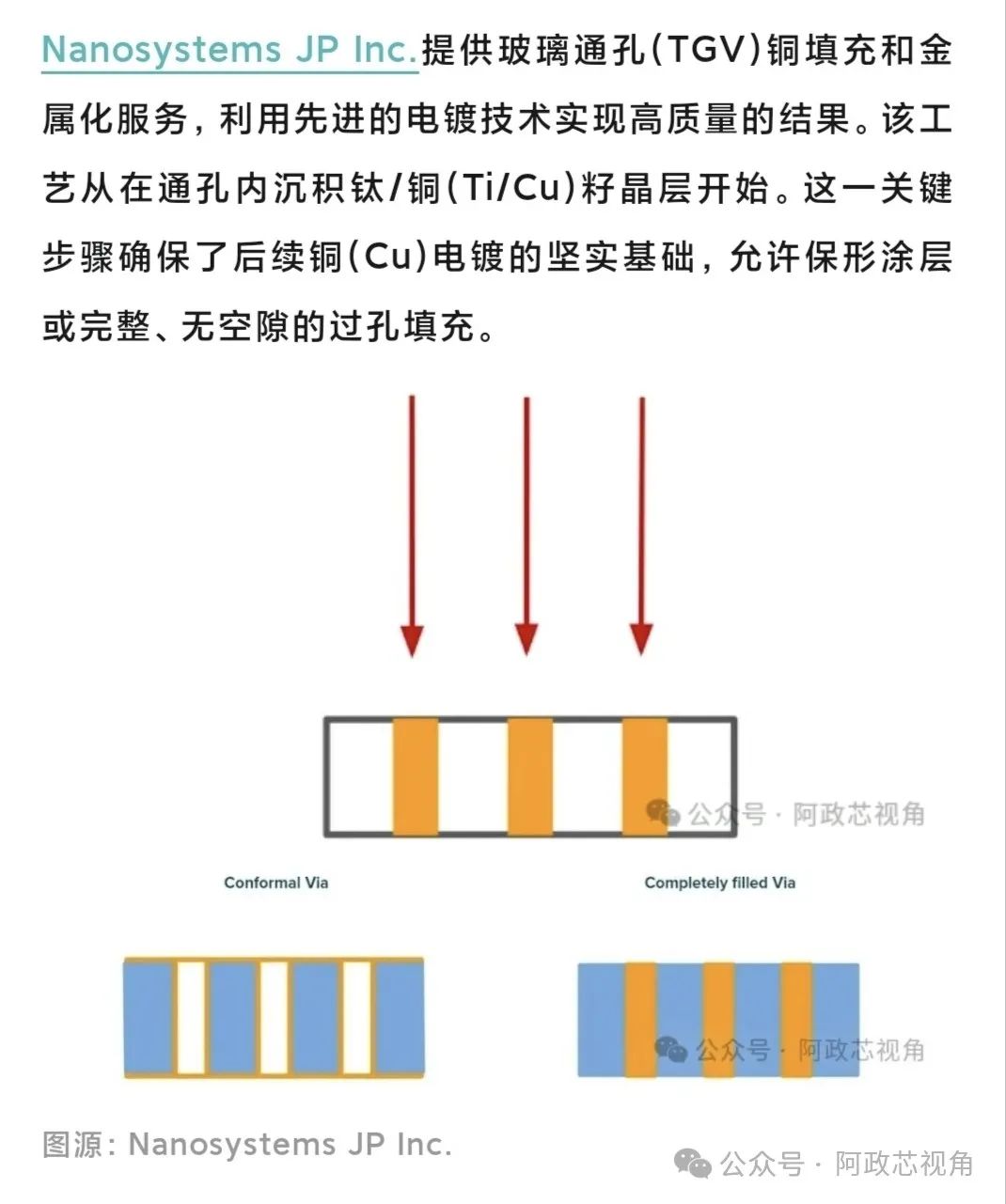

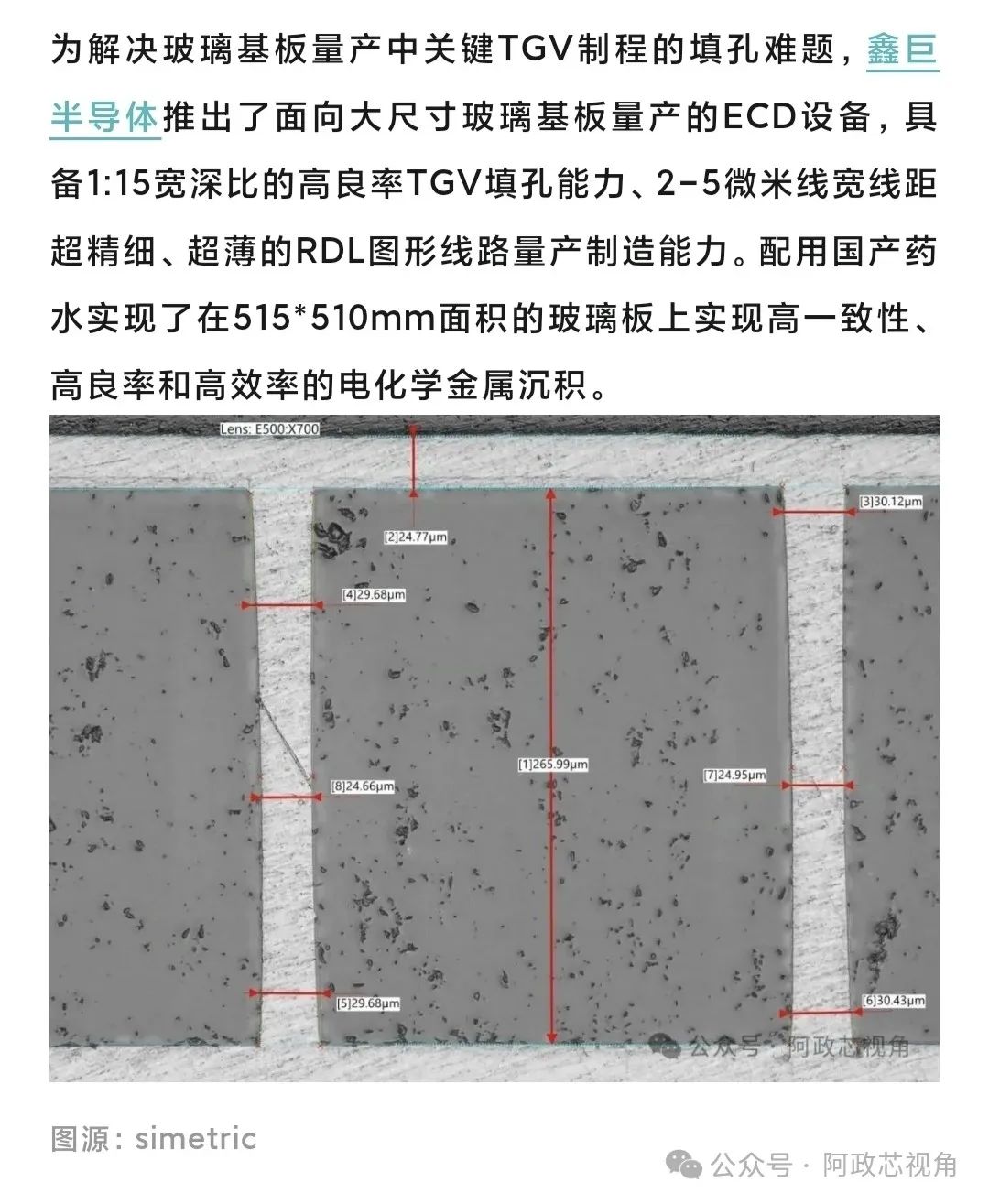
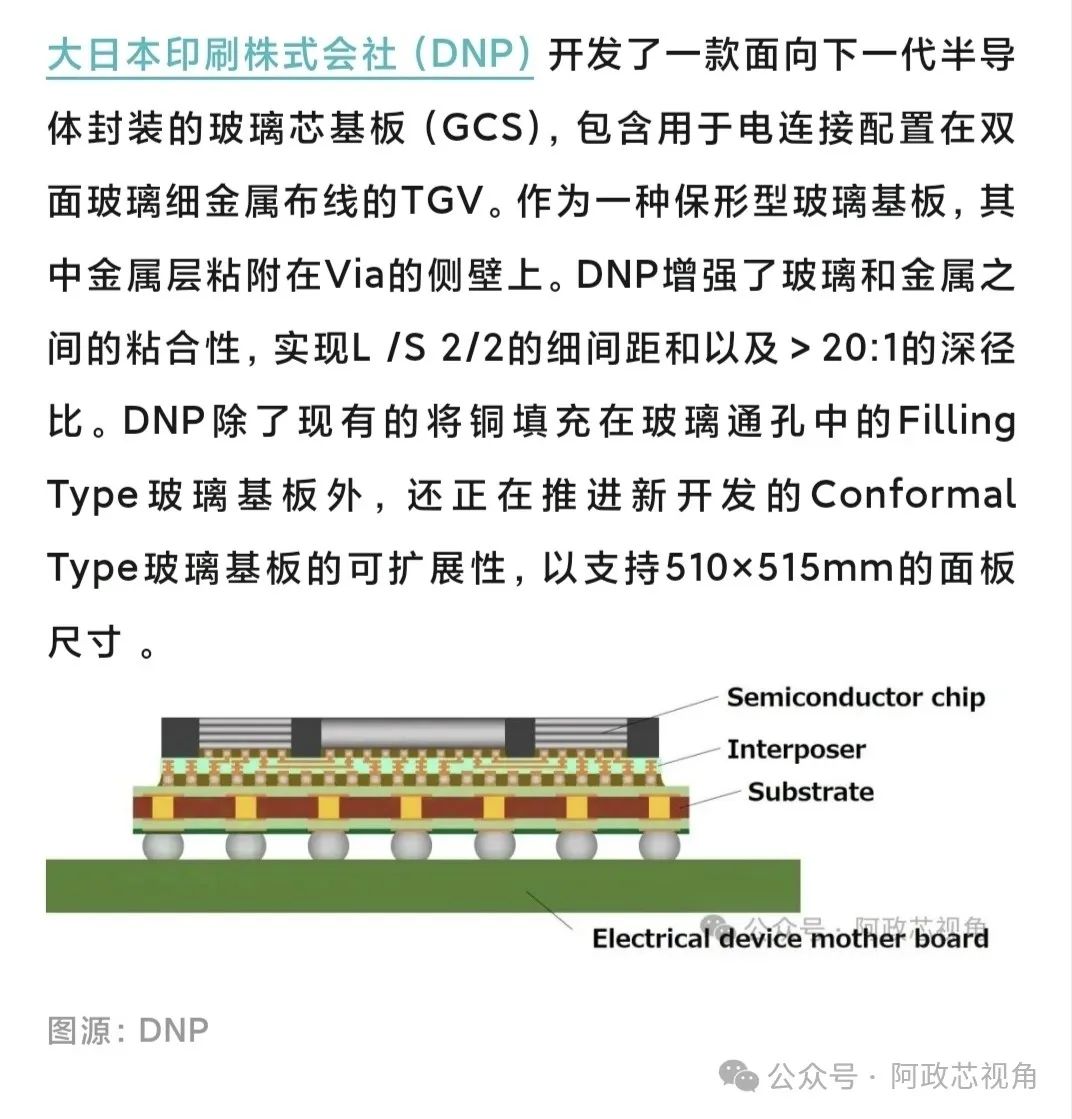



聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點(diǎn)僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場(chǎng)。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請(qǐng)聯(lián)系本站處理。
舉報(bào)投訴
-
電鍍
+關(guān)注
關(guān)注
16文章
478瀏覽量
25839 -
玻璃基板
+關(guān)注
關(guān)注
1文章
104瀏覽量
11089 -
導(dǎo)電
+關(guān)注
關(guān)注
0文章
252瀏覽量
22276
原文標(biāo)題:玻璃基板 | 通孔金屬化電鍍技術(shù)
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
熱點(diǎn)推薦
芯片封裝用玻璃基板四大核心技術(shù)一覽
有望在電子產(chǎn)品中獲得更廣泛應(yīng)用,進(jìn)而推動(dòng)整個(gè)產(chǎn)業(yè)鏈的創(chuàng)新升級(jí)。玻璃基板芯板的結(jié)構(gòu)實(shí)現(xiàn)與功能落地,核心依賴四類關(guān)鍵技術(shù),即玻璃通孔(TGV)成

激光誘導(dǎo)燒火協(xié)同無銀化Ni/Cu電鍍:高性能TOPCon電池金屬化應(yīng)用
全球能源轉(zhuǎn)型加速下,晶體硅太陽電池仍占據(jù)超95%市場(chǎng)份額,其中TOPCon技術(shù)憑借隧穿氧化硅/多晶硅鈍化接觸結(jié)構(gòu)成為產(chǎn)業(yè)化主流,最高效率已達(dá)26.4%。然而,傳統(tǒng)絲網(wǎng)印刷銀漿成本高、碳足跡大,電鍍

與NOKIA大咖共敘 | 玻璃芯技術(shù)的優(yōu)勢(shì)所在
其應(yīng)用價(jià)值 。 ? ? Samtec采用獨(dú)特的玻璃加工技術(shù),實(shí)現(xiàn)了 光刻級(jí)精度控制 、 金屬化工藝穩(wěn)定性 ,以

松下汽車用金屬化聚丙烯薄膜電容器ECWFJ系列技術(shù)分析
松下汽車用金屬化聚丙烯薄膜電容器ECWFJ系列技術(shù)分析 在電子設(shè)備的設(shè)計(jì)中,電容器作為關(guān)鍵元件,其性能直接影響著整個(gè)電路的穩(wěn)定性和可靠性。今天,我們來深入探討一下松下的ECWFJ系列金屬化聚丙烯薄膜
探秘Class Y2浸漬金屬化紙EMI抑制電容器SMP253
探秘Class Y2浸漬金屬化紙EMI抑制電容器SMP253 在電子工程師的日常設(shè)計(jì)工作中,選擇合適的電容器對(duì)于抑制電磁干擾(EMI)至關(guān)重要。今天,我們就來深入了解一下KEMET的Class Y2
金屬化薄膜電容是什么?結(jié)構(gòu)原理、材料分類與應(yīng)用全面解析
貞光科技從車規(guī)微處理器MCU、功率器件、電源管理芯片、信號(hào)處理芯片、存儲(chǔ)芯片、二、三極管、光耦、晶振、阻容感等汽車電子元器件為客戶提供全產(chǎn)業(yè)鏈供應(yīng)解決方案!金屬化薄膜電容結(jié)構(gòu)金屬化薄膜電容器是以

玻璃芯片基板成功實(shí)現(xiàn)激光植球技術(shù)新突破
紫宸激光焊錫應(yīng)用ApplicationofVilaserSoldering高效節(jié)能綠色環(huán)保行業(yè)領(lǐng)先微型化浪潮下的封裝革命在5G通信、人工智能、自動(dòng)駕駛等技術(shù)的推動(dòng)下,半導(dǎo)體器件正朝著更高集成度、更小

金屬淀積工藝的核心類型與技術(shù)原理
在集成電路制造中,金屬淀積工藝是形成導(dǎo)電結(jié)構(gòu)(如互連線、柵電極、接觸塞)的關(guān)鍵環(huán)節(jié),主要包括蒸發(fā)、濺射、金屬化學(xué)氣相淀積(金屬 CVD)和銅電鍍四種
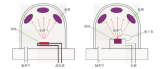
TGV產(chǎn)業(yè)發(fā)展:玻璃通孔技術(shù)如何突破力學(xué)瓶頸?
這場(chǎng)技術(shù)革命中,玻璃基板封裝憑借其優(yōu)異的物理特性——更大的封裝尺寸、更低的傳輸損耗、更強(qiáng)的抗翹曲能力,被視為替代硅中介層的關(guān)鍵材料。然而,玻璃通孔
從DBC到AMB:氮化鋁基板金屬化技術(shù)演進(jìn)與未來趨勢(shì)
,AlN陶瓷的強(qiáng)共價(jià)鍵特性導(dǎo)致其與金屬材料的浸潤(rùn)性較差,這給金屬化工藝帶來了巨大挑戰(zhàn)。下面由金瑞欣小編介紹當(dāng)前氮化鋁陶瓷基板金屬化的主流技術(shù)

太陽能電池金屬化印刷技術(shù)綜述:絲網(wǎng)印刷優(yōu)化、質(zhì)量控制與新興技術(shù)展望
本文全面綜述了硅太陽能電池金屬化印刷技術(shù),重點(diǎn)關(guān)注絲網(wǎng)印刷的演進(jìn)、核心挑戰(zhàn)(如細(xì)線柵線、銀漿消耗優(yōu)化)、漿料流變學(xué)作用,并通過美能網(wǎng)版智能檢測(cè)儀進(jìn)行質(zhì)量控制,確保印刷過程的精度。最后對(duì)比新興技術(shù)(如

功率器件電鍍的原理和步驟
在功率半導(dǎo)體制程里,電鍍扮演著舉足輕重的角色,從芯片前端制程到后端封裝,均離不開這一關(guān)鍵工序。目前,我國(guó)中高檔功率器件在晶圓背面金屬化方面存在技術(shù)短板,而攻克這些技術(shù)難題的關(guān)鍵在于

電子封裝中的高導(dǎo)熱平面陶瓷基板及金屬化技術(shù)研究
隨著大功率器件朝著高壓、高電流以及小型化的方向發(fā)展,這對(duì)于器件的散熱要求變得更為嚴(yán)格。陶瓷基板因其卓越的熱導(dǎo)率和機(jī)械性能,被廣泛應(yīng)用于大功率器件的封裝工藝中。




 玻璃基板之通孔金屬化電鍍技術(shù)
玻璃基板之通孔金屬化電鍍技術(shù)


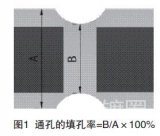



評(píng)論