在半導體技術迅猛發展的當下,玻璃基板憑借卓越的物理化學特性,在電子元件材料領域的作用愈發關鍵。玻璃基板技術的進步,不僅能提升封裝密度,更可顯著優化電子產品性能;隨著技術日趨成熟、成本效益持續提升,其有望在電子產品中獲得更廣泛應用,進而推動整個產業鏈的創新升級。
玻璃基板芯板的結構實現與功能落地,核心依賴四類關鍵技術,即玻璃通孔(TGV)成孔技術、玻璃表面及通孔內金屬化技術、玻璃通孔填孔(TGVF)技術與玻璃表面布線技術。這四類技術協同發力,共同支撐玻璃基板的產業化應用。
TGV成孔技術
TGV成孔技術是實現玻璃基板垂直電氣互連的核心,通過在玻璃基板精準打孔構建高效垂直互連路徑,大幅提升芯片封裝集成度與性能。當前業內主流成孔工藝包括噴砂成孔、超聲波鉆孔、濕法刻蝕、等離子刻蝕、激光刻蝕、激光誘導后濕法刻蝕等。目前,激光誘導后濕法刻蝕法因其較高的成孔質量顯示出大規模應用的潛力,采用皮秒/飛秒激光工藝對玻璃改質。在改質區域形成細微爆破孔,該區域被強堿/強酸蝕刻的速率顯著比其他區域更快,利用蝕刻速率差異,研究人員能夠在玻璃基板上制備出深寬比高達20∶1的通孔,且孔壁形貌良好,蝕刻過程還能消除激光帶來的微細裂紋和爆破孔。
 激光誘導刻蝕制作TGV的流程 來源:《玻璃通孔技術研究進展》(陳力等)
激光誘導刻蝕制作TGV的流程 來源:《玻璃通孔技術研究進展》(陳力等)
玻璃表面及通孔內金屬化
玻璃金屬化是通過物理或化學手段在玻璃表面及通孔內壁沉積金屬種子層,從而賦予玻璃表面與通孔導電性的關鍵工藝。目前,常用的種子層沉積方法主要為物理氣相沉積法(PVD)與化學鍍銅法。
玻璃金屬化的核心挑戰在于兩點:一是保障玻璃與金屬化種子層的結合力,二是確保種子層對玻璃通孔(TGV)的貫通覆蓋能力。研究表明,增加玻璃表面粗糙度可有效提升上述結合力,且隨著玻璃算術平均粗糙度(Ra)的提升,結合力呈現顯著增強的趨勢。
值得注意的是,化學鍍制備的金屬化種子層,其結合力略低于PVD法制備的種子層。推測這一現象與化學鍍層內部應力較高相關,但化學鍍法以液流為介質,更易于提升種子層的沉積分散性。若能解決化學鍍種子層的結合力問題,該方法將成為極具應用前景的玻璃金屬化技術路線。
玻璃通孔填孔
當前業內主流TGV填孔技術為銅漿塞孔和電鍍填孔,兩種方案各具優劣。銅漿是銅粉與有機黏合劑的均勻混合物,配合真空塞孔技術可實現TGV無空隙填充,適用于高厚徑比通孔;電鍍填孔技術基于電解沉積過程,主要包括由下至上填孔、蝶形填孔和保形填孔等方式。隨著TGV需求孔徑越來越小,厚徑比越來越大,先搭橋后填孔的蝶形(X形)填孔表現出較好的技術適配性。

厚徑比5∶1的TGV蝶形電鍍過程切片 來源:《玻璃基芯板制作流程概述》(梁智斌等)
玻璃表面布線
高密度線路圖形制作是玻璃基板技術的另一大瓶頸。作為有機樹脂載板的替代品,玻璃基載板沿用適配樹脂基板的成熟制程工藝與設備(如高密度互聯HDI技術、有機載板相關技術),可有效降低研發成本、提升生產效率。目前成熟的線路圖形技術包括減成法和半加成法(SAP):先進減成法可在薄面銅條件下完成通孔填孔,已應用于先進HDI電路板及芯片載板芯板制造;SAP通過在超薄種子銅層電鍍線路銅,后續閃蝕去除種子層,可實現銅線的精準制備,最大化電路密度,適配玻璃基板高密度布線需求。
這四類技術的協同發展,將推動玻璃基板在半導體封裝領域實現規模化應用,為半導體行業的高密度、高性能發展注入核心動力。
-
半導體
+關注
關注
339文章
31062瀏覽量
265712 -
基板
+關注
關注
2文章
324瀏覽量
24075 -
芯片封裝
+關注
關注
14文章
619瀏覽量
32365
發布評論請先 登錄
區塊鏈中的四大核心技術介紹
淺析先進封裝的四大核心技術




 芯片封裝用玻璃基板四大核心技術一覽
芯片封裝用玻璃基板四大核心技術一覽




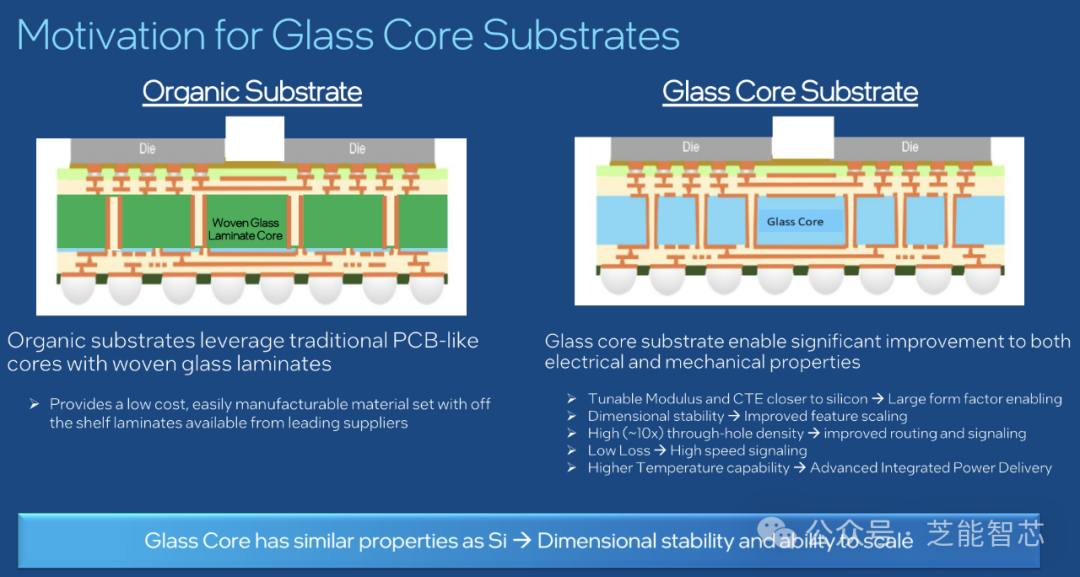






評論