本文介紹了SiO2薄膜的刻蝕機理。
干法刻蝕SiO2的化學方程式怎么寫?刻蝕的過程是怎么樣的?干法刻氧化硅的化學方程式?
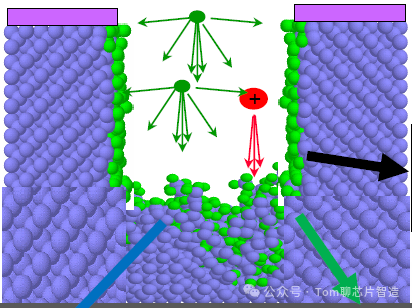
如上圖,以F系氣體刻蝕為例,反應的方程式為: SiO2(s)+ CxFy +Ar(+)>SiF4 (g)+ CO(g) CxFy是來自刻蝕氣體(如CF?、CHF?)解離產生的氟自由基,用于氧化硅的化學刻蝕。 Ar(+)是被加速的高能離子,起到物理轟擊的作用。 SiF4 :四氟化硅,氣相形式的揮發性產物。 CO:一氧化碳,副產物。 紅色箭頭代表離子轟擊,高能離子轟擊表面,破壞SiO?分子的鍵,為自由基提供更多反應位點,同時起到“方向性”作用,使刻蝕更具各向異性。 綠色箭頭代表氟自由基,即CxFy。Ar離子轟擊與化學刻蝕的結合,才能顯著提高刻蝕速率。單一的物理或化學機制均不足以實現高效刻蝕。 離子與中性粒子比值對反應速率的影響

如上圖: 中性粒子(自由基)濃度:Ar(+)濃度:當比值較低時,刻蝕速率主要受自由基的濃度限制。在高比值時,Ar離子轟擊成為限制因素,刻蝕速率趨于飽和。
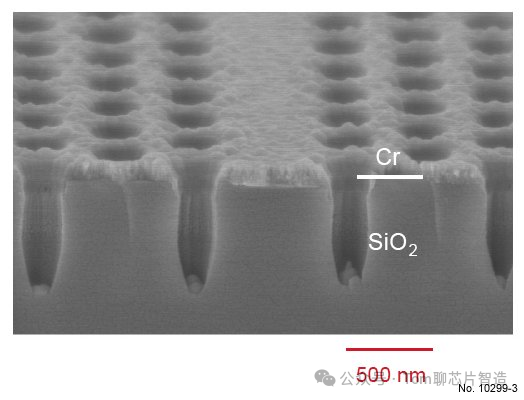
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
薄膜
+關注
關注
0文章
359瀏覽量
46152 -
SiO2
+關注
關注
0文章
24瀏覽量
8851 -
刻蝕
+關注
關注
2文章
220瀏覽量
13776
原文標題:SiO2薄膜的刻蝕機理
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
集成電路制造中薄膜生長設備的類型和作用
薄膜生長設備作為集成電路制造中實現材料沉積的核心載體,其技術演進與工藝需求緊密關聯,各類型設備通過結構優化與機理創新持續突破性能邊界,滿足先進節點對薄膜均勻性、純度及結構復雜性的嚴苛要求。

基于橢偏光譜法研究不同基底對TiO?/SiO?薄膜光學常數的影響
橢偏儀作為表征光學薄膜性能的核心工具,在光學薄膜領域具有不可替代的作用。本研究聚焦基底類型(K9玻璃、石英玻璃、單晶硅)對溶膠-凝膠法制備的TiO?和SiO?薄膜光學性能的調控機制。F

橢偏儀表征薄膜非晶相 | 精準分析不同襯底溫度下氫化非晶氧化硅(i-a-SiO?:H)薄膜的光學性質與結構
本征氫化非晶氧化硅(i-a-SiO?:H)是a-Si:H/c-Si異質結太陽電池的重要鈍化材料,兼具PECVD低溫沉積、帶隙寬等優勢,但i-a-SiO?:H鈍化性能與制備工藝、儀器密切相關;目前室溫

臺階儀表征MEMS壓力傳感器硅槽刻蝕:TMAH80℃下薄膜良率達到92.67%
當前MEMS壓力傳感器在汽車、醫療等領域的應用廣泛,其中應力敏感薄膜的厚度是影響傳感器性能的關鍵一,因此刻蝕深度合格且均勻性良好的薄膜至關重要。費曼儀器作為薄膜測量技術革新者,致力于為

濕法刻蝕sc2工藝應用是什么
濕法刻蝕SC2工藝在半導體制造及相關領域中具有廣泛的應用,以下是其主要應用場景和優勢:材料選擇性去除與表面平整化功能描述:通過精確控制化學溶液的組成,能夠實現對特定材料的選擇性去除。例如,它能

濕法刻蝕的主要影響因素一覽
濕法刻蝕是半導體制造中的關鍵工藝,其效果受多種因素影響。以下是主要影響因素及詳細分析:1.化學試劑性質與濃度?種類選擇根據被刻蝕材料的化學活性匹配特定溶液(如HF用于SiO?、KOH用于硅襯底
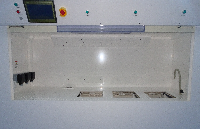
橢偏儀原理和應用 | 精準測量不同基底光學薄膜TiO?/SiO?的光學常數
橢偏儀作為表征光學薄膜性能的核心工具,在光學薄膜領域具有不可替代的作用。本研究聚焦基底類型(K9玻璃、石英玻璃、單晶硅)對溶膠-凝膠法制備的TiO?和SiO?薄膜光學性能的調控機制。F

VirtualLab Fusion應用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
VirtualLab Fusion中的橢圓偏振分析器在二氧化硅(SiO2)涂層上的使用。對于系統的參數,我們參考Woollam等人的工作 \"可變角度橢圓偏振光譜儀(VASE)概述。I.
發表于 06-05 08:46
芯片刻蝕原理是什么
芯片刻蝕是半導體制造中的關鍵步驟,用于將設計圖案從掩膜轉移到硅片或其他材料上,形成電路結構。其原理是通過化學或物理方法去除特定材料(如硅、金屬或介質層),以下是芯片刻蝕的基本原理和分類: 1. 刻蝕
半導體boe刻蝕技術介紹
泛應用。以下是其技術原理、組成、工藝特點及發展趨勢的詳細介紹: 一、技術原理 BOE刻蝕液是一種以氫氟酸(HF)和氟化銨(NH?F)為基礎的緩沖溶液,通過化學腐蝕作用去除半導體表面的氧化層(如SiO?、SiN?)。其核心反應機制包括: 氟化物離子攻擊: 氟化銨(NH?
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】芯片怎樣制造
的光刻膠,剩下未感光的光刻膠。
最后進行刻蝕,第五步是通過物理和化學手段把SiO2薄層上未被光刻膠保護的SiO2“刻蝕”掉,只保留受光刻膠保護的Si
發表于 04-02 15:59
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】了解芯片怎樣制造
工藝:光刻膠除膠,蝕刻未被保護的SiO2,顯影,除膠。 材料:晶圓,研磨拋光材料,光按模板材料。光刻膠,電子化學品。工業氣體,靶材,封裝材料 硅片制造:單晶硅棒拉制,硅棒切片,硅片研磨拋光,硅片氧化
發表于 03-27 16:38



 SiO2薄膜的刻蝕機理
SiO2薄膜的刻蝕機理







評論