▼關注公眾號:工程師看海▼
失效分析一直伴隨著整個芯片產業鏈,復雜的產業鏈中任意一環出現問題都會帶來芯片的失效問題。芯片從工藝到應用都會面臨各種失效風險,筆者平時也會參與到失效分析中,這一期就對失效分析進行系統的講解,筆者能力有限,且失效分析復雜繁瑣,只能盡力的總結一些知識體系,肯定會有很多不足與缺漏。
一.失效的定義:
造成失效的原因不一而足,失效的表現也紛擾復雜,在進行失效分析之前需要確定什么是失效?
1.性能異常:
這種情況比較常見,芯片的功能正常,但是某些性能未達標。面對這種情況更多的是從設計端入手,結合測試數據與設計指標去定位原因,無論是版圖還是電路設計問題,亦或是其他原因,失效分析時都要需要很精細的去排查問題。
2.功能異常:
芯片某些功能失常,甚至芯片無法啟動。而發生這種情況的原因大致有三種:
2.1 電路設計:
芯片完全滿足電路設計要求,但是問題出在電路設計上,電路有缺陷從而導致功能異常。這種情況下很多失效分析手段都無能為力,因為問題出在設計端,所有的芯片都面臨同一問題,無法提供參照指標,沒有基線也就無法判定“好”與“壞”。只能通過FIB對各個模塊進行切割/連接,利用Nano-Probe對各個模塊進行電學性能測量,從而慢慢推斷出問題,過程會伴隨著巨大的工作量。
2.2 芯片可靠性設計:
芯片本身的電路設計沒有問題,但是芯片在物理可靠性設計上有所欠缺,從而造成芯片存在可靠性缺陷。芯片在面對EOS、ESD、EMI、應力、溫度等外界刺激時發生了損傷,從而造成了功能失常。可靠性的強弱也直接決定了芯片量產后的良率。
2.3 工藝:
這種情況在先進工藝上比較明顯,Fab的工藝出現問題從而導致芯片失效。現在很多先進制程下的芯片最后的良率只能達到50%~60%很大因素是因為工藝上的問題(筆者的分析主要是針對已經固化的成熟工藝)。
電路功能失效的顯著特征就是普遍性,同一批都會出現相同的問題,無一幸免。而大多數因物理可靠性造成的失效都具備一定隨機性,要么失效程度不一,要么需要一定的觸發條件。因為物理可靠性的缺陷而造成某一性能發生異常的可能性也有,所以失效分析還是要基于實際情況,具體問題具體分析。(筆者也見過很嚴重的物理可靠性缺陷而導致同批芯片全部失效)
二.失效層次:
半導體器件的失效可以根據失效發生的階段劃分為三個層次:
芯片(裸片)層次:芯片層次的失效是目前出現概率最高的階段,因為現在芯片工藝與設計的復雜性,工藝偏差,設計不到位等多方面因素,都會造成芯片在制造、運輸等過程中發生失效。
封裝層次:封裝過程中鍵合失效,打線過重,粘連失效,空洞過多等因素都會造成封裝層次上的失效,隨著現在封裝技術愈發先進,封裝過程中出現失效的風險也在上升。
應用層次:下游客戶在芯片應用端造成的失效。諸如PCB板設計不合理、超出極限的應用場景等,這種情況就不表了。
三.失效分析流程:
記錄失效表現,將芯片失效的“癥狀”記錄下來,諸如短路、開路、漏電、性能異常、功能異常、時好時壞等。很多失效原因其表現出的“癥狀”是相似的,例如漏電,物理損壞能造成漏電,隔離不到位也能造成漏電,Latch-up問題也會造成漏電。
定位失效層次,在交付后的應用端發生失效,還是封裝后失效,亦或是裸片自身就有問題。三種不同層次對應不同的失效分析思路。
失效觸發條件,正常功能測試中出現失效;高低溫測試出現失效;ATE出現失效;ESD失效,封裝造成失效。(如果測試工程師能嚴格遵守靜電防護要求進行測試和設計測試板,芯片在測試過程中面臨ESD/EOS的風險很低)
統計失效概率,是隨機性的出現單顆失效還是按一定比例出現多個失效,亦或是全部芯片都出現失效。
復現失效條件,要對失效問題進行復現或追查,確認芯片失效原因,從而幫助推測失效原因。
確定失效類型,對失效類型做出推斷,從而確定失效分析的方向。如果無法通過失效結果推斷出失效類型,那么只能根據后續的測試結果進行推斷。
規劃實驗計劃,對失效原因有大致推斷后就需要進行實驗去尋找數據支撐,如果推斷比較清晰的話實驗就比較好去定位。
總結改善措施,得出失效原因的結論后就需要制定相對應的改善措施,并記錄在冊。每一次的失效結論都是拿錢砸出來的經驗教訓,也是產品公司必須要經歷的過程。
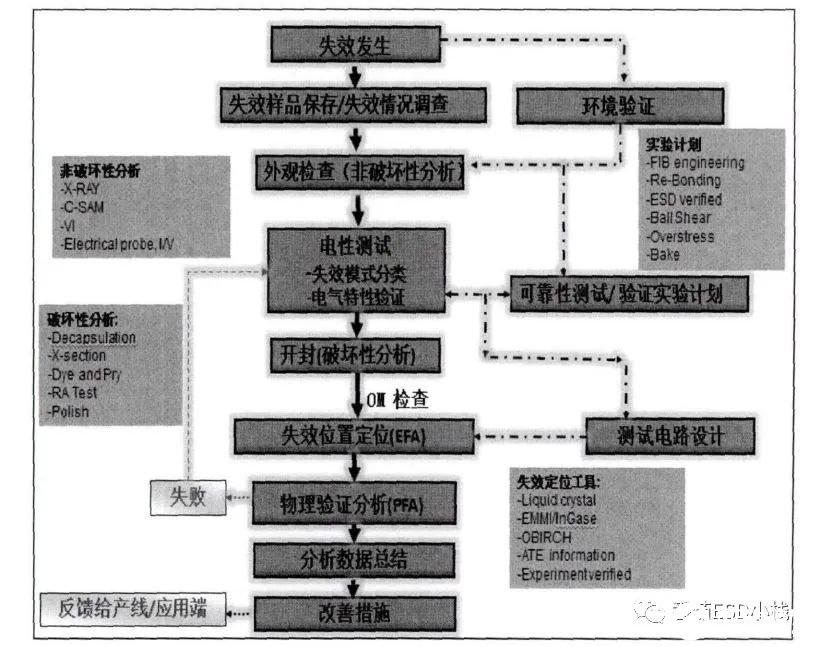
圖一.失效分析流程示意圖。
四.失效分析手段
目前國內已經有很多專業的團隊在做失效分析和測試,他們不僅具備專業的儀器設備,還會有專業人員對失效分析進行技術支持。但是筆者認為IC設計公司還是得具備一定的失效分析能力,因為整個芯片各個模塊的設計與電路指標都是設計公司確立的,版圖/后端也是設計公司做的,設計公司對整個芯片更加清楚。第三方公司能輔助定位失效點和提供技術支持,但是其對芯片的熟悉程度遠不如設計公司,設計公司應該主導失效分析。這里對幾種常見的失效分析手段進行簡介:
4.1.非破壞性分析:
4.1.1. OM(Optica Microscope):
利用高倍數顯微鏡對芯片或者封裝表面進行視覺檢測。如圖二所示為OM結果,其中暗場技術能觀察到表面劃痕與污染,Nomarski技術能觀察到裂縫與刻蝕坑。
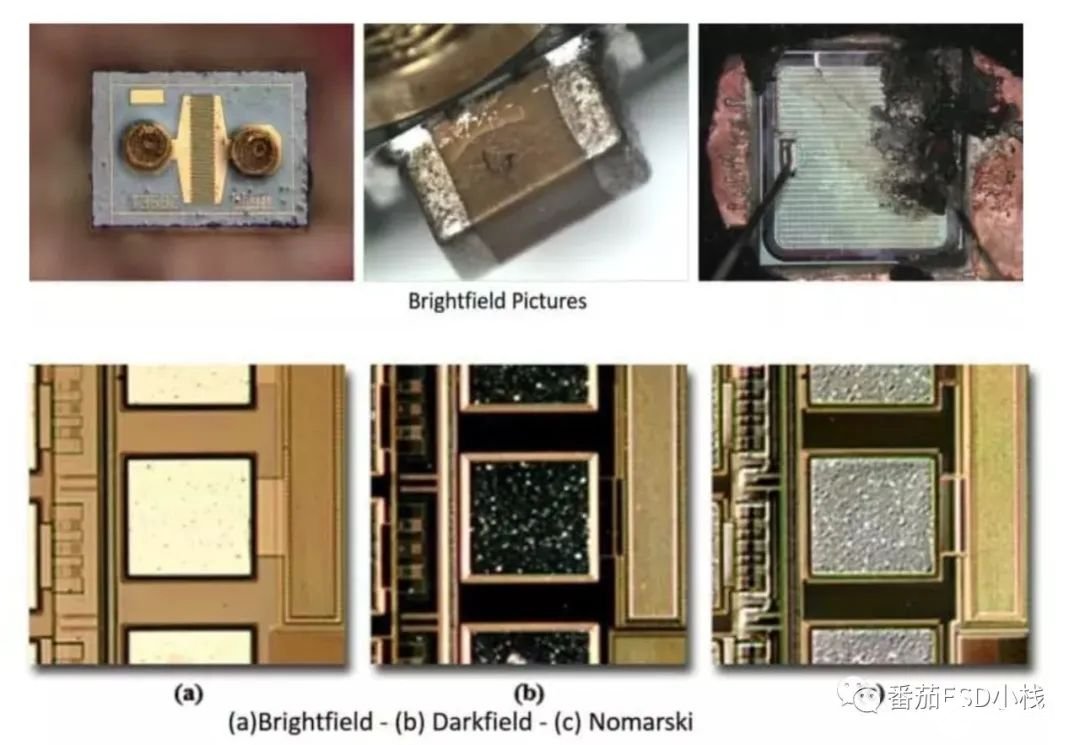
圖二.OM觀測結果。
4.1.2. SAT/SAM (Scanning AcousticTomography/Scanning Acoustic Microscopy) :
SAT/SAM利用超聲波在不同介質中的反射系數,得出封裝內部的結構圖。該技術能用于檢查樣品中的空隙、裂紋和分層。而SAM的精度與分辨率是強于SAT的。

圖三.SAT/SAM觀測結果。
4.1.3.X-Ray/ Computed Tomography (CT) X-Ray:
利用X光和CT對芯片進行拍照從而得出內部結構圖。如果需要得到更詳細的內部結構,可以將樣品進行360°拍照,然后利用圖像處理技術構建出芯片的3D結構圖。

圖四.3D X-Ray 結果。
4.1.4. Decapsulation:
大部分封裝所造成失效都能通過上述手段檢測出來,但是如果需要對芯片進行檢測就得去封裝(開蓋)。目前Decapsulation的手段有兩種:1. 化學法:利用硫酸和硝酸去腐蝕開蓋。2. 激光法:利用激光將封裝熔解。

圖五.Decapsulation結果示意圖。
4.2. EFA (Electrical Failture Analysis ):
4.2.1. Electrical Testing:
利用探針臺+半導體分析儀+電學測試設備,利用探針對芯片內部進行采樣和施加激勵,直接對電路模塊進行電學特性分析。這是最普遍的電學失效分析手段,不過探針的扎針落點有很多限制,有時得配合FIB和金屬去層才能對指定的模塊進行電學性能測量。
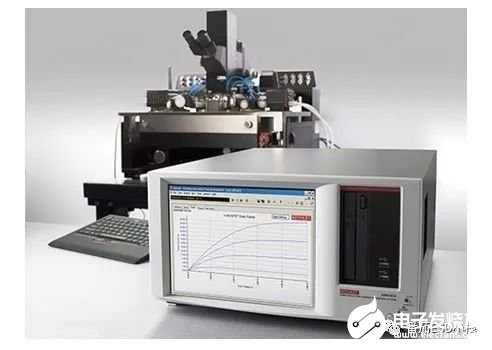
圖六.電學特性分析。
4.2.2. Photo Emission Microscope (EMMI InGaAs OBIRCH)
其中關于EMMI之前已經介紹過,傳統EMMI的探頭為CCD,而InGaAs是EMMI的一種探頭,兩者的接收波段有區別,且InGaAs更加快速與靈敏。 
圖七.EMMI、InGaAs、Thermal波段范圍。
OBIRCH是利用紅外激光照射局部位置引起熱梯度造成局部電阻變化,從而觀察到電流變化。阻抗異常其電流變化會與其它地方不同,從而定位失效點。EMMI InGaAs OBIRCH是三種應用非常廣泛的FA手段,其結果不如SEM, X-Ray等技術直觀,且依賴偏置條件,但是能快速定位失效點,其應用場景遠比SEM等廣泛,是主流的失效分析手段之一。日后筆者會總結EMMI的分析心得,進行EMMI前最好先對失效點及失效原因有個推斷,然后給予適當的偏置條件。
4.3.PFA (Physical Failure Analysis)
物理失效分析就需要對芯片進行一些物理處理,其中最主要的處理方式一個是縱刨,一個是金屬去層。縱刨的樣品制備包括清洗、安裝然后將樣品放入聚酯或環氧樹脂中。
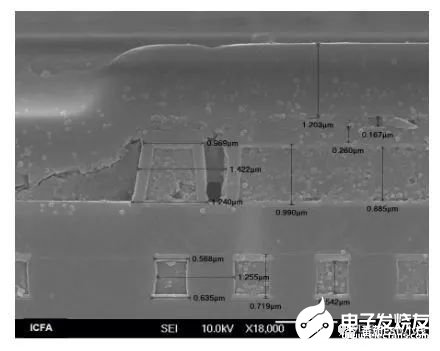
圖八.縱刨SEM圖像。
去層工藝使用化學溶液/氣體蝕刻和機械拋光來緩慢、精確地去除芯片上的每一層金屬。
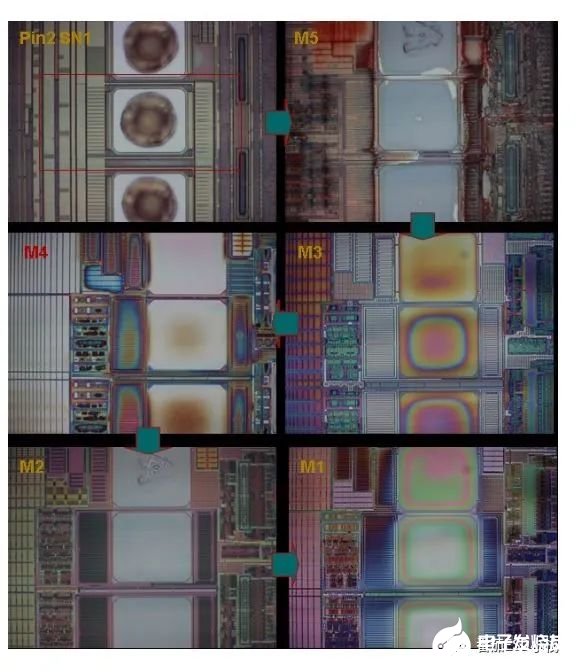
圖九.金屬去層示意圖。
4.3.1.FIB (Focus Ion Beam):
FIB是IC設計公司最常用的失效分析手段之一,這里就不贅述了。
淺談失效分析—FIB聚焦離子束加工技術簡介
4.3.2.SEM(Scanning Electron Microscope ):
SEM也是常用手段之一,因為其放大倍數很大,所以利用其他手段確認失效點后便可利用SEM進行直觀觀察,從而確認失效原因。SEM可以對表面進行觀察,也可配合縱刨技術對截面進行觀察。
4.3.3 SCM(Scannin Capacitance Microscope):
掃描電容顯微鏡,這種顯微鏡主要是利用探針對半導體器件施加信號,然后測量C-V曲線,從而確定半導體器件的摻雜類型。
而類似AFM、TEM、EDX、XPS、XRD等微觀物相測量手段,一般是Fab進行更深層次的失效分析時才會用到,Design House一般不需要介入如此深的物相表征。
因為失效分析比較特例化,很難總結出一套通用的細則,且能產生芯片失效的可能性不勝枚舉。筆者認為失效分析更需要經驗的積累,只有見多識廣后才能總結出失效的規律與普遍特征,筆者還有很長的路要走,也希望大家多多交流,畢竟一個人的見識總歸是有限的。
原作者:番茄ESD小棧
如果看到這里,請點贊、收藏、分享三連!
限時免費掃碼進群,交流更多行業技術

審核編輯 黃宇
-
芯片
+關注
關注
463文章
54200瀏覽量
468005 -
電路設計
+關注
關注
6745文章
2727瀏覽量
219906 -
失效分析
+關注
關注
18文章
250瀏覽量
67870
發布評論請先 登錄
對于伺服行星減速機的軸承失效的原因分析
IC引腳失效模式和影響分析(FMEA)的重要性
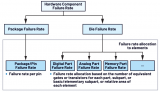
LED失效分析方法與應用實踐

常見的電子元器件失效分析匯總
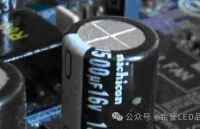
熱發射顯微鏡下芯片失效分析案例:IGBT 模組在 55V 就暴露的問題!

芯片失效步驟及其失效難題分析!

LED芯片失效和封裝失效的原因分析

連接器會失效情況分析?
破局SiC封裝瓶頸 | 攻克模組失效分析全流程問題




 淺談失效分析—失效分析流程
淺談失效分析—失效分析流程


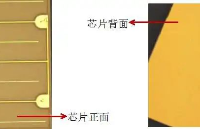

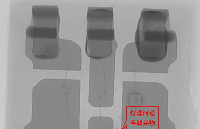



評論