在半導體器件研發與制造領域,失效分析已成為不可或缺的環節,FIB(聚焦離子束)截面分析,作為失效分析的利器,在微觀世界里大顯身手。它運用離子束精準切割樣品,巧妙結合電子束成像技術,實現對樣品內部結構的高分辨率觀察,尤其擅長處理微小、復雜的器件結構。
什么是截面分析?
截面分析是失效分析中的一種重要方法,而使用雙束聚焦離子束 - 掃描電鏡(FIB-SEM)則是截面分析的主要加工方式之一。FIB 技術將離子束切割與電子束成像相結合,能夠實現精準定位,并以高度可控的方式對樣品的不同區域進行截面切割。
使用FIB做截面分析基本有以下步驟:
1.準備樣品
樣品制備是截面分析的基礎環節,其目的是為后續的分析提供合適且高質量的樣品。樣品制備一般包括裁切樣品尺寸、使樣品表面平整無起伏、導電處理(如噴金、噴碳等)、裝載固定在樣品臺等。
聚焦離子束技術(FIB)注意事項:
(1)樣品大小5×5×1cm,當樣品過大需切割取樣;
(2)樣品需導電,不導電樣品必須能噴金增加導電性;
(3)切割深度必須小于10微米。
2.位置確認將預處理后的樣品置于 FIB 設備中,利用電子束掃描觀察樣品表面形貌,確定截面切割位置。
在目標區域表面沉積保護層,以減少切割過程中對樣品表面的離子損傷。
3.離子切割
使用聚焦離子束對樣品表面進行切割,先挖開樣品表面以暴露出截面區域,然后對截面部分進行精修。精修的目的是使截面平滑,使形貌細節更加清晰明顯,以便后續的觀察和分析。在離子切割過程中,需要精確控制離子束的參數,如離子束電流、加速電壓等,以實現對截面的精確加工。
4.截面分析
對材料截面進行多種表征分析,以獲取豐富的信息:
(1)表征截面結構形貌:通過電子束成像技術,對截面的微觀結構進行觀察和分析,了解樣品內部的組織結構、缺陷分布等情況。
(2)測量各層尺寸厚度:利用 FIB 設備的高精度測量功能,對截面中各層的尺寸和厚度進行精確測量,為評估材料的制備工藝和性能提供數據支持。
(3)能譜測試成分信息:結合能譜分析技術(EDS),對截面進行成分分析,確定不同區域的元素組成和含量,從而了解材料的成分分布情況,為研究材料的性能和失效機理提供重要的依據。
-
失效分析
+關注
關注
18文章
250瀏覽量
67871 -
fib
+關注
關注
1文章
129瀏覽量
11787 -
半導體器件
+關注
關注
12文章
808瀏覽量
34240
發布評論請先 登錄
FIB技術
如何找到專業做FIB技術的?
聚焦離子束顯微鏡(FIB-SEM)
芯片IC可靠性測試、靜電測試、失效分析
FIB加工就在你身邊-芯片IC電路修改-芯片IC開封-FIB截面分析
【經典案例】芯片漏電失效分析-LED芯片失效點分析(OBIRCH+FIB+SEM)
芯片漏電點FIB切片分析
FIB技術在印刷線路板PCB失效分析的應用
SEM/FIB雙束系統及其截面加工技術




 如何用FIB截面分析技術做失效分析?
如何用FIB截面分析技術做失效分析?


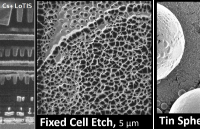
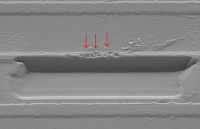





評論