英特爾在2023年國際電子設備制造大會上宣布,他們已經成功完成了一項名為PowerVia的背面供電技術的開發。這個技術是基于英特爾的最新晶體管研究成果,它實現了互補金屬氧化物半導體場效應晶體管(CFET)的60納米柵極間距垂直堆疊。通過堆疊晶體管,該技術提高了面積效率和性能,同時還結合了背面供電和直接背面接觸這兩種技術。
英特爾解釋說,過去幾年芯片制造都是層層疊加的,從最小的元件-晶體管開始制造,之后需要創建更小的線路層,用于連接晶體管和金屬層。這些線路被稱為信號互連線,其中還包括用于給晶體管供電的電源線等。但是隨著晶體管逐漸變小、密度日益提高,互連線和電源線共享的線路層變得越來越混亂。面對這個問題,英特爾開始尋找將電源線遷移到芯片背面的背面供電技術。
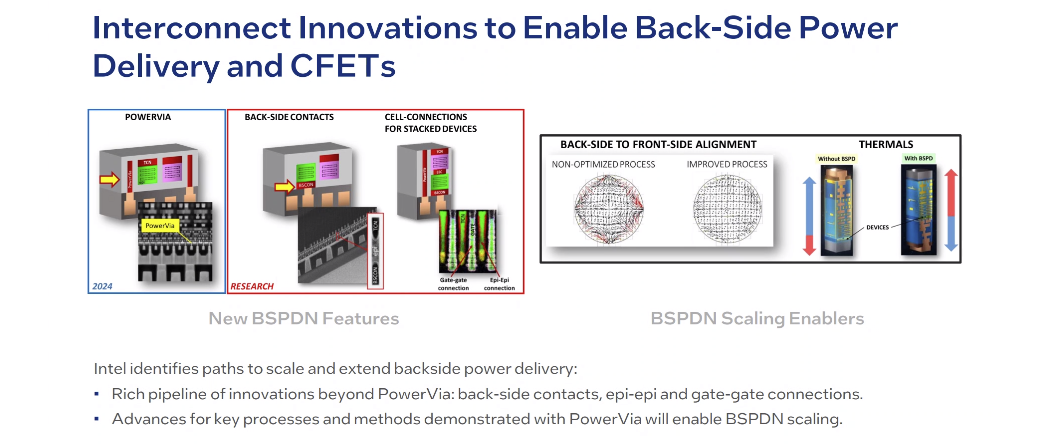
英特爾的背面供電解決方案PowerVia已經產生了具有競爭力的測試結果。這項技術解決了傳統"披薩式"制造方法帶來的問題,尤其是電源線和互連線的分離以及線徑的擴大,從而改進了供電和信號的傳輸。

對于英特爾的晶體管堆疊和背面供電的技術,研究表明,它將在微縮晶體管的密度上發揮重要作用。英特爾強調,這將超越其"四年五個制程節點計劃",以背面供電技術繼續微縮晶體管。
目前,英特爾的這項技術在競爭對手中具有一定的優勢。比如臺積電將在2025年量產的第一代2納米制程時引入全環繞柵極(GAA)架構,然后在2026年的第二代2納米制程中引入背面供電技術。與此同時,盡管韓國三星在2022年量產的3納米制程技術上已經引入了GAA架構,但是他們預計要到2025年量產的2納米制程才會引入背面供電技術。從這個角度來看,英特爾確實領先了一步。
-
芯片
+關注
關注
463文章
53949瀏覽量
464796 -
英特爾
+關注
關注
61文章
10296瀏覽量
180129 -
晶體管
+關注
關注
78文章
10392瀏覽量
147431 -
三星
+關注
關注
1文章
1760瀏覽量
34063
發布評論請先 登錄
被指存散熱硬傷,英特爾代工iPhone芯片幾無可能?
吉方工控亮相2025英特爾技術創新與產業生態大會
18A工藝大單!英特爾將代工微軟AI芯片Maia 2
硬件與應用同頻共振,英特爾Day 0適配騰訊開源混元大模型

英特爾宣布工程技術領導層重要任命,加速CEO陳立武轉型布局
新思科技與英特爾在EDA和IP領域展開深度合作
英特爾發布全新GPU,AI和工作站迎來新選擇
英特爾持續推進核心制程和先進封裝技術創新,分享最新進展

英特爾代工:明確重點廣合作,服務客戶鑄信任
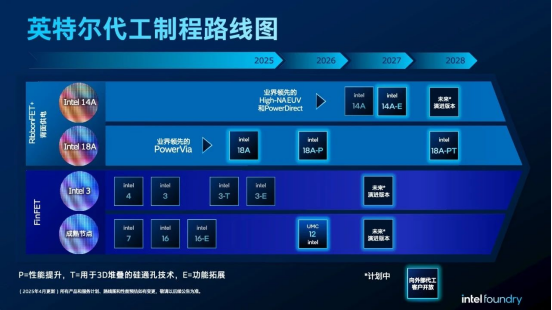



 英特爾宣布完成PowerVia背面供電技術的開發
英特爾宣布完成PowerVia背面供電技術的開發




評論