碳化硅MOSFET在材料與器件特性上不同于傳統(tǒng)硅,如何保證性能和可靠性的平衡是所有廠家需要面對(duì)的首要問(wèn)題,英飛凌作為業(yè)界為數(shù)不多的采用溝槽柵做SiC MOSFET 的企業(yè),如何使用創(chuàng)新的非對(duì)稱(chēng)溝槽柵既解決柵極氧化層的可靠性問(wèn)題、又提高了SiC MOSFET 的性能? 增強(qiáng)型M1H CoolSiC芯片又“強(qiáng)“在哪里?英飛凌零碳工業(yè)功率事業(yè)部高級(jí)工程師趙佳女士,在2023英飛凌工業(yè)功率技術(shù)大會(huì)(IPAC)上,發(fā)表了《增強(qiáng)型M1H CoolSiC MOSFET的技術(shù)解析及可靠性考量》的演講,深入剖析了CoolSiC MOSFET的器件結(jié)構(gòu),以及M1H芯片在可靠性方面的卓越表現(xiàn)。點(diǎn)擊視頻可觀看回放。
1
碳化硅的材料特性
(a)SiC是寬禁帶半導(dǎo)體,它的帶隙寬度約是Si的3倍,由此帶來(lái)的好處是SiC的臨界場(chǎng)強(qiáng)約是Si的10倍。對(duì)于高壓Si基MOSFET來(lái)說(shuō),漂移區(qū)電阻占總導(dǎo)通電阻的主要分量。SiC臨界擊穿場(chǎng)強(qiáng)高,要達(dá)到相同的耐壓,可以使用更薄以及更高摻雜的漂移區(qū),從而大大降低了導(dǎo)通電阻。
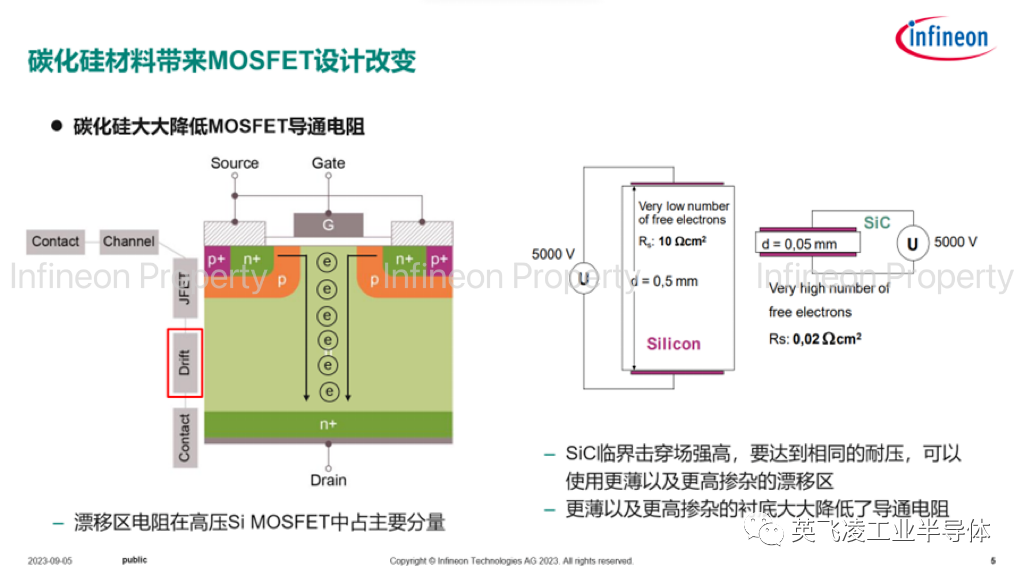
(b)IGBT是雙極性器件,電子和空穴同時(shí)參與導(dǎo)電,關(guān)斷時(shí)空穴復(fù)合產(chǎn)生拖尾電流,增加了關(guān)斷損耗。而SiC MOSFET是單極性器件,沒(méi)有拖尾電流,相比Si IGBT節(jié)省至多80%開(kāi)關(guān)損耗。SiC材料大大拓展了MOSFET的電壓等級(jí),最高電壓可到3300V以上,重新定義了MOSFET的應(yīng)用范圍。
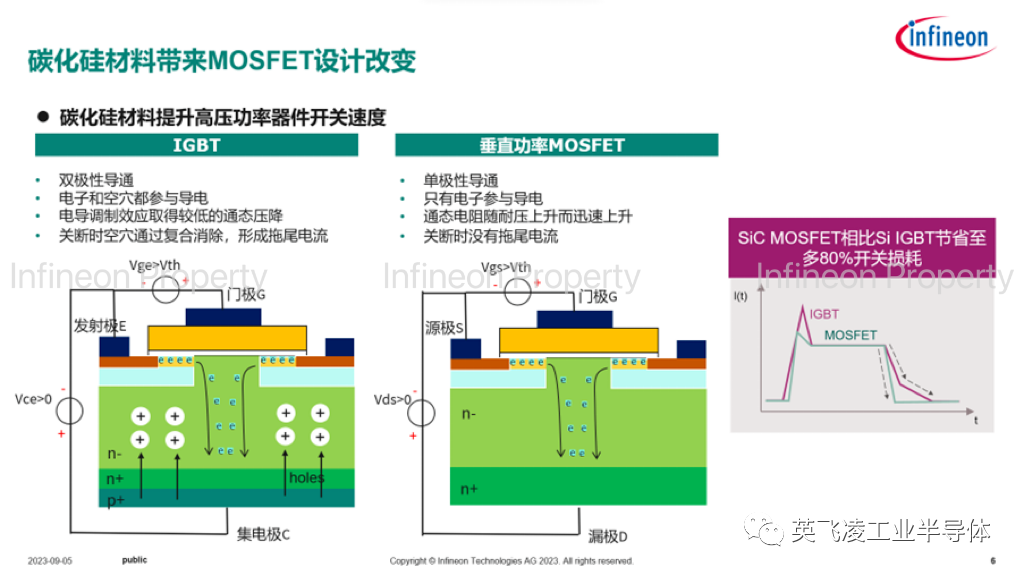
(c)SiC材料為器件設(shè)計(jì)即帶來(lái)了機(jī)遇也帶來(lái)了挑戰(zhàn)。最大的挑戰(zhàn)在于柵氧化層界面SiC-SiO2存在較高的缺陷密度和界面電荷,可能導(dǎo)致早期擊穿、閾值漂移、導(dǎo)通電阻上升等問(wèn)題,最終威脅到器件的壽命和可靠性。

2
為什么SiC MOSFET需要溝槽柵
(a)SiC材料的應(yīng)用使得MOSFET漂移區(qū)非常薄,因此溝道電阻就成為了降低總電阻的關(guān)鍵。
(b)根據(jù)溝道電阻的公式,可以采用以下手段,但是會(huì)加大可靠性風(fēng)險(xiǎn):
多元胞并聯(lián)導(dǎo)致高成本和高短路電流
降低柵氧化層厚度將導(dǎo)致柵氧化層應(yīng)力上升,對(duì)柵極可靠性造成影響
提高驅(qū)動(dòng)電壓,同樣會(huì)加大柵氧化層應(yīng)力
降低閾值電壓,可能會(huì)帶來(lái)串?dāng)_問(wèn)題
最優(yōu)的辦法是增加溝道載流子遷移率un
(c)SiC-SiO2界面態(tài)密度和缺陷遠(yuǎn)大于Si-SiO2界面,SiC MOSFET溝道載流子遷移率相比IGBT偏低。溝道載流子遷移率低會(huì)導(dǎo)致溝道電阻和損耗上升。SiC是各向異性晶體,垂直晶面上的氧化層缺陷密度小于水平晶面。可以利用這一特性解決上述難題。
(d) 比較溝槽柵和平面柵兩種技術(shù),如果要保持同等柵氧可靠性,平面與溝槽需同時(shí)使用同樣厚度的柵氧化層,平面型MOS面積要顯著大于溝槽柵;如果要保持相同的芯片面積,為了維持低導(dǎo)通電阻,平面型需要更薄的柵極氧化層,柵氧應(yīng)力高,可靠性差。
(e) 英飛凌CoolSiC MOSFET采用非對(duì)稱(chēng)溝槽柵結(jié)構(gòu),有如下技術(shù)點(diǎn):

溝道所使用晶面與垂直軸呈4C夾角,具有最低的界面態(tài)密度與氧化層陷阱,因而能保證最高溝道載流子遷移率
深P阱作為增強(qiáng)型體二極管,增大二極管的面積和發(fā)射效率
溝槽型底部拐角承受高電場(chǎng),深P阱另一個(gè)作用是保護(hù)溝槽拐角
JFET區(qū)域限制短路電流,增加可靠性。
3
CoolSiC MOSFET的可靠性考量
(a)英飛凌SiC MOSFET柵氧化層厚度與Si 器件柵氧化層厚度相當(dāng)。而平面型SiC MOSFET 柵氧化層厚度普遍低于溝槽柵。柵氧化層的電壓應(yīng)力與厚度成反比,過(guò)高的電場(chǎng)應(yīng)力使得器件經(jīng)時(shí)擊穿的風(fēng)險(xiǎn)增加。可通過(guò)施加門(mén)極階躍電壓的方式來(lái)評(píng)估柵氧化層可靠性。英飛凌CoolSiC MOSFET擁有最低的失效率,并且與Si IGBT的失效特性相似。
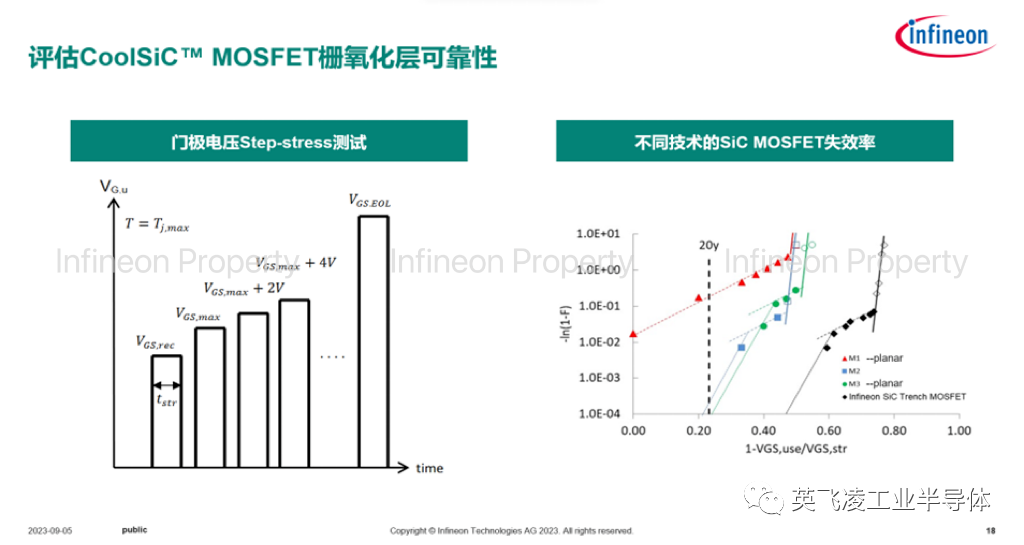
(b)在長(zhǎng)期的開(kāi)關(guān)過(guò)程中,SiC MOSFET會(huì)出現(xiàn)閾值漂移的現(xiàn)象。這是平面型器件與溝槽型器件都需要共同面對(duì)的難題。英飛凌最早發(fā)現(xiàn)并研究了這一現(xiàn)象。最新的M1H芯片,進(jìn)一步改善了柵氧化層質(zhì)量,使得閾值漂移可以忽略不計(jì)。當(dāng)?shù)竭_(dá)預(yù)期目標(biāo)壽命時(shí),導(dǎo)通電壓為18V時(shí),預(yù)計(jì)25°C時(shí)的RDS(on)的相對(duì)變化小于6%,175°C時(shí)小于3%。
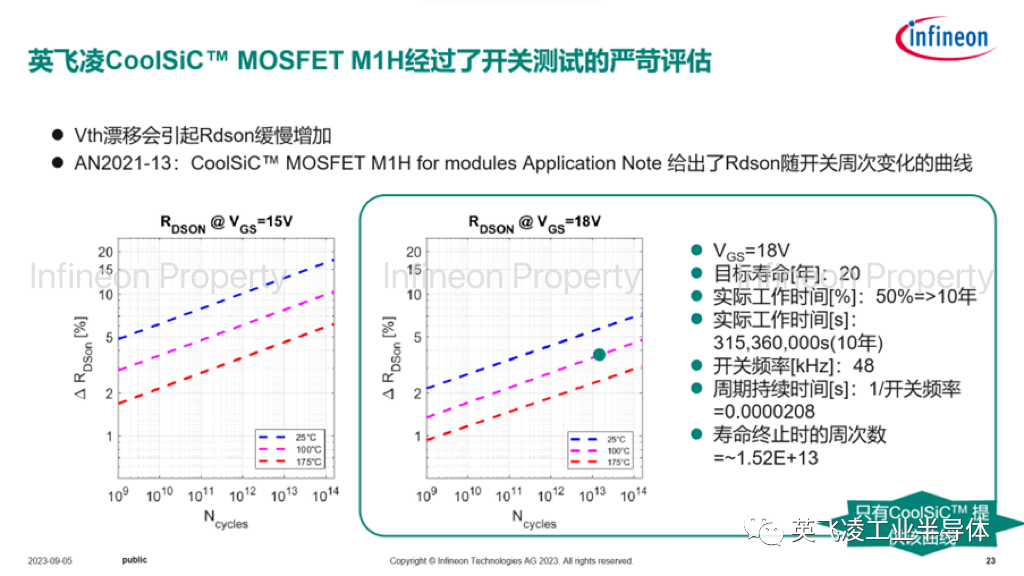
(c) M1H芯片的閾值電壓約4.5V,高于其他競(jìng)爭(zhēng)對(duì)手,并且具有非常低的米勒電容。高閾值電壓能夠有效抑制寄生導(dǎo)通現(xiàn)象。

4
CoolSiC MOSFET的短路特性
(a)大部分SiC MOSFET不承諾短路能力。CoolSiC是唯一承諾短路能力的SiC MOSFET。在門(mén)極15V電壓下,單管具有3us的短路時(shí)間,EASY模塊具有2us的短路時(shí)間。

(b)SiC MOSFET在短路時(shí)具有電流飽和的特性,但短路時(shí)間往往低于IGBT。這是因?yàn)镾iC MOSFET具有更高的短路電流密度,更小的面積以及更薄的漂移區(qū),使得熱量更加集中,從而降低了短路時(shí)間。
5
總結(jié)
英飛凌M1H CoolSiC MOSFET非對(duì)稱(chēng)溝槽柵提供性能與可靠性的最優(yōu)折衷設(shè)計(jì)

-
MOSFET
+關(guān)注
關(guān)注
151文章
9674瀏覽量
233550 -
SiC
+關(guān)注
關(guān)注
32文章
3721瀏覽量
69412 -
碳化硅
+關(guān)注
關(guān)注
26文章
3464瀏覽量
52348
發(fā)布評(píng)論請(qǐng)先 登錄
新品 | CoolSiC? MOSFET M1H共源配置62mm模塊

新品 | CoolSiC? 碳化硅MOSFET M1H EasyDUAL? 1200V

探索IMYR140R008M2H CoolSiC? 1400 V SiC MOSFET G2:高性能與多功能的完美結(jié)合
TCAN114x-Q1增強(qiáng)型CAN FD收發(fā)器:設(shè)計(jì)與應(yīng)用全解析
選型手冊(cè):VS4610AE N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS4620GP N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS3618BE N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS3618AP N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS3633GE N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS3618AE N 溝道增強(qiáng)型功率 MOSFET 晶體管

選型手冊(cè):VS4020AP N 溝道增強(qiáng)型功率 MOSFET 晶體管

MOT4913J N+N 增強(qiáng)型 MOSFET 技術(shù)解析:參數(shù)、特性與應(yīng)用場(chǎng)景

新潔能推出增強(qiáng)型N溝道MOSFET系列產(chǎn)品

新品 | 英飛凌EconoDUAL? 3 CoolSiC? SiC MOSFET 1200V模塊

新品 | 采用高性能DCB的Easy B系列CoolSiC? 2kV SiC MOSFET模塊




 增強(qiáng)型M1H CoolSiC MOSFET的技術(shù)解析及可靠性考量
增強(qiáng)型M1H CoolSiC MOSFET的技術(shù)解析及可靠性考量




評(píng)論