二次回流焊集成電路芯片模組封裝底部填充膠應用方案由漢思新材料提供
客戶是一家主要生產集成電路芯片模組的企業
研發生產,制造及銷售包括:電源、辦公自動化設備,無線電器材,集成電路芯片模組,半導體器件,通訊設備及計算機等。其中集成電路芯片模組生產用到漢思新材料的底部填充膠。
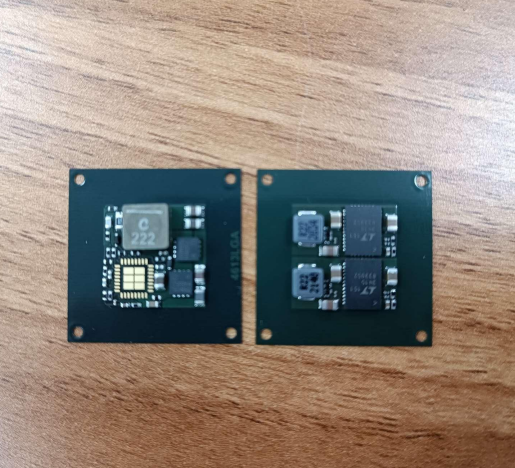
客戶產品: 集成電路芯片模組
客戶產品用膠部位:
生產芯片模組,需要二次底填膠加固芯片。
膠水測試要求:
1,高低溫測試
2,點膠固化后無空洞
3,產品可過二次回流焊。
漢思新材料推薦用膠:
推薦客戶使用漢思底部填充膠HS767,
HS767底填膠是漢思專業為芯片BGA研發生產的填充膠,其具有耐高溫,流動性好,高TG點,適用于高溫工作環境的芯片填充加固封裝。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54200瀏覽量
467999 -
集成電路
+關注
關注
5460文章
12631瀏覽量
375293 -
膠粘劑
+關注
關注
1文章
119瀏覽量
11595 -
芯片封裝
+關注
關注
13文章
619瀏覽量
32359
發布評論請先 登錄
相關推薦
熱點推薦
一次講透二次回流工藝的核心邏輯
二次回流工藝是通過兩次分步高溫焊接,解決復雜封裝中多層級器件互連、敏感器件與大功率器件共存焊接難題的核心技術,核心邏輯為“高溫打底、低溫疊加”。其主要應用于PoP堆疊封裝、SiP系統級

回流焊問題導致SMT產線直通率下降,使用我司回流焊后改善的案例
以下是一個回流焊以及工藝失控導致SMT產線直通率驟降,通過更換我司晉力達回流焊、材料管理以及工藝優化后直通率達98%的案例分析,包含根本原因定位、系統性改進方案及量化改善效果:
背景:某通信設備
發表于 06-10 15:57
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利
漢思新材料取得一種封裝芯片高可靠底部填充膠及其制備方法的專利2025年4月30日消息,國家知識產權局信息顯示,深圳市漢思新材料科技有限公司取

二次回流如何破解復雜封裝難題?專用錫膏解密高密度集成難題
二次回流工藝因高密度封裝需求、混合元件焊接剛需及制造經濟性提升而普及,主要應用于消費電子芯片堆疊、服務器多 Die 整合、汽車電子混合焊接、大尺寸背光模組、陶瓷 LED 與制冷
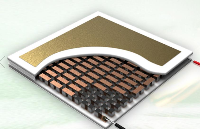



 二次回流焊集成電路芯片模組封裝底部填充膠應用方案
二次回流焊集成電路芯片模組封裝底部填充膠應用方案








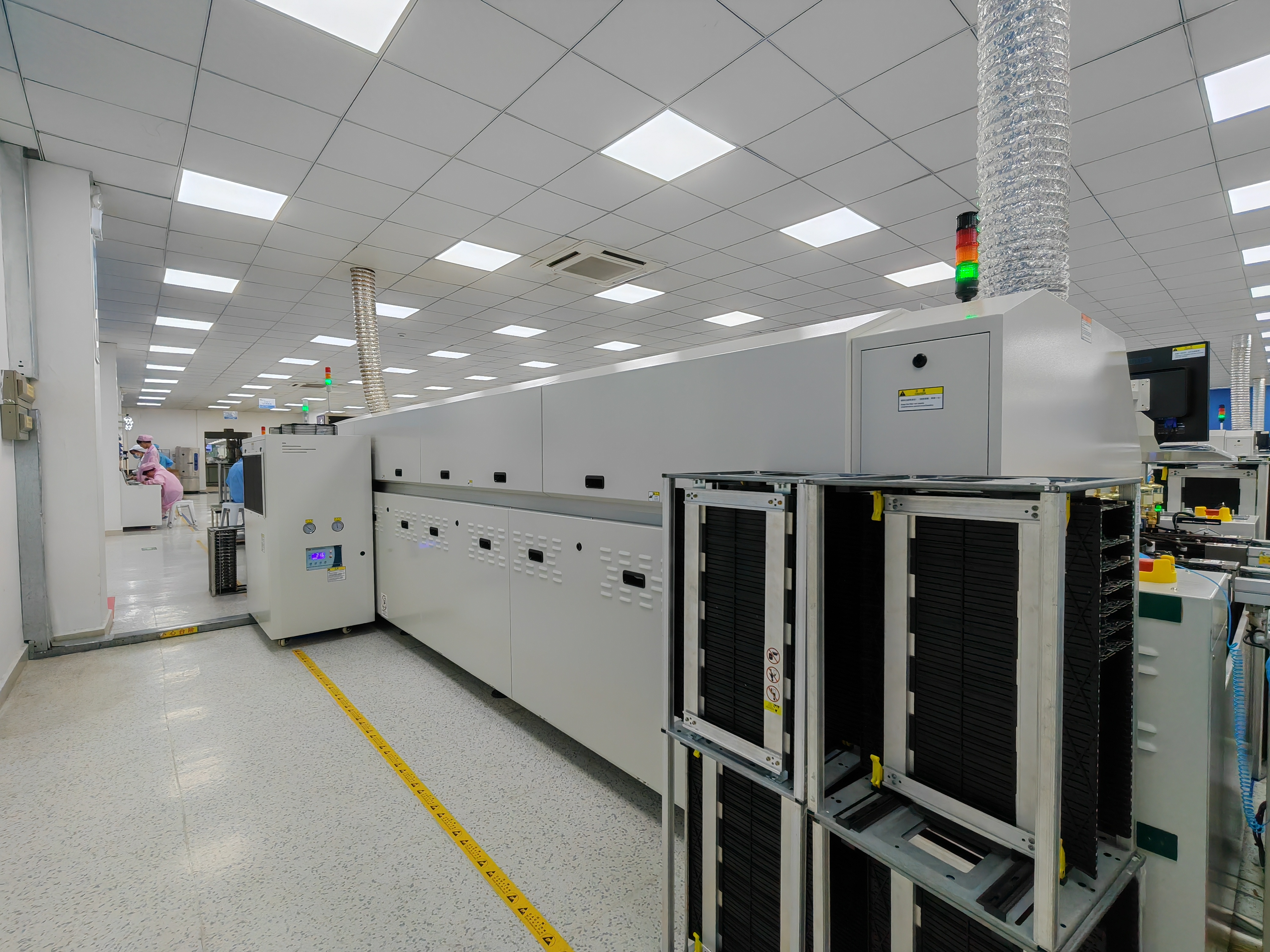





評論