2022年和2023年,蘋果陸續(xù)發(fā)布了搭載第二代蘋果Mac處理器“M2”的產(chǎn)品。2023年6月,發(fā)布了搭載頂級處理器“M2 Ultra”的“Mac Pro”和“Mac Studio”。在本報告中,由于日程安排(計劃很快到貨),我們未能獲得 M2 Ultra,M2 Ultra 的芯片分析計劃在今年夏天進行。
M2 在 2022 年 6 月發(fā)布的“MacBook Pro”中首次采用。8 個月后的 2023 年 2 月,搭載更多 CPU/GPU 核心的升級版“M2 Pro”和“M2 Max”的 Mac 系列發(fā)布。此外,在 2023 年 6 月,一開始就宣布了搭載 M2 Ultra 的機型。2020年發(fā)布的“M1”系列同樣采用了“M1”、“M1 Pro”、“M1 Max”和“M1 Ultra”4款機型,因此M2陣容完整。
板子左右開有兩個開孔,開孔內(nèi)裝有散熱風扇。由空氣冷卻風扇的熱管連接的散熱器覆蓋處理器。
處理器右側(cè)和頂部有蘋果自研的電源IC,板子背面有五顆蘋果自研的電源IC。蘋果不僅在處理器上,還在并行開發(fā)電源IC,如果處理器和電源IC合起來,蘋果就做了八顆芯片。處理器上刻有“APL1111”,這是M2 Max的處理器型號名稱。
帶有超過 4000 個球的端子的“M2 Max”封裝
圖2是將M2 Max封裝從基板上拆下,拆下封裝的端子面,并拆下覆蓋在封裝上的金屬LID后的外觀照片。

封裝背面有4000多個端子球。目前,大規(guī)模芯片封裝越來越多地配備3000多個端子。一個封裝7000多終端開始出現(xiàn)。
在封裝中,不僅安裝了處理器,還安裝了存儲器和各種用于改善特性的部件,并且包含系統(tǒng)本身,例如電源增強,由于寬位而增加的端子以及由于功能而增加的端子聚合..
M2 Max 的端子之間有 27 塊微小的硅片。這些是硅電容器。過去使用陶瓷電容,但蘋果使用硅(大容量)并將其直接放置在處理器上方,以增強電源穩(wěn)定性等特性。
取下蓋子可以看到包裝內(nèi)有五個芯片。中間是M2 Max處理器。處理器上方和下方的模制封裝中共有四個 LPDDR5。這四個是一樣的。4 個 LPDDR5 每個內(nèi)部有 8 個硅和 2 個虛擬硅。一個 LPDDR5 封裝中有 10 個硅片。
虛擬硅是 Apple 以外的許多公司使用的技術(shù)。虛擬硅,顧名思義,就是沒有電路的硅。通過將其放置在硅的側(cè)面或頂部和底部,通常用于改善特性,例如使厚度均勻,增加封裝強度,提高散熱性。在 M2 Max 的情況下,可以通過將處理器放在中間來平衡到內(nèi)存的距離。低配的M2 Pro在處理器和LPDDR5的封裝上也有同樣的排列關(guān)系。
硅片總面積大于2000mm2
圖 3顯示了從包裝中取出的 M2 Max。在硅上,有用于連接晶體管之間的布線層,圖3的右側(cè)示出了布線層被取出的狀態(tài)。
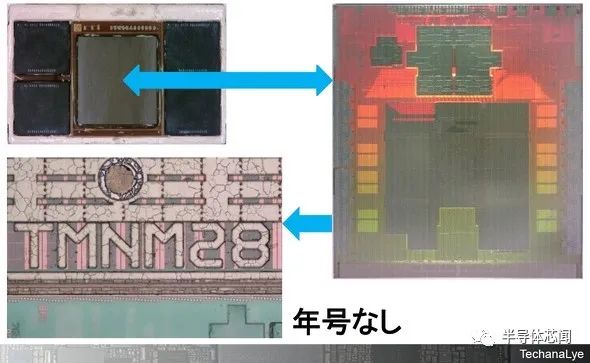
即使有布線層,也能知道大概的內(nèi)部狀態(tài)。芯片頂部中央有8個高性能CPU核心,左側(cè)有4個高效CPU核心。也就是說,CPU總共有12個核心。CPU 底部是一個 38 核的 GPU。
GPU左右兩側(cè)為LPDDR5接口。GPU底部的接口部分是蘋果專用于連接M2 Max的接口(詳情見付費Techanarie報告)。如果將 M2 Max 倒置并通過接口處的硅中介層連接,它將成為 M2 Ultra。這是使用兩個 M1 Max 來創(chuàng)建 M1 Ultra 的行之有效的方法。
通過仔細觀察帶有布線層的硅片,可以發(fā)現(xiàn)硅片上寫有布線層的硅型號名稱。M2 Max 的硅型號名稱是“TMNM28”。許多半導(dǎo)體不僅有型號名稱,還有制造商的標志和年份信息,但蘋果的許多芯片只有硅型號名稱。
表 1總結(jié)了 Apple M2 Max 封裝中使用的所有硅的數(shù)量、總面積等。從2010年開始,對于智能手機和PC,出現(xiàn)了很多整合,比如SIP(System In Package)、POP(Package On Package)、MCP(Multi Chip Package)、chiplets等技術(shù)的使用。

Apple 使用 TSMC 的 InFO(集成扇出)等技術(shù),通過將功能芯片和特性芯片組合在一個封裝中來創(chuàng)建處理器。它是圍繞處理器和支撐處理器的硅電容器的存儲器結(jié)構(gòu)。同樣的結(jié)構(gòu)不僅適用于 M2 Max,也適用于智能手機的“A 系列”。M2 Max 封裝 APL1111 總共包含 68 塊硅片。功能硅33個,特性硅35個。內(nèi)部硅片總面積超過2000mm2 !
表2是蘋果產(chǎn)品高性能CPU的一個核心放大圖。雖然分辨率略有降低,但四款產(chǎn)品的尺寸、形狀等都是一樣的。
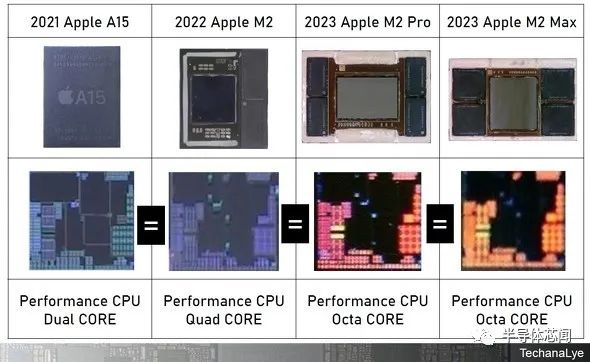
完成一個 CPU 后,將其復(fù)制
Tekanarye 獲得了幾乎所有的 Apple 芯片,將它們拆開并進行了分析。CPU、GPU、接口等主要部件都在剝掉布線層,露出內(nèi)部晶體管的情況下拍照。
據(jù)透露,M2系列的高性能CPU與“iPhone”的“A15 Bionic”相同。M1 系列基于 A14 仿生。我們正在做理想的可擴展開發(fā),即完成一個 CPU 并復(fù)制核心以擴展性能。
傳聞下一代“M3”會采用3nm代工制程,但如果是基于“A16 Bionic”(應(yīng)用4nm代制程)的話,應(yīng)用4nm似乎是有可能的。
無論如何,一旦有實物,這種謠言和預(yù)測就會變得清晰,所以我想等待實物。在蘋果M2系列中,不僅是CPU,GPU、NE(Neural Engine)等很多基礎(chǔ)功能電路都是從A系列抄襲而來,并增加了數(shù)量。我們開發(fā)了一個基座,改變了核心數(shù)量,創(chuàng)造了超高、高、中高、中、低。為了方便起見,我用“低”這個詞,但它并不是真正的低端,它實際上是高端中的一個劃分。
圖 4顯示了 Apple 的 A15 Bionic、M2、M2 Pro 和 M2 Max 之間的關(guān)系。圖中紅框為高性能CPU核心數(shù),綠框為GPU核心數(shù)。
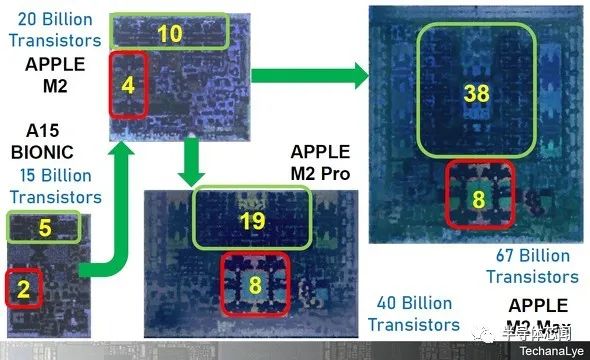
M2是iPhone版A15 Bionic的CPU和GPU核心數(shù)翻倍的(不過顯示器等假設(shè)不同,所以周邊功能和連接功能也不同,接口也不同)。M2 Pro 和 M2 Max 的 CPU 內(nèi)核是 M2 的兩倍,GPU 幾乎翻了一番,幾乎翻了四倍。這四款芯片極有可能從一開始就同時開發(fā),而不是按發(fā)布順序開發(fā)。不管怎么說,蘋果從出貨量最多的A系列開始,逐步推出高端產(chǎn)品的作風,與以往A系列給“iPad”的設(shè)計一脈相承。看來以后的M3和M4幾乎就是同款了。
審核編輯:劉清
-
處理器
+關(guān)注
關(guān)注
68文章
20296瀏覽量
253465 -
存儲器
+關(guān)注
關(guān)注
39文章
7744瀏覽量
171967 -
電源IC
+關(guān)注
關(guān)注
4文章
414瀏覽量
48211 -
蘋果手機
+關(guān)注
關(guān)注
1文章
2254瀏覽量
41955
原文標題:蘋果自研芯片的“套路”
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
成功點亮并上車!對標Orin X,Momenta自研芯片來了

加快進程!Meta計劃2027年底前推出四代自研AI芯片
阿里自研AI芯片“真武”亮相 “通云哥”黃金三角浮出水面

1600TOPS!美國新勢力車企自研5nm芯片,轉(zhuǎn)用激光雷達硬剛特斯拉

速騰聚創(chuàng)全棧自研數(shù)字激光雷達芯片通過AEC-Q認證
AI業(yè)界新聞:OpenAI官宣自研首顆芯片 黃仁勛時隔9年再次給馬斯克“送貨”
今日看點丨臺積電助力蘋果自研芯片;均勝電子再獲150億元項目定點
江波龍自研UFS4.1主控芯片,順序讀取速率高達4350MB/s,性能對標主流產(chǎn)品

集創(chuàng)北方聯(lián)合發(fā)布首顆自研RRAM AMOLED顯示驅(qū)動芯片

理想自研芯片預(yù)計明年量產(chǎn)上車
消息稱蘋果首款自研CMOS傳感器有望明后年登 iPhone 18/19 系列手機
Arm CEO:公司正在自研芯片
今日看點丨郭明錤:蘋果或于明年推出首款折疊iPhone;傳蔚來擬為芯片自研部門引入戰(zhàn)略投資者
高端芯片自研,服務(wù)器芯片傳來好消息!




 蘋果自研芯片的“套路”
蘋果自研芯片的“套路”




評論