引線鍵合是封裝過程中一道關(guān)鍵的工藝,鍵合的質(zhì)量好壞直接關(guān)系到整個封裝器件的性能和可靠性,半導(dǎo)體器件的失效約有1/4~1/3是由芯片互連引起的,故芯片互連對器件長期使用的可靠性影響很大。引線鍵合技術(shù)也直接影響到封裝的總厚度。下面科準(zhǔn)測控小編就來介紹一下半導(dǎo)體集成電路鍵合強(qiáng)度試驗原理、試驗程序、試驗條件、設(shè)備、失效判斷及說明!
一、什么是鍵合(Wire Bonding)
鍵合就是用金絲、銅絲或鋁絲將半導(dǎo)體器件芯片表面的電極引線與底座或引線框架外引線相連接起來。鍵合的目的是把半導(dǎo)體器件芯片表面的電極與引線框架的外引線連接起來。
二、試驗原理
本試驗的目的是測量鍵合強(qiáng)度,評估鍵合強(qiáng)度分布或測定鍵合強(qiáng)度是否符合適用的訂購文件的要求。本試驗可應(yīng)用于采用低溫焊、熱壓焊、超聲焊或有關(guān)技術(shù)鍵合的、具有內(nèi)引線的微電子器件封裝內(nèi)部的引線-芯片鍵合、引線-基板鍵合或內(nèi)引線-封裝引線鍵合。它也可應(yīng)用于器件的外部鍵合,如器件外引線-基板或布線板的鍵合,或應(yīng)用于不采用內(nèi)引線的器件(如梁式引線或倒裝片器件)中的芯片-基板之間的內(nèi)部鍵合。
三、試驗程序
應(yīng)采用與特定器件結(jié)構(gòu)相符的、適用訂購文件中規(guī)定的試驗條件進(jìn)行試驗。應(yīng)計算全部鍵合拉力,并應(yīng)根據(jù)適用情況遵守抽樣、接收和追加樣品規(guī)定。除另有規(guī)定外,對于條件A、C和D,所需要的試驗鍵合點應(yīng)從至少四個器件中隨機(jī)抽取,為鍵合強(qiáng)度試驗規(guī)定的樣本大小用于確定進(jìn)行拉力試驗的最少鍵合線數(shù),而不是確定至少需要的完整器件數(shù)。按試驗條件以D、F、G和H進(jìn)行的鍵合拉力試驗,雖然同時涉及到兩個或多個鍵合點,但是對鍵合強(qiáng)度試驗和計算樣本大小來說,應(yīng)將其看成是一個拉力試驗。除另有規(guī)定外,按照試驗條件F、G和H的鍵合拉力試驗規(guī)定的樣本大小用于確定被試驗的芯片的數(shù)量,而不是鍵合數(shù)。對于混合或者多芯片器件(無論哪種條件)而言,應(yīng)至少采用四個芯片,或者如果二個完整的器件上不足四個芯片,那么應(yīng)采用全部芯片。在芯片下面、芯片上面或芯片周圍,若存在任何導(dǎo)致增加表面鍵合強(qiáng)度的粘附劑、密封劑或其他材料,應(yīng)在使用這些材料前進(jìn)行鍵合強(qiáng)度試驗。
當(dāng)?shù)寡b片或梁式引線芯片是與基板鍵合而不是在成品器件中的鍵合時,則應(yīng)采用下述條件∶
a) 從與成品器件中采用的芯片屬于同一批的芯片中,隨機(jī)抽取本試驗用的芯片樣本;
b) 在鍵合成品器件的同一期間內(nèi),使用與鍵合成品器件時相同的鍵合設(shè)備鍵合用于本試驗的芯片
c) 在處理成品器件基板的同一期間內(nèi),對試驗芯片基板進(jìn)行與成品器件基板相同的加工、金屬化和有關(guān)處理。
四、試驗條件
1、試驗條件A--鍵合拉脫
本試驗通常用于器件封裝的外部鍵合。在固定引線或外引線以及器件的外殼時,應(yīng)在引線或外引線以及布線板或基板之間,以某一角度施加拉力。除另有規(guī)定外,該角度為90°。當(dāng)出現(xiàn)失效時,應(yīng)記錄引起失效的力的大小和失效類別。
2、試驗條件C-引線拉力(單個鍵合點)
本試驗通常應(yīng)用于微電子器件的芯片或基板以及引線框架上的內(nèi)部鍵合。連接芯片或基板的引線應(yīng)被切斷,以使兩端都能進(jìn)行拉力試驗。在引線較短的情況下,有必要靠近某一端切斷導(dǎo)線,以便在另一端可以進(jìn)行拉力試驗。把導(dǎo)線固定于適當(dāng)?shù)难b置,然后對引線或夾緊引線的裝置施加拉力,其作用力大致垂直于芯片表面或基板。當(dāng)出現(xiàn)失效時,記錄引起失效的力的大小和失效類別。
3、試驗條件D-引線拉力(雙鍵合點)
此試驗的步驟與試驗條件C相同,只是現(xiàn)在是在引線(該引線與芯片、基板或底座或兩個端點相連)下方插入一個鉤子夾緊器件,大約在引線中央施加拉力。該力方向與芯片或基板表面垂直,或與兩鍵合墊肩的直線大致垂直。當(dāng)出現(xiàn)失效時,記錄引起失效的力的大小和失效類別。表1給出最小鍵合強(qiáng)度。圖1用于確定表1中未說明的引線直徑的最小鍵合強(qiáng)度。對引線直徑或者等效橫截面大于127μm,在引線下不適于使用鉤子的地方,可用一個適當(dāng)?shù)?a target="_blank">夾子取代鉤子。
4、試驗條件F一鍵合剪切力(倒裝焊)
本試驗通常用于半導(dǎo)體芯片與基板之間以面鍵合結(jié)構(gòu)進(jìn)行連接的內(nèi)部鍵合,它也可用來試驗基板和安裝芯片的中間載體或子基板之間的鍵合。用適當(dāng)?shù)墓ぞ呋蚺墩迷谖挥谥骰逯系奈恢门c芯片(或載體)接觸,在垂直于芯片或載體的一個邊界并平行于主基板的方向上施加外力,由剪切力引起鍵合失效。當(dāng)出現(xiàn)失效時,記錄失效時力的大小和失效類別。
5、試驗條件G-推開試驗(梁式引線)
本試驗通常用來進(jìn)行工藝控制,并采用鍵合到一特別準(zhǔn)備的基板上的半導(dǎo)體芯片樣品進(jìn)行試驗,因此不能用于產(chǎn)品或檢驗批的隨機(jī)抽樣試驗。試驗時應(yīng)采用帶有小孔的金屬化基板,這個接近中心位置的小孔應(yīng)足夠大,從而為推壓工具提供間隙,但是又不能大到影響鍵合區(qū)。推壓工具應(yīng)足夠大,以使在試驗期間的器件斷裂減到最小,但又不能大到與固定鍵合區(qū)的梁式引線相碰。應(yīng)按下述方式進(jìn)行推開試驗∶牢固固定基板并穿過小孔插入推壓工具,以小于0.25mm/min的速率實現(xiàn)推壓工具與硅器件的接觸(這樣不會產(chǎn)生明顯沖擊),并以恒定速率對鍵合器件下側(cè)加力。當(dāng)失效出現(xiàn)時,記錄失效時力的大小和失效類別。
6、試驗條件H-拉開試驗(梁式引線)
本試驗通常應(yīng)用在以抽樣方式測試陶瓷或其他合適的基板上鍵合的梁式引線。經(jīng)過校準(zhǔn)的拉開設(shè)備包括一個拉開桿(例如鎳鉻或可伐合金線的環(huán)),通過粘膠材料(例如熱敏聚乙烯醋酸鹽樹酯膠)與梁式引線芯片的背部(頂側(cè))牢固連接。把基板牢固地裝在拉開夾具中,而拉開桿和粘膠材料保持牢固的機(jī)械連接,在垂直方向的5°內(nèi)施加應(yīng)力,其值應(yīng)不小于計算的應(yīng)力大小(見第六條)或者直到把芯片拉倒離開基板2.54mm為止。當(dāng)失效出現(xiàn)時,記錄失效時力的大小、計算力的極限值和失效類別。
五、推拉力測試機(jī)試驗設(shè)備:
科準(zhǔn)測控多功能推拉力機(jī)是用于為微電子引線鍵合后引線焊接強(qiáng)度測試、焊點與基板表面粘接力測試及其失效分析領(lǐng)域的專用動態(tài)測試儀器,常見的測試有晶片推力、金球推力、金線拉力等,采用高速力值采集系統(tǒng)。根據(jù)測試需要更換相對應(yīng)的測試模組,系統(tǒng)自動識別模組量程。可以靈活得應(yīng)用到不同產(chǎn)品的測試,每個工位獨立設(shè)置安全高度位及安全限速,防止誤操作對測試針頭造成損壞。且具有測試動作迅速、準(zhǔn)確、適用面廣的特點。適用于半導(dǎo)體IC封裝測試、LED 封裝測試、光電子器件封裝測試、PCBA電子組裝測試、汽車電子、航空航天、軍工等等。亦可用于各種電子分析及研究單位失效分析領(lǐng)域以及各類院校教學(xué)和研究。
六、失效判據(jù)
試驗中,若外加應(yīng)力小于表1中指定的試驗條件、組成和結(jié)構(gòu)所要求的最小鍵合強(qiáng)度時出現(xiàn)鍵合的分離,則為失效。
6.1、失效類別
當(dāng)有規(guī)定時,應(yīng)記錄造成分離所需要的應(yīng)力,以及分離或失效類別。失效分類如下∶
a)對于內(nèi)引線鍵合∶
1) 在頸縮點處(即由于鍵合工藝而使內(nèi)引線截面減小的位置)引線斷開;
2) 在非頸縮點上引線斷開;
3) 芯片上的鍵合(在引線和金屬化層之間的界面)失效;
4) 在基板、封裝外引線鍵臺區(qū)或非芯片位置上的鍵合(引線和金屬化層之間的界面)失效;
5) 金屬化層從芯片上浮起;
6) 金屬化層從基板或封裝外引線鍵合區(qū)上浮起;7) 芯片破裂8) 基板破裂。
b)對于連接器件與電路板或基板的外部鍵合∶
1) 在變形處(受鍵合影響的部位)的外引線或引出端斷開;
2) 在未受鍵合工藝影響的外引線或引出端斷開;
3) 鍵合界面(在進(jìn)行鍵合的外引線或引出端和布線板或基板導(dǎo)體間的低溫焊或熔焊交界面)
失效
- 金屬化導(dǎo)體從布線板或基板上浮起;
- 布線板或基板內(nèi)部斷裂。
c) 對于倒裝片結(jié)構(gòu)∶
1) 鍵合材料或基板鍵合區(qū)(適用時)的失效;
2) 芯片(或載體)或基板的破裂(緊靠在鍵合處下面的芯片或基板失掉一部分);3) 金屬化層浮起(金屬化層或基板鍵合區(qū)與芯片、載體或基板分離)。
d) 對于梁式引線器件∶
1) 硅片破碎
2) 梁在硅片上浮起;
3) 鍵合處梁斷裂;
4) 硅片邊緣處梁斷裂;
5) 梁在鍵合處和硅片邊線之間斷裂;
6) 鍵合點浮起
7) 金屬化層從芯片上浮起(金屬化層分離),鍵合區(qū)的分離;
8) 金屬化層浮起
注∶射頻微波混合電路要求鍵合引線平直,這可能引起不正確的引線拉力數(shù)據(jù)。可運(yùn)用下述公式確定合適的
引線拉力值∶
此外對射頻/微波混合電路中含有不能采用拉力鉤的引線,必須復(fù)制測試試樣,使拉力鉤可以接入,達(dá)到拉力試驗的目的。為此,應(yīng)該在鍵合混合電路產(chǎn)品的同時,采用同樣設(shè)備、操作者和步驟鍵合作為試樣的引線。對試驗樣引線進(jìn)行拉力測試,以取代混合電路上的調(diào)諧引線或難以接近的引線的測試。試樣的失效被認(rèn)為是產(chǎn)品的失效,并應(yīng)按照適用規(guī)范考慮采取合適的處理措施(見圖3)。
七、說明
有關(guān)的訂購文件應(yīng)規(guī)定以下內(nèi)容∶
a) 試驗條件類別的字母代號;
b) 如果不按條六規(guī)定,應(yīng)規(guī)定最小鍵合強(qiáng)度或規(guī)定所需強(qiáng)度分布的細(xì)節(jié)(需要時);
c) 采用的樣本數(shù)、接收數(shù)或?qū)γ恳粋€器件規(guī)定拉力試驗的數(shù)目和選取方法。如果被試器件不是
4個,還應(yīng)規(guī)定器件數(shù)目
d) 對于試驗條件A,如果施加于鍵合上使其脫落的應(yīng)力角度不是90°,應(yīng)規(guī)定其角度和鍵合強(qiáng)度
極限值(見第六條);
e) 需要時,給出分離力和失效類別報告的要求(見6.1)。
以上就是編給大家?guī)淼陌雽?dǎo)體集成電路鍵合強(qiáng)度的測試介紹,以上包含測試原理、程序、試驗條件、說明等,希望能給大家?guī)韼椭】茰?zhǔn)專注于推拉力測試機(jī)研發(fā)、生產(chǎn)、銷售。廣泛用于與LED封裝測試、IC半導(dǎo)體封裝測試、TO封裝測試、IGBT功率模塊封裝測試、光電子元器件封裝測試、大尺寸PCB測試、MINI面板測試、大尺寸樣品測試、汽車領(lǐng)域、航天航空領(lǐng)域、軍工產(chǎn)品測試、研究機(jī)構(gòu)的測試及各類院校的測試研究等應(yīng)用。如果您有遇到任何有關(guān)推拉力機(jī)、半導(dǎo)體集成電路等問題,歡迎給我們私信或留言,科準(zhǔn)的技術(shù)團(tuán)隊也會為您免費解答!
審核編輯 黃昊宇
-
芯片
+關(guān)注
關(guān)注
463文章
54010瀏覽量
466151 -
半導(dǎo)體
+關(guān)注
關(guān)注
339文章
30737瀏覽量
264205
發(fā)布評論請先 登錄
半導(dǎo)體芯片鍵合技術(shù)概述

德州儀器:銅鍵合線在半導(dǎo)體封裝中的應(yīng)用變革
隱形失效:金屬間化合物尖刺如何“欺騙”半導(dǎo)體鍵合強(qiáng)度測試
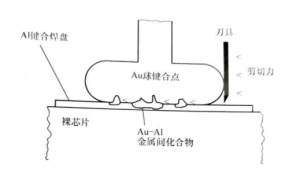
誰更有效?解碼焊球剪切與鍵合點拉力測試的真實對比
拉力測試過關(guān),產(chǎn)品仍會失效?揭秘不可替代的半導(dǎo)體焊球-剪切測試
半導(dǎo)體“金(Au)絲引線鍵合”失效機(jī)理分析、預(yù)防及改善的詳解;

基于焊接強(qiáng)度測試機(jī)的IC鋁帶鍵合強(qiáng)度全流程檢測方案

電子元器件失效分析之金鋁鍵合

探秘鍵合點失效:推拉力測試機(jī)在半導(dǎo)體失效分析中的核心應(yīng)用

銀線二焊鍵合點剝離失效原因:鍍銀層結(jié)合力差VS銀線鍵合工藝待優(yōu)化!
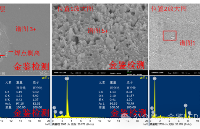
鍵合線剪切試驗——確保汽車電子產(chǎn)品的可靠連接

引線鍵合里常見的金鋁鍵合問題

粗鋁線鍵合強(qiáng)度測試:如何選擇合適的推拉力測試機(jī)?
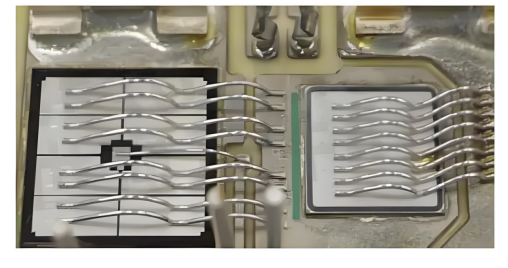
低氣壓試驗箱:揭秘集成電路在高原與航空環(huán)境下的失效機(jī)制
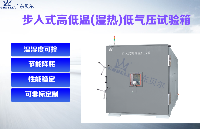



 半導(dǎo)體集成電路鍵合強(qiáng)度原理、試驗程序、試驗條件、失效判據(jù)分享!
半導(dǎo)體集成電路鍵合強(qiáng)度原理、試驗程序、試驗條件、失效判據(jù)分享!





評論