摘要: 研究并總結(jié)了銅絲鍵合塑封器件在實際應(yīng)用環(huán)境中工作時發(fā)生的幾種不同失效模式和失效機理,包括常見封裝類型電路的失效,這些封裝類型占據(jù)絕大部分銅絲鍵合的市場比例。和傳統(tǒng)的實驗室可靠性測試相比,實際應(yīng)用中的銅絲失效能夠全面暴露潛在可靠性問題和薄弱點,因為實際應(yīng)用環(huán)境存在更多不可控因素。
實際應(yīng)用時的失效或退化機理主要包括:外鍵合點氯腐蝕、金屬間化合物氯腐蝕、電偶腐蝕、鍵合彈坑、封裝缺陷五種類型。對實際應(yīng)用中的數(shù)據(jù)和分析為進一步改善銅絲鍵合可靠性、提高器件穩(wěn)定性提供了依據(jù)。
0引言
近些年銅絲鍵合技術(shù)獲得了快速發(fā)展,在集成電路封裝中逐步取代金絲鍵合。與金絲相比,銅絲除了價格低之外,還具有機械強度高、電阻率低、銅鋁金屬間化合物(IMC)生長慢、熱導(dǎo)率高等優(yōu)勢,特別是低電阻率和高熱導(dǎo)率,使銅絲的直徑更小(通常為20μm)、鍵合密度更高。不過,銅絲鍵合的工藝窗口較小,鍵合力的控制較為嚴格,同時,銅絲容易氧化,需采用惰性氣體(如氮氣)或混合氣體進行保護。
目前,覆鈀銅絲也得到廣泛應(yīng)用,比純銅引線更抗氧化。因為鍵合時力較大,鋁焊盤也相應(yīng)進行了改進,例如增加鋁的厚度、鋁上鍍鎳鈀、焊盤介質(zhì)增加通孔結(jié)構(gòu)的設(shè)計等。為了更好地保護銅絲,封裝塑封料也有了相應(yīng)的改進,如改進pH值(pH值約為7.1)、減少氯離子含量、增加離子捕捉劑濃度。因此,在晶圓廠、封裝廠的合作下,這些工藝上的可靠性問題正在減少。
實驗室采用高溫貯存試驗、溫度循環(huán)試驗、高溫高濕試驗或高加速熱應(yīng)力試驗等對銅絲鍵合可靠性進行評估,結(jié)果均顯示銅絲鍵合具有非常好的使用壽命。然而許多可靠性測試是在實驗室環(huán)境下進行的,為了避免突發(fā)失效的產(chǎn)生,產(chǎn)品的濕度、溫度、電流、化學(xué)污染等因素均得到控制。在現(xiàn)實使用中有許多不可控的因素,如污染、水汽侵入、整機加電條件等,在這些綜合應(yīng)力作用下會加速退化并引起突發(fā)性或不穩(wěn)定性失效。
本文通過對近五年來典型的實際應(yīng)用樣品進行失效分析,給出了銅絲鍵合在實際應(yīng)用中常見的失效模式、主要的退化機理或者失效機理,為提高銅絲鍵合的可靠性以及器件使用壽命提供依據(jù)。
1 試驗方法
1.1 用于失效分析的樣品制備方法
銅絲鍵合與傳統(tǒng)金絲鍵合相比,因材料差異,器件開封方法上有所不同,可以采用等離子開封方法、陽極保護法等,但這些方法需要昂貴的設(shè)備或者給器件加電。為了在傳統(tǒng)方法上直接改進,經(jīng)過多次試驗,最后采用如下的方法:先用激光開封機減薄芯片表面塑封料直至露出銅絲,再采用質(zhì)量比為2∶3的濃硫酸和發(fā)煙硝酸(高溫120℃)進行滴酸開封。
除了采用化學(xué)方法外,為觀察銅絲的腐蝕失效,采用了機械開封方法,該方法主要采用平面機械研磨技術(shù)。通過機械方式剝離塑封料進而觀察芯片的表面形貌特征。
第三種方法為剖面制樣技術(shù),首先通過固封環(huán)氧進行剖面機械研磨,再通過氬離子束拋光技術(shù)進行剖面減薄以降低金屬延展對結(jié)果判斷產(chǎn)生的干擾,目的是進行界面形貌觀察和材料表征。
1.2 物理分析方法
銅絲鍵合失效為封裝級失效,首先采用高分辨率X射線成像系統(tǒng)對內(nèi)部結(jié)構(gòu)、鍵合絲材質(zhì)進行初步判斷。一般情況下,銅絲的輪廓在X射線下較為模糊,而金絲則較為清晰。復(fù)雜封裝則需要采用CT斷層掃描進行重構(gòu)。制樣完成后,采用光學(xué)顯微鏡和掃描電子顯微鏡(SEM)進行圖像分析,采用能譜儀(EDS)、離子色譜儀或者二次離子質(zhì)譜儀進行元素、離子等材料分析。
2 結(jié)果與討論
銅絲鍵合塑封器件實際應(yīng)用過程的常見失效模式和失效機理如下所述。這些失效發(fā)生的位置不同,具體的失效原因也不盡相同。
2.1 外鍵合點腐蝕
TI公司生產(chǎn)的超薄縮小型封裝(TSSOP)微處理器在現(xiàn)場使用幾個月后出現(xiàn)失效。銅絲鍵合在表面鍍鈀(或銀)的金屬框架上形成外鍵合點連接,激光開封可見氯腐蝕銅絲后,整個楔形鍵合消失(圖1(a)),切片分析可見外鍵合點銅絲變色形成了含氯的腐蝕產(chǎn)物(圖1(b)),其中氯元素的質(zhì)量分數(shù)(w)約為0.83%(如圖2所示,圖中x為原子數(shù)分數(shù),E為元素能量)。
對其塑封材料進行分析,發(fā)現(xiàn)一般塑封料中也可以檢測到少量的氯元素。一般認為銅不能直接與氯離子產(chǎn)生化學(xué)反應(yīng),但銅的表面可以形成Cu2O,發(fā)生電化學(xué)的腐蝕作用,并且能夠和氯離子形成絡(luò)合離子產(chǎn)生進一步反應(yīng),整個腐蝕反應(yīng)的化學(xué)方程式為

因此,為預(yù)防此類失效,塑封材料的抗?jié)裥阅堋Ⅺu素含量的控制都需要進一步提高,并盡量減少環(huán)境污染、濕度等對器件的影響,減少印制板組件(PCBA)的離子殘留并涂覆三防漆防護。
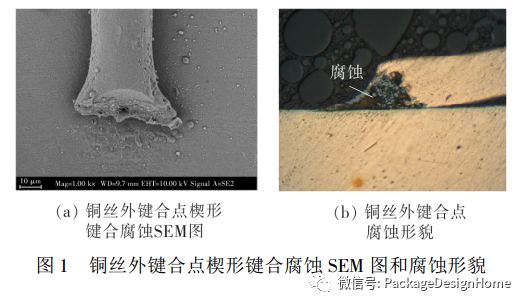
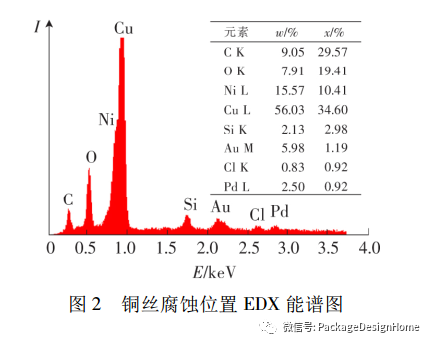
2.2 封裝缺陷
封裝缺陷的產(chǎn)品可能不會立刻失效,只有在外場應(yīng)力下可能加速其失效。本文介紹兩種主要類型的封裝缺陷:①外鍵合點頸部裂紋;②鍵合絲間距過小。在外鍵合點頸部位置形成裂紋可能與鍵合工藝有關(guān),也可能與注塑過程有關(guān)。以NXP品牌QFN16封裝的微處理器為例,該器件用于基站中的通信設(shè)備,外部環(huán)境為熱帶,溫度應(yīng)力較大,很快即發(fā)現(xiàn)失效。
塑封與引線框之間并沒有產(chǎn)生明顯的分層,但其外鍵合點頸部產(chǎn)生了局部裂紋甚至貫穿性裂紋,如圖3所示。這種失效在初次測試階段可能可以排查到,通過對初次測試失效的樣品進行分析,就可以確定是否存在批次性缺陷,從而避免實際應(yīng)用時出現(xiàn)大規(guī)模失效。
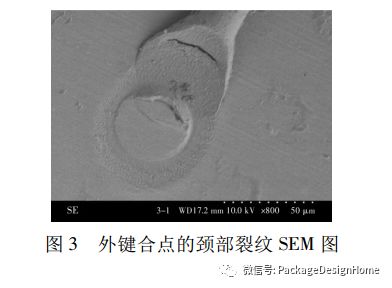
鍵合絲間距過小的缺陷未必是銅絲獨有,鍵合引線間距過小導(dǎo)致兩線之間場強過大,在長期應(yīng)用時產(chǎn)生漏電、退化并發(fā)生突發(fā)失效。例如ST公司UFQFPN48封裝的ARM處理器芯片,隨整機在現(xiàn)場使用一段時間后電源和地之間短路失效,通過CT斷層掃描重構(gòu)出內(nèi)部鍵合引線,鍵合引線間距非常小,懷疑失效與鍵合引線間距偏小有關(guān),切片結(jié)果顯示,鍵合絲之間塑封料已過熱炭化,如圖4所示。
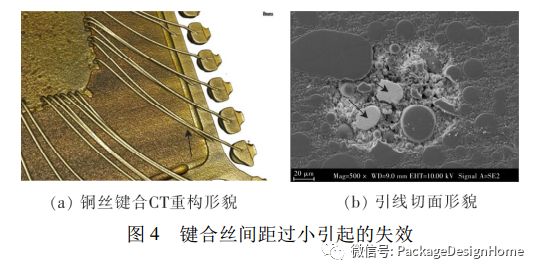
2.3
內(nèi)鍵合點鍵合彈坑
在銅絲鍵合工藝中,通常會調(diào)整工藝窗口以適合不同芯片的鍵合需要,但工藝調(diào)整不當時仍然會發(fā)生批次性的鍵合彈坑現(xiàn)象。內(nèi)鍵合點的彈坑損傷失效也具有潛伏性,導(dǎo)致鍵合強度和介質(zhì)絕緣性下降等,在應(yīng)用時加電應(yīng)力或者溫度應(yīng)力下可以加速失效。 國產(chǎn)SOT23-6封裝的脈沖寬度調(diào)制控制芯片產(chǎn)品初測合格,焊接完成后即發(fā)現(xiàn)功能失效,失效率達1%,已通過測試產(chǎn)品投入使用后依然有很高的失效率。
實驗室測試其I-V特性曲線并無明顯異常,通過化學(xué)開封和鍵合拉力測試分析,部分鍵合絲拉力為0N,脫離界面伴隨著介質(zhì)層和硅層損傷,呈現(xiàn)典型的“彈坑”形貌,切片分析也確認了這種失效現(xiàn)象,如圖5所示。銅絲鍵合周圍的鋁擠壓現(xiàn)象比較嚴重,表明鍵合的力較大。

2.4 內(nèi)鍵合點IMC的化學(xué)腐蝕
微電子器件有多種腐蝕機理,常見的三種形式為化學(xué)腐蝕、電偶腐蝕和電解腐蝕。在不加電情況下最常見的方式為化學(xué)腐蝕。
SOT23塑封封裝電壓基準源用于電源適配器,使用一段時間后輸出電壓出現(xiàn)漂移。通過機械開封后目檢觀察,確認芯片表面鋁焊盤被腐蝕,銅發(fā)生了遷移和再沉積,IMC界面存在含氯的化合物,具體結(jié)果如圖6所示。
銅鋁鍵合的IMC主要成分為CuAl2、CuAl和Cu9Al4,以CuAl2和Cu9Al4為主。銅絲內(nèi)鍵合點腐蝕主要是因Cu9Al4和CuAl2受到Cl-侵蝕導(dǎo)致,最終導(dǎo)致鍵合強度下降,可能的一系列反應(yīng)為
因此,針對IMC氯腐蝕失效,需要進一步改進器件封裝材料和表面防護材料。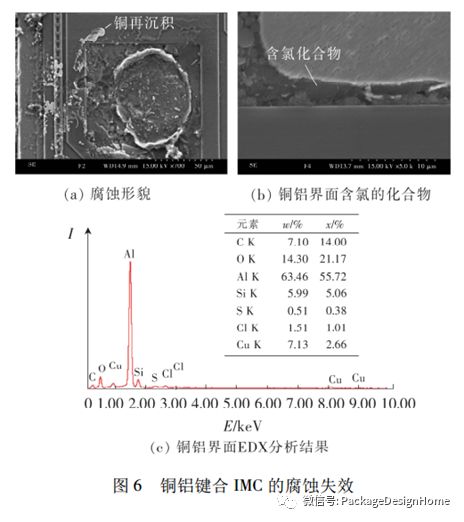
2.5 電偶腐蝕
銅鋁鍵合界面鍵合強度的下降可能是一個長期的過程,一般情況下不會引起突發(fā)性失效,并且鍵合點位置過熱會形成塑封料的炭化現(xiàn)象。這種鍵合強度下降的失效在“雙85”高溫高濕試驗和實際使用中都得到了很好的驗證。失效表現(xiàn)為內(nèi)鍵合點沒有形成彈坑,沒有明顯的過電應(yīng)力和化學(xué)污染,鍵合點呈現(xiàn)過熱失效。
這是因為銅鋁界面在吸濕環(huán)境時會形成電偶(接觸)腐蝕,也稱之為原電池腐蝕,最終引起鋁層氧化,鍵合強度降低。分析過三起電磁爐風(fēng)扇不轉(zhuǎn)的失效原因,均為TO-94封裝的霍爾傳感器失效引起的,該類傳感器出現(xiàn)失效的鍵合點為地(GND)端口,失效形貌見圖7。

以上五種銅絲鍵合器件的失效模式、失效機理以及后續(xù)改進措施見表1。

3 結(jié)論
研究了銅絲鍵合塑封電路在實際應(yīng)用時主要的失效模式和失效機理,主要包括:外鍵合點氯腐蝕、金屬間化合物氯腐蝕、電偶腐蝕、鍵合彈坑以及封裝缺陷。這些分析結(jié)果為銅絲鍵合封裝器件的制造、生產(chǎn)和使用提供了參考,同時給出預(yù)防銅絲器件的突發(fā)失效或者加速退化失效的思路,最終目標是提高器件可靠性,從而改善系統(tǒng)的穩(wěn)定性。
審核編輯:劉清
-
微處理器
+關(guān)注
關(guān)注
11文章
2431瀏覽量
85837 -
EDS
+關(guān)注
關(guān)注
0文章
105瀏覽量
12293 -
IMC
+關(guān)注
關(guān)注
1文章
34瀏覽量
5146
原文標題:銅絲鍵合在實際應(yīng)用中的失效分析
文章出處:【微信號:半導(dǎo)體封裝工程師之家,微信公眾號:半導(dǎo)體封裝工程師之家】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
IC引腳失效模式和影響分析(FMEA)的重要性
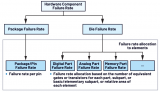
一文了解什么是功率半導(dǎo)體器件產(chǎn)品的失效

半導(dǎo)體“金(Au)絲引線鍵合”失效機理分析、預(yù)防及改善的詳解;

電子元器件典型失效模式與機理全解析

電子元器件失效分析之金鋁鍵合

探秘鍵合點失效:推拉力測試機在半導(dǎo)體失效分析中的核心應(yīng)用

常見的電子元器件失效分析匯總
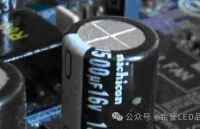
IGBT 芯片平整度差,引發(fā)鍵合線與芯片連接部位應(yīng)力集中,鍵合失效

風(fēng)華貼片電感的失效模式有哪些?如何預(yù)防?
怎么找出PCB光電元器件失效問題

LED失效的典型機理分析
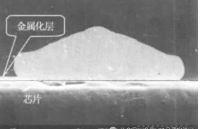



 銅絲鍵合塑封器件的幾種不同失效模式和失效機理分析
銅絲鍵合塑封器件的幾種不同失效模式和失效機理分析

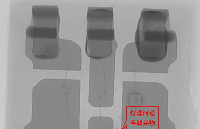





評論