由于測試芯片的復雜性和覆蓋范圍的原因,單個小芯片對復合材料成品率下降的影響正在為晶圓測試帶來新的性能要求。從測試的角度來看,使小芯片成為主流技術取決于確保以合理的測試成本獲得“足夠好的模具”
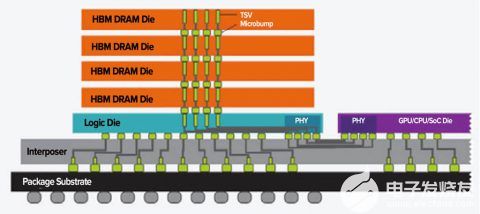
在異構集成系統(tǒng)中,由于單個小芯片而導致的復合成品率下降的影響,就晶圓復雜度和測試復雜性而言,為晶圓測試帶來了新的性能要求。
從測試的角度來看,使小芯片成為主流技術取決于確保以合理的測試成本獲得“足夠好的模具”。 晶圓級測試在小芯片制造過程中扮演著至關重要的角色。以HBM(高帶寬內存)為例,它可以及早發(fā)現(xiàn)有缺陷的DRAM和邏輯芯片,以便可以在復雜而昂貴的堆疊階段之前將其刪除。堆疊后晶圓的進一步測試可確保完成的堆疊在切割成獨立組件之前具有完整的功能。
理想情況下,每個DRAM芯片在堆疊之前都應進行已知良好芯片(KGD)測試,以獨立驗證其性能。但這在經(jīng)濟上通常是不可行的。在某些時候,測試成本超過了系統(tǒng)完成后增加的價值。
因此,需要一種平衡測試成本和未做芯片不良率檢測的測試策略,以將異構集成引入大批量生產。得益于MEMS探針卡技術的創(chuàng)新,F(xiàn)ormFactor的產品可以幫助客戶實現(xiàn)全流程的KGD測試(例如支持45μm柵格陣列間距微凸點測試的Altius?探針卡,用于高速HBM和Interposer插入連接器的良品率驗證),并且可以接受有限的測試成本(例如SmartMatrix?探針卡,通過同時測試300mm晶圓上的數(shù)千個芯片,大大降低了每個芯片的測試成本)。
最終,我們在小型芯片制造過程的每個階段獲得有關產品性能和成品率的更多信息,從而幫助客戶降低總體制造成本。
審核編輯:符乾江
-
芯片
+關注
關注
463文章
54253瀏覽量
468217 -
晶圓測試
+關注
關注
1文章
46瀏覽量
13870
發(fā)布評論請先 登錄
離線語音芯片哪些品牌好用?如何選擇?
虹科分享 | 為什么MPDO成為電梯通信的關鍵技術?從CiA417標準說起

芯知識|如何選擇核心語音IC?盤點廣州唯創(chuàng)電子主流語音芯片方案

AI數(shù)據(jù)中心制冷,磁懸浮離心壓縮機或成為主流
華大九天ALPS CS技術提升數(shù)模混合信號仿真效率

AI芯片冷卻技術,正在成為關鍵
【「AI芯片:科技探索與AGI愿景」閱讀體驗】+半導體芯片產業(yè)的前沿技術
遠距MEMS/固態(tài)vsTOF近距方案,哪種會成為主流?

普誠PT2513B芯片在冰箱風機的應用
國產芯片的崛起:機遇與挑戰(zhàn)并存
QC/PD/FCP/AFC快充協(xié)議,快充電壓誘騙芯片 - PD和QC快充電壓誘騙芯片

主流汽車電子SoC芯片對比分析
靈動微電子MM32MCU的主流型芯片選型




 小芯片成為主流技術的最大挑戰(zhàn)是什么
小芯片成為主流技術的最大挑戰(zhàn)是什么

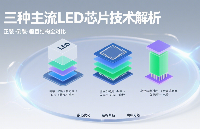




評論