LED 芯片作為半導體照明核心部件,其結構設計直接影響性能與應用。目前主流的正裝、倒裝和垂直三類芯片各有技術特點,以下展開解析。
正裝 LED 芯片:傳統(tǒng)主流之選
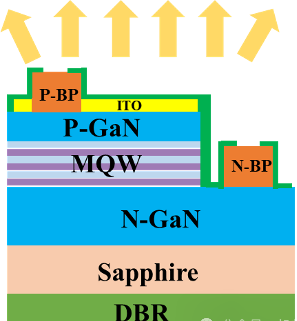
正裝 LED 是最早出現(xiàn)的結構,從上至下依次為電極、P 型半導體層、發(fā)光層、N 型半導體層和藍寶石襯底。其核心問題在于散熱:PN 結熱量需經(jīng)藍寶石襯底傳導至熱沉,而藍寶石導熱性差(約 20 W/(m?K)),易導致效率下降和可靠性降低。
性能上,正裝芯片結構簡單、工藝成熟、成本較低,適合大規(guī)模量產(chǎn)。但短板明顯:P、N 電極同側導致電流橫向流動時出現(xiàn)擁擠,限制驅(qū)動電流;藍寶石襯底阻礙散熱;溫濕度變化可能引發(fā)電極金屬遷移,小尺寸芯片短路風險增加。
按功率可分為三類:小功率芯片采用 MESA、ITO、PAD 三次光刻;中功率芯片增加 CBL 和 PV 光刻共五次制程,背鍍 DBR 提升亮度;大功率芯片沿用五次光刻,背鍍層改為 ODR。目前,藍寶石襯底正裝芯片因成本優(yōu)勢,仍是室內(nèi)照明、指示燈等中低功率場景的主流選擇。
倒裝 LED 芯片:高效散熱新方案
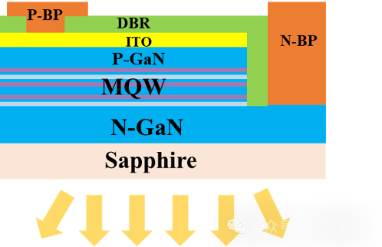
倒裝芯片結構倒置,從上至下為藍寶石襯底、N 型層、P 型層和電極。革新點在于熱量無需經(jīng)藍寶石,直接通過電極傳導至 Si 熱沉(Si 導熱系數(shù)約 150 W/(m?K)),散熱效率大幅提升;底面電極設計避免遮光,光提取效率更高。
其優(yōu)勢顯著:支持大電流驅(qū)動,適合高功率場景;芯片可小型化、高密度化,電極間距遠減少短路風險;散熱優(yōu)化延長壽命,抗靜電能力增強,還簡化后續(xù)封裝。但制造設備要求高、成本較高,目前廠商參與度低,市場應用尚未普及,不過在汽車大燈、高端顯示等領域前景廣闊。
垂直 LED 芯片:襯底革新突破

垂直芯片用 Si、Ge、Cu 等高導熱襯底替代藍寶石,從根本解決散熱問題。采用通孔垂直結構,無需金線連接,顯著降低封裝厚度。
性能亮點包括:兼容紅、綠、藍及紫外全色系;所有工藝在晶圓水平完成,一致性好;抗靜電能力強,可通過大直徑或多數(shù)量通孔進一步提升散熱。但工藝復雜,激光剝離、襯底鍵合等步驟技術要求高,導致合格率較低。
制備需經(jīng)表面處理、臺面蝕刻等步驟,核心是實現(xiàn)外延層與高熱導率襯底的穩(wěn)定鍵合。雖解決了散熱痛點,但因成本和工藝問題,目前發(fā)展平緩,主要應用于特種照明等高端場景。
-
led
+關注
關注
244文章
24634瀏覽量
691409 -
LED芯片
+關注
關注
40文章
631瀏覽量
86820 -
LED工藝
+關注
關注
0文章
3瀏覽量
6415
發(fā)布評論請先 登錄
教你如何識別和挑選LED三種背光技術
三種主流的手機支付技術:RF-SIM、NFC、SIM Pass

LED燈技術的發(fā)展及三種主流燈光優(yōu)缺點對比
三種主流LED背光源技術解析
三種主流投影儀技術類型
三種LED彩電技術登場,誰才是未來的主宰?
芯片制造的藝術與科學:三種主流鍵合技術的綜述

繼電保護的三種狀態(tài)解析
深入解析三種鋰電池封裝形狀背后的技術路線與工藝奧秘




 三種主流 LED 芯片技術解析
三種主流 LED 芯片技術解析

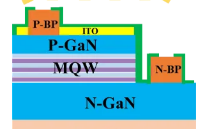
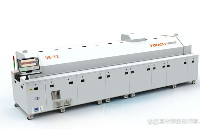



評論