摘要
III-V材料與絕緣子上硅平臺的混合集成是一種很有前景的技術。二乙烯基硅氧烷-雙苯并環丁烯(簡稱DVS-BCB或BCB)是作為一種技術出現適合在工業規模上實現這樣的集成。耦合為這些混合器件文章全部詳情:壹叁叁伍捌零陸肆叁叁叁的設計和制造提供了許多優勢,但對于 一種高效的耦合,是一種非常薄(幾十納米)且均勻的鍵合層。 然而BCB在SOI波導結構上的平坦性較差。
關鍵詞:消失偶聯,膠接,BCB,化學機械平整度,平整度
介紹
硅光子學顯得非常有前途,使大規模的研究領域成為無源器件和一些有源器件的制造在集成光子學。 然而,硅它的間接帶隙阻礙了所以它不適用于光源的制造。解決這個問題的一個辦法是混合集成硅與III-V半導體。 在混合集成中,是III-V 半導體被綁定在SOI之上波導電路。
實驗
將BCB配方環烯3022-35旋涂于空白硅上并進行圖紋處理SOI樣本。 粘附促進劑AP3000旋轉涂布前使用。略

審核編輯:符乾江
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
電路
+關注
關注
173文章
6076瀏覽量
178409 -
半導體
+關注
關注
339文章
30737瀏覽量
264157
發布評論請先 登錄
相關推薦
熱點推薦
功率放大器在超聲化學機械拋光設備研究中的應用
,襯底是技術發展的基石與核心材料。藍寶石(α-Al?O?)憑借其卓越的物理、化學和光學特性,成為常用的襯底和窗口材料,如在LED襯底和紅外窗口中廣泛應用。為提升藍寶石加工質量,科研人員將超聲振動引入CMP,開發出藍寶石超聲振動輔助

如何選擇適合12英寸大硅片拋光后清洗的化學品
針對12英寸大硅片拋光后的清洗,化學品選擇需兼顧污染物類型、硅片表面特性、工藝兼容性、環保安全等多重因素,核心目標是實現高潔凈度、低表面損傷,并適配后續工藝需求。以下從核心維度拆解選擇

功率放大器在UV-CMP拋光機中的應用
電信號達到超聲轉換裝置工作的電壓和功率;第三,放大的電信號傳輸給超聲轉換裝置,使得超聲電信號轉換成同頻率的機械振動。經過上面的三個步驟,CMP拋光機升級為UV-CMP,傳統的化學機械拋光也升級為超聲振動輔助
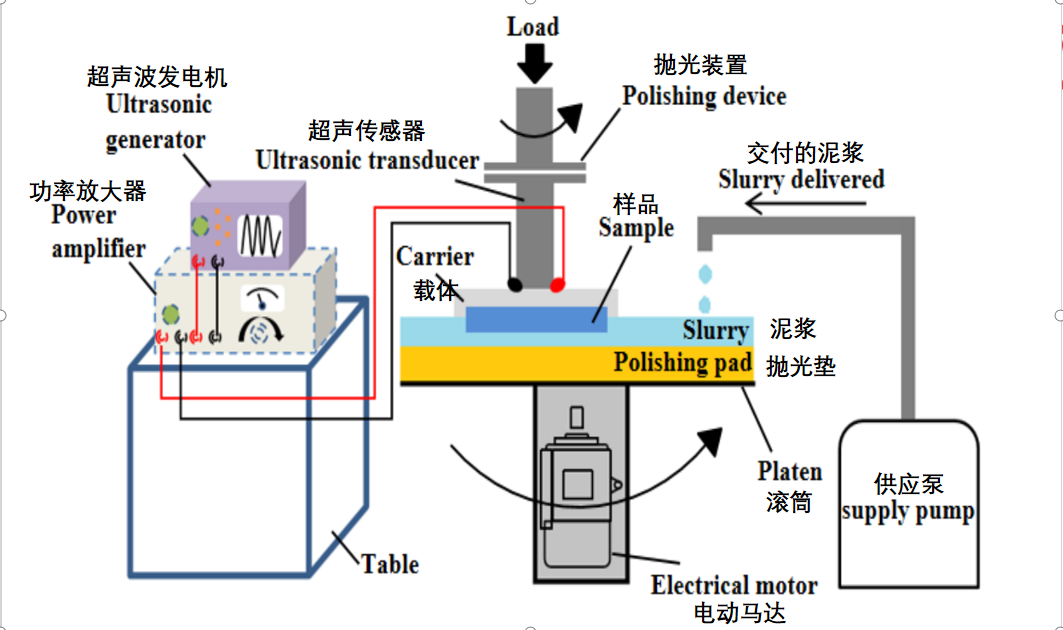
化學機械拋光(CMP)工藝技術制程詳解;
如有雷同或是不當之處,還請大家海涵。當前在各網絡平臺上均以此昵稱為ID跟大家一起交流學習! 20 世紀 80 年代初,IBM 公司在制造DRAM的過程中,為了達到圓片表面金屬間介電質層(IMD)的全局平坦,建立起了硅氧化物(SiO2)的 CMP 工藝

碳化硅 TTV 厚度在 CMP 工藝中的反饋控制機制研究
一、引言
化學機械拋光(CMP)工藝是實現碳化硅(SiC)襯底全局平坦化的關鍵技術,對提升襯底質量、保障后續器件性能至關重要。總厚度偏差(TTV)作為衡量碳化硅襯底質量的核心指標之一,其精確控制

半導體碳化硅SiC制造工藝CMP后晶圓表面粗糙度檢測
在半導體材料領域,碳化硅(SiC)因其卓越的電導性、熱穩定性和化學穩定性而成為制作高功率和高頻電子器件的理想材料。然而,為了實現這些器件的高性能,必須對SiC進行精細的表面處理。化學機械拋光(CMP

研磨盤在哪些工藝中常用
的背面減薄,通過研磨盤實現厚度均勻性控制(如減薄至50-300μm),同時保證表面粗糙度Ra≤0.1μm。 在化學機械拋光(CMP)工藝中,研磨盤配合拋光液對晶圓表面進行全局平坦化,滿足集成電路對層間平整度的要求。 ? 芯片封裝
半導體國產替代材料 | CMP化學機械拋光(Chemical Mechanical Planarization)
一、CMP工藝與拋光材料的核心價值化學機械拋光(ChemicalMechanicalPlanarization,CMP)是半導體制造中實現晶圓表面全局平坦化的關鍵工藝,通過“

深度解析芯片化學機械拋光技術
化學機械拋光(Chemical Mechanical Polishing, 簡稱 CMP)技術是一種依靠化學和機械的協同作用實現工件表面材料去除的超精密加工技術。下圖是一個典型的 CMP 系統示意圖:
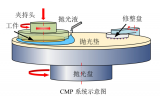
全球CMP拋光液大廠突發斷供?附CMP拋光材料企業盤點與投資邏輯(21361字)
(CMP)DSTlslurry斷供:物管通知受臺灣出口管制限制,Fab1DSTSlury(料號:M2701505,AGC-TW)暫停供貨,存貨僅剩5個月用量(267桶)。DSTlslurry?是一種用于半導體制造過程中的拋光液,主要用于化學機械拋光(CMP)

一文詳解銅互連工藝
銅互連工藝是一種在集成電路制造中用于連接不同層電路的金屬互連技術,其核心在于通過“大馬士革”(Damascene)工藝實現銅的嵌入式填充。該工藝的基本原理是:在絕緣層上先蝕刻出溝槽或通孔,然后在溝槽或通孔中沉積銅,并通過

半導體芯片集成電路工藝及可靠性概述
(Czochralski)生長為圓柱形硅錠。切割與拋光:硅錠切割成0.5-1mm厚的晶圓(常見尺寸12英寸/300mm),經化學機械拋光(CMP)達到納米級平整度。2.氧

氬離子拋光技術之高精度材料表面處理
,適用于多種微觀分析技術。怎樣利用氬離子拋光技術氬離子拋光技術利用氬離子束對樣品表面進行轟擊,氬離子與樣品表面原子發生彈性碰撞,使表面原子逐漸被移除。與傳統的機械拋光




 III-V族化學-機械拋光工藝開發
III-V族化學-機械拋光工藝開發


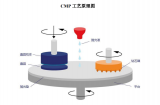



評論