在7月27日凌晨舉辦的Intel Accelerated活動中,英特爾放出了幾個重磅消息,未來制程節(jié)點的全面改名,后續(xù)先進(jìn)制程的技術(shù)推進(jìn)和時間節(jié)點,以及全新的封裝技術(shù)和代工客戶。
新的命名:10nm變Intel 7
過去的報道中,我們已經(jīng)多次提到了英特爾在10nm和7nm制程上,英特爾在晶體管密度上其實是領(lǐng)先同節(jié)點名的臺積電和三星的。英特爾也深知這一點,過去的節(jié)點命名方式讓他們在營銷上吃了大虧,7nm開發(fā)進(jìn)度被延后也就加劇了這一問題,于是英特爾決定改變這一現(xiàn)狀。
英特爾今年年末會在Alder Lake 12代酷睿CPU上用到10nm Enhanced SuperFin(10ESF),而如今他們已經(jīng)將10ESF制程改名為Intel 7制程,而過去提及的7nm將改名為Intel 4制程,很明顯英特爾想以這樣的方式來對標(biāo)臺積電和三星同命名節(jié)點的晶體管密度。
與10nm SuperFin制程相比,Intel 7制程可以做到10至15%的性能/功耗增益,并引入了對FinFET晶體管的進(jìn)一步優(yōu)化。英特爾稱其10nm目前已經(jīng)進(jìn)入了全面量產(chǎn)狀態(tài),超過了14nm的產(chǎn)量。而Intel 7現(xiàn)在也已進(jìn)入量產(chǎn)狀態(tài),為今明兩年的產(chǎn)品做好準(zhǔn)備,比如客戶機(jī)CPU Alder Lake和數(shù)據(jù)中心CPU Sapphire Rapids。
Intel 4則提供了20%的性能/功耗提升,在這個節(jié)點上,英特爾將全面利用EUV光刻機(jī)。使用這一節(jié)點的Meteor Lake CPU也已在今年第二季度完成了Tape In,據(jù)了解,該制程也會用于未來Granite Rapids數(shù)據(jù)中心CPU的生產(chǎn)。通過對IMS的收購,英特爾也會將其多束電子束Mask Writer應(yīng)用于EUV光刻機(jī)中。根據(jù)英特爾公布的合作伙伴,Applied Materials、Lam Research和Tel Tokyo Electron這些頂級半導(dǎo)體設(shè)備供應(yīng)商也會提供對應(yīng)的方案。
后續(xù)制程:Intel 3和20A
此次發(fā)布會上,英特爾也宣布了后續(xù)的兩大制程Intel 3和20A。其中Intel 3將在功率和面積上進(jìn)行進(jìn)一步改進(jìn),為客戶提供18%的性能/功耗提升。Intel 3將擁有更密集的HP庫,以及更高內(nèi)在驅(qū)動電流,并減少了通孔電阻。Intel 3還會繼續(xù)加大EUV光刻機(jī)的使用,英特爾預(yù)計在2023年下半年開始投入該制程節(jié)點的生產(chǎn)。
PowerVia技術(shù)與試產(chǎn)晶圓 / Intel
20A則是英特爾用來追趕臺積電和三星的最后一個沖刺區(qū)。英特爾稱它象征著半導(dǎo)體從納米時代進(jìn)入埃米時代。英特爾給該節(jié)點定下的時間點為2024年上半年,不過具體的量產(chǎn)時間還不好說。英特爾會在該節(jié)點中應(yīng)用全新的RibbonFET晶體管架構(gòu)和PowerVia互聯(lián)技術(shù)。
三星將在3nm上推出GAA(全環(huán)繞柵極)技術(shù),而、臺積電則計劃在2nm上才使用GAA技術(shù),而RibbonFET正是英特爾自己的GAA解決方案。全新的GAA晶體管架構(gòu)運用了納米帶技術(shù),進(jìn)一步提升了電氣性能,加快晶體管開關(guān)速度,減少占用空間。
除此之外,在這20A這一節(jié)點上,英特爾的代工業(yè)務(wù)也將迎來一個新的客戶——高通。
接下高通和亞馬遜大單,制程封裝兩開花
高通在芯片代工上已經(jīng)嘗試了臺積電和三星這樣的合作伙伴,如今又將多出一個英特爾。不過高通預(yù)定的并不是近兩年的Intel 4和Intel 3制程,而是最先進(jìn)的Intel 20A,這意味著我們可能需要在2024年才能看到英特爾代工的高通手機(jī)芯片。這樣的選擇其實也很合理,畢竟今年是英特爾開展代工的第一年,不少人都還在觀望英特爾的代工表現(xiàn)。而且高通一向會選擇最先進(jìn)的制程工藝,只有當(dāng)Intel 20A可以與臺積電與三星比肩時,才會列入可選項。
另一大宣布合作的客戶則是亞馬遜,不過這次合作可不是為其AWS提供CPU的,而是承接其芯片封裝。亞馬遜造芯早就不是什么秘密了,2015年亞馬遜就收購了一家以色列芯片制造公司Annapurna。為了給自己的AWS提供更具競爭力的基礎(chǔ)架構(gòu),自研芯片是必不可少的一環(huán)。亞馬遜此次合作,就是為了數(shù)據(jù)中心芯片的半導(dǎo)體封裝。那么英特爾的封裝究竟有何優(yōu)勢,值得亞馬遜的垂青呢?
封裝全面進(jìn)化:下一代EMIB和Foveros
EMIB和Foveros作為英特爾的封裝王牌技術(shù),在IDM 2.0的運營模式下,也會對客戶開放。Intel Accelerated上,英特爾揭開了下一代EMIB和Foveros技術(shù)的真面目。
EMIB為英特爾2.5D嵌入式多芯片互聯(lián)橋接方案,在EMIB的幫助下,芯片可以做到與尋常封裝相比2倍的帶寬密度和4倍的功率效率。更重要的是,其凸點間距可以做到55微米。而英特爾的下一代EMIB進(jìn)一步減小了凸點間距,將其逐漸降至40微米。
除了EMIB之外,F(xiàn)overos 3D堆疊技術(shù)同樣可以進(jìn)一步減小凸點間距。結(jié)合了兩種技術(shù)后,凸點間距可以降低至36微米。英特爾正式公布了下一代Foveros技術(shù)Foveros Omni和Foveros Direct。
Foveros Omni引入了裸片分解互聯(lián)和模組化的設(shè)計,為芯片設(shè)計提供更高的靈活性。該技術(shù)將硅通孔(TSV)的性能懲罰最小化,并優(yōu)化了功耗和IO,為互聯(lián)提供更高的帶寬。運用Foveros Omni技術(shù)后,凸點間距可以降低至25微米。Foveros Direct更是實現(xiàn)了銅到銅的直接鍵合,為互聯(lián)提供更低的阻值,凸點間距降低至10微米以下。
展望2025年之后
對于2025年之后的計劃,英特爾只用了三句話來描述:堆疊式GAA,下一代背部供電系統(tǒng)和先進(jìn)光學(xué)封裝。在這些技術(shù)上,英特爾會和法國CEA-Leti實驗室、比利時微電子研究中心IMEC和IBM緊密合作。英特爾也會在今年10月27日和28日舉辦的Intel Innovation活動中進(jìn)一步詳解其技術(shù)創(chuàng)新。
新的命名:10nm變Intel 7
過去的報道中,我們已經(jīng)多次提到了英特爾在10nm和7nm制程上,英特爾在晶體管密度上其實是領(lǐng)先同節(jié)點名的臺積電和三星的。英特爾也深知這一點,過去的節(jié)點命名方式讓他們在營銷上吃了大虧,7nm開發(fā)進(jìn)度被延后也就加劇了這一問題,于是英特爾決定改變這一現(xiàn)狀。
英特爾今年年末會在Alder Lake 12代酷睿CPU上用到10nm Enhanced SuperFin(10ESF),而如今他們已經(jīng)將10ESF制程改名為Intel 7制程,而過去提及的7nm將改名為Intel 4制程,很明顯英特爾想以這樣的方式來對標(biāo)臺積電和三星同命名節(jié)點的晶體管密度。
與10nm SuperFin制程相比,Intel 7制程可以做到10至15%的性能/功耗增益,并引入了對FinFET晶體管的進(jìn)一步優(yōu)化。英特爾稱其10nm目前已經(jīng)進(jìn)入了全面量產(chǎn)狀態(tài),超過了14nm的產(chǎn)量。而Intel 7現(xiàn)在也已進(jìn)入量產(chǎn)狀態(tài),為今明兩年的產(chǎn)品做好準(zhǔn)備,比如客戶機(jī)CPU Alder Lake和數(shù)據(jù)中心CPU Sapphire Rapids。
Intel 4則提供了20%的性能/功耗提升,在這個節(jié)點上,英特爾將全面利用EUV光刻機(jī)。使用這一節(jié)點的Meteor Lake CPU也已在今年第二季度完成了Tape In,據(jù)了解,該制程也會用于未來Granite Rapids數(shù)據(jù)中心CPU的生產(chǎn)。通過對IMS的收購,英特爾也會將其多束電子束Mask Writer應(yīng)用于EUV光刻機(jī)中。根據(jù)英特爾公布的合作伙伴,Applied Materials、Lam Research和Tel Tokyo Electron這些頂級半導(dǎo)體設(shè)備供應(yīng)商也會提供對應(yīng)的方案。
后續(xù)制程:Intel 3和20A
此次發(fā)布會上,英特爾也宣布了后續(xù)的兩大制程Intel 3和20A。其中Intel 3將在功率和面積上進(jìn)行進(jìn)一步改進(jìn),為客戶提供18%的性能/功耗提升。Intel 3將擁有更密集的HP庫,以及更高內(nèi)在驅(qū)動電流,并減少了通孔電阻。Intel 3還會繼續(xù)加大EUV光刻機(jī)的使用,英特爾預(yù)計在2023年下半年開始投入該制程節(jié)點的生產(chǎn)。
PowerVia技術(shù)與試產(chǎn)晶圓 / Intel
20A則是英特爾用來追趕臺積電和三星的最后一個沖刺區(qū)。英特爾稱它象征著半導(dǎo)體從納米時代進(jìn)入埃米時代。英特爾給該節(jié)點定下的時間點為2024年上半年,不過具體的量產(chǎn)時間還不好說。英特爾會在該節(jié)點中應(yīng)用全新的RibbonFET晶體管架構(gòu)和PowerVia互聯(lián)技術(shù)。
三星將在3nm上推出GAA(全環(huán)繞柵極)技術(shù),而、臺積電則計劃在2nm上才使用GAA技術(shù),而RibbonFET正是英特爾自己的GAA解決方案。全新的GAA晶體管架構(gòu)運用了納米帶技術(shù),進(jìn)一步提升了電氣性能,加快晶體管開關(guān)速度,減少占用空間。
除此之外,在這20A這一節(jié)點上,英特爾的代工業(yè)務(wù)也將迎來一個新的客戶——高通。
接下高通和亞馬遜大單,制程封裝兩開花
高通在芯片代工上已經(jīng)嘗試了臺積電和三星這樣的合作伙伴,如今又將多出一個英特爾。不過高通預(yù)定的并不是近兩年的Intel 4和Intel 3制程,而是最先進(jìn)的Intel 20A,這意味著我們可能需要在2024年才能看到英特爾代工的高通手機(jī)芯片。這樣的選擇其實也很合理,畢竟今年是英特爾開展代工的第一年,不少人都還在觀望英特爾的代工表現(xiàn)。而且高通一向會選擇最先進(jìn)的制程工藝,只有當(dāng)Intel 20A可以與臺積電與三星比肩時,才會列入可選項。
另一大宣布合作的客戶則是亞馬遜,不過這次合作可不是為其AWS提供CPU的,而是承接其芯片封裝。亞馬遜造芯早就不是什么秘密了,2015年亞馬遜就收購了一家以色列芯片制造公司Annapurna。為了給自己的AWS提供更具競爭力的基礎(chǔ)架構(gòu),自研芯片是必不可少的一環(huán)。亞馬遜此次合作,就是為了數(shù)據(jù)中心芯片的半導(dǎo)體封裝。那么英特爾的封裝究竟有何優(yōu)勢,值得亞馬遜的垂青呢?
封裝全面進(jìn)化:下一代EMIB和Foveros
EMIB和Foveros作為英特爾的封裝王牌技術(shù),在IDM 2.0的運營模式下,也會對客戶開放。Intel Accelerated上,英特爾揭開了下一代EMIB和Foveros技術(shù)的真面目。
EMIB為英特爾2.5D嵌入式多芯片互聯(lián)橋接方案,在EMIB的幫助下,芯片可以做到與尋常封裝相比2倍的帶寬密度和4倍的功率效率。更重要的是,其凸點間距可以做到55微米。而英特爾的下一代EMIB進(jìn)一步減小了凸點間距,將其逐漸降至40微米。
除了EMIB之外,F(xiàn)overos 3D堆疊技術(shù)同樣可以進(jìn)一步減小凸點間距。結(jié)合了兩種技術(shù)后,凸點間距可以降低至36微米。英特爾正式公布了下一代Foveros技術(shù)Foveros Omni和Foveros Direct。
Foveros Omni引入了裸片分解互聯(lián)和模組化的設(shè)計,為芯片設(shè)計提供更高的靈活性。該技術(shù)將硅通孔(TSV)的性能懲罰最小化,并優(yōu)化了功耗和IO,為互聯(lián)提供更高的帶寬。運用Foveros Omni技術(shù)后,凸點間距可以降低至25微米。Foveros Direct更是實現(xiàn)了銅到銅的直接鍵合,為互聯(lián)提供更低的阻值,凸點間距降低至10微米以下。
展望2025年之后
對于2025年之后的計劃,英特爾只用了三句話來描述:堆疊式GAA,下一代背部供電系統(tǒng)和先進(jìn)光學(xué)封裝。在這些技術(shù)上,英特爾會和法國CEA-Leti實驗室、比利時微電子研究中心IMEC和IBM緊密合作。英特爾也會在今年10月27日和28日舉辦的Intel Innovation活動中進(jìn)一步詳解其技術(shù)創(chuàng)新。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
高通
+關(guān)注
關(guān)注
78文章
7742瀏覽量
200137 -
臺積電
+關(guān)注
關(guān)注
44文章
5804瀏覽量
176837 -
intel
+關(guān)注
關(guān)注
19文章
3510瀏覽量
191526 -
光刻機(jī)
+關(guān)注
關(guān)注
31文章
1199瀏覽量
48974
發(fā)布評論請先 登錄
相關(guān)推薦
熱點推薦
被指存散熱硬傷,英特爾代工iPhone芯片幾無可能?
的低端M系列芯片、2028年推出的iPhone標(biāo)準(zhǔn)版芯片,有望率先采用英特爾18A-P先進(jìn)工藝。 ? 然而,這一看似“臺積電+
超越臺積電?英特爾首個18A工藝芯片邁向大規(guī)模量產(chǎn)
電子發(fā)燒友網(wǎng)報道(文/李彎彎)10月9日,英特爾公布了代號Panther Lake的新一代客戶端處理器英特爾?酷睿?Ultra(第三代)的架構(gòu)細(xì)節(jié),這款產(chǎn)品預(yù)計于今年晚些時候出貨。Panther

讓英特爾再次偉大,新CEO推動18A提前量產(chǎn),14A已在路上
知道目前英特爾有哪些地方面需要改進(jìn)。 ? 要知道在全球半導(dǎo)體代工版圖中,英特爾曾長期占據(jù)統(tǒng)治地位。然而隨著臺積

英特爾代工變天:高管跳槽高通,印度裔雙雄掌舵新航向
電子發(fā)燒友網(wǎng)綜合報道,2026年2月,半導(dǎo)體行業(yè)迎來了一場地震級的人事變動。英特爾晶圓代工服務(wù)負(fù)責(zé)人凱文·奧巴克利(Kevin O'Buckley)在任職僅兩年后,突然宣布離職并跳槽至老
突破供電瓶頸,英特爾代工實現(xiàn)功率傳輸?shù)目绱H飛躍
瓶頸,為AI和高性能芯片提供了更穩(wěn)定、更高效的電源解決方案。 電容材料創(chuàng)新 英特爾代工的研究人員展示了三種新型金屬-絕緣體-金屬(MIM)電容器材料,用于深溝槽結(jié)構(gòu): (1)鐵電鉿鋯氧
吉方工控榮膺英特爾中國2025市場突破獎
2025年11月19日晚,重慶悅來國際會議中心華燈璀璨,2025英特爾技術(shù)創(chuàng)新與產(chǎn)業(yè)生態(tài)大會(Intel Connection)歡迎晚宴圓滿落幕。在這一匯聚全球科技領(lǐng)袖、生態(tài)伙伴與行業(yè)
吉方工控亮相2025英特爾技術(shù)創(chuàng)新與產(chǎn)業(yè)生態(tài)大會
2025年11月19日至20日,由英特爾公司主辦的年度重磅盛會——2025英特爾技術(shù)創(chuàng)新與產(chǎn)業(yè)生態(tài)大會(Intel Connection)暨
今日看點丨英特爾 Panther Lake 高規(guī)格型號被曝 TDP 45W;消息稱追覓汽車 7 項專利“全球首創(chuàng)性存疑”
三星2nm晶圓代工 降價 以競爭臺積電 近日,三星電子宣布將其2nm(SF2)制程晶圓的
發(fā)表于 09-28 10:59
?1706次閱讀
特斯拉Dojo重塑供應(yīng)鏈,三星和英特爾分別贏得芯片和封裝合同
獨家生產(chǎn),但從第三代 Dojo(Dojo 3)開始,特斯拉將轉(zhuǎn)向與三星電子及英特爾合作,形成一套全新的供應(yīng)鏈雙軌制模式。這情況不但代表著半導(dǎo)體產(chǎn)業(yè)內(nèi)一次前所未有的合作模式,也可能重塑 AI 芯片制造和封裝的產(chǎn)業(yè)生態(tài)。 新的分工模

臺積電引領(lǐng)全球半導(dǎo)體制程創(chuàng)新,2納米制程備受關(guān)注
在全球半導(dǎo)體行業(yè)中,先進(jìn)制程技術(shù)的競爭愈演愈烈。目前,只有臺積電、三星和英特爾三家公司能夠進(jìn)入3

詳細(xì)解讀三星的先進(jìn)封裝技術(shù)
集成電路產(chǎn)業(yè)通常被分為芯片設(shè)計、芯片制造、封裝測試三大領(lǐng)域。其中,芯片制造是集成電路產(chǎn)業(yè)門檻最高的行業(yè),目前在高端芯片的制造上也只剩下臺積電(TSMC)、三星(SAMSUNG)和
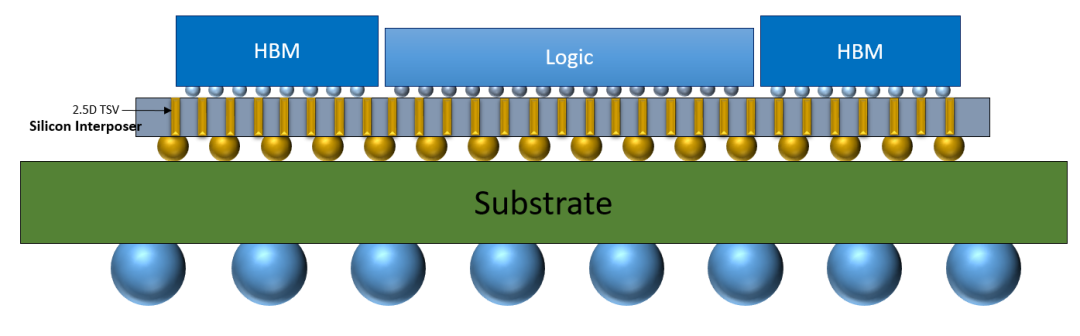
英特爾以系統(tǒng)級代工模式促進(jìn)生態(tài)協(xié)同,助力客戶創(chuàng)新
在半導(dǎo)體代工領(lǐng)域,贏得客戶信任是業(yè)務(wù)長期發(fā)展的關(guān)鍵,而構(gòu)建完善的代工生態(tài)系統(tǒng),毫無疑問是實現(xiàn)這一目標(biāo)的前提。英特爾在2025英特爾
英特爾代工:明確重點廣合作,服務(wù)客戶鑄信任
英特爾代工大會召開,宣布制程技術(shù)路線圖、先進(jìn)封裝里程碑和生態(tài)系統(tǒng)合作。 今天,2025英特爾代工大會(Intel Foundry Direc
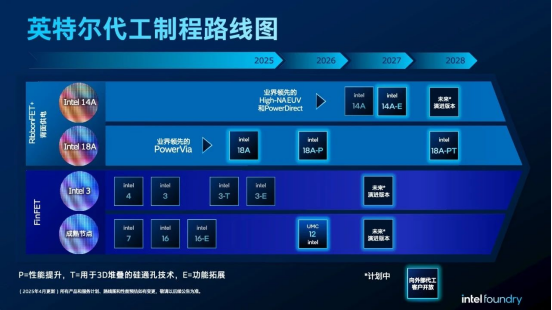



 英特爾接手高通代工,2025年趕超臺積電和三星
英特爾接手高通代工,2025年趕超臺積電和三星





評論