??????近年來隨著電子設備的小型輕量化和高性能化,高密度封裝的半導體器件等正在飛速地發展成多針化和窄間距化(見圖1),為此,要求小型輕量化和高密度細線化的印制電路板與此要相適應,方能滿足半導體器件高精度封裝技術要求。于是在90年代初期,松下電子部品(株)研制和開發出新型的積層式多層板,并實現產量化。并與96年實現全層積層構造(全層IVH構造)的樹脂多層印制電板,稱之謂ALIVH(Any Layer IVHstmcturc Multi-layer Printed Wir-ing Board),并實現了量產化。此后又于98年開發了CSP或MCM等小型封裝裸芯片封裝用的載體即AILVH-B(ALIVH for Bare-chip mounting)實現產量化。同時,日本維克托公司在94年采用液態樹脂絕緣層制作積層用的基板即VIL(Victor Company of Japan Interconnected Layers PWB)并達到量產化開始提供、擴大銷售。
積層板的構造是由「芯板+積層」和「全層積層」之區分,前者是以SLC(Surface Laminar Circuit)/日本IBM、APPl0/ィビヂソ、VIH/日本的維克托為代表的;芯板是來之常規工藝制造的印制電路板,并在其表面覆蓋上絕緣層和布線層的。后者是以B2it (Buried Bump Intercotion Technology)/東芝、ALIVH為代表的,在制造工藝方面有差別,其積層的形成是由絕緣層構成的。所以采用芯板加積層的構造,是由于常規工藝制造高密度的、細線化的多層板無論從印制電路板的設計、制造工藝受到了很大的制約,同時孔金屬化也形成了一定的難度。于是在98年實現孔內用「電鍍柱充填的類型」。特別在JPCA2001年展覽展示這種工藝方法,滿足世紀封裝技術發展的要求。
以下就是敘述ALIVH和VIH制造概況和ALIVH+VIH研制與開發過程。
一. ALIVHzz結構
1.與常規多層板結構的比較 從圖2所示常規工藝制造的多層板,為達到層間的電氣互連,必須進行數鉆孔和貫通孔的孔化與電鍍,這種孔勢必減少基板的有效面積,為了與器件安裝盤的連接,就必須在焊盤和別的位置設置貫通孔,因此極大的浪費了有效的面積。所有這些都成為印制電路板的小型化、設計合理化或者適應高速電路的大課題。如圖2、圖3所示的ALIVH構造的所有層間都設有IVH構造,在器件的正下方進行層間連接,無需電鍍通孔,無論哪層都可以任意連接。 傳統多層板電氣連接采用金屬化孔構造.
2.構成材料 從圖3構成材料與技術所示,原來傳統生產印制電路板所采用的基板材料為玻璃布,環氧樹脂為代表,它基本上滿足電子材料、防彈衣和消防服等強性和耐熱性要求,而使用芳胺無紡布和含浸有高耐熱性環氧樹脂的半固化材料取代傳統的高密度安裝用印制電路板的玻璃布/環氧樹脂絕緣材料。因為芳胺無紡布的無紡纖維具有高的性能特征如低熱膨脹率、低的介電常數、高耐熱性、高剛性和輕量化等,是一種優良的基板絕緣材料。此外,傳統的印制電路板的通孔加工多數采用鉆頭的機械加工技術,而ALIVH構造則是采用脈沖振蕩的CO:激光蝕孔進行導通孔加工,無紡布采用的小徑化,實現了多數導通孔加工,而導通孔采用導電膠充填技術,取代了孔化和電鍍銅,實現層間的電氣互連的目的。不采用電鍍銅的方法,導體由銅箔構成,導體厚度均一性高對細導線的形成非常有利。見金相圖1 表1所示,表示了ALIVH的基本規格和特性。如四層板的板厚度為0.45mm、六層板板厚度為0.70mm。導體所使用的銅箔厚度,內層標準銅箔厚度18(最小12)μm,外層銅箔厚度使用35μm。孔徑為200(最小150)μm、焊盤直徑為400(最小300)μm或更小些,設計的導體標準寬度為100(最小60)μm、導體標準間距為100(最小70μm.從表2所示,它與FR-4(用玻璃布/環氧樹脂制造多層板)從電氣性能、機械性能等特性的比較,ALIVH的介質常數、密度、熱膨脹系數小和玻璃轉化溫度高。從可靠性試驗結果分析(見表3)表示了ALIVH層間電氣互連的可靠性,在高濕氛圍放置試驗和各種類型的熱沖擊試驗中,ALIVH的可靠性優良,電阻變化率都在20%范圍以內。
3.設計規格特征: AUVH產品的設計規格的主要特征如下: ①全層IVH構造,導通孔的設置層沒有限制。 ②全層均一規格無異種導通孔或者異種格子配線。 ③導通孔上焊盤,部晶安裝盤可以與導通孔共用。 ④導通孔上導通孔與相鄰接層導通孔位置沒有限制(對于疊加型)。
4.展開 AHVH于96年10月應用于攜帶電話,使其急速地進入超細微化。隨著材料研制開發和制造工藝等的改善和整合,正拓展到攜帶電話以外的領域,開發了作為細線化的半導體裸芯片安裝用的載體即ALIVH-B并已量產化。ALIVH-B沿用導通孔上導通孔、導通孔上焊盤構造等的母板用的優點,為安裝裸芯片的封裝和組件用提供載體即積層板。 圖5所示是部晶搭載狀態。表4是兩種類型構造的積層板布線工藝特性的比較。而制造工藝方面相同的,特別是開發制作細線圖形,導體寬度/導體間距為50/50微米的圖形加工和激光鉆小孔120微米的技術。此外,使用在模塊封裝方面,所采用的導電膠、銅箔、絕緣基板材料都有很大的改進,大大提高可靠性。
5.環境保護 AHVH和ALIVH-B在環境保護方面,研制與開發無鹵素絕緣基板材料。此外,封裝時采用無鉛焊料、高絕緣基板材料的高耐熱性能。
二.VIL及其它
1.特長 VIH屬于熱硬化樹脂和激光鉆孔為「芯板+積層」提供構造的高密度積層用的基板。積層基板激光成孔,就是在積層絕緣材料采用激光射線直接照射即為直接成像法,也可采用附樹脂銅箔或半固化片加銅箔等都可采用此法形成所需要的孔徑。VIH就是采用直接成像法見圖6: VIL第1個特長是獨自開發的二種類型的熱硬化性的樹脂,從功能上它與FR-4同等,具有高的剝離強度、機械特性、絕緣性能可靠性和電氣特性見圖7:
第2特長就是精細電路圖形、小孔徑采用適當的電氣連接方法。導體層是采用芯板銅箔并通過減成法使導體厚度減薄形成細導線化。此外,采用圖形電鍍法也很容易和適宜。因此制作成精細導線圖形就成為可能。從精細圖形制作方法和激光鉆孔,經過加工后孔所形成的斷面圖,其孔的形狀,有著良好的藥液循環性能。但必須將孔內的殘渣除去,才能很容易的使孔內形成均一的電鍍層,特別是量產化,就必須確保小孔徑具有高可靠性電氣連接。
第3特長,多次積層所形成的多層積層板而不采用壓力方法,因此高層數層間的定位精度經過多次積層會有變化的。從量產化角度分析,要確保高層數層間的高的定位精度。獨自開發高精度激光加工機和CCD攝像機用于高精度孔定位機,確保精細孔徑加工用小徑鉆頭接觸的可靠性,保證電氣連接的可靠性。此外多次積層另一個課題,就是內層孔徑被絕緣材料埋人和要確保多次積層表層表面的平坦度,前者臺形的孔的形狀具有良好的脫氣性,較好的實現形成第二層絕緣層的。 寫真3封裝基板的實例所示,其中設計的線寬和間距為L/S40微米、孔徑為90微米。
2.應用: 圖形精細化的形成,其主要特征就是適應0.5節距的CSP部品的小型化的需要,積層板適應了電子設備的高性能化的要求。VIL的代表產品就是攜帶電話的使用,基板表面封裝部品的封裝率達到80%以上,超過其它數字化電影、數字照相機、PDA等所使用的高性能高密度模塊封裝占有率。 VIL典型的結構層見寫真5所示。其基本構成有IVH上的孔設置、阻抗控制、散熱結構等已商品化。
3.環境對策: 主要對VIL積層材料中的鹵素化合物對環境的影響。這就需要研發無鹵素成實現環境和VIL協調發展。同時,無鉛焊料也于99年開始供應市埸,
4.今后的發展: VIL的今后發展重要的有三點,第1點就是向精細圖形化發展。從現在的量產的情況采用L/S=50/50微米是實現高密度封裝必要條件之一。VIL的特長之一就是不采用銅箔而采用圖形電鍍工藝方法實現50微米以下的精細導線化圖形。第2點就是根據攜帶電子設備的特性要求,重要的提高機械強度。要研究與開發出用戶所需要的VIL絕緣材料。第3點就是實現層間高密度互連的自由度。根據VIL的特長和導通孔上焊盤、導通孔上導通、導通孔上導通孔技術,必然會快速實現三次積層量產化。使全層IVH構造的「ALIVH」,結合使用芯板層實現高密度化成為可能。
三、ALIVH+VIL
1.積層構造的比較 前言已述基本有二種類型的積層印制電路板并進行構造上的比較,見圖8所示。右側有支承板型的積層印制電路板,左側是全層積層型印制電路板。所謂支承板即芯板是按照傳統工藝制造的多層板用于布線的需要,因為傳統制造的多層板實現高密度布線受到制約。為此,采用積層就是為實現導線精細化,增加層數并超周期地完成量產化。
2.開發的經過: 根據「芯板層型積層印制電路板」缺點開發出新的構造ALIVH+VIL基板。由于支承板(芯板)和全層IVH構造在ALIVH上的采用使層間連接達到100%,及在VIL絕緣材料精細導線化形成技術的應用,就很容易使表層細線化與內層布線接受性獲得高性能印制電路板。
3.商品概要: 圖9所示,ALIVH和VIL技術的融合概念圖ALIVH用4層多層芯板,表層是單面1層由VIL構成。圖10所示,ALIVH用4層由VIL構成單面2層的斷面構造圖。積層中的VIL部分1層、3層,6層、4層就有可能采用跳躍式孔。芯板及全層積層ALIVH結構上使用全層IVH構造。
4.設計的優越性: 從設計規范分析,ALIVH繼承原設計的上優點,提出更優越性設計規格如下: ①全層IVH規格:孔徑的設置層不受限制; ②每層規格:每層設計組合可自由選擇。表5標準設計規格和精細設計規格組合。 ③焊盤上導通孔:焊盤與孔的共用化(開發了精細孔鍍層采用電鍍銅); ④導通孔上導通孔:鄰近層孔位置不受限制(對應采用跳躍孔)。
5.共同開發的意向: 這個開發就是繼續完成制造高密度封裝基板和制造技術的完善。使高多層的ALIVH印制電路板高密度積層板用VIL技術的融,達到次世紀高密度封裝技術的要求的商品。為此,實現早期開發合作于2001年5月組成,原因是由于新業務的發展需要,在思想上取得一致同意組合的。 今后兩公司發展,以確保研制與開發各工程間順利進行,于是在2002年4月組成共同開發組織。并確保各組織獨自業務活動和產,同商品銷售。圖11就是兩公司研發商品系列。
四.今后的發展 96年10月統計ALIVH產品用于攜帶電話上,生產累計近一億臺以上,獲得高速的發展,今后從ALIVH+VIL兩種技術的融合,生產出環保型的基板材料,基材不含有鹵素化、封裝焊料無鉛化和提高耐熱性能,克服ALIVH用料的吸濕性的缺點,繼承全層IVH結構的優越性和新材料的開發,就能全面的推動新的高精度封裝所需要的新商品研制與開發。
- 制電路板(4922)
印制電路板PCB工藝設計規范
 2223
2223印制電路板的分類
印制電路板的地線設計
印制電路板設計小技巧
印制電路板設計的經驗
印制電路板(PCB)的設計步驟
單面印制電路板簡述
多層印制電路板簡易制作工藝
電鍍對印制電路板的重要性
組裝印制電路板的檢測
組裝印制電路板的檢測
印制電路板設計規范
 73
73新編印制電路板故障排除手冊
 0
0Allegro印制電路板設計610
 0
0印制電路板的設計基礎
 2135
2135印制電路板電磁繼電器
 1482
1482印制電路板柔性和可靠性設計
 485
485印制電路板設計原則和抗干擾措施
 682
682印制電路板設計中手工設計和自動設計的比較
 637
637高密度印制電路板(HDI),高密度印制電路板(HDI)是什么
 3061
3061印制電路板封裝要求
 1187
1187印制電路板EMC設計技巧
 3838
3838印制電路板水平電鍍技術
 0
0印制電路板基礎知識點匯總_印制電路板制作過程
 6541
6541
印制電路板的上市公司有哪些_十大印制電路板上市公司排名
 173312
173312印制電路板的質量要求_印制電路板的原理
 6527
6527
為什么叫印制電路板?印制電路板來由介紹
 9630
9630印制電路板設計心得體會_設計印制電路板的五個技巧
 18826
18826簡單DIY印制電路板設計制作過程
 51157
51157印制電路板的種類有哪些_印制電路板布線要求
 4890
4890印制電路板的裝配工藝
 7864
7864印制電路板翹曲的原因及預防方法
 7456
7456印制電路板PCB具有哪些功能及優點
 10738
10738印制電路板怎樣實現自動功能測試
 2261
2261印制電路板的設計基礎教程免費下載
 0
0印制電路板的水平電鍍工藝解析
 2090
2090SMT印制電路板制造和組裝技術的發展
 1329
1329印制電路板的布線流程
 4124
4124印制電路板的內層加工的步驟
 16944
16944印制電路板表面樹脂層厚度的測量方法
 793
793PCB印制電路板技術水平的標志是什么
 1178
1178
印制電路板工藝設計規范
 1927
1927印制電路板(PCB)的安裝和裝配
 1440
1440 電子發燒友App
電子發燒友App









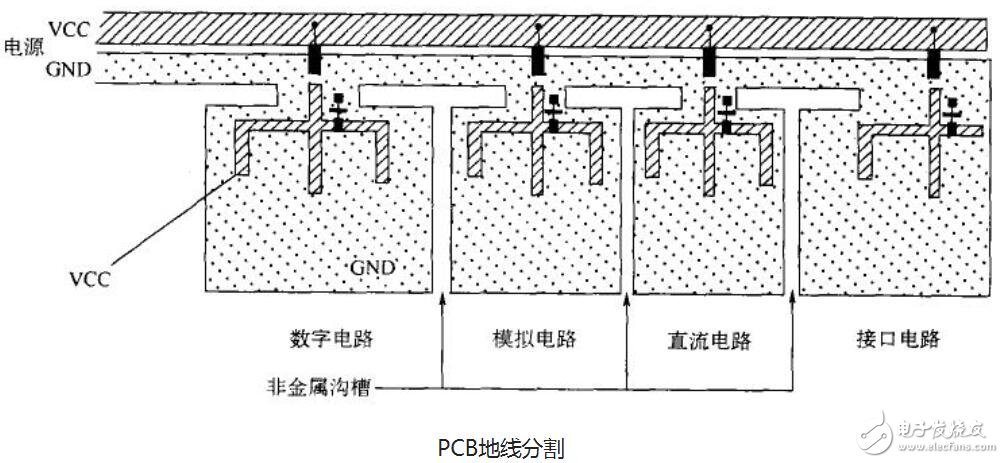



評論