文章來源:學習那些事
原文作者:小陳婆婆
本文介紹了倒角工藝技術及其發展方向。
硅片倒角加工是半導體硅片制造中保障邊緣質量與可靠性的關鍵工序,其核心目標在于消除切割后邊緣產生的棱角、毛刺、崩邊、裂縫及表面污染,通過降低邊緣粗糙度、增強機械強度、減少顆粒沾污,為后續研磨、拋光等工序提供優質基底。

該工序嚴格遵循SEMI標準及IC技術要求,通過精密磨削實現邊緣輪廓的精準控制,常見邊緣形狀包括圓弧形(R-type)與梯形(T-type),其中圓弧形磨輪因磨削效率更高而被廣泛采用——如日本SHE公司從梯形磨輪升級至圓弧形磨輪后,加工效率提升約30%,成為行業技術迭代的典型案例。
加工過程中,硅片被固定于可旋轉支架上,與高速旋轉的金剛石倒角磨輪形成相對運動,轉速范圍通常為5000~6000r/min,高端設備可達15萬r/min,配合適宜磨削液實現高效磨削。

為平衡直徑尺寸公差、表面粗糙度與機械應力損傷控制,行業普遍采用粗精磨結合工藝:先用800粒度粗磨輪以80kr/min轉速進行粗磨,表面機械應力損傷層深約35~40μm,粗糙度Ra約0.5μm;隨后用3000#粒度精磨輪以150kr/min轉速進行精磨,損傷層深降至<3μm,粗糙度Ra優化至0.03μm(約300?)。

先進倒角機如日本東京精密TSKW-GM-5200系統,集成螺旋磨削功能,通過粗精磨輪協同作業實現連續加工,產能達21~25秒/片(144~171片/小時),且配備自動修整裝置——如采用GC 320G(SiC)修整磨輪,針對200mm硅片每加工1000片、300mm硅片每加工500片需修整一次,確保磨輪狀態穩定。

當前技術演進聚焦于自動化與智能化升級,例如AI算法在磨削參數優化、實時狀態監測及質量在線評估中的應用,結合高精度傳感器實現加工過程的閉環控制。同時,環保型磨削液的開發與循環利用系統成為降低運行成本的重要方向,部分企業已實現切削液回收率超95%。
此外,針對300mm及以上大直徑硅片的加工需求,倒角設備正朝著更高轉速、更精密輪廓控制方向發展,如采用超細粒度磨輪(如6000#)進一步降低表面損傷,或探索激光輔助磨削等新型工藝以提升加工效率與質量一致性。這些技術進步不僅推動硅片邊緣質量的持續提升,更為半導體產業向更先進制程、更高可靠性要求的發展提供堅實支撐。
-
半導體
+關注
關注
339文章
31001瀏覽量
265473 -
工藝
+關注
關注
4文章
716瀏覽量
30372 -
芯片制造
+關注
關注
11文章
728瀏覽量
30498
原文標題:芯片制造——硅片倒角加工
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
【「大話芯片制造」閱讀體驗】+芯片制造過程工藝面面觀
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測
影響硅片倒角加工效率的工藝研究
芯片制造中硅片的表面拋光加工工藝介紹




 芯片制造中的硅片倒角加工工藝介紹
芯片制造中的硅片倒角加工工藝介紹

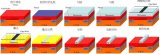

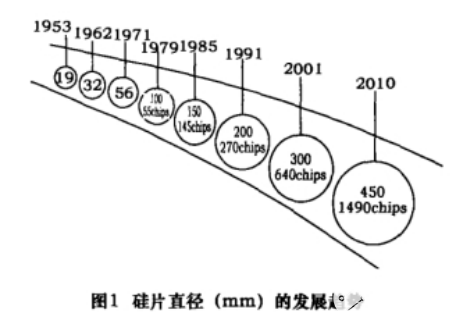
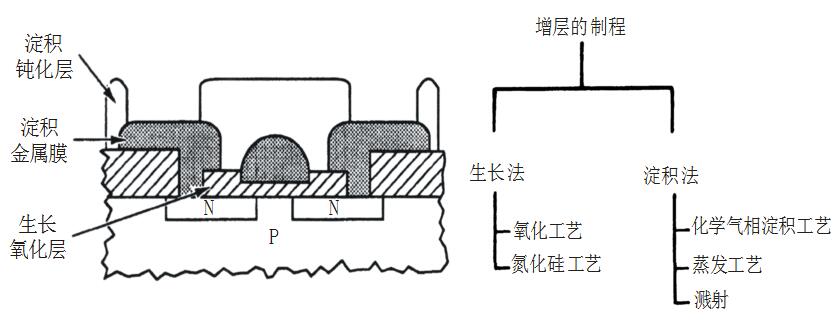







評論