據科創板30日報道,康寧韓國業務總裁Vaughn Hall周三表示,康寧希望利用其特殊的專有技術,擴大其在半導體玻璃基板市場的份額。“我對玻璃基板未來的發展寄予厚望,它似乎比目前芯片封裝工藝中廣泛使用的有機材料基板更具競爭優勢。”
康寧目前供應兩種用于芯片生產的玻璃基板產品,一種用于處理器中中介層的臨時載體,即承接芯片(die)之間互聯所用介質的玻璃基板;另一種用于DRAM芯片中晶圓(wafer)減薄的玻璃基板產品。未來,康寧正準備推出玻璃芯,用于芯片封裝,公司正在向多個潛在客戶提供樣品。
當前,中國大陸為康寧全球最大的玻璃基板生產基地。玻璃基板主要供應給當前部署TGV技術路線的基板廠、封裝廠和實驗室。
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。
審核編輯 黃宇
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
463文章
54010瀏覽量
465995 -
半導體
+關注
關注
339文章
30737瀏覽量
264079 -
封裝
+關注
關注
128文章
9249瀏覽量
148615
發布評論請先 登錄
相關推薦
熱點推薦
與NOKIA大咖共敘 | 玻璃芯技術的優勢所在
。 ? ? ?? 觀點精選 ? ? ? 玻璃是一種性能卓越的材料 。它支持實現 傳統PCB材料無法達成的技術方案 ,其精度與功能可媲美 半導體級別 。但本質而言,玻璃僅是基礎載體,關鍵在于通過 專項工藝賦予

鍵合玻璃載板:半導體先進封裝的核心支撐材料
(UV)、加熱或機械方式解鍵合移除。 ? 需要注意區別玻璃載板與玻璃基板,玻璃載板屬于臨時支撐工具,可重復使用3-4次,而玻璃
玻璃芯片基板成功實現激光植球技術新突破
紫宸激光焊錫應用ApplicationofVilaserSoldering高效節能綠色環保行業領先微型化浪潮下的封裝革命在5G通信、人工智能、自動駕駛等技術的推動下,半導體器件正朝著更高集成度、更小

TGV產業發展:玻璃通孔技術如何突破力學瓶頸?
在后摩爾時代,芯片算力提升的突破口已從單純依賴制程工藝轉向先進封裝技術。當硅基芯片逼近物理極限,2.5D/3D堆疊技術通過Chiplet(芯粒)拆分與異構集成,成為突破光罩限制的核心路
【海翔科技】玻璃晶圓 TTV 厚度對 3D 集成封裝可靠性的影響評估
一、引言
隨著半導體技術向小型化、高性能化發展,3D 集成封裝技術憑借其能有效提高芯片集成度、縮短信號傳輸距離等優勢,成為行業發展的重要方向 。玻璃晶圓因其良好的光學透明性、化學穩定

玻璃中介板技術的結構和性能優勢
半導體行業持續推進性能和集成度的邊界,Chiplet技術作為克服傳統單片設計局限性的解決方案正在興起。在各種Chiplet集成方法中,玻璃中介板代表了一個突破性進展,提供了傳統硅基或有機基板無法實現
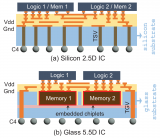
用于高性能半導體封裝的玻璃通孔技術
半導體行業正在經歷向更緊湊、更高效封裝解決方案的轉型。隨著移動設備和物聯網(IoT)應用對更小、更薄且具有增強電氣可靠性的封裝提出需求,研究人員將注意力轉向3D封裝技術。雖然硅

「行業動態」玻璃基技術:透明基板上的中國智造革命
CHIPSAILING 從實驗室的意外發現,到撬動千億市場的核心材料,玻璃基板如何悄然重塑半導體與生物識別的未來? 1970年,康寧實驗室的化學家們面對一塊“失敗”的微晶
TGV技術:推動半導體封裝創新的關鍵技術
隨著半導體行業的快速發展,芯片制造技術不斷向著更高的集成度、更小的尺寸和更高的性能邁進。在這一過程中,封裝技術的創新成為了推動芯片性能提升的關鍵因素之一。TGV(

MEMS制造中玻璃的刻蝕方法
在MEMS中,玻璃因具有良好的絕緣性、透光性、化學穩定性及可鍵合性(如與硅陽極鍵合),常被用作襯底、封裝結構或微流體通道基板。玻璃刻蝕是制備這些微結構的核心工藝,需根據精度要求、結構尺
震驚!半導體玻璃芯片基板實現自動激光植球突破
在半導體行業“超越摩爾定律”的探索中,玻璃基板與激光植球技術的結合,不僅是材料與工藝的創新,更是整個產業鏈協同突破的縮影。未來,隨著5G、AI、汽車電子等需求的爆發,激光錫球焊接機這一技術組合或將成為中國

玻璃中介層:顛覆傳統封裝,解鎖高性能芯片 “新密碼”
電子發燒友網報道(文/黃山明)玻璃中介層是一種用于芯片先進封裝的半導體材料,主要用于連接多個芯片與基板



 康寧計劃擴大半導體玻璃基板市占 擬推出芯片封裝用玻璃芯
康寧計劃擴大半導體玻璃基板市占 擬推出芯片封裝用玻璃芯







評論