以下完整內(nèi)容發(fā)表在「SysPro電力電子技術(shù)」知識星球![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
- 關(guān)于全球十大車規(guī)級功率模塊封裝 · 全景解析,共19500字- 文字原創(chuàng),素材來源:各器件廠商信息,第二次更新
- 「SysPro電力電子技術(shù)」知識星球節(jié)選,非授權(quán)不得轉(zhuǎn)載
- 本篇為節(jié)選,完整內(nèi)容會在知識星球發(fā)布,歡迎學(xué)習(xí)、交流
導(dǎo)語:在新能源汽車和智能電動化的時(shí)代背景下,功率半導(dǎo)體作為"能源轉(zhuǎn)換與能量驅(qū)動的心臟”,正在迎來前所未有的發(fā)展機(jī)遇。無論是驅(qū)動電機(jī)逆變器、車載充電機(jī)(OBC)、機(jī)器人模組、數(shù)據(jù)中心,都需要功率半導(dǎo)體模塊來實(shí)現(xiàn)高效、可靠的能量傳遞。而在這些模塊中,封裝技術(shù)起著至關(guān)重要的作用。它不僅決定了器件的電性能和熱性能,還直接關(guān)系到系統(tǒng)的可靠性、成本與壽命。
目前,車規(guī)級功率半導(dǎo)體模塊封裝正呈現(xiàn)出多元化的發(fā)展趨勢。既有Infineon HybridPACK系列代表的HPD封裝,也有Direct Cooled Module (DCM)為代表的直冷方案,還有Tesla的TPAK、致瞻等中國廠商的ZPAK、以及博世的PM6、Danfoss eMPACK,都在不同的場景中展示了獨(dú)特的技術(shù)路徑。此外,新興的芯片內(nèi)嵌PCB封裝、混合芯片封裝,則代表了未來高集成度與輕量化方向。其背后的思考遠(yuǎn)超越技術(shù)本身,更關(guān)乎整車的平臺化戰(zhàn)略、供應(yīng)鏈安全與終極成本控制。

圖片來源:SysPro
為觀全局,今天我們對車規(guī)級功率模塊封裝技術(shù)進(jìn)行一次的全景式深度剖析。我們將以十大典型封裝為經(jīng)緯,逐一拆清它們的結(jié)構(gòu)特征、拓?fù)浣M織方式、冷卻與互連思路、優(yōu)劣勢與系統(tǒng)級最優(yōu)戰(zhàn)場,希望你看完能對車規(guī)功率封裝的技術(shù)生態(tài)形成一張清晰的“全景地圖”。
目錄
上篇
01 HPD封裝:HybridPACK Drive系列
02 DCM封裝:DCM1000系列
03 TPAK 單管模封路線:特斯拉案例★
04 ZPAK 半橋平臺化模封:致瞻科技案例★
05 eMPack 三維重疊平臺:賽米控丹佛斯路線★
下篇
06 PM6 平臺化封裝:博世路線★
07 芯片內(nèi)嵌 PCB 封裝:舍弗勒、采埃孚、麥格納、保時(shí)捷★
08 SiC+Si混碳融合封裝:英飛凌、匯川、小鵬、舍弗勒★
09 分立器件封裝:TO-247 系列★
10 總結(jié):車規(guī)功率封裝的"熱—電—可靠—平臺化"演進(jìn)規(guī)律
| SysPro備注:本文節(jié)選,完整內(nèi)容在知識星球中發(fā)布★
01
HPD 平臺化封裝:HybridPACK Drive系列
——主驅(qū)通用平臺
首先我們來看看HPD封裝的整體結(jié)構(gòu),這也是最常見的一種封裝結(jié)構(gòu)。HPD,即Hybrid Power Drive,典型代表就是HybridPACK Drive系列,是 Infineon 專門為新能源汽車電驅(qū)系統(tǒng)設(shè)計(jì)的典型功率半導(dǎo)體封裝方案。

圖片來源:SysPro
1.1 結(jié)構(gòu)特點(diǎn)
從外觀上看,HybridPACK Drive 模塊呈現(xiàn)矩形平面化設(shè)計(jì),模塊內(nèi)部采用了銅基板(Cu baseplate)+ Si?N?陶瓷+ 芯片 + 鍵合互連 + 引線框架 + 外部封裝的典型堆疊結(jié)構(gòu)。這種分層結(jié)構(gòu)保證了在有限的空間內(nèi)實(shí)現(xiàn)高電流承載能力與良好的散熱路徑。
簡單一句話概括HPD封裝的目標(biāo),實(shí)現(xiàn):功率密度與模塊擴(kuò)展性之間的平衡。HPD 模塊的設(shè)計(jì)思路就是要在一塊中等尺寸的功率模塊上,既能夠支持高功率(100~300 kW)驅(qū)動逆變器,又能保證模塊化并聯(lián)擴(kuò)展的靈活性。
換句話說,HPD 封裝不是單點(diǎn)突破,而是一種通用型電驅(qū)模塊平臺。
 圖片來源:Infineon
圖片來源:Infineon
1.2 拓?fù)湫问?/strong>
了解了結(jié)構(gòu),我們再來看HPD 模塊的拓?fù)湫问健?/strong>
HPD 模塊典型的內(nèi)部拓?fù)涫?/span>三相逆變器結(jié)構(gòu),每相包含上下橋臂器件(IGBT 或 SiC MOSFET),并集成相應(yīng)的續(xù)流二極管(SiC 模塊則為體二極管)。這種拓?fù)鋷缀跏请妱悠囼?qū)動逆變器的標(biāo)準(zhǔn)。
具體來說:
三相橋臂:共 6 個功率開關(guān)器件
直流母排:正極和負(fù)極母排通過模塊引出端口直接連接
母排設(shè)計(jì):采用疊層母排(laminated busbar),以降低寄生電感
電流路徑:短而對稱,保證電流分布均勻
傳感集成:部分 HPD 模塊內(nèi)置電流傳感或溫度監(jiān)測接口
我們可以用一個簡化示意圖來表示 HPD 內(nèi)部的拓?fù)洌?/strong>
 圖片來源:Infineon
圖片來源:Infineon
|SysPro備注,這里簡述下拓?fù)錇槭裁粗匾?/strong>
主要原因在于:拓?fù)渲苯記Q定了器件布局、電感大小、開關(guān)損耗以及系統(tǒng)效率。例如,HPD 采用疊層母排與模塊化橋臂結(jié)構(gòu),大大降低了寄生電感,使得其在高速開關(guān)的SiC MOSFET應(yīng)用中依然能夠保持低電磁干擾。因此,拓?fù)洳粌H是“內(nèi)部電路圖”,更是封裝能否支撐未來高頻、高效、緊湊逆變器的關(guān)鍵。
1.3 冷卻方式
接下來我們要講的是散熱,也就是HPD 模塊的冷卻方式。
對于功率半導(dǎo)體模塊來說,熱是壽命的最大敵人。HPD 模塊典型的冷卻方式是底板冷卻(baseplate cooling),也就是通過模塊底部與冷卻水道或冷卻板直接接觸,將熱量帶走。
它的關(guān)鍵點(diǎn)在于:
DBC 陶瓷材料選擇:常見的是 Al?O?(低成本)和 Si?N?(高導(dǎo)熱率,機(jī)械可靠性好)
焊料層優(yōu)化:通過低空洞率焊接工藝減少熱阻
銅底板厚度:典型值 2~3 mm,兼顧導(dǎo)熱與機(jī)械強(qiáng)度
冷卻水道設(shè)計(jì):通常采用微通道水冷板,水流直接帶走熱量
下表給出不同 DBC 材料的對比:
 圖片來源:SysPro
圖片來源:SysPro
這里我們需要重點(diǎn)關(guān)注的是:冷卻方式?jīng)Q定了模塊的持續(xù)工作電流能力。比如,同樣是 IGBT 模塊,如果采用 Si?N? 基板+液冷水道,其電流容量可以比 Al?O? 空冷方案提升 20%~30%。因此,HPD 模塊的散熱能力直接支撐了其在 300 kW 級電驅(qū)動中的應(yīng)用。
1.4 其他技術(shù)特點(diǎn)
除了上面講的結(jié)構(gòu)、拓?fù)浜蜕幔琀PD 模塊還有一些“隱性”的技術(shù)亮點(diǎn)。
低寄生電感設(shè)計(jì):例如,母排層疊結(jié)構(gòu)、內(nèi)部引線短而對稱、典型寄生電感低于 10 nH
先進(jìn)鍵合技術(shù):從傳統(tǒng)鋁絲鍵合轉(zhuǎn)向+ 銅絲鍵合/釬焊 sintering,提升功率循環(huán)壽命,從 10? 次提升到 10? 次級別
芯片并聯(lián)一致性:模塊內(nèi)部往往需要多顆 IGBT 或 SiC 芯片并聯(lián),HPD 封裝通過精確的電流路徑設(shè)計(jì)保證均流
可擴(kuò)展性:同一封裝外殼可以放置不同電壓等級、不同芯片材料的元件,為客戶提供設(shè)計(jì)靈活性
 圖片來源:Infineon
圖片來源:Infineon
1.5 典型案例
最后我們來看幾個典型案例,說明HPD 模塊到底用在什么地方呢?
它主要應(yīng)用于新能源汽車驅(qū)動逆變器。HPD 模塊適合功率范圍 100–300 kW,這正好覆蓋主流電驅(qū)動的需求。如下幾個典型應(yīng)用案例:
大眾 MEB 平臺:
使用 Infineon HybridPACK Drive IGBT 模塊
功率約 150–200 kW
冷卻方式為水冷板直冷
支撐了 ID.4、ID.6 等車型
現(xiàn)代 IONIQ 5:
采用 Infineon HybridPACK Drive SiC 版本
電壓 800 V,提升快充與高效率性能
在 WLTP 工況下效率提升約 3–5%
保時(shí)捷 Taycan:
雙電機(jī)四驅(qū)系統(tǒng),前后橋均采用模塊化逆變器
選用 SiC HybridPACK Drive
在高功率工況下仍能保證散熱與效率
 圖片來源:SysPro
圖片來源:SysPro
|SysPro備注,更多閱讀:
IGBT關(guān)鍵特性參數(shù)的應(yīng)用實(shí)踐指南 v3.0
電動汽車動力"心臟"IGBT全面解析:構(gòu)成本質(zhì)、工作原理與范圍、關(guān)鍵特性、應(yīng)用指南
英飛凌最新IGBT賦能奇瑞鯤鵬系列混動車型的底層技術(shù)揭秘
02
DCM封裝:DCM1000
——冷卻結(jié)構(gòu)做進(jìn)底板
在講完了 HPD 封裝之后,我們接下來看另一類代表性的模塊——DCM(Direct Cooled Module)。顧名思義,DCM 的最大特點(diǎn)就是直接冷卻,典型代表就是Danfoss的DCM1000 系列。
2.1 結(jié)構(gòu)特點(diǎn)
它的核心特點(diǎn)是去基板化+直接冷卻。
它采用了直冷baseplate(內(nèi)置流道)+熱阻鏈路縮短/換熱增強(qiáng)工藝手段:將功率芯片通過銀燒結(jié)工藝直接連接在一個一體化加工的、內(nèi)部嵌有精密微通道的銅質(zhì)冷卻底板上。芯片與冷卻液之間僅隔著一層薄薄的燒結(jié)層和銅底板壁,創(chuàng)造了最短的可能散熱路徑。|SysPro備注,Danfoss為此起了個比較牛的名字 ——ShowerPower 3D cooling。
 圖片來源:Danfoss
圖片來源:Danfoss
我們通過一張表來說明HPD和DCM結(jié)構(gòu)分層對比:
 圖片來源:SysPro
圖片來源:SysPro
這里面我們需要關(guān)注的重點(diǎn)是:少了一層銅底板,熱流路徑縮短,所以散熱效率大幅提升。此外,DCM 封裝通常體積更薄、更緊湊,能適應(yīng)空間受限的電驅(qū)動總成。
2.2 拓?fù)湫问?/strong>
DCM 平臺面向電驅(qū)逆變器應(yīng)用,是一個“可定制功率模塊平臺”的定位;其技術(shù)平臺可覆蓋不同半導(dǎo)體組合(Si、Si+SiC、全SiC等),并非只限定單一拓?fù)洹?/span>核心采用對稱半橋架構(gòu),集成高性能 SiC MOSFET 與 SiC 肖特基二極管,充分釋放寬禁帶半導(dǎo)體的技術(shù)優(yōu)勢。
 圖片來源:HITACHI
圖片來源:HITACHI
通過優(yōu)化內(nèi)部布線與封裝布局,大幅降低雜散電感,為高頻、高效開關(guān)創(chuàng)造條件。SiC 器件的共源共柵集成設(shè)計(jì),實(shí)現(xiàn)了功率回路與驅(qū)動回路的解耦,提升信號完整性。
2.3 冷卻方式
其實(shí),DCM 的名字已經(jīng)暗示了它的核心優(yōu)勢——直接冷卻,這也是DCM的名片:ShowerPower 3D cooling
傳統(tǒng)方式:功率模塊的熱量要先經(jīng)過銅底板再傳導(dǎo)到冷卻板,等效熱阻約為 0.1~0.2 K/W。
DCM 方式:芯片熱量幾乎直接傳導(dǎo)至冷卻板,等效熱阻可降低至 0.05 K/W 以下。
 圖片來源:SysPro
圖片來源:SysPro
那么,冷卻效率提升意味著什么呢?意味著在同樣的水冷條件下,DCM 模塊能承受更大的電流、更高的功率。
 圖片來源:Danfoss
圖片來源:Danfoss
2.4 其他技術(shù)特點(diǎn)
除了上面講的結(jié)構(gòu)、拓?fù)浜蜕幔珼CM 模塊還有一些其他技術(shù)亮點(diǎn):
模塊厚度薄:DCM 模塊厚度可控制在 5 mm 左右,比傳統(tǒng)模塊薄 30% 以上
寄生電感極低:封裝高度降低,電流路徑更短,典型寄生電感 < 5 nH
更適合 SiC 器件:高頻高速開關(guān)下,低電感與高散熱能力正好發(fā)揮 SiC 特性
工藝挑戰(zhàn):去掉銅底板后,機(jī)械應(yīng)力管理更困難,需要高可靠性的 DBC 基板
2.5 應(yīng)用場景與典型案例
DCM 模塊適合用于以下幾大場景:
高性能電動車驅(qū)動逆變器(800 V 平臺)
賽車與超級跑車電驅(qū)動
商用車大功率電驅(qū)動(對散熱要求極高)
 圖片來源:Danfoss
圖片來源:Danfoss
與此對應(yīng)的典型案例有:
Danfoss DCM1000:直接冷卻模塊,額定電流 1000 A,電壓 1200 V,采用 SiC MOSFET,主要用于巴士與卡車驅(qū)動逆變器。
Hitachi Automotive:為日本電動巴士項(xiàng)目開發(fā)直冷模塊,散熱能力提高約 20%。

圖片來源:HITACHI
|SysPro備注,更多閱讀:
SiC功率模塊應(yīng)用全景解讀:標(biāo)稱/極限特征參數(shù)、電氣/熱/機(jī)械特性、特性曲線與應(yīng)用函數(shù)解讀、實(shí)踐筆記
SiC功率半導(dǎo)體可靠性全面解析:失效的本質(zhì)、缺陷控制手段、失效率測試兩種方法
選擇IGBT還是SIC,牽引逆變器設(shè)計(jì)平衡之道
03
TPAK 單管模封路線:特斯拉案例
——積木化開關(guān)單元
TPAK 的底層邏輯,是把主驅(qū)逆變器的功率開關(guān)從"一個大模塊"拆成"很多個強(qiáng)一致的小開關(guān)積木",用數(shù)量換布局自由度,用結(jié)構(gòu)扁平化換低寄生與可制造。
其實(shí)TPAK 并不是傳統(tǒng)意義上由國際大廠標(biāo)準(zhǔn)化定義的量產(chǎn)型封裝,而是特斯拉在電動車逆變器和驅(qū)動模塊中獨(dú)立推進(jìn)的功率半導(dǎo)體模塊封裝方案,這也是我們大多數(shù)人了解Tpak的初始。它的最大特點(diǎn)就是:高度集成化、扁平化、針對車規(guī)應(yīng)用場景的定制優(yōu)化。

圖片來源:TESLA
3.1 結(jié)構(gòu)特點(diǎn)
下面我們先聊聊結(jié)構(gòu)。
TPAK 這條路線的典型結(jié)構(gòu)關(guān)鍵詞就三個:模封 + 銅引線框架 + 絕緣基板(DBC)。你可以把它理解成:...(知識星球發(fā)布)
這個是什么意思呢?它其實(shí)是為了解決兩個非常現(xiàn)實(shí)的問題:...(知識星球發(fā)布)
同時(shí),這條路線還會把芯片連接做成更"抗循環(huán)"的形式:比如用銀基連接把芯片固定在基板上,目的是在熱循環(huán)與功率循環(huán)里保持界面更穩(wěn)定。|SysPro備注,相關(guān)文章:電動汽車驅(qū)動系統(tǒng)IGBT可靠性與壽命估算指南
3.2 拓?fù)湫问?/strong>
|SysPro備注:這里先說明個基本概念,在功率模塊里,拓?fù)洳皇请娐穲D,拓?fù)涫?幾何結(jié)構(gòu)"——你怎么擺、怎么走線、怎么出端子,會直接決定你能把寄生壓到什么程度。
TPAK封裝模塊通常為單開關(guān)或半橋(2-in-1)拓?fù)洌鳛橐粋€獨(dú)立的、高性能的開關(guān)單元使用:
單個模塊承擔(dān)一個開關(guān)單元(你可以理解為"單管積木"或"半橋積木"中的一半)
逆變器的一個"開關(guān)位置",往往是多個模塊并聯(lián)去承載電流
最終用很多個積木(六個半橋)拼成完整的三相逆變器
 圖片來源:網(wǎng)絡(luò)
圖片來源:網(wǎng)絡(luò)
這個拼裝思路的意義在于:...(知識星球發(fā)布)
3.3 冷卻方式(知識星球發(fā)布)…
3.4 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
3.5 應(yīng)用場景與典型案例(知識星球發(fā)布)...
|SysPro備注,更多閱讀:
第一性原理在Tesla逆變器中是如何應(yīng)用的?20年路、4代產(chǎn)品、2種封裝、1種方案
 圖片來源:SystemPlus
圖片來源:SystemPlus
04
ZPAK 半橋平臺化封裝:致瞻科技案例
——半橋積木+磚級集成
(知識星球發(fā)布)
ZPAK 是近年來由國內(nèi)功率模塊廠商和主機(jī)廠共同探索的一種新型封裝,之前我們再在致瞻科技的案例解讀中提到過:|SysPro備注,更多閱讀:大道至簡、回歸本源,如何以第一性原理洞見電驅(qū)功率模塊的未來?| ZPAK背后的底層思考
其實(shí),其底層邏輯也很簡單,可以簡單理解成再TPAK上的衍生:
保留積木化擴(kuò)展性,但把積木從單管升級成半橋,并把系統(tǒng)級集成(母線電容、冷卻、驅(qū)動、傳感)一起納入封裝邊界,從而把體積和裝配復(fù)雜度一起壓下去。

圖片來源:致瞻科技
4.1 結(jié)構(gòu)特點(diǎn)(知識星球發(fā)布)...
4.2 拓?fù)湫问?/strong>(知識星球發(fā)布)...

圖片來源:致瞻科技
4.3 冷卻方式(知識星球發(fā)布)...
4.4 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
4.5 應(yīng)用場景(知識星球發(fā)布)...

圖片來源:致瞻科技
下篇
05
05 eMPack 三維重疊平臺:賽米控丹佛斯路線
——疊層端子+低高度連接
(知識星球發(fā)布)
開始前,我們先聊聊eMPack 的底層邏輯。
Danfoss做這款模塊的初衷:把電流去程與回程盡可能重疊,把磁場抵消效果拉滿;再把模塊到母線電容的連接從"螺絲"改成"焊接",把雜散電感、接觸電阻、裝配高度一起壓下去,服務(wù) 800V 主驅(qū)里高速開關(guān) + 大電流 + 高可靠 + 易裝配的組合目標(biāo)。
5.1 結(jié)構(gòu)特點(diǎn)(知識星球發(fā)布)...

圖片來源:Semikron Danfoss
5.2 拓?fù)湫问?/strong>(知識星球發(fā)布)...
|SysPro備注,關(guān)于eMPack三電平應(yīng)用,這點(diǎn)我們再之前的文章中有系統(tǒng)性做過解讀,詳細(xì)的關(guān)于EMPACK的內(nèi)部結(jié)構(gòu)的映射關(guān)系會在專題中說明,這里不再展開,關(guān)于多電平方案大家可以看這個解讀:
多電平逆變器的全景解析:2L/3L概念與原理、硬件架構(gòu)、控制算法、電容設(shè)計(jì)、系統(tǒng)應(yīng)用與價(jià)值

圖片來源:Dana
5.3 冷卻方式(知識星球發(fā)布)...
5.4 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
5.5 應(yīng)用場景與典型案例(知識星球發(fā)布)...

圖片來源:Semikron Danfoss
|SysPro備注,這里我們先做簡述,后續(xù)會做個專題展開講講里面的細(xì)節(jié)
06
PM6平臺化封裝:博世案例
——對稱低寄生+可拓展化平臺
(知識星球發(fā)布)
博世的PM6功率模塊,堪稱業(yè)內(nèi)經(jīng)典,也是諸多新型半導(dǎo)體廠商研發(fā)時(shí)的核心對標(biāo)產(chǎn)品。例如25年底,富士電機(jī)與博世也達(dá)成合作,聯(lián)合開發(fā)具備封裝兼容性的SiC功率半導(dǎo)體模塊。我們曾系統(tǒng)化的解構(gòu)過PM6的設(shè)計(jì)與思路,這里再做個簡要概述:博世PM6功率模塊平臺化方案全景解析:拓?fù)浣Y(jié)構(gòu)、三維布局、燒結(jié)/互聯(lián)、AMB+DBC,這里再做個簡要概述。
6.1 結(jié)構(gòu)特點(diǎn)(知識星球發(fā)布)...
6.2 拓?fù)湫问?/strong>(知識星球發(fā)布)...

6.3 冷卻方式(知識星球發(fā)布)...
6.4 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
6.5 應(yīng)用場景(知識星球發(fā)布)...
 圖片來源:SysPro上海車展拍攝
圖片來源:SysPro上海車展拍攝
|SysPro備注,關(guān)于類似PM6封裝結(jié)構(gòu)的還有理想汽車自研的功率模塊,我們從其結(jié)構(gòu)、拓?fù)洹⒗鋮s、技術(shù)特點(diǎn)、應(yīng)用場景到典型案例進(jìn)行深入解讀,感興趣的朋友可以先行查閱星球中相關(guān)技術(shù)資料,獲取(關(guān)鍵字:理想自研):理想汽車LPM高壓SiC功率模塊技術(shù)深度解析
 圖片來源:理想汽車
圖片來源:理想汽車 圖片來源:理想汽車
圖片來源:理想汽車
07
芯片內(nèi)嵌PCB封裝:舍弗勒、采埃孚、麥格納、保時(shí)捷
——功率芯片做到板中的低電感、高集成
(知識星球發(fā)布)
關(guān)于芯片內(nèi)嵌PCB封裝技術(shù)與方案,我在知識星球中也系統(tǒng)性的解析過這一技術(shù)方案,也構(gòu)建了詳細(xì)的專欄內(nèi)容。顧名思義,通過把功率芯片埋進(jìn)板里、走面板級工藝,縮短電流環(huán)路、打通熱路徑、降低寄生與熱阻,服務(wù)xEV 牽引逆變器、AI / 高功率密度電源、機(jī)器人伺服等場景:面向xEV驅(qū)動+AI數(shù)據(jù)中心的功率封裝前瞻:芯片嵌入封裝與互聯(lián)技術(shù)的全景解析
7.1 拓?fù)湫问?/strong>(知識星球發(fā)布)...
7.2 冷卻方式(知識星球發(fā)布)...
 圖片來源:Schaeffler
圖片來源:Schaeffler
7.3 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
7.4 應(yīng)用場景(知識星球發(fā)布)...
 圖片來源:SysPro 2025上海車展拍攝
圖片來源:SysPro 2025上海車展拍攝
|SysPro備注,更多閱讀:
面向xEV驅(qū)動+AI數(shù)據(jù)中心的功率封裝前瞻:芯片嵌入封裝與互聯(lián)技術(shù)的全景解析
芯片內(nèi)嵌PCB封裝 · 電-熱-可靠性三維協(xié)同優(yōu)化指南
功率芯片PCB嵌入式封裝技術(shù) · 從晶圓到系統(tǒng)級應(yīng)用的全路徑解析
PCIM Asia 2025觀察:那些關(guān)于芯片內(nèi)嵌PCB封裝技術(shù)的前瞻故事
功率芯片PCB內(nèi)埋式封裝技術(shù) · 從概念到量產(chǎn)的全鏈路解析"三部曲"(匯總篇)
功率GaN芯片PCB嵌埋封裝技術(shù)全維解析的"三部曲"
英飛凌1200V芯片嵌入PCB解決方案 + Schweizer的技術(shù)核心(附報(bào)告)
08
SiC+Si混碳融合封裝:英飛凌、匯川、小鵬、舍弗勒
——成本與效率的折中策略
(知識星球發(fā)布)
混合芯片封裝,顧名思義,就是把不同材料、不同類型的芯片(Si、SiC、GaN等)集成在同一個封裝中。混合芯片封裝的結(jié)構(gòu)設(shè)計(jì)圍繞"電氣性能匹配、熱應(yīng)力均衡、集成度提升"三大目標(biāo)展開,典型結(jié)構(gòu)由基板、芯片陣列、互連系統(tǒng)、封裝外殼四部分組成:...

圖片來源:YOLE
8.1 設(shè)計(jì)理念(知識星球發(fā)布)...
8.2 拓?fù)浣Y(jié)構(gòu)(知識星球發(fā)布)...
|SysPro備注,更多閱讀:
SiC+Si混碳融合逆變器 · 從概念到系統(tǒng)方案落地的全景解析

圖片來源:Inovance
8.3 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
|SysPro備注,知識星球更多閱讀:
SiC+Si,全球8大混碳技術(shù)方案揭秘
Si/SiC功率半導(dǎo)體選型與應(yīng)用指南:兩類器件特性、4種控制策略與拓?fù)洹⒍喾N動力構(gòu)型/駕駛循環(huán)/性能需求
 圖片來源:SysPro拍攝,2025上海車展,舍弗勒混碳
圖片來源:SysPro拍攝,2025上海車展,舍弗勒混碳
8.4 應(yīng)用場景與典型哪里(知識星球發(fā)布)...
|SysPro備注,更多閱讀:
SiC+Si,全球8大混碳技術(shù)方案揭秘
SiC+Si混碳融合逆變器 · 從概念到系統(tǒng)方案落地的全景解析
SiC+Si混合 , 如何用單顆主控芯片實(shí)現(xiàn)雙通道控制? | 意法半導(dǎo)體 · 柵極驅(qū)動方案解析
09
分立器件封裝:TO-247系列
——標(biāo)準(zhǔn)件+系統(tǒng)能力換性能
(知識星球發(fā)布)
我們首先來看分立器件封裝。分立器件是最經(jīng)典、最成熟的封裝形式,如TO-247、TO-247-4L(帶開爾文發(fā)射極引腳)、TOLL、D2PAK等。芯片被封裝在一個獨(dú)立的塑料體中,引腳伸出,結(jié)構(gòu)非常簡單,久經(jīng)市場考驗(yàn)。那么,這類封裝到底長什么樣子?它為什么能長期存在并且不斷迭代呢?
9.1 結(jié)構(gòu)特點(diǎn)(知識星球發(fā)布)...
9.2 拓?fù)湫问?/strong>(知識星球發(fā)布)...
 圖片來源:SysPro
圖片來源:SysPro
9.3 其他技術(shù)特點(diǎn)(知識星球發(fā)布)...
9.4 應(yīng)用場景(知識星球發(fā)布)...
 圖片來源:SysPro
圖片來源:SysPro
10 總結(jié)
——車規(guī)功率封裝的"熱—電—可靠—平臺化"演進(jìn)規(guī)律
(知識星球發(fā)布)
以上是關(guān)于車規(guī)級功率半導(dǎo)體十大模塊封裝技術(shù)方案的深度解析,我們簡單總結(jié)下...

圖片來源:SysPro
上面集中封裝,我們可以看到幾條非常清晰的分化邏輯:
HPD...
DCM...
TPAK → ZPAK → eMPack...
PM6...
芯片內(nèi)嵌 PCB...
混碳融合...
TO-247 分立器件...

圖片來源:SysPro(非絕對,僅供參考)
...
這篇文章在1.0的基礎(chǔ)上做了糾錯、補(bǔ)充和結(jié)構(gòu)優(yōu)化。
感謝你的閱讀,希望有所幫助!
注:以上節(jié)選,完整版「SysPro電力電子技術(shù)」知識星球發(fā)布
以上是關(guān)于全球十大 · 車規(guī)級功率模塊封裝 · 全景解析 V2.0的節(jié)選(原文19300字)。10大封裝技術(shù)的完整版內(nèi)容、相關(guān)產(chǎn)品技術(shù)方案資料、技術(shù)報(bào)告、深度解讀會在知識星球中發(fā)布,歡迎進(jìn)一步查閱、學(xué)習(xí),希望有所幫助!
-
DCM
+關(guān)注
關(guān)注
0文章
172瀏覽量
28205 -
功率半導(dǎo)體
+關(guān)注
關(guān)注
23文章
1475瀏覽量
45218 -
大功率封裝
+關(guān)注
關(guān)注
0文章
5瀏覽量
5698
發(fā)布評論請先 登錄
車規(guī)二級管
2018全球十大突破性技術(shù)發(fā)布
新能源汽車市場熱度不斷高漲,十家車規(guī)級芯片上市公司一覽
埋嵌元件PCB的元件互聯(lián)技術(shù)和評價(jià)解析

淺談車規(guī)級功率模塊測試

車規(guī)級功率模塊封裝的現(xiàn)狀,SiC MOSFET對器件封裝的技術(shù)需求
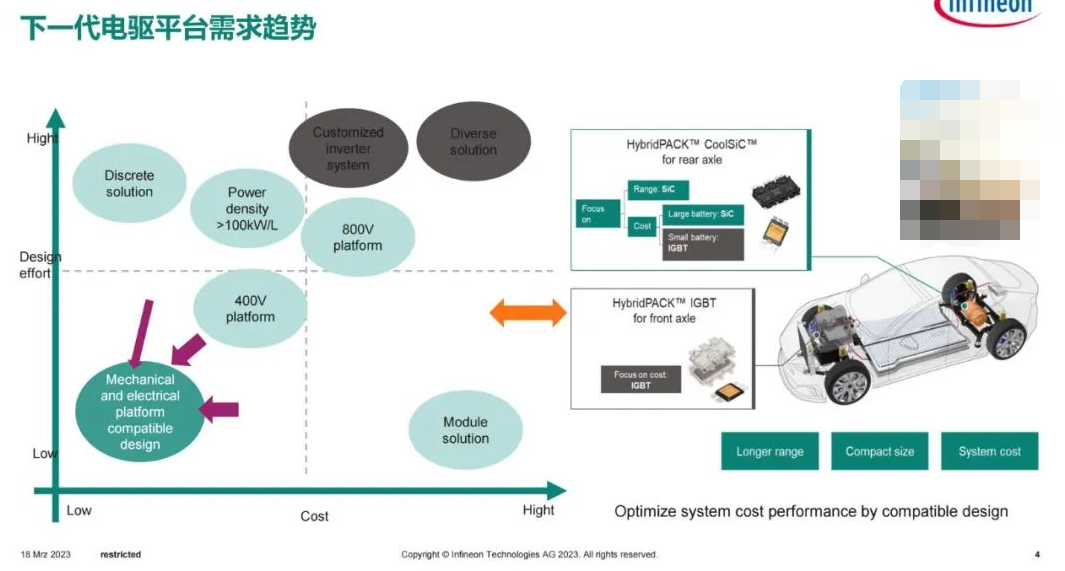
博世自研PM6 SiC功率模塊產(chǎn)品介紹
賽米控丹佛斯eMPack系列車規(guī)級功率模塊的亮點(diǎn)
Si、SiC與GaN,誰更適合上場?| GaN芯片PCB嵌埋封裝技術(shù)解析

BOSCH PM6功率模塊平臺化方案深度解析

博世PM6功率模塊平臺化方案全景解析:拓?fù)浣Y(jié)構(gòu)、三維布局、燒結(jié)/互聯(lián)、AMB+DBC

基本半導(dǎo)體汽車級Pcore6 HPD Mini封裝碳化硅MOSFE模塊介紹

博世PM6功率模塊方案深度解析:拓?fù)浣Y(jié)構(gòu)、三維布局、互連方式、高熱導(dǎo)與可靠性設(shè)計(jì)




 全球十大主流車規(guī)級功率封裝全景解析:HPD, DCM, TPAK, ZPAK, eMPack, PM6, 埋嵌, 混碳, 分立
全球十大主流車規(guī)級功率封裝全景解析:HPD, DCM, TPAK, ZPAK, eMPack, PM6, 埋嵌, 混碳, 分立




評論