文章來源:學習那些事
原文作者:小陳婆婆
本文系統梳理了刻蝕技術從濕法到等離子體干法的發展脈絡,解析了物理、化學及協同刻蝕機制差異,闡明設備與工藝演進對先進制程的支撐作用,并概述國內外產業格局,體現刻蝕在高端芯片制造中的核心地位與技術挑戰。
刻蝕工藝概述
集成電路制造工藝中的刻蝕技術作為關鍵工藝環節,其演進路徑深刻反映了半導體技術發展的內在邏輯。早期濕法刻蝕雖憑借工藝成熟、成本較低的優勢占據主導地位,但隨著特征尺寸向3μm以下推進,其線寬控制精度不足、刻蝕方向性差等固有缺陷逐漸凸顯,促使行業向干法刻蝕體系轉型。干法刻蝕的核心在于利用氣態化學刻蝕劑與晶圓表面材料發生反應,生成揮發性產物后通過真空系統抽離,這一過程依賴刻蝕氣體等離子體的產生——等離子體在射頻電磁場驅動下形成弱電離態氣體,包含電子、離子及中性活性粒子,構成復雜的物理-化學協同作用環境。
從作用機制分析,純化學刻蝕依賴活性粒子與被刻蝕材料的直接反應,但僅適用于少數材料且缺乏方向性;純物理濺射雖可通過高能離子轟擊實現刻蝕,卻存在刻蝕速率低、選擇性差的問題。實際工業應用中,絕大多數等離子體刻蝕采用活性粒子與離子協同模式:離子轟擊一方面破壞材料表面原子鍵,提升中性粒子反應速率;另一方面清除反應界面生成物,保障刻蝕劑與材料持續接觸,而側壁沉積物因方向性離子轟擊難以有效去除,最終形成各向異性刻蝕特征。這種機制特性決定了等離子體刻蝕在精度控制、方向性及材料選擇性上的顯著優勢,成為先進制程的必然選擇。
設備發展層面,早期多晶圓片系統如圓筒形、六角形及部分平板設備曾占據主流,但隨著晶圓直徑增大至200mm以上,單片式系統逐步取代多片系統成為行業標配。單片系統需在低氣壓環境下實現高密度等離子體穩定產生,這對設備真空系統、等離子體源及過程控制軟件提出了極高要求。值得關注的是,高密度等離子體并非等同于高刻蝕率,過度追求密度可能導致器件損傷、選擇比下降等問題,因此現代設備更注重等離子體穩定性、能量分布控制及多參數協同優化。近年來,三維器件結構如FinFET、立體閃存等的普及,進一步推動刻蝕工藝向多樣化、特殊化發展,要求設備在均勻性、垂直度控制、深孔/溝槽刻蝕能力等方面實現突破。
當前,全球刻蝕設備市場呈現高度集中態勢,美國與日本廠商憑借技術積累占據領先地位,其中Lam Research、Applied Materials、東京電子及日立等企業通過持續創新保持競爭力。中國半導體設備產業在政策支持與市場需求雙重驅動下實現跨越式發展,中微半導體介質刻蝕設備已進入國內外先進生產線量產,其硅通孔刻蝕設備在封裝領域實現規模化應用;北方華創硅刻蝕機則在中芯國際等產線完成先進工藝驗證,標志著國產設備在關鍵工藝環節的突破。
刻蝕技術分類
濕法刻蝕作為集成電路制造工藝的基石技術之一,雖受限于各向同性刻蝕特性在亞微米以下制程中逐漸被干法刻蝕替代,但在大尺寸非關鍵層清洗、氧化物殘留去除及表皮剝離等場景中仍占據不可替代的地位。其核心優勢體現在對氧化硅、氮化硅、單晶硅及多晶硅等材料的針對性處理上——氧化硅刻蝕以氫氟酸(HF)為基礎,通過氟化銨緩沖液提升選擇性,并輔以少量強酸穩定pH值,確保刻蝕均勻性;摻雜氧化硅因晶格缺陷導致的化學活性增強,更易被腐蝕,這一特性在特定工藝中可被有效利用。在化學剝離環節,熱磷酸(H?PO?)作為氮化硅去除的主力試劑,對氧化硅展現出優異選擇比,但需預先采用氫氟酸預處理表面氧化硅,以避免局部過度刻蝕,保障氮化硅均勻清除。濕法清洗則通過硫酸、鹽酸、氫氟酸、磷酸、過氧化氫、氫氧化銨及氟化銨等化學品的復配(如SC1堿性溶液去除顆粒與有機物、SC2酸性溶液去除金屬污染物),形成標準化清洗液體系,在氧化膜沉積前的硅片表面清潔中發揮關鍵作用,確保氧化層生長的純凈基底。經典RCA清洗法由W.Kern與D.Puotinen于1970年提出,其雙溶液體系歷經半個世紀仍被優化應用,近年來結合霧化蒸汽清洗、超聲波輔助等物理增強技術,在高端芯片制造中實現了污染物去除效率與表面損傷控制的雙重提升。
干法刻蝕以等離子體刻蝕為核心,依托低溫非平衡態等離子體的物理-化學協同效應實現高精度刻蝕。電容耦合放電模式通過平行板電極間的射頻電源激發等離子體,氣壓控制在數毫托至數十毫托,電離率低于10??,適用于大面積均勻刻蝕;電感耦合放電則在更低氣壓(數十毫托)下通過電感線圈輸入能量,電離率超10??,形成高密度等離子體,結合射頻/微波電源與基片偏壓,可獨立調控離子流量與轟擊能量,優化刻蝕速率、選擇比及側壁形貌。其工藝流程涵蓋氣體注入、壓力穩定、等離子體產生、自由基分解擴散、表面吸附反應及氣態副產物排出等步驟,具體可分為四類:物理濺射刻蝕以離子轟擊為主,呈現各向異性但選擇性有限;化學刻蝕通過氣相原子/分子與表面反應生成揮發性產物(如Si + 4F → SiF?),各向同性且選擇性優異;離子能量驅動刻蝕結合物理轟擊與化學活性,效率提升一個量級以上;離子-阻擋層復合刻蝕則通過聚合物保護層(如Cl/Cl?刻蝕中添加碳形成氯碳化合物)抑制側壁刻蝕,實現高深寬比結構加工。干法清洗作為等離子體清洗的延伸,利用離子轟擊與激活粒子去除光刻膠及殘留物,參數設計側重化學自由基反應而非方向選擇性,常采用氟基氣體(如NF?)、氧/氫及氬增強轟擊效果。遠程等離子體技術通過腔體外微波源生成高密度等離子體,減少離子轟擊損傷,提升自由基反應效率,氟基氣體在微波場中分解率超99%,有效保護硅片并延長腔體壽命,已成為先進制程中的主流方案。

在最新發展方面,濕法清洗領域正探索納米氣泡輔助清洗、電化學清洗等新技術,通過增強傳質效率與反應活性,提升污染物去除效率并降低化學試劑用量;干法刻蝕則向原子層刻蝕(ALE)方向發展,通過自限制反應實現亞納米級精度控制,滿足3D NAND閃存、先進封裝等三維結構加工需求;干法清洗方面,低溫等離子體與臭氧協同清洗、等離子體-化學復合清洗等方案正逐步應用于5nm及以下制程,在平衡清洗效率與表面損傷控制的同時,為高k介質、金屬柵等新型材料體系的引入提供工藝保障。這些技術演進不僅推動了集成電路制造工藝的升級,也為三維集成、先進封裝等新興領域的發展奠定了堅實基礎。
-
集成電路
+關注
關注
5459文章
12621瀏覽量
375241 -
制造工藝
+關注
關注
2文章
214瀏覽量
21306 -
刻蝕
+關注
關注
2文章
222瀏覽量
13807
原文標題:刻蝕技術概述及其分類
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
最全最詳盡的半導體制造技術資料,涵蓋晶圓工藝到后端封測



集成電路芯片類型和技術介紹
半導體制造中刻蝕工藝技術介紹
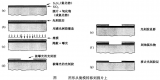



 集成電路制造工藝中的刻蝕技術介紹
集成電路制造工藝中的刻蝕技術介紹



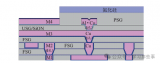





評論