一、 如前所述:行業(yè)背景與工藝挑戰(zhàn)
在半導(dǎo)體后道封裝工藝中,晶圓劃片/鋸切(Water Dicing)是將完成前道工藝的整片晶圓通過(guò)機(jī)械刀片或激光切割分離成獨(dú)立芯片(Die)的關(guān)鍵步驟。隨著制程工藝向更微小化發(fā)展,芯片間的切割道(Street/Scribe Line)寬度不斷壓縮,同時(shí)為了保證封裝可靠性,對(duì)切割質(zhì)量的管控要求達(dá)到了亞微米級(jí)。
本工藝環(huán)節(jié)主要面臨的三大檢測(cè)痛點(diǎn)如下:
切割槽寬度(Kerf Width)一致性: 刀片的磨損、主軸的一致性誤差或激光能量波動(dòng)都會(huì)導(dǎo)致槽寬變化。過(guò)寬會(huì)損傷芯片電路區(qū)(Active Area),過(guò)窄可能導(dǎo)致分片失敗或應(yīng)力釋放不足。檢測(cè)精度需達(dá)到微米級(jí)甚至更高。
槽深(Cut Depth)檢測(cè)難度: 對(duì)于半切(Half-cut)或隱形切割工藝,必須精確控制深度及剩余厚度。特別是傳統(tǒng)測(cè)量手段中,由于槽寬極窄(通常在20μm-100μm之間),傳統(tǒng)三角法激光傳感器因“陰影效應(yīng)”無(wú)法探測(cè)到底部數(shù)據(jù)。
崩邊(Chipping)量化: 切割邊緣不可避免會(huì)產(chǎn)生微小裂紋與碎屑。正面崩邊(Front Chipping相和背面崩邊(Backside Chipping)如果超過(guò)安全閾值,會(huì)誘發(fā)芯片隱裂失效。這種形貌主要由不規(guī)則的微觀粗糙表面構(gòu)成,這對(duì)反光不均或鏡面反射率劇烈變化的檢測(cè)提出了挑戰(zhàn)。
結(jié)合所應(yīng)用場(chǎng)景“高精度、高深寬比、材質(zhì)反光特性復(fù)雜”的特點(diǎn),本項(xiàng)目推薦采用光譜共焦技術(shù)(Chromatic Confocal Technology) 作為核心檢測(cè)手段,并選用文檔中提供的HC(泓川科技)LTC系列傳感器進(jìn)行方案設(shè)計(jì)。
二、 核心技術(shù)原理與優(yōu)勢(shì)分析
本方案采用的光譜共焦傳感器系統(tǒng)主要包括控制器、光纖線(xiàn)和共焦探測(cè)頭。不同于傳統(tǒng)的激光三角測(cè)距成像,光譜共焦基于“色散編碼”原理,完美契合晶圓微槽的測(cè)量。
1. 軸向色散共焦原理(Axial Chromatic Aberration)
根據(jù)資料《光譜共焦傳感器LTC系列 HC.pdf》,系統(tǒng)采用白光光源。白光通過(guò)特制的色散透鏡組后,由于不同波長(zhǎng)的光折射率不同,不同頻段的光譜會(huì)在光軸上產(chǎn)生不同的聚焦點(diǎn)。
λ1λ1?(紅光)聚焦因折射率小聚焦較遠(yuǎn);
λ2λ2?(籃/紫光)聚焦因折射率大聚焦較近。
當(dāng)探測(cè)物體表面處于特定位置時(shí),只有對(duì)應(yīng)波長(zhǎng)的光能精確聚焦在物體表面,并以此位置作為反射點(diǎn),反射光沿原光路返回,通過(guò)特有針孔(Pinhole)濾光結(jié)構(gòu)進(jìn)入光譜分析儀。系統(tǒng)通過(guò)光譜儀解析光強(qiáng)最強(qiáng)的波長(zhǎng)λpeakλpeak?,即可映射出精確的距離DD。
2. 針對(duì)晶圓切割場(chǎng)景的技術(shù)優(yōu)勢(shì)
基于上傳資料中的系統(tǒng)基本原理部分,我們提煉其對(duì)本應(yīng)用的核心價(jià)值:
無(wú)測(cè)量死角、能夠測(cè)量深槽: 文檔明確指出“對(duì)凹坑、段差實(shí)現(xiàn)無(wú)死角測(cè)量”。由于入射與反射采用同光軸設(shè)計(jì),不存在三角法固有的發(fā)射光與接收光在深窄槽內(nèi)的遮擋陰影問(wèn)題,非常適合檢測(cè)幾十微米寬的Dicing Street底部深度。
適應(yīng)各種表面材質(zhì)(Si/Tape): 晶圓表面通常為鏡面,切割崩邊處為粗糙散射面,而底部的切割膜(Dicing Tape)可能是透明或半透明材料。光譜共焦技術(shù)“只要能接收部分反射光,就可以進(jìn)行測(cè)量”,且針對(duì)高反光和透明材質(zhì)均不需要重置探頭,對(duì)多層透明測(cè)厚更是其標(biāo)準(zhǔn)功能。
亞微米級(jí)精度: 文檔顯示系列產(chǎn)品重復(fù)精度低至3nm,線(xiàn)性誤差低至0.03μm,完全涵蓋并高于劃片工藝對(duì)于 1-3μm檢測(cè)限的要求。
三、 硬件選型與系統(tǒng)集成設(shè)計(jì)
為了覆蓋絕大多數(shù)Dicing檢測(cè)需求,我們需要兼顧光斑尺寸(需小于崩邊細(xì)節(jié))、測(cè)量范圍(覆蓋0-300μm甚至更深的切割槽)以及光路的可進(jìn)入角。基于《光譜共焦傳感器LTC系列 HC.pdf》中的參數(shù)表,本次方案選型如下:
選型推薦模型:LTC400 高精度型傳感器
經(jīng)過(guò)對(duì)比LTC100B至LTC50000等多款型號(hào),我們選定LTC400作為12寸晶圓劃片檢測(cè)的最佳平衡選擇。以下是其具體參數(shù)及選型依據(jù)(參考資料P8參數(shù)表):
測(cè)量范圍(Range):
參數(shù): ±0.2mm±0.2mm(總計(jì) 400μmμm 全量程)。
選型理由: 一般晶圓由于背面研磨,厚度通常在50μm-350μm之間,而劃片刀造成的深度通常在幾十微米之半切或全切。400μm的量程剛好完整覆蓋切割槽從頂端到底部的由于Z軸波動(dòng)。相較于LTC100B(100μm量程可能不足)和LTC1200(1200μm量程雖然大但犧牲了分辨率),LTC400實(shí)現(xiàn)了黃金平衡。
測(cè)量角度(Angle Reliability):
參數(shù): ±??43°??±??43°??(接受角)。
選型理由: 這是檢測(cè)崩邊(Chipping) 的關(guān)鍵能力。崩邊通常是不規(guī)則的斜面,如果傳感器無(wú)法接收大角度反射光,崩邊區(qū)域?qū)⒊霈F(xiàn)數(shù)據(jù)丟失。LTC400提供了極大的角度耐性,能確保在復(fù)雜破碎邊緣仍有數(shù)據(jù)反饋。
光斑直徑(Signal Precision):
參數(shù): Φ7μmΦ7μm / Φ14μmΦ14μm (取決于模式)。
選型理由: 切割槽(Kerf)往往在30-50μm寬。7μm的小光斑能輕松進(jìn)入槽內(nèi),并以此光斑沿橫切方向掃描,能對(duì)槽及崩邊進(jìn)行細(xì)膩的采樣,橫向分辨率極高。
絕對(duì)精度與線(xiàn)性度(Accuracy):
參數(shù): 線(xiàn)性誤差 <±0.12μm<±0.12μm ;重復(fù)精度 12nm12nm 。
選型理由: 即使加上運(yùn)動(dòng)平臺(tái)的振動(dòng),這套精度系統(tǒng)也完全可以分辨出0.5μm以?xún)?nèi)的崩邊偏差或深度起伏。
配套控制器:LT-CCS 或 LT-CPD
根據(jù)采樣率需求建議選擇LT-CC系列(高速控制) 。掃描模式下需要高頻率采樣以構(gòu)建截面與形貌。
參數(shù)支撐: 支持 10kHz(單通道)采樣頻率(參考資料描述控制器部分),即每秒生成10,000個(gè)高度數(shù)據(jù)點(diǎn)。配合以太網(wǎng)或RS-485輸出,可以滿(mǎn)足Inline高速在線(xiàn)檢測(cè)。
系統(tǒng)架構(gòu)說(shuō)明:
Z軸/H軸:安裝LTC400探頭。
XY運(yùn)動(dòng)平臺(tái):承載晶圓片,按照切割路徑(Scribe Lane)做垂直截性?huà)呙杌蚋S龍門(mén)架掃描。
四、 具體實(shí)施檢測(cè)方案與步驟
檢測(cè)不僅僅依靠單一的點(diǎn),而是依靠**“Profile Scan(輪廓掃描)”** 。以下是針對(duì)本次需求的三維檢測(cè)實(shí)施流程:
1?. 掃描軌跡規(guī)劃(掃描機(jī)制)
LTC400傳感器在Z軸對(duì)焦晶圓表面參考點(diǎn)設(shè)定為"0"位。
執(zhí)行跨槽掃描(Line Profiling) :運(yùn)動(dòng)機(jī)構(gòu)帶動(dòng)傳感器,以垂直于切割道方向橫越切割槽進(jìn)行掃描。根據(jù)LTC400 7μm的光斑,如果跨域一個(gè)100μm寬度的測(cè)試區(qū),在10kHz采樣下,即便以10mm/s的速度快速位移,也能每1μm獲得一個(gè)數(shù)據(jù)點(diǎn),獲得一個(gè)極度密集的凹字形輪廓數(shù)據(jù)。
2?. 數(shù)據(jù)與三個(gè)核心參數(shù)解析(算法轉(zhuǎn)換)
從控制器獲取到的原始數(shù)據(jù)是 [Position_X, Height_Z] 的陣列,形成的波形呈現(xiàn)倒“Π”狀或“U”狀。
A. 切割槽深度檢測(cè)(Depth Measurement)
利用共焦無(wú)盲區(qū)特性,我們分別提取:
基準(zhǔn)面高度區(qū)段(Wafer Surface):取兩側(cè)平整區(qū)的 ZZ 值均值 HMsHMs?。
槽底高度區(qū)段(Groove bottom):截面中間段的底部平整區(qū)數(shù)據(jù)取均值 HMbHMb?。
Depth=HMs?HMbDepth=HMs??HMb?
數(shù)據(jù)支撐: 結(jié)合LTC400量程數(shù)據(jù),線(xiàn)性精度<±0.12μm<±0.12μm,即使考慮底部膠膜反光變化,也能精確判斷是否切穿Si進(jìn)入Tape層。針對(duì)透明膠膜,共焦的多峰值檢測(cè)還可同時(shí)測(cè)量膜厚,監(jiān)控是否切向Deep Cut過(guò)載。
B. 切割槽道寬(Kerf Width)量化
根據(jù)掃描生成的輪廓,通過(guò)算法尋找高度劇烈突變點(diǎn)(Edges):
對(duì)輪廓求導(dǎo) dZdXdXdZ?。當(dāng)導(dǎo)數(shù)出現(xiàn)正負(fù)極大值的一對(duì)坐標(biāo)及定義為切割槽的左右邊界點(diǎn) (XL,XRXL?,XR?)。
寬度 Width=∣XR?XL∣Width=∣XR??XL?∣。
校準(zhǔn): 7μm光斑大小需要通過(guò)卷積算法做邊緣補(bǔ)償,得到實(shí)際真實(shí)的開(kāi)口寬度。
C. 崩邊(Chipping)識(shí)別
崩邊體現(xiàn)為邊緣處不在一個(gè)鋒利的垂直線(xiàn)上,而是在其邊緣的 Z軸高度上存在異常抖動(dòng)或與基準(zhǔn)平面的塌陷區(qū)域。
針對(duì) WidthWidth 邊界定義點(diǎn)向外延伸特定距離(Process Margin,例如10μm范圍內(nèi)):
Chippingmax=max?∣Zmeasured?ZIdealSurf∣Chippingmax?=max∣Zmeasured??ZIdealSurf?∣
也可定義橫向?qū)挾缺肋吜浚◤睦硐肭锌诰€(xiàn)算起的水平距離)。
由于LTC400具有±43°±43°的極大接收角,崩邊斷裂面的散射光能被有效回收,生成可視化的微觀“毛刺圖”。如果監(jiān)測(cè)數(shù)值 > 設(shè)定的工藝SPEC(如5μm),系統(tǒng)自動(dòng)觸發(fā)Bad Flag報(bào)警。
五、 工藝優(yōu)勢(shì)系統(tǒng)性評(píng)估 (為什么選擇此方案)
此章節(jié)為技術(shù)評(píng)審或客戶(hù)方案書(shū)的重要依據(jù),對(duì)比傳統(tǒng)方案:
1. 對(duì)比“顯微視覺(jué)檢測(cè) (AOI)”
AOI方案劣勢(shì): 目前多數(shù)劃片機(jī)使用AOI CCD主要基于灰度變化來(lái)判定崩邊面積。痛點(diǎn)及其嚴(yán)重的是:2D圖像無(wú)法通過(guò)灰度精確換算成崩邊深度。有色污漬可能誤判為嚴(yán)重崩邊,而淺層但大面積的剝離可能被忽略。
本方案優(yōu)勢(shì): LTC400 提供的是真實(shí)高度數(shù)據(jù)。通過(guò)3D數(shù)據(jù)的算法濾波,可以輕易刨除僅是表面變色但無(wú)形變的“偽瑕疵”,避免過(guò)殺(Over-kill);同時(shí)即便切割在不反光的Low-k層上,光譜探測(cè)依然穩(wěn)定有效。
2. 對(duì)比“普通點(diǎn)激光 (Trignometry)”
激光劣勢(shì): 傳統(tǒng)三角激光在槽通過(guò)時(shí)經(jīng)常產(chǎn)生假信號(hào)(Ghost Peak),因?yàn)楣馕磸牡撞糠瓷洌嵌啻卧趶腣型槽壁折射丟失。且三角法的光斑往往橢圓且較大(30μm X 900μm線(xiàn)光等),橫向分辨率極低,很難探測(cè)精細(xì)槽寬。
本方案優(yōu)勢(shì): “同軸光路”是此類(lèi)應(yīng)用的所謂“Game Changer”,直下直上,數(shù)據(jù)可靠性極高。
3. 環(huán)境適應(yīng)穩(wěn)定性(Environment Durability)
晶圓工廠環(huán)境要求嚴(yán)苛,該款傳感器具有顯著適應(yīng)性:
無(wú)電子發(fā)熱源: 探測(cè)頭為只含有光學(xué)透鏡的無(wú)源器件(資料中列明“光纖頭與控制器分離”)。探頭本身不發(fā)熱也不帶電,適合于有去離子水(DI Water)和易燃冷卻液的Dicing濕操作區(qū)域(需配合適合的IP防護(hù)或架設(shè)防護(hù)位),也避免了電磁干擾。
溫度穩(wěn)定性: 系統(tǒng)中提到的溫漂特性?xún)H為 <0.03%?F.S./°C<0.03%?F.S./°C ,配合半導(dǎo)體車(chē)間的恒溫控制,系統(tǒng)的熱漂移誤差可忽略不計(jì)。
六、 結(jié)論與實(shí)測(cè)參數(shù)模擬
本方案通過(guò)選用 HC系列 中的 LTC400 光譜共焦位算法移傳感器,可以建立對(duì)12寸晶圓工藝中最為關(guān)鍵的 Sawing/Dicing 環(huán)節(jié)進(jìn)行全閉環(huán)控制(Process Control):
實(shí)時(shí)的刀片(Blade)磨損及斷裂監(jiān)控: 若監(jiān)測(cè)的Groove底面形狀變圓或產(chǎn)生V形畸變,意味著劃片刀磨損,提醒更換。
成品良率保障: 定量輸出 Chipping(崩邊)數(shù)據(jù),拒絕主觀目測(cè)判廢。
技術(shù)指標(biāo)落實(shí):
深度分辨率: < 0.1 μm (能力) vs 工藝要求 ~5μm
槽寬重復(fù)性: < 1 μm (通過(guò)掃描算法保證重構(gòu)精度)
速度覆蓋: 原生2-10kHz采樣速率支持在線(xiàn)Scanning需求。
綜上所述,采用以LTC400為核心的檢測(cè)系統(tǒng),以精確的光譜編碼距離融合高速截面掃描,是解決窄槽深切工藝中復(fù)雜形貌管控的最佳科學(xué)解決方案。這完全符合現(xiàn)代先進(jìn)封裝工藝對(duì)SPC(統(tǒng)計(jì)過(guò)程控制)的高標(biāo)準(zhǔn)要求。
審核編輯 黃宇
-
晶圓
+關(guān)注
關(guān)注
53文章
5408瀏覽量
132280 -
在線(xiàn)監(jiān)測(cè)
+關(guān)注
關(guān)注
1文章
1200瀏覽量
28095 -
傳感系統(tǒng)
+關(guān)注
關(guān)注
1文章
105瀏覽量
17358
發(fā)布評(píng)論請(qǐng)先 登錄
半導(dǎo)體精密制造檢測(cè)選型白皮書(shū) ——基于LTC系列光譜共焦技術(shù)的應(yīng)用解決方案
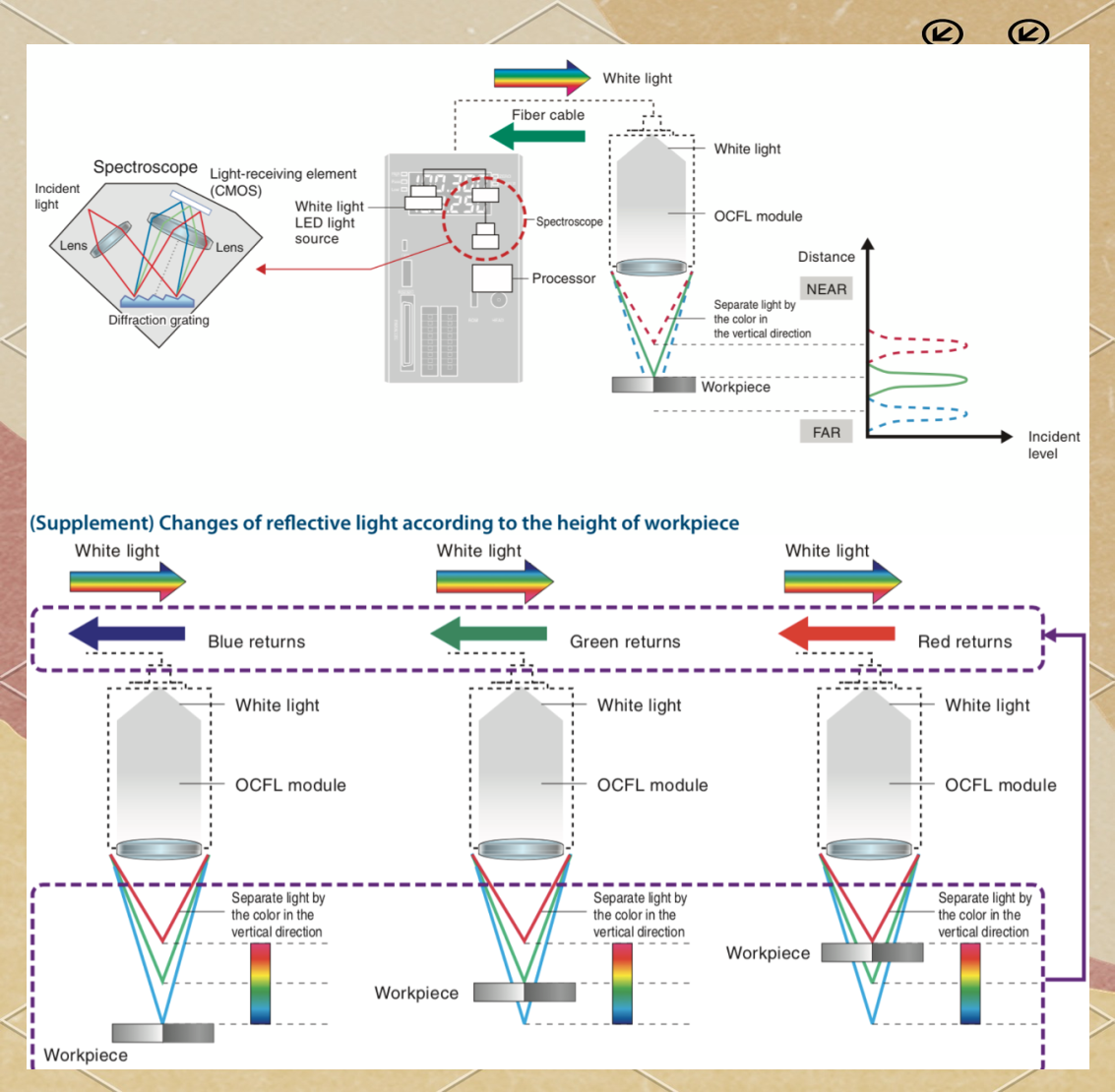
半導(dǎo)體行業(yè)案例:晶圓切割工藝后的質(zhì)量監(jiān)控

切割液性能智能調(diào)控系統(tǒng)與晶圓 TTV 預(yù)測(cè)模型的協(xié)同構(gòu)建

新增型號(hào)!40mm大工作距離光譜共焦位移傳感器為影像儀檢測(cè)賦能

技術(shù)指南丨深視智能點(diǎn)光譜共焦位移傳感器定時(shí)觸發(fā)功能操作指南

晶圓切割中淺切多道工藝與切削熱分布的耦合效應(yīng)對(duì) TTV 的影響

晶圓切割振動(dòng)監(jiān)測(cè)系統(tǒng)與進(jìn)給參數(shù)的協(xié)同優(yōu)化模型

TC Wafer晶圓測(cè)溫系統(tǒng)——半導(dǎo)體制造溫度監(jiān)控的核心技術(shù)

泓川科技小量程光譜共焦傳感器雙探頭對(duì)射法實(shí)現(xiàn)4-5mm玻璃鏡片大厚度1μm 精度測(cè)量案例

技術(shù)指南丨深視智能點(diǎn)光譜共焦位移傳感器測(cè)量透明物體厚度操作指南

應(yīng)用案例丨光譜共焦位移傳感器,讓細(xì)小孔洞的深度檢測(cè)更精準(zhǔn)

wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量的設(shè)備
深視智能SCI系列光譜共焦位移傳感器以亞微米精度測(cè)量晶圓平整度
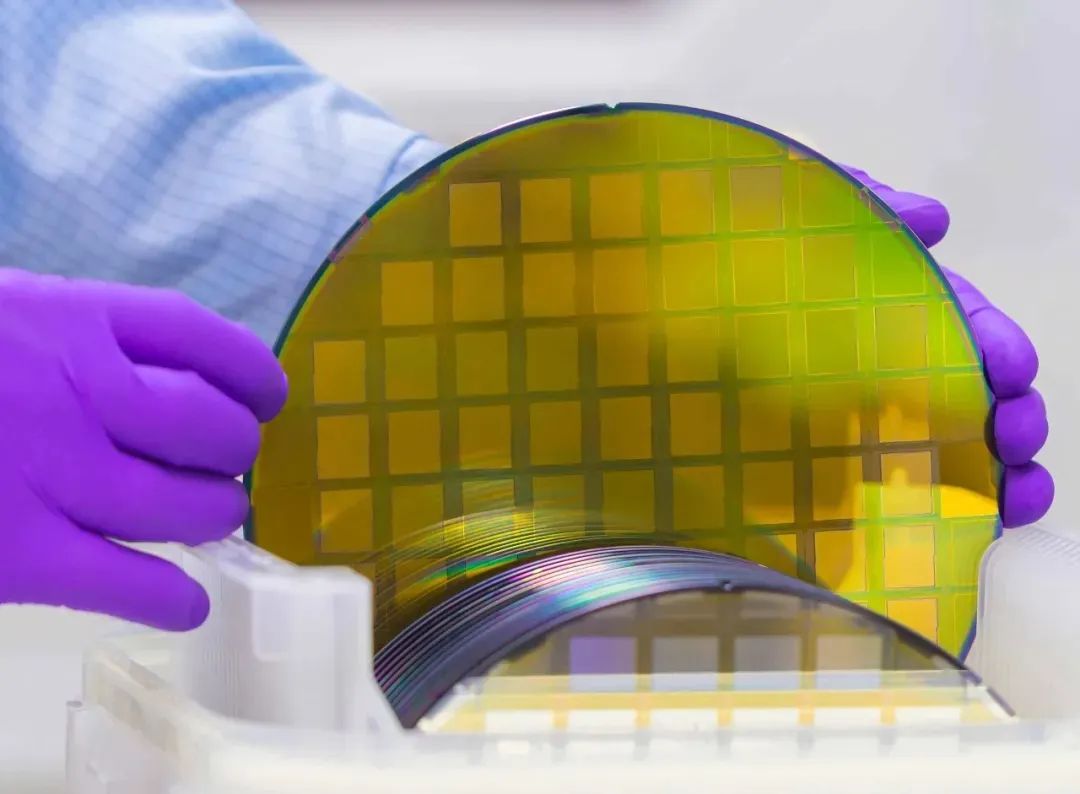
深視智能SCI系列點(diǎn)光譜共焦位移傳感器破解晶圓搭邊檢測(cè)難題




 晶圓切割(Dicing)工藝在線(xiàn)監(jiān)測(cè)系統(tǒng)解決方案 ——基于泓川科技LTC系列光譜共焦位移傳感系統(tǒng)的應(yīng)用
晶圓切割(Dicing)工藝在線(xiàn)監(jiān)測(cè)系統(tǒng)解決方案 ——基于泓川科技LTC系列光譜共焦位移傳感系統(tǒng)的應(yīng)用





評(píng)論