文章來源:學習那些事
原文作者:小陳婆婆
本文主要講述芯片制造檢驗工藝——全數檢查。
在IC芯片制造的檢驗工藝中,全數檢查原則貫穿于關鍵工序的缺陷篩查,而老化測試作為可靠性驗證的核心手段,通過高溫高壓環(huán)境加速潛在缺陷的暴露,確保芯片在生命周期內的穩(wěn)定運行。以邏輯芯片與存儲器芯片的測試策略差異為例,靜態(tài)老化測試在邏輯芯片中廣泛應用——僅施加恒定直流電壓,不檢測實際工作狀態(tài),通過高溫環(huán)境誘發(fā)靜態(tài)缺陷。

存儲器芯片則采用動態(tài)老化測試,在高溫下疊加交流電壓以模擬實際工作負載,同步監(jiān)測電路響應,如DRAM制造中常結合監(jiān)控老化測試(MBT)與試驗老化測試(TBI),通過時鐘信號驅動內部電路并實時捕獲輸出異常,實現(xiàn)缺陷的精準定位。

老化測試系統(tǒng)的設計高度集成化,典型配置包含高溫室、老化測試電路板及自動插拔機。高溫室可精確控制溫度梯度,模擬極端工作條件;老化測試電路板配備專用插座陣列,支持數千顆芯片并行測試;插拔機作為自動化搬運核心,通過機器人手臂實現(xiàn)芯片的快速裝卸,提升測試效率。這種系統(tǒng)架構在保證測試覆蓋率的同時,需平衡測試成本與產能需求——例如,TBI測試通過循環(huán)高低溫度沖擊結合特性測試,減輕單次測試儀負荷,優(yōu)化資源分配。
進貨檢驗階段嚴格執(zhí)行全數檢查,涵蓋外觀缺陷(如劃痕、引線變形)、標記完整性及電路功能驗證,確保每一顆芯片均符合設計規(guī)范;而出貨檢驗則采用抽樣策略,在保證可靠性的前提下降低檢測成本。近年來,AI驅動的缺陷預測模型在老化測試中嶄露頭角,通過分析歷史測試數據與工藝參數,可提前識別高風險芯片,將測試效率提升20%以上;同時,基于機器學習的動態(tài)測試模式優(yōu)化,能夠自適應調整測試向量,減少無效測試時間,進一步壓縮測試周期。
在技術前沿方向,量子傳感技術與老化測試的結合正被探索,利用量子隧穿效應實現(xiàn)亞納米級缺陷檢測,提升早期缺陷識別能力;而3D封裝芯片的測試則面臨新挑戰(zhàn),需開發(fā)多層互連結構的熱應力模擬與缺陷定位算法,確保堆疊芯片的可靠性。這些進展表明,檢驗工藝的演進始終圍繞“精度、效率、成本”的三角平衡展開,通過技術創(chuàng)新持續(xù)推動半導體行業(yè)的質量管控水平提升,支撐更復雜、更可靠的芯片產品量產落地。
-
芯片制造
+關注
關注
11文章
719瀏覽量
30464 -
邏輯芯片
+關注
關注
1文章
167瀏覽量
32152 -
IC芯片
+關注
關注
8文章
265瀏覽量
28111
原文標題:芯片制造檢驗工藝——全數檢查
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
PCB在設計后需要哪些檢驗?
【「大話芯片制造」閱讀體驗】+芯片制造過程工藝面面觀
【「大話芯片制造」閱讀體驗】+ 芯片制造過程和生產工藝
雙面印制電路板制造工藝
PCB在設計后需要哪些檢查?
汽車線束的加工工藝及檢查




 芯片制造檢驗工藝中的全數檢查
芯片制造檢驗工藝中的全數檢查

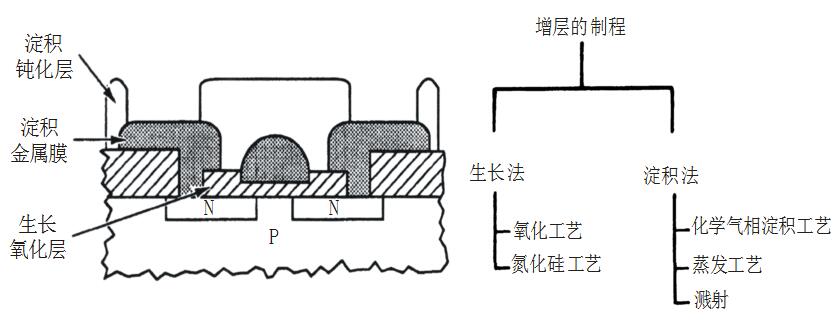




評論