
靜電噴涂沉積(ESD)作為一種經(jīng)濟(jì)高效的薄膜制備技術(shù),因其可精確調(diào)控薄膜形貌與化學(xué)計(jì)量比而受到廣泛關(guān)注。然而,薄膜的厚度均勻性是影響其最終性能與應(yīng)用可靠性的關(guān)鍵因素,其優(yōu)劣直接受到電壓、流速、針基距等多種工藝參數(shù)的復(fù)雜影響。傳統(tǒng)均勻性評(píng)估方法往往效率較低或具有破壞性,難以滿足快速工藝優(yōu)化的需求。Flexfilm探針式臺(tái)階儀可以實(shí)現(xiàn)表面微觀特征的精準(zhǔn)表征與關(guān)鍵參數(shù)的定量測(cè)量,精確測(cè)定樣品的表面臺(tái)階高度與膜厚,為材料質(zhì)量把控和生產(chǎn)效率提升提供數(shù)據(jù)支撐。
本研究提出并建立了一種基于光學(xué)圖像分析的快速、非破壞性均勻性定量評(píng)估方法。該方法將半透明薄膜置于均勻光源上,通過數(shù)碼相機(jī)獲取透射光圖像,并依據(jù)朗伯-比爾定律將灰度信息轉(zhuǎn)換為厚度分布。通過自主開發(fā)的圖像處理算法,從宏觀(基于厚度方差的區(qū)塊分析)和微觀(基于厚度梯度的分布統(tǒng)計(jì))兩個(gè)尺度對(duì)均勻性進(jìn)行量化評(píng)價(jià),從而實(shí)現(xiàn)對(duì)薄膜質(zhì)量的高通量、全場(chǎng)表征,為工藝參數(shù)的系統(tǒng)優(yōu)化提供了直接、有效的分析工具。
1
實(shí)驗(yàn)方法
flexfilm

用于制備薄膜的靜電噴涂沉積裝置示意圖
薄膜制備
以CuCl?·2H?O、InCl?和硫脲為前驅(qū)體,配制水-醇基溶液,在SnO?:F導(dǎo)電玻璃基板上進(jìn)行ESD沉積。
系統(tǒng)研究了溶液濃度(0.21–0.49 M)、電壓(10–20 kV)、流速(25–200 μL/min)、針?基距(4–5 cm)及基板溫度(380–450°C)對(duì)薄膜形貌的影響。
均勻性評(píng)估流程

宏觀均勻性測(cè)試流程圖
圖像采集:將半透明薄膜置于均勻光源上,通過數(shù)碼相機(jī)獲取透射光圖像。
厚度轉(zhuǎn)換:將圖像轉(zhuǎn)換為灰度矩陣,并依據(jù)朗伯?比爾定律,假設(shè)固定吸收系數(shù)(10?? cm?1),將灰度值換算為相對(duì)厚度分布。
兩段式分析:

左:人工生成圖像(用于驗(yàn)證MUT);右:MUT對(duì)人工圖像的分析結(jié)果
宏觀均勻性測(cè)試(MUT):將厚度矩陣劃分為不同尺寸的區(qū)塊,計(jì)算各區(qū)塊平均厚度的方差。隨著區(qū)塊尺寸減小,方差的變化趨勢(shì)反映了薄膜在大尺度上的厚度波動(dòng)。設(shè)定方差閾值(μ(t) ≤ 10?12 @ 200像素區(qū)塊)可用于快速篩選均勻性合格的樣品。
微觀均勻性測(cè)試(μUT):對(duì)通過MUT的樣品,計(jì)算厚度矩陣在行、列方向上的梯度分布,并統(tǒng)計(jì)其半高寬(FWHM)。FWHM越小,表明薄膜局部厚度變化越平緩,微觀均勻性越好。

樣品的噴涂沉積條件
2
實(shí)驗(yàn)結(jié)果
flexfilm

左:不同條件下樣品的數(shù)字圖像;中:宏觀均勻性測(cè)試(MUT)結(jié)果;右上:微觀均勻性測(cè)試(μUT)結(jié)果;右下:計(jì)算粗糙度與臺(tái)階儀測(cè)量粗糙度對(duì)比圖
通過對(duì)多組工藝條件下制備的薄膜進(jìn)行分析,結(jié)果表明:
較高的電壓(16–20 kV)與適中的流速(100–200 μL/min)有利于獲得宏觀均勻的薄膜。
微觀均勻性最佳的樣品(如2號(hào)樣品)表現(xiàn)出最窄的厚度梯度分布(FWHM ≈ 3.95 nm)。
該方法計(jì)算的厚度分布粗糙度與臺(tái)階儀的測(cè)量結(jié)果趨勢(shì)一致,驗(yàn)證了其可靠性。相較于輪廓儀的單點(diǎn)測(cè)量,圖像分析法能提供全視野的平均信息,對(duì)不均勻樣品更具表征優(yōu)勢(shì)。
靜電噴涂沉積(ESD)是一種可在低溫下制備可控薄膜的靈活技術(shù)。高電場(chǎng)的使用減少了材料損失,有利于優(yōu)化薄膜性能。通過調(diào)整實(shí)驗(yàn)參數(shù)可改善沉積薄膜形貌。本文開發(fā)的測(cè)試方法簡(jiǎn)單有效,可用于評(píng)估薄膜厚度均勻性。對(duì)于成分均勻的薄膜,該方法通過分析圖像亮度變化反映厚度均勻性;也可用于監(jiān)測(cè)成分變化引起的局部光學(xué)密度差異。該方法無損、高效,基于圖像處理與分析實(shí)現(xiàn)均勻性量化。盡管本研究針對(duì)ESD薄膜,但同樣適用于其他沉積技術(shù)制備的半透明薄膜。
Flexfilm探針式臺(tái)階儀
flexfilm
 技術(shù)支持:180-1566-6117在半導(dǎo)體、光伏、LED、MEMS器件、材料等領(lǐng)域,表面臺(tái)階高度、膜厚的準(zhǔn)確測(cè)量具有十分重要的價(jià)值,尤其是臺(tái)階高度是一個(gè)重要的參數(shù),對(duì)各種薄膜臺(tái)階參數(shù)的精確、快速測(cè)定和控制,是保證材料質(zhì)量、提高生產(chǎn)效率的重要手段。
技術(shù)支持:180-1566-6117在半導(dǎo)體、光伏、LED、MEMS器件、材料等領(lǐng)域,表面臺(tái)階高度、膜厚的準(zhǔn)確測(cè)量具有十分重要的價(jià)值,尤其是臺(tái)階高度是一個(gè)重要的參數(shù),對(duì)各種薄膜臺(tái)階參數(shù)的精確、快速測(cè)定和控制,是保證材料質(zhì)量、提高生產(chǎn)效率的重要手段。
- 配備500W像素高分辨率彩色攝像機(jī)
- 亞埃級(jí)分辨率,臺(tái)階高度重復(fù)性1nm
- 360°旋轉(zhuǎn)θ平臺(tái)結(jié)合Z軸升降平臺(tái)
- 超微力恒力傳感器保證無接觸損傷精準(zhǔn)測(cè)量
費(fèi)曼儀器作為國(guó)內(nèi)領(lǐng)先的薄膜厚度測(cè)量技術(shù)解決方案提供商,Flexfilm探針式臺(tái)階儀可以對(duì)薄膜表面臺(tái)階高度、膜厚進(jìn)行準(zhǔn)確測(cè)量,保證材料質(zhì)量、提高生產(chǎn)效率。
原文參考:《A method to quantify the degree of uniformity of thickness of thin films》
*特別聲明:本公眾號(hào)所發(fā)布的原創(chuàng)及轉(zhuǎn)載文章,僅用于學(xué)術(shù)分享和傳遞行業(yè)相關(guān)信息。未經(jīng)授權(quán),不得抄襲、篡改、引用、轉(zhuǎn)載等侵犯本公眾號(hào)相關(guān)權(quán)益的行為。內(nèi)容僅供參考,如涉及版權(quán)問題,敬請(qǐng)聯(lián)系,我們將在第一時(shí)間核實(shí)并處理。
關(guān)于我們
Flexfilm
蘇州費(fèi)曼測(cè)量?jī)x器有限公司(Flexfilm)——薄膜材料智檢先鋒,致力于為全球工業(yè)智造提供精準(zhǔn)測(cè)量解決方案。薄膜結(jié)構(gòu)精密測(cè)量設(shè)備:臺(tái)階儀、全光譜橢偏儀、單點(diǎn)膜厚儀、自動(dòng)膜厚儀、在線厚度測(cè)量系統(tǒng),為客戶提供接觸式、非接觸式、自動(dòng)化測(cè)量系統(tǒng)三種薄膜厚度測(cè)試技術(shù)。
材料電學(xué)性能表征設(shè)備: 離線/在線四探針測(cè)試儀、半導(dǎo)體晶圓在線方阻測(cè)試儀、平板顯示在線方阻測(cè)試儀、TLM接觸電阻測(cè)試儀、霍爾測(cè)試儀、擴(kuò)展電阻SRP測(cè)試儀。Flexfilm 致力于成為客戶在材料研發(fā)、工藝控制和質(zhì)量保證環(huán)節(jié)最值得信賴的合作伙伴,以創(chuàng)新的測(cè)量技術(shù)驅(qū)動(dòng)全球工業(yè)智造的進(jìn)步。
-
ESD
+關(guān)注
關(guān)注
50文章
2416瀏覽量
180148 -
光學(xué)成像
+關(guān)注
關(guān)注
0文章
94瀏覽量
10698
發(fā)布評(píng)論請(qǐng)先 登錄
集成電路制造中薄膜生長(zhǎng)設(shè)備的類型和作用

集成電路制造中薄膜生長(zhǎng)工藝的發(fā)展歷程和分類

應(yīng)用材料AMAT/APPLIED MATERIALS Producer? XP Precision? CVD系列二手薄膜沉積CVD設(shè)備拆機(jī)/整機(jī)|現(xiàn)場(chǎng)驗(yàn)機(jī)評(píng)測(cè)
光刻膠涂層如何實(shí)現(xiàn)納米級(jí)均勻性?橢偏儀的工藝控制與缺陷分析

OCT光學(xué)成像技術(shù)及其相關(guān)光源介紹
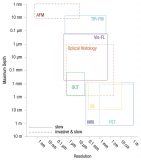
臺(tái)階儀在光電材料中的應(yīng)用:基于AZO薄膜厚度均勻性表征的AACVD工藝優(yōu)化

機(jī)器視覺光學(xué)基礎(chǔ)概念——眩光、鬼影與熱點(diǎn)

FLIR聲學(xué)成像儀在工業(yè)檢測(cè)領(lǐng)域的應(yīng)用
半導(dǎo)體外延和薄膜沉積有什么不同

基于納米流體強(qiáng)化的切割液性能提升與晶圓 TTV 均勻性控制

半導(dǎo)體薄膜厚度測(cè)量丨基于光學(xué)反射率的厚度測(cè)量技術(shù)

大面積薄膜光學(xué)映射與成像技術(shù)綜述:全光譜橢偏技術(shù)

薄膜厚度高精度測(cè)量 | 光學(xué)干涉+PPS算法實(shí)現(xiàn)PCB/光學(xué)鍍膜/半導(dǎo)體膜厚高效測(cè)量

詳解原子層沉積薄膜制備技術(shù)

質(zhì)量流量控制器在薄膜沉積工藝中的應(yīng)用
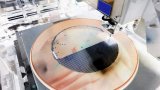



 基于光學(xué)成像的沉積薄膜均勻性評(píng)價(jià)方法及其工藝控制應(yīng)用
基于光學(xué)成像的沉積薄膜均勻性評(píng)價(jià)方法及其工藝控制應(yīng)用




評(píng)論