從最初的光學顯微鏡到如今的電子顯微鏡,我們觀察微觀世界的能力不斷提升,推動了材料科學、生物學、半導體技術等領域的革命性進展。本文將講解現代微觀分析的兩大主力工具——掃描電子顯微鏡(SEM)和透射電子顯微鏡(TEM)。
為什么選擇電子成像?
要理解電子顯微鏡的價值,我們首先需要明白成像的基本原理。日常生活中我們熟悉的光學顯微鏡,其分辨能力受到可見光波長的限制。
可見光的波長范圍在380-760納米之間,這意味著即使最理想的光學顯微鏡,也無法分辨出小于幾百納米的結構。
在半導體行業,器件尺寸已縮小至幾十納米甚至更小,傳統光學顯微鏡已無法滿足觀察需求。科學家們將目光轉向了更小的“探針”——電子。根據物理原理,電子具有波動性,其波長與質量和速度相關。通過計算可知,電子的波長可以輕易達到納米甚至更小尺度,這為觀察超微結構提供了可能。電子顯微鏡的誕生,正是基于這種原理。通過使用電子束代替光線,科學家們打開了通往納米世界的大門。
掃描電子顯微鏡(SEM)
1.基本成像原理掃描電鏡的工作原理可以概括為“轟擊-收集-成像”三個步驟。
系統首先通過電子槍產生電子束,經過一系列電磁透鏡(這些透鏡實際上是利用磁場聚焦電子的線圈,而非傳統意義上的玻璃透鏡)的聚焦和加速,形成精細的電子探針。
2.二次電子與背散射電子
在SEM成像中,二次電子和背散射電子是最常用的兩種信號,它們提供著不同類型的樣品信息。
二次電子主要來自樣品最表層(1–10納米),由入射電子激發表面價電子產生。
由于能量低,它們僅能從極淺區域逸出,對表面形貌極為敏感。凸起、邊緣等處信號強,凹陷處信號弱,由此形成具有立體感的形貌圖像,分辨率可達1–3納米,是觀察表面微觀結構的理想選擇。
背散射電子是入射電子與原子核發生彈性碰撞后反射回來的高能電子,來自樣品較深區域(約100納米至1微米)。
其產額與原子序數正相關,重元素區域信號亮,輕元素區域暗,因此常用于分析成分分布,如合金中不同相的分布,但對表面形貌的靈敏度較低。
3.明場與暗場成像在SEM中,明場和暗場成像通過選擇不同信號角度,提供了觀察樣品的不同視角。明場成像
是SEM中最常規的成像模式,主要收集從樣品表面直接逸出的二次電子或小角度散射的背散射電子。在這種模式下,表面凸起、邊緣等區域信號強,顯示為亮區;凹陷、溝槽等區域信號弱,顯示為暗區。這種成像方式呈現的圖像立體感強,適合觀察樣品的整體形貌結構。
暗場成像
則反其道而行,通過調整探測器位置,專門收集大角度散射的電子信號。在這種模式下,直接逸出電子的區域信號反而較弱,顯示為暗區;而那些需要經過反射才能到達探測器的區域(如凹陷、孔洞)則信號較強,顯示為亮區。暗場成像特別適合觀察樣品表面的凹陷結構,如材料裂紋、孔隙分布等,能提供明場成像難以展現的結構信息。
4.不同材料的SEM響應
不同類型的材料在SEM下會呈現截然不同的響應特征,這主要取決于材料的導電性和原子序數。
(1)金屬材料由于導電性好,二次電子容易逸出,且通常原子序數較大,背散射電子產額高,因此在SEM圖像中通常呈現較亮的襯度。
(2)半導體材料導電性中等,二次電子產額低于金屬,雖然原子序數可能與某些金屬相近,背散射電子信號相當,但整體亮度通常低于金屬。有趣的是,N型和P型半導體由于摻雜差異,在SEM下也會呈現輕微的襯度區別,這為半導體器件的分析提供了有用信息。
(3)絕緣體材料由于導電性差,且通常由輕元素組成,二次電子和背散射電子產額都較低,因此在SEM圖像中通常呈現暗色。為了觀察絕緣體樣品,一般需要在表面噴涂一層導電膜,以避免電荷積累對成像質量的影響。
透射電子顯微鏡(TEM)
1.基本成像原理
如果說SEM是觀察樣品表面的利器,那么TEM則是探索材料內部結構的法寶。
透射電鏡的工作原理基于高能電子束穿透超薄樣品(通常小于100納米)的過程。
當電子束穿過樣品時,會與樣品中的原子發生相互作用,產生吸收、衍射等不同程度的散射。樣品不同區域的原子序數、厚度和晶體結構差異會導致電子束產生不同的散射程度。透過樣品的電子束攜帶了這些結構信息,最終在熒光屏或探測器上形成與樣品內部結構對應的明暗圖像。
2.TEM的明場與暗場成像
TEM中的明場和暗場成像概念與SEM有所不同,它們基于不同的成像機制。
明場成像僅允許未被樣品衍射的透射電子參與成像。
在晶體材料中,滿足衍射條件的區域(如晶界、缺陷)會將電子衍射,這些衍射電子被物鏡光闌阻擋,無法參與成像,因此對應區域顯示為暗區;而未發生衍射的區域則透射電子較多,顯示為亮區。這種成像模式特別適合觀察晶體中的各種缺陷。
暗場成像則通過調整物鏡光闌,阻擋直射電子,僅允許特定方向的衍射電子參與成像。
在這種情況下,產生該特定衍射的區域會有電子信號,顯示為亮區;其他區域則無信號,顯示為暗區。暗場成像可以精確定位具有特定晶體取向的晶粒或缺陷。值得一提的是,還有一種特殊的中心暗場成像技術,通過傾斜入射電子束,使衍射斑移到透鏡中心位置,利用該衍射束成像。這種技術可以提高圖像質量,減少像差。
3.不同材料的TEM響應
在TEM中,金屬、半導體和絕緣體由于電子散射特性的差異,會呈現不同的成像襯度。
(1)金屬材料含有大量自由電子,入射電子容易發生非彈性散射,散射信號強烈。在明場成像中,金屬區域因散射電子多,直射電子少,呈現暗襯度;而在高角度環形暗場(HAADF)成像中,信號與原子序數的平方成正比,金屬區域(通常原子序數較高)呈現亮區。
(2)半導體材料的自由電子數量遠少于金屬,電子散射以彈性散射為主,散射強度中等。在明場成像中,其襯度介于金屬和絕緣體之間;對于單晶半導體,還容易因晶格取向產生衍射襯度。
(3)絕緣體材料幾乎不含自由電子,電子散射以彈性散射和微弱的非彈性散射為主,散射強度最弱。在明場成像中,絕緣體區域直射電子多,通常呈現亮襯度。
高分辨率透射電子顯微鏡(HRTEM)
HRTEM代表了透射電鏡技術的巔峰,它將觀察尺度推向了原子級別。與普通TEM基于電子束的振幅差異成像不同,HRTEM利用的是電子束的相位差異。當電子穿透樣品時,會被不同位置的原子散射,產生微小的相位差。這些帶有相位信息的電子在物鏡后焦面發生干涉,最終在像平面形成干涉條紋。這些條紋的規律直接對應樣品中原子的排列周期,使得我們能夠直接“看到”原子的排列情況。HRTEM的分辨率可達0.1-0.2納米,這種超高分辨率也對樣品制備提出了極高要求——樣品必須極薄(通常小于20納米),且要盡可能無缺陷、無污染。HRTEM在材料科學、納米技術、凝聚態物理等領域發揮著不可替代的作用。無論是分析晶體的晶格結構、觀察原子尺度的缺陷,還是表征納米材料的精細結構、研究界面的原子結合方式,HRTEM都提供了最為直接和有力的證據。
-
SEM
+關注
關注
0文章
274瀏覽量
15678 -
TEM
+關注
關注
0文章
122瀏覽量
11129 -
電鏡
+關注
關注
0文章
104瀏覽量
9762
發布評論請先 登錄
影響掃描電鏡(SEM)的幾大要素?
透射電鏡(TEM)
透射電鏡(TEM)原理及應用介紹
LED焊球不良品觀察(掃描電鏡)SEM失效分析

PMMA顆粒形貌觀察和直徑測量(掃描電鏡,SEM)
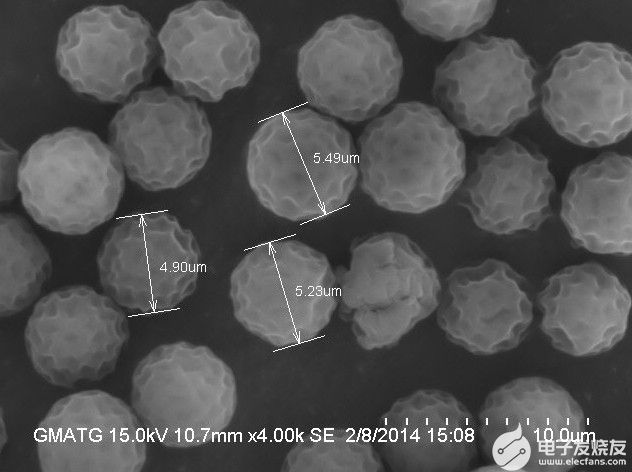
透射電鏡TEM測試原理及過程

透射電鏡與 FIB 制樣技術解析

正確選擇透射電鏡的不同模式——TEM,HRTEM,HAADF-STEM




 一文看懂掃描電鏡(SEM)和透射電鏡(TEM)
一文看懂掃描電鏡(SEM)和透射電鏡(TEM)









評論