電子發燒友網報道(文/莫婷婷)隨著人工智能與可穿戴設備的深度融合,增強現實(AR)智能眼鏡正逐步從概念走向大眾市場。盡管當前AI眼鏡在消費端熱度較高,其中AR智能眼鏡作為下一代人機交互的核心載體,其技術迭代與產業布局正迎來關鍵轉折點。尤其在中國市場的推動下,AR眼鏡已逐漸完善產業鏈生態,中國企業成為近眼顯示技術發展的中流砥柱。
中國主導全球AR眼鏡市場,Meta帶動LCoS技術份額提升
TrendForce集邦咨詢的數據顯示,當前AR眼鏡的開發和出貨主力集中在中國市場,占據全球88%的份額。以影目、Xreal、Rokid等為代表的中國企業,憑借快速的產品迭代能力和成本控制優勢,持續推出具備競爭力的AR產品。 
TrendForce集邦咨詢資深研究副總經理邱宇彬指出,目前AR眼鏡的產品發展路徑愈發清晰,產品功能也開始明確、收斂。原先各家廠商入局的搭配OLEDoS顯示技術的觀影功能,也在逐步形成新的共識:資訊提示類為AR眼鏡的最佳戰場。因此,新一代AR眼鏡的設計標準正在向重量低于60克、FOV控制在30°以內的方向演進。這一轉變不僅降低了佩戴負擔,對整個產品的設計、各組件的成本都有很大的助益。
在顯示技術層面,2025年AR眼鏡光引擎市場呈現“三足鼎立”態勢:OLEDoS(Micro OLED)顯示技術方案大約占據53%的市場份額,依然為市場主流;LCoS 在Meta產品的帶動下來到7%,LEDoS(Micro LED)方案憑借室內提示與戶外騎行等應用場景的崛起上升至37%。
集邦咨詢認為,LEDos憑借其在亮度、對比度方面的先天優勢,將在AR終端產品中占據一席之地。而LCoS則憑借成熟的供應鏈、技術工藝在成本性價比上表現更佳,且在較高APL下,相較于LEDoS具備一定的功耗優勢,也因此受到Meta的青睞,其在9月發布的最新AR眼鏡 Ray-Ban Display采用的就是“LCoS + 陣列光波導”方案。而Meta的選擇也讓業內開始重新評估LCoS在AR領域的潛力,預計其帶動效應將在2026年推動LCoS市場份額提升至13%。同時邱宇彬也指出,LEDoS發展還很前期,在高APL下,EQE外部量子效率的提升將有非常顯著的效果,這也對LEDoS的未來滲透率的提升至關重要。 
全彩化需求驅動Micro LED技術突破:垂直堆疊成關鍵方向
目前主流的全彩化方案分為兩類:三色合光、單片全彩。三色合光技術通過紅、綠、藍三片獨立LED面板進行光學合成。該方案成熟度較高,但存在結構復雜、組裝精度要求高、成本難以壓縮等問題。單片全彩技術將紅、綠、藍三種顏色集成在同一芯片上,避免多片拼接帶來的對準誤差。
目前,行業的終極目標還是希望可以做到單片全彩化。單片全彩又進一步分為單片全彩和垂直堆疊兩個主流的技術路線。 垂直堆疊的核心原理是將紅光置于最底層,藍/綠光位于上方,利用不同波長穿透能力差異實現分層發光。在企業的技術進展方面,JBD、鴻石智能、諾視科技等企業均在此領域取得突破。
例如JBD 完成各階段 R/G/B LED 晶圓片的電極線路后再透過晶圓片接合技術垂直堆疊而成電極線路皆制作在芯片內層。邱宇彬表示,垂直堆疊技術難度極高,而對位精準度(1um)會是最大的技術挑戰。
鴻石智能在2025年發布混合堆疊結構技術,融合兩次晶圓鍵合和一次亮度色轉,實現藍綠外延片的集成和紅光的精準呈現,將光效提高60%以上,同時搭配光學微結構,可再提高出光效率20%。新市場開拓副總經理劉懌在演講中指出,公司在今年上半年已經推出了0.12英寸的320×240分辨率單片全彩的產品。
但是Micro LED作為新技術,也面臨多個技術問題亟須解決,邱宇彬指出在材料與晶圓尺寸兩大方面存在的問題:
材料層面:傳統LED采用藍寶石襯底,而Micro LED需與硅背板鍵合。由于兩者熱膨脹系數差異,在250℃工藝溫度下,有可能會產生0.1%的微米級分離,無法滿足近眼顯示的高精度要求。尺寸層面:主流LED晶圓為4寸為主,慢慢過渡到6寸;而硅基工藝普遍采用8/12寸晶圓,兩者之間很難達到百分之百的利用鍵合率。
為解決傳統LED外延片(藍寶石襯底)與硅基背板之間的熱膨脹系數不匹配問題,業界提出了多種鍵合方案:Die to Die(D2D):小面積鍵合,可有效緩解CTE失配,但生產效率低;Wafer to Wafer(W2W):整片晶圓鍵合,效率高,但面臨尺寸不匹配挑戰;Die to Wafer to Wafer(D2W2W):引入臨時襯底,先將LED芯片排列至臨時基板,再整體鍵合至硅基板,兼顧良率與效率,被認為是中長期最優解,但相對來講,制程的復雜度也進一步提高。
在廠商方案的選擇上也有所差異,例如英國Porotech公司投資開發8英寸硅基GaN平臺,實現與8英寸CMOS的100%鍵合利用率;而國內的JBD則通過將12英寸晶圓切割為7塊4英寸區域,實現約80%的利用率,具備一定的產業化可行性。目前無論從材料層面還是尺寸匹配度上都有相應的解決方案,只是行業內還未形成共識。 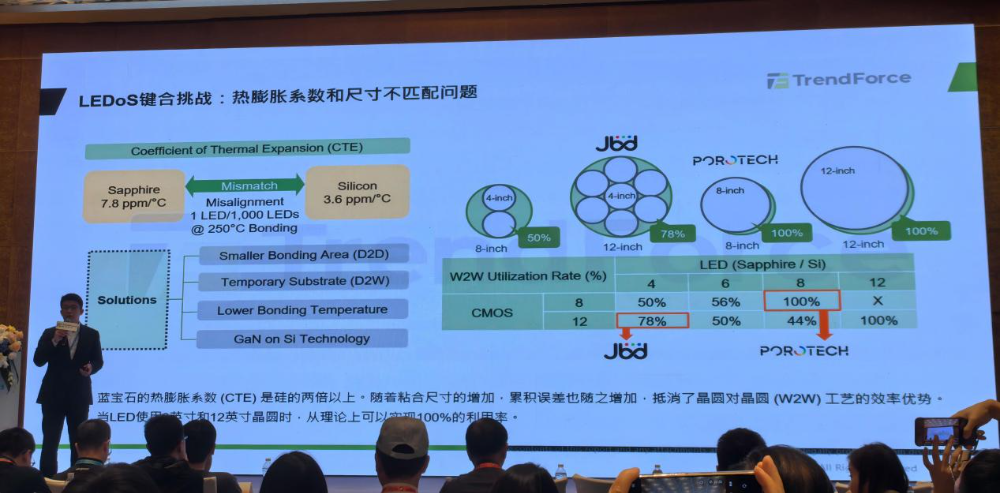
但依舊可以期待的是,隨著硅基GaN向8英寸甚至12英寸演進,以及基于硅襯底Micro LED的各種全彩技術發展,Micro LED一定會迎來大規模的產業機遇。 在量產進程上,邱宇彬指出,AR應用作為科技行業產品,面臨一個隱形的挑戰:目前來說并未形成統一的規格共識,因此在發展過程中,目標持續滾動升級,這使得后進廠商在跟進時會有資源分配的抉擇,也會影響第二、第三梯隊實際規模化量產的時程,因而或延緩行業的發展節奏。
小結
盡管當前AR眼鏡仍處于成長初期,但以中國為核心的產業鏈正在加速構建。從輕量化設計到全彩化突破,從LEDos的垂直堆疊到LCoS的微型化革新,再到光波導材料的升級換代,每一項技術進步都在為AR眼鏡的普及鋪平道路。正如邱宇彬所言:“AR眼鏡正在從‘我全都要’走向‘精準服務’。”唯有聚焦核心需求,優化用戶體驗,才能真正實現“人手一副”的愿景。
-
Ar
+關注
關注
25文章
5288瀏覽量
176476 -
智能眼鏡
+關注
關注
8文章
792瀏覽量
75163
發布評論請先 登錄

靈犀微光陣列光波導技術推動消費級AR眼鏡普及

CPO量產再加速,高塔半導體推新型CPO代工平臺
芯片制造中的鍵合技術詳解




 國產霸屏88%出貨!垂直堆疊+晶圓鍵合技術升級,AR眼鏡加速跨越量產鴻溝
國產霸屏88%出貨!垂直堆疊+晶圓鍵合技術升級,AR眼鏡加速跨越量產鴻溝



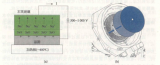







評論