
在半導(dǎo)體產(chǎn)業(yè)不斷演進(jìn)的歷程中,異質(zhì)異構(gòu)集成技術(shù)正逐漸成為推動(dòng)行業(yè)突破現(xiàn)有瓶頸、邁向全新發(fā)展階段的關(guān)鍵力量。在這樣的產(chǎn)業(yè)變革背景下,九峰山論壇暨化合物半導(dǎo)體產(chǎn)業(yè)博覽會(huì)于武漢光谷盛大召開(kāi),吸引了來(lái)自美國(guó)、比利時(shí)、奧地利及中國(guó)等多國(guó)的行業(yè)領(lǐng)軍企業(yè)高管與技術(shù)精英共襄盛舉。會(huì)議期間,超200場(chǎng)主題演講密集釋放前沿洞察,其中異質(zhì)異構(gòu)集成技術(shù)平行論壇吸引了眾多目光,業(yè)內(nèi)權(quán)威科研機(jī)構(gòu)、領(lǐng)軍企業(yè)及專(zhuān)家代表匯聚一堂,圍繞技術(shù)演進(jìn)路徑展開(kāi)深度思辨。
在這場(chǎng)由材料革命引發(fā)的產(chǎn)業(yè)重構(gòu)中,光電子、功率集成、異質(zhì)異構(gòu)集成技術(shù)等技術(shù)集群正形成突破合力,不僅推動(dòng)化合物半導(dǎo)體從實(shí)驗(yàn)室走向規(guī)模化商用,更重構(gòu)了全球半導(dǎo)體產(chǎn)業(yè)的競(jìng)爭(zhēng)格局。

正如中國(guó)工程院院士,華中科技大學(xué)校長(zhǎng)尤政在開(kāi)幕致辭中所言“中國(guó)半導(dǎo)體行業(yè)正以自主創(chuàng)新的決心,在全球產(chǎn)業(yè)變革中書(shū)寫(xiě)自己的方案。”作為這場(chǎng)變革的重要參與者與見(jiàn)證者,九峰山會(huì)議已然成為記錄產(chǎn)業(yè)轉(zhuǎn)型的關(guān)鍵坐標(biāo)。未來(lái),隨著半導(dǎo)體集成工藝的成熟,泛半導(dǎo)體產(chǎn)業(yè)將在6G通信、智能汽車(chē)、量子計(jì)算等領(lǐng)域開(kāi)啟新一輪技術(shù)革命。
一、光電子領(lǐng)域的異質(zhì)集成創(chuàng)新

在光電子技術(shù)高速發(fā)展的當(dāng)下,異質(zhì)集成創(chuàng)新正成為突破性能邊界的關(guān)鍵引擎。從數(shù)據(jù)中心的高速互聯(lián)到精密傳感的細(xì)微洞察,光電子系統(tǒng)對(duì)集成度、效率與功能融合的需求持續(xù)攀升。異質(zhì)集成打破材料與器件邊界,將激光器、調(diào)制器等不同光電器件,以及硅基、化合物半導(dǎo)體等異質(zhì)材料精準(zhǔn)整合,重塑光子集成電路架構(gòu)。這一創(chuàng)新,為光互聯(lián)的帶寬突破、傳感精度躍升與通信場(chǎng)景拓展筑牢根基,驅(qū)動(dòng)光電子領(lǐng)域邁向更智能、更高效的全新維度,開(kāi)啟技術(shù)變革與產(chǎn)業(yè)升級(jí)的新征程。
(1)光互聯(lián)集成芯片:構(gòu)建高速光鏈路
在半導(dǎo)體產(chǎn)業(yè)逼近摩爾定律極限、算力需求呈指數(shù)級(jí)爆發(fā)的時(shí)代背景下,光電融合技術(shù)正以顛覆性姿態(tài)重塑全球信息處理格局。作為新一代信息傳輸與處理的核心載體,光互聯(lián)集成芯片通過(guò)將光發(fā)射、接收、調(diào)制、放大等功能器件高度集成于同一芯片,構(gòu)建起高速低耗、抗干擾能力強(qiáng)的光傳輸鏈路,為高速數(shù)據(jù)通信、云計(jì)算、人工智能等前沿領(lǐng)域提供了堅(jiān)實(shí)的技術(shù)支撐。
日本NTT公司指出,“光電融合技術(shù)是50年一遇的技術(shù)創(chuàng)新”。作為應(yīng)對(duì)后摩爾時(shí)代挑戰(zhàn)的關(guān)鍵路徑,光電融合的信息處理以建模仿真為核心基礎(chǔ)。盡管當(dāng)前面臨物理機(jī)制復(fù)雜、多尺度模擬困難等挑戰(zhàn),仍可通過(guò)技術(shù)創(chuàng)新并借鑒集成電路設(shè)計(jì)經(jīng)驗(yàn),開(kāi)發(fā)更精準(zhǔn)高效的緊湊模型與仿真工具,推動(dòng)光電融合從物理制備向信息處理躍升,助力其在6G、人工智能等戰(zhàn)略領(lǐng)域的應(yīng)用。華中科技大學(xué)集成電路學(xué)院教授,武漢光電國(guó)家研究中心教授譚旻專(zhuān)家認(rèn)為,光電信息產(chǎn)業(yè),特別是光電融合芯片,是有條件率先實(shí)現(xiàn)突破的高技術(shù)產(chǎn)業(yè)。
在產(chǎn)業(yè)實(shí)踐層面,杭州廣立微電子研發(fā)副總裁潘偉偉指出,硅光芯片規(guī)模化量產(chǎn)的核心在于突破系統(tǒng)級(jí)良率瓶頸,而非局限于單一工藝環(huán)節(jié)的優(yōu)化。這要求設(shè)計(jì)、制造、測(cè)試全流程的深度協(xié)同,以及EDA工具對(duì)硅光芯片特殊需求的針對(duì)性適配。廣立微通過(guò)SemiMind平臺(tái)的智能化升級(jí),并引入DeepSeek大模型,實(shí)現(xiàn)了從工程工具到智能分析的跨越,充分展現(xiàn)了AI與大數(shù)據(jù)技術(shù)在良率提升中的關(guān)鍵賦能作用。
上海工研院高級(jí)技術(shù)總監(jiān)蔡艷,以硅光集成平臺(tái)為核心樞紐,串聯(lián)起技術(shù)演進(jìn)脈絡(luò)、工藝突破成果與產(chǎn)業(yè)生態(tài)體系,清晰勾勒出從“單一器件集成” 向 “系統(tǒng)級(jí)異構(gòu)創(chuàng)新” 跨越的發(fā)展路徑。上海工研院全力打造具有全球影響力的 “超越摩爾” 重大功能型平臺(tái),其90 nm硅光工藝平臺(tái)實(shí)力彰顯,成功入選《2023上海科技進(jìn)步報(bào)告》 。在技術(shù)推進(jìn)上,由TSMC、GF等主導(dǎo)的12英寸硅光平臺(tái)發(fā)力,CD、刻蝕深度等關(guān)鍵工藝誤差實(shí)現(xiàn)精準(zhǔn)把控,依托微環(huán)調(diào)制器開(kāi)發(fā)的高密度集成芯片,正深度革新現(xiàn)有硅光集成芯片架構(gòu)。而光量子計(jì)算、5G/6G通信、神經(jīng)形態(tài)計(jì)算等新興應(yīng)用,持續(xù)驅(qū)動(dòng)集成創(chuàng)新浪潮,多材料平臺(tái)集成與混合解決方案開(kāi)發(fā),成為未來(lái)技術(shù)突破與產(chǎn)業(yè)發(fā)展的關(guān)鍵引擎,引領(lǐng)硅基光電子集成邁向更廣闊的創(chuàng)新天地。
(2)激光器:突破光子集成電路局限
光子集成電路在現(xiàn)代互聯(lián)、傳感和計(jì)算等領(lǐng)域占據(jù)著愈發(fā)重要的地位,而異質(zhì)集成激光器則是解鎖其更大潛力的鑰匙。上海曼光信息科技有限公司董事長(zhǎng)趙佳從歷史、現(xiàn)狀、實(shí)踐多維度,系統(tǒng)呈現(xiàn)半導(dǎo)體激光器及異質(zhì)集成激光器仿真技術(shù)的發(fā)展邏輯、痛點(diǎn)挑戰(zhàn)與實(shí)踐路徑,為技術(shù)攻堅(jiān)與自主產(chǎn)業(yè)鏈構(gòu)建提供專(zhuān)業(yè)指引,凸顯異質(zhì)集成技術(shù)重塑半導(dǎo)體產(chǎn)業(yè)格局的核心價(jià)值。同時(shí)著重提及,開(kāi)發(fā)全國(guó)產(chǎn)商業(yè)化半導(dǎo)體激光器仿真設(shè)計(jì)平臺(tái)迫在眉睫,以此填補(bǔ)空白,筑牢產(chǎn)業(yè)鏈安全根基。
光電子領(lǐng)域?qū)ξ⑿突⒏咝阅芗す馄鞯男枨笥l(fā)迫切,傳統(tǒng)激光器在尺寸、功耗與集成度上的短板,倒逼產(chǎn)業(yè)尋求突破。西北工業(yè)大學(xué)教授甘雪濤團(tuán)隊(duì)在報(bào)告中總結(jié)前道集成納米線工藝,在激光器上原位直寫(xiě)波導(dǎo),構(gòu)建光子回路,不僅實(shí)現(xiàn)波分復(fù)用功能,更通過(guò)集成外腔,達(dá)成單模輸出、低閾值驅(qū)動(dòng)、窄線寬調(diào)控的特性突破,為光電子系統(tǒng)微型化、高性能化發(fā)展提供關(guān)鍵支撐,加速光子集成技術(shù)從理論到應(yīng)用的落地進(jìn)程。

(3)先進(jìn)封裝賦能光電混合集成:促進(jìn)光電子與微電子融合
先進(jìn)封裝技術(shù)在光電混合集成中起著橋梁作用,將光電子器件與電子器件緊密結(jié)合在一起。通過(guò)采用如扇出型封裝、2.5D/3D封裝等先進(jìn)封裝技術(shù),實(shí)現(xiàn)光電器件與電子器件在空間上的緊密布局,縮短信號(hào)傳輸距離,降低信號(hào)傳輸損耗與延遲。在數(shù)據(jù)中心的光模塊中,利用先進(jìn)封裝將光發(fā)射、接收芯片與電信號(hào)處理芯片集成在一起,形成高度集成的光電混合模塊,提高模塊性能與可靠性,同時(shí)減小體積,降低成本,推動(dòng)光電混合集成技術(shù)在數(shù)據(jù)通信、高性能計(jì)算等領(lǐng)域的實(shí)際應(yīng)用與產(chǎn)業(yè)化發(fā)展。
硅基憑借優(yōu)異兼容性與成熟工藝,成為功能融合最優(yōu)襯底,而微電子先進(jìn)封裝技術(shù),更是突破光電共封瓶頸的核心引擎。中國(guó)科學(xué)院微電子研究所劉豐滿(mǎn)研究員,提出硅基光電混合集成三大核心趨勢(shì):一是多種先進(jìn)封裝技術(shù)被用于光子集成,允許所有封裝共存;二是晶圓級(jí)封裝成為關(guān)鍵抓手,推動(dòng)“大系統(tǒng)光進(jìn)銅退”進(jìn)程向封裝層級(jí)深度滲透;三是“單片異質(zhì)集成+封裝異構(gòu)集成”雙輪驅(qū)動(dòng),實(shí)現(xiàn)跨維度融合。同時(shí),依托華進(jìn)半導(dǎo)體與國(guó)家集成電路特色工藝及封裝測(cè)試創(chuàng)新中心,建成8/12吋兼容的晶圓級(jí)先進(jìn)封裝中試線和配套封裝產(chǎn)線,其中TSV Interposer、Fanout和FCBGA等成熟產(chǎn)品的產(chǎn)能分別為1000片/月、600片/月和100萬(wàn)顆/月,為產(chǎn)業(yè)發(fā)展筑牢制造根基。
東南大學(xué)教授王俊嘉在報(bào)告中指出,團(tuán)隊(duì)聚焦硅基光電子異質(zhì)集成芯片關(guān)鍵技術(shù)突破,開(kāi)展石墨烯熱光調(diào)制器、電光調(diào)制器,鐵電薄膜調(diào)制器,薄膜鈮酸鋰黑磷光電探測(cè)器,石墨烯光電探測(cè)器及黑磷光源等系列研究。這些技術(shù)突破構(gòu)建起自主可控的硅基光電芯片集成工藝平臺(tái)底層支撐,可廣泛賦能硅基光電器件與芯片制造,兼具科學(xué)探索深度與產(chǎn)業(yè)應(yīng)用價(jià)值,為硅基光電集成技術(shù)規(guī)模化發(fā)展筑牢根基。
先進(jìn)封裝與互聯(lián)技術(shù)在異質(zhì)異構(gòu)集成中的應(yīng)用是本次會(huì)議討論的熱點(diǎn)。通過(guò)如硅通孔(TSV)、玻璃通孔(TGV)、重分布層(RDL)以及微凸點(diǎn)(micro-bump)等關(guān)鍵技術(shù),能夠?qū)崿F(xiàn)不同芯片和器件之間在垂直與水平方向上的高效連接與協(xié)同工作。硅通孔和玻璃通孔技術(shù)分別使用硅和玻璃材料制造通孔,作為芯片間的電連接通道,突破了傳統(tǒng)二維互聯(lián)方式的局限;重分布層技術(shù)則通過(guò)在芯片表面添加額外的互聯(lián)層,優(yōu)化信號(hào)傳輸路徑,提升集成度和性能;微凸點(diǎn)技術(shù)則在芯片之間建立微小的凸點(diǎn)連接,實(shí)現(xiàn)更加緊湊和高效的模塊組合。國(guó)內(nèi)的長(zhǎng)電科技、通富微電等企業(yè)在這些先進(jìn)封裝與互聯(lián)技術(shù)上不斷創(chuàng)新,取得了長(zhǎng)足進(jìn)步,有力推動(dòng)了異質(zhì)異構(gòu)集成技術(shù)的產(chǎn)業(yè)化應(yīng)用。

二、功率與射頻領(lǐng)域的異質(zhì)異構(gòu)集成探索
在摩爾定律漸近極限的當(dāng)下,功率與射頻領(lǐng)域正經(jīng)歷技術(shù)革新的關(guān)鍵轉(zhuǎn)折。傳統(tǒng)單一材料與工藝的集成模式,已難以滿(mǎn)足5G/6G通信、先進(jìn)雷達(dá)系統(tǒng)及智能終端對(duì)高性能、小型化的嚴(yán)苛需求。異質(zhì)異構(gòu)集成技術(shù)通過(guò)將硅基、Ⅲ-Ⅴ族(如GaN、SiC)等不同材料體系的器件與電路跨工藝融合,突破物理性能瓶頸。從通信基站的射頻前端集成,到新能源汽車(chē)的功率電子系統(tǒng),這一技術(shù)正以跨學(xué)科融合的創(chuàng)新邏輯,重構(gòu)從材料設(shè)計(jì)到系統(tǒng)級(jí)應(yīng)用的全鏈條技術(shù)體系,成為驅(qū)動(dòng)功率與射頻領(lǐng)域向更高效率、更優(yōu)性能演進(jìn)的核心引擎。

(1)氮化鎵集成:發(fā)揮氮化鎵材料優(yōu)勢(shì)
氮化鎵憑借其高功率密度、高效率、高電子遷移率等卓越性能,在半導(dǎo)體領(lǐng)域備受關(guān)注。氮化鎵單片集成致力于將氮化鎵基的各類(lèi)器件,如高電子遷移率晶體管(HEMT)、二極管等集成在同一氮化鎵襯底上。在工藝上,攻克了氮化鎵外延生長(zhǎng)的均勻性、器件間隔離等難題,實(shí)現(xiàn)了高密度、高性能的單片集成。相較于傳統(tǒng)硅基功率器件,氮化鎵單片集成器件在高頻、高功率應(yīng)用中展現(xiàn)出更低的導(dǎo)通電阻、更快的開(kāi)關(guān)速度,可廣泛應(yīng)用于5G基站功率放大器、快充電源、射頻雷達(dá)等領(lǐng)域,有效提升系統(tǒng)性能與能效。
氮化鎵器件在高低壓及集成化方向的研究對(duì)突破現(xiàn)有技術(shù)瓶頸、拓展應(yīng)用場(chǎng)景(如新能源汽車(chē)、光伏、AI等)至關(guān)重要。GaN-on-SiC在高壓領(lǐng)域的性能優(yōu)勢(shì)使其成為重點(diǎn)發(fā)展方向,而AI等新興領(lǐng)域?yàn)榈蛪篏aN帶來(lái)機(jī)遇。異構(gòu)集成與單片集成是提升器件性能、滿(mǎn)足系統(tǒng)級(jí)需求的關(guān)鍵路徑,通過(guò)技術(shù)互補(bǔ)實(shí)現(xiàn)電子系統(tǒng)的優(yōu)化。西安電子科技大學(xué)教授張葦杭提到西電廣州第三代半導(dǎo)體創(chuàng)新中心,建立了完善的中試驗(yàn)證服務(wù)平臺(tái),為第三代半導(dǎo)體技術(shù)從研發(fā)到產(chǎn)業(yè)化提供了關(guān)鍵支撐,加速技術(shù)轉(zhuǎn)化與產(chǎn)業(yè)升級(jí),對(duì)我國(guó)第三代半導(dǎo)體產(chǎn)業(yè)發(fā)展具有重要戰(zhàn)略意義。
為滿(mǎn)足高性能芯片設(shè)計(jì)需求,PDK技術(shù)正朝著更小工藝節(jié)點(diǎn)邁進(jìn),以提升器件集成度與性能,同時(shí)加強(qiáng)與三維集成、碳化硅基氮化鎵等新型工藝材料的融合。湖北九峰山實(shí)驗(yàn)室無(wú)線領(lǐng)域首席專(zhuān)家吳暢也指出,GaN-on-Si憑借成本低、CMOS兼容等優(yōu)勢(shì),可實(shí)現(xiàn)先進(jìn)集成應(yīng)用,覆蓋未來(lái)小型化,低功耗,高能量密度場(chǎng)景,在5G基站、手機(jī)終端和通信中潛力巨大。吳首席表示,九峰山實(shí)驗(yàn)室于2025年1月正式對(duì)外發(fā)布的基于6英寸平臺(tái)的0.1μm GaN-on-Si PDK,可實(shí)現(xiàn)國(guó)內(nèi)RF GaN-on-Si技術(shù)重要布局。此外,JFS提出了國(guó)內(nèi)首套面向Ka頻段以上的GaN-on-Si解決方案。目前已完成100 nm硅基氮化鎵工藝及器件和PDK的完整開(kāi)發(fā)。

(2)毫米波三維異質(zhì)異構(gòu)集成:推動(dòng)5G及未來(lái)通信發(fā)展
在5G全面普及與6G探索不斷深入的背景下,毫米波頻段成為通信技術(shù)演進(jìn)的核心戰(zhàn)場(chǎng)。毫米波三維異質(zhì)異構(gòu)集成技術(shù)通過(guò)三維堆疊與異質(zhì)集成,將毫米波射頻芯片、基帶處理芯片、電源管理芯片等功能各異的芯片有機(jī)組合。依托先進(jìn)的硅通孔(TSV)技術(shù),芯片間實(shí)現(xiàn)垂直方向的高速互聯(lián),大幅縮短信號(hào)傳輸路徑,顯著降低傳輸損耗與延遲;同時(shí),通過(guò)精準(zhǔn)選擇襯底材料和創(chuàng)新封裝技術(shù),有效抑制信號(hào)干擾,全面提升毫米波通信系統(tǒng)的性能表現(xiàn)。這種集成方案不僅助力5G基站實(shí)現(xiàn)小型化、輕量化目標(biāo),顯著提升通信容量與速率,更為未來(lái)6G復(fù)雜通信場(chǎng)景與功能的實(shí)現(xiàn)筑牢技術(shù)根基。
憑借頻譜資源豐富、器件尺寸小、傳輸速率高等顯著優(yōu)勢(shì),毫米波頻段已廣泛應(yīng)用于5G通信、自動(dòng)駕駛雷達(dá)、生物醫(yī)療等前沿領(lǐng)域。上海交通大學(xué)電子信息與電氣工程學(xué)院副院長(zhǎng)周亮在報(bào)告中指出,通過(guò)異質(zhì)生長(zhǎng)或異質(zhì)鍵合等方式,可將GaAs、GaN、InP等化合物半導(dǎo)體(CS)材料的高性能有源器件,以及RF MEMS、IPD等高性能無(wú)源器件,與硅基低成本、高集成度、高復(fù)雜度的數(shù)字/模擬/混合電路模塊,集成為一個(gè)完整的2維至3維毫米波集成電路。并強(qiáng)調(diào),當(dāng)前摩爾定律正面臨極限挑戰(zhàn),轉(zhuǎn)折點(diǎn)日益臨近,而異質(zhì)集成技術(shù)將為我國(guó)集成電路產(chǎn)業(yè)實(shí)現(xiàn)變道超車(chē)發(fā)展提供歷史性機(jī)遇。

三、集成技術(shù)與關(guān)鍵工藝的探討
集成技術(shù)與關(guān)鍵工藝作為異質(zhì)異構(gòu)集成的基石,其每一次創(chuàng)新都深刻影響著半導(dǎo)體產(chǎn)業(yè)格局。無(wú)論是晶圓鍵合面臨的大尺寸挑戰(zhàn)與化合物半導(dǎo)體適配難題,還是微轉(zhuǎn)印集成技術(shù)帶來(lái)的靈活創(chuàng)新可能,都成為科研與產(chǎn)業(yè)界競(jìng)相探索的前沿領(lǐng)域。
(1)大尺寸晶圓鍵合與化合物半導(dǎo)體晶圓鍵合:實(shí)現(xiàn)晶圓級(jí)集成
晶圓鍵合是實(shí)現(xiàn)異質(zhì)異構(gòu)集成的關(guān)鍵工藝之一。大尺寸晶圓鍵合面臨著鍵合均勻性、應(yīng)力控制等挑戰(zhàn)。隨著晶圓尺寸增大,鍵合過(guò)程中不同區(qū)域的溫度、壓力均勻性難以保證,容易導(dǎo)致鍵合強(qiáng)度不一致、產(chǎn)生應(yīng)力集中,影響集成芯片性能。在化合物半導(dǎo)體晶圓鍵合方面,由于化合物半導(dǎo)體材料特性與硅基材料不同,如晶格常數(shù)、熱膨脹系數(shù)差異,使得鍵合工藝更為復(fù)雜。在九峰山論壇上,相關(guān)企業(yè)與科研機(jī)構(gòu)分享了通過(guò)優(yōu)化鍵合工藝參數(shù),如采用低溫鍵合技術(shù)減少熱應(yīng)力影響,以及開(kāi)發(fā)新的鍵合材料與界面處理方法,提升化合物半導(dǎo)體晶圓鍵合質(zhì)量,為大規(guī)模、高性能異質(zhì)異構(gòu)集成提供可靠的工藝基礎(chǔ)。
在半導(dǎo)體產(chǎn)業(yè)的后摩爾時(shí)代,晶圓鍵合與減薄作為關(guān)鍵共性技術(shù),于芯片先進(jìn)封裝、MEMS傳感器、功率電源及光電子芯片等領(lǐng)域展現(xiàn)出重大產(chǎn)業(yè)化價(jià)值。甬江實(shí)驗(yàn)室功能材料與器件異構(gòu)集成研究中心主任萬(wàn)青,成功發(fā)明低成本室溫臨時(shí)鍵合技術(shù)。該技術(shù)可實(shí)現(xiàn)大尺寸(6-12英寸)單晶硅、鈮酸鋰/鉭酸鋰晶圓與玻璃、硅片襯底間的平整鍵合,為相關(guān)領(lǐng)域的技術(shù)革新與產(chǎn)業(yè)發(fā)展提供了有力支撐。

(2)微轉(zhuǎn)印集成技術(shù):提供靈活集成方案
微轉(zhuǎn)印集成技術(shù)為異質(zhì)異構(gòu)集成提供了一種靈活且高效的手段。該技術(shù)可以將不同材料、不同尺寸的微小芯片或器件,通過(guò)特殊的轉(zhuǎn)印工藝精確放置在目標(biāo)襯底上預(yù)定位置。與傳統(tǒng)的光刻、刻蝕等集成工藝相比,微轉(zhuǎn)印集成技術(shù)不受光刻分辨率限制,能夠?qū)崿F(xiàn)更精細(xì)、更復(fù)雜的集成結(jié)構(gòu)。在制備包含多種功能芯片的系統(tǒng)級(jí)封裝時(shí),可利用微轉(zhuǎn)印技術(shù)將預(yù)先制備好的各類(lèi)芯片精準(zhǔn)轉(zhuǎn)移集成,大大縮短制備周期,提高生產(chǎn)效率,且能更好地適應(yīng)小批量、多品種的產(chǎn)品需求,為新型芯片集成設(shè)計(jì)與制造提供了創(chuàng)新思路。
上海大學(xué)副教授葉楠團(tuán)隊(duì)創(chuàng)新突破,提出微轉(zhuǎn)印集成技術(shù),憑借高集成密度、高有源材料利用率及高對(duì)準(zhǔn)精度,攻克傳統(tǒng)工藝瓶頸。開(kāi)發(fā)無(wú)栓繩微轉(zhuǎn)印方法,省去額外栓繩成型與斷裂工序,實(shí)現(xiàn)硅基異質(zhì)芯粒集成Ⅲ-Ⅴ族雪崩光電探測(cè)器。實(shí)測(cè)集成器件帶寬達(dá)4GHz,暗電流13nA(@-13V),性能逼近原器件,為硅光異構(gòu)集成光電探測(cè)技術(shù)規(guī)模化應(yīng)用筑牢根基,推動(dòng)光電融合向高效、緊湊方向進(jìn)階。
中國(guó)電子科技集團(tuán)公司第五十五研究所高級(jí)工程師王宇軒團(tuán)隊(duì)在報(bào)告中提出,器件制備方面依托本所固態(tài)微波國(guó)家重點(diǎn)實(shí)驗(yàn)室與芯谷高頻平臺(tái),已建成4英寸化合物半導(dǎo)體晶圓加工產(chǎn)線。通過(guò)對(duì)化合物半導(dǎo)體器件微轉(zhuǎn)印集成初步探索,明確未來(lái)將向更高工程化水平邁進(jìn),朝著更優(yōu)性能器件、多材料融合、多功能融合、多集成手段融合的芯片方向持續(xù)發(fā)展,為構(gòu)建自主可控先進(jìn)異質(zhì)異構(gòu)集成技術(shù)體系筑牢根基 。

四、總結(jié)
在當(dāng)今半導(dǎo)體產(chǎn)業(yè)蓬勃發(fā)展的進(jìn)程中,異質(zhì)異構(gòu)集成技術(shù)正逐漸嶄露頭角,成為突破摩爾定律極限的關(guān)鍵力量。其通過(guò)跨材料與跨工藝的深度交融與協(xié)同創(chuàng)新,正引領(lǐng)全球產(chǎn)業(yè)變革的浪潮,推動(dòng)著產(chǎn)業(yè)向更高效、更先進(jìn)的方向邁進(jìn)。在光電子領(lǐng)域,硅光芯片、異質(zhì)集成激光器及TSV等先進(jìn)封裝技術(shù),突破帶寬與集成度瓶頸,加速6G、AI場(chǎng)景下高速光互聯(lián)應(yīng)用的落地。功率與射頻領(lǐng)域,GaN-on-SiC/Si技術(shù)憑借高效能優(yōu)勢(shì),廣泛滲透至5G基站、新能源汽車(chē)等場(chǎng)景;毫米波三維異質(zhì)集成通過(guò)TSV互聯(lián)實(shí)現(xiàn)芯片堆疊,為5G基站小型化與6G通信技術(shù)奠定基礎(chǔ)。集成工藝方面,大尺寸晶圓鍵合與微轉(zhuǎn)印技術(shù)突破材料兼容性與工藝精度挑戰(zhàn),為復(fù)雜系統(tǒng)級(jí)封裝提供關(guān)鍵支撐。
未來(lái),隨著異質(zhì)異構(gòu)集成技術(shù)的不斷成熟與完善,其勢(shì)必將引發(fā)6G通信、智能汽車(chē)、量子計(jì)算等戰(zhàn)略領(lǐng)域的新一輪技術(shù)革命。這不僅將重塑全球半導(dǎo)體產(chǎn)業(yè)的競(jìng)爭(zhēng)格局,還將對(duì)整個(gè)信息產(chǎn)業(yè)的發(fā)展產(chǎn)生廣泛而深遠(yuǎn)的影響。在此背景下,中國(guó)正以自主創(chuàng)新為核心驅(qū)動(dòng)力,積極凝聚產(chǎn)業(yè)共識(shí),匯聚各方力量,推動(dòng)半導(dǎo)體行業(yè)從 “跟跑” 向 “領(lǐng)跑” 奔邁跨越,在全球半導(dǎo)體產(chǎn)業(yè)變革的宏大舞臺(tái)上,書(shū)寫(xiě)著獨(dú)具特色的中國(guó)方案,為世界半導(dǎo)體產(chǎn)業(yè)的多元化、均衡化發(fā)展貢獻(xiàn)著不可或缺的中國(guó)智慧與力量。
-
芯片
+關(guān)注
關(guān)注
463文章
54275瀏覽量
468312 -
化合物半導(dǎo)體
+關(guān)注
關(guān)注
2文章
19瀏覽量
4096
發(fā)布評(píng)論請(qǐng)先 登錄
2.5D封裝關(guān)鍵技術(shù)的研究進(jìn)展

青禾晶元常溫鍵合方案,破解第三代半導(dǎo)體異質(zhì)集成熱損傷難題
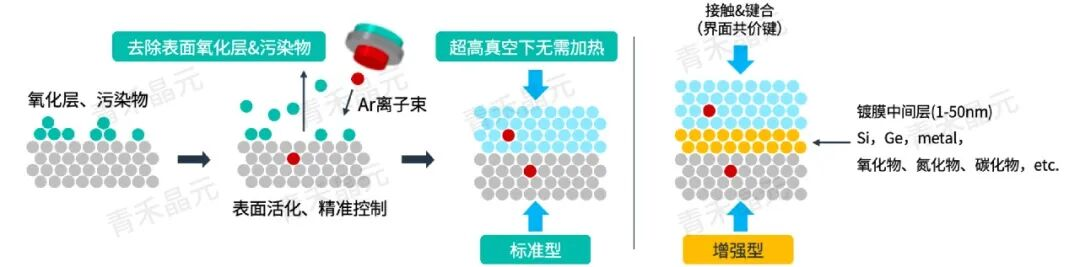
躍昉科技受邀出席第四屆HiPi Chiplet論壇

華大九天Argus 3D重塑3D IC全鏈路PV驗(yàn)證新格局

巨霖科技分享國(guó)產(chǎn)SI仿真工具的破局之道

九同方:EDA工具“單點(diǎn)登頂”與產(chǎn)業(yè)鏈協(xié)同,方能破局行業(yè)內(nèi)卷

【2025九峰山論壇】從材料革命到制造工藝破局,揭秘化合物半導(dǎo)體產(chǎn)業(yè)重構(gòu)密碼

CSEAC 2025:從原子級(jí)制造到鍵合集成,國(guó)產(chǎn)設(shè)備的 “高端局”
當(dāng)摩爾定律 “踩剎車(chē)” ,三星 、AP、普迪飛共話半導(dǎo)體制造新變革新機(jī)遇

晶心科技:摩爾定律放緩,RISC-V在高性能計(jì)算的重要性突顯

行芯科技亮相2025世界半導(dǎo)體博覽會(huì)
聚焦2025中國(guó)(深圳)集成電路峰會(huì)——匯聚灣區(qū)智慧,共探產(chǎn)業(yè)破局之道

電力電子中的“摩爾定律”(1)




 【2025九峰山論壇】破局摩爾定律:異質(zhì)異構(gòu)集成如何撬動(dòng)新賽道?
【2025九峰山論壇】破局摩爾定律:異質(zhì)異構(gòu)集成如何撬動(dòng)新賽道?




評(píng)論