芯片封裝是將芯片封裝在外部保護殼體內的過程,通常包括以下步驟:
準備工作:包括準備封裝材料(封裝膠、封裝蓋板等)、準備好的芯片、引腳、基板等。
粘合:將芯片粘合到封裝基板上。通常使用導熱膠或其他粘合劑將芯片固定在基板上。
導線鍵合:將芯片引腳與基板上的連接點用金線或鋁線等進行焊接連接。這一步驟通常稱為鍵合(wire bonding)。
封裝膠注入:將封裝膠注入到封裝基板和芯片之間,以保護芯片并提高封裝的強度。
固化:對封裝膠進行固化處理,使其變硬并固定芯片和引腳。
封裝蓋板安裝:將封裝蓋板安裝到封裝基板上,用以保護芯片和封裝膠。
測試:對封裝后的芯片進行測試,以確保其功能正常。
清潔和包裝:清潔封裝后的芯片,然后進行包裝,以便存儲和運輸。
這些步驟通常是芯片封裝過程中的基本步驟,不同類型的封裝可能會有一些額外的步驟或細節處理。
審核編輯:劉清
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片封裝
+關注
關注
13文章
614瀏覽量
32262
原文標題:知識科普 | 芯片封裝的封裝步驟
文章出處:【微信號:兆億微波,微信公眾號:兆億微波】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦




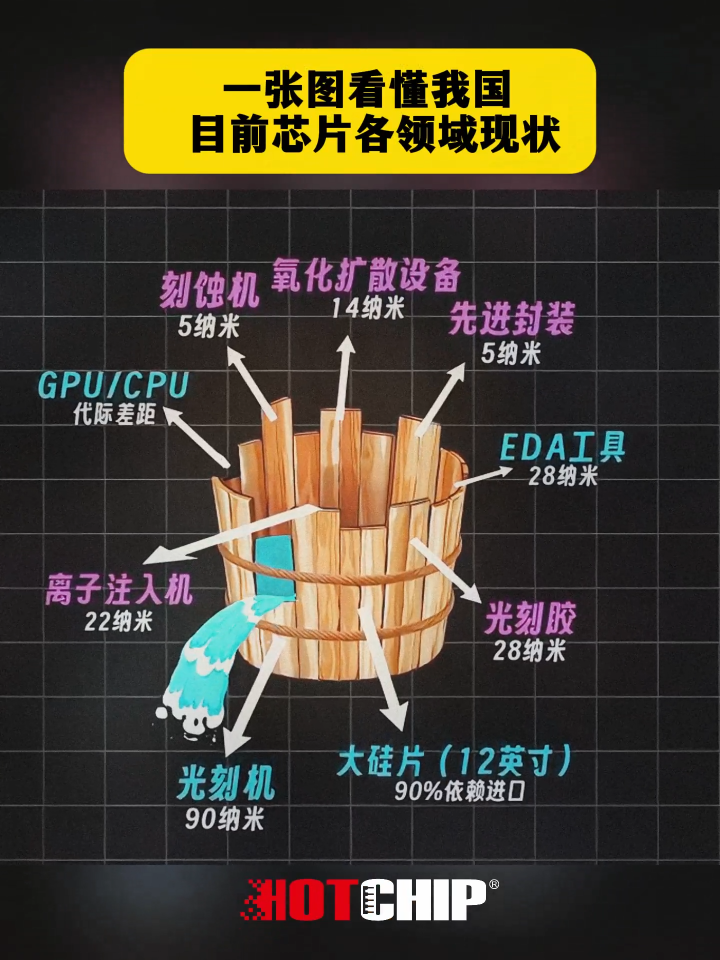


芯片封裝工藝詳解
封裝工藝正從傳統保護功能向系統級集成演進,其核心在于平衡電氣性能、散熱效率與制造成本?。 一、封裝工藝的基本概念 芯片封裝是將半導體芯片通過
如何制定芯片封裝方案
封裝方案制定是集成電路(IC)封裝設計中的關鍵環節,涉及從芯片設計需求出發,制定出滿足功能、電氣性能、可靠性及成本要求的封裝方案。這個過程的核心是根據不同產品的特性、應用場景和生產工藝
制定芯片封裝方案的主要步驟和考慮因素
封裝方案制定是集成電路(IC)封裝設計中的關鍵環節,涉及從芯片設計需求出發,制定出滿足功能、電氣性能、可靠性及成本要求的封裝方案。這個過程的核心是根據不同產品的特性、應用場景和生產工藝

封裝基板設計的詳細步驟
封裝基板設計是集成電路封裝工程中的核心步驟之一,涉及將芯片與外部電路連接的基板(substrate)設計工作。基板設計不僅決定了芯片與外部電



 芯片封裝的封裝步驟
芯片封裝的封裝步驟







評論