季豐MA實驗室目前擁有Talos系列透射電鏡和HF5000球差矯正透射電鏡,具有納米材料與結構的亞原子尺度分析能力,同時多位博士領銜的工程師團隊具有豐富的半導體行業材料分析經驗,能為客戶提供非常全面的TEM解決方案。
EELS基本原理簡介
電子能量損失譜(EELS)是一種通過分析高能入射電子與材料原子發生非彈性碰撞后能量損失特征的先進表征技術,可用于獲取材料的成分、化學態及電子結構信息。其在芯片工藝研發和失效分析中具有獨特優勢,尤其在納米尺度下可對芯片工藝結構中的材料成分如原子比和摻雜、元素種類和價態、材料禁帶寬度和介電常數等進行精細分析。
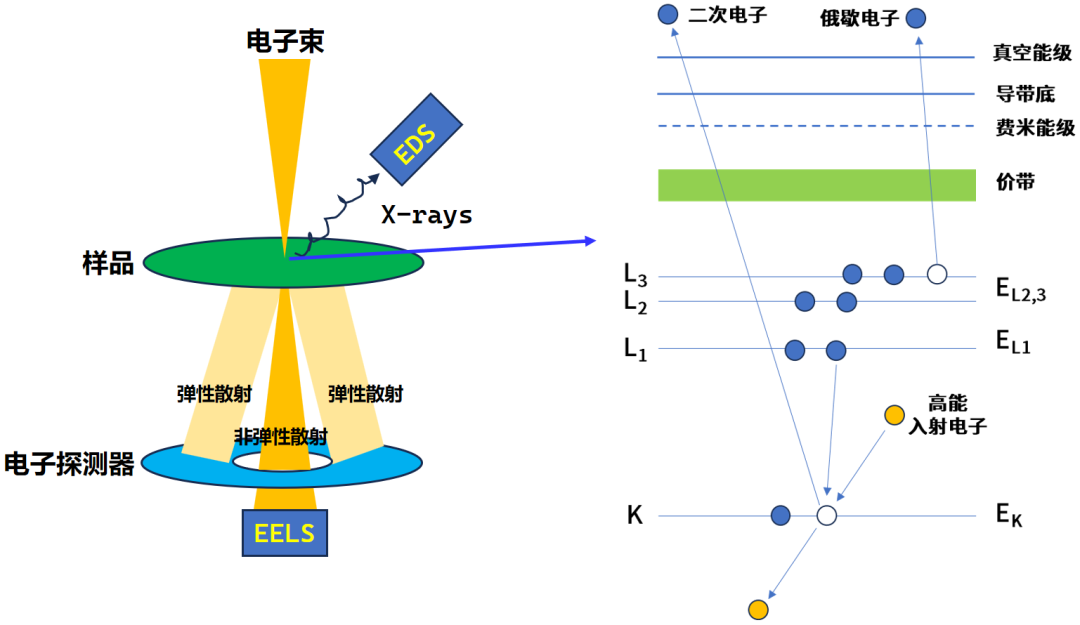
▲圖一
電子束與樣品原子作用過程
電子與樣品相互作用時,能量損失主要分為:
低能損失區(0-50 eV):
對應入射電子誘導的等離子體激發、帶間躍遷等,可反映材料的介電性質和載流子濃度。其中等離子體峰也叫指紋峰,因相同元素組成但價態不同的材料的等離子體峰有各自不同的峰形和峰位。
芯損失區(>50 eV):
對應內殼層電子的電離,形成元素特征電離邊(如K、L邊),這些電離邊的形狀和位置與元素的多少、種類和價態有關,可用于元素鑒別、成分定量和價態分析等。
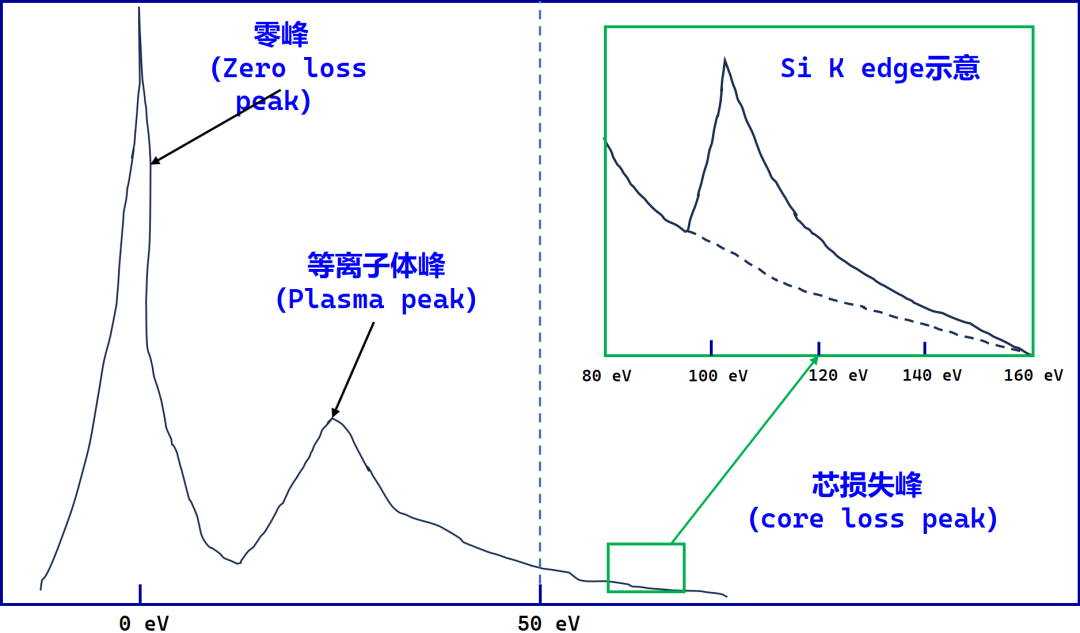
▲圖二
EELS譜的構成:零峰、低損失峰(等離子體峰)和芯損失峰
EELS的主要應用
1元素鑒別
目前半導體工業界最常用的檢測元素的電子顯微鏡技術是EDS分析,半導體工藝涉及的元素種類非常多,包含金屬如W、Al、Cu、Au、Fe、Ti、Ta、Hf、Co、Ni、Ge、Ga、Ag、Pt等和非金屬元素如B、C、N、O、F、Si、P、S、Cl、Ar等,其中很多小原子序數的非金屬元素的特征X射線產額低,且易被探測器窗口(如鈹窗)吸收,導致信號弱、背景噪聲高,定性和定量分析均很困難。輕元素的K層或L層電離邊通常出現在低能量范圍(如碳的K邊約280 eV)。
EELS在低能量損失區域(通常<2000 eV)具有非常高的能量分辨率(可優于1 eV)和靈敏度,能夠清晰分辨這些電離邊,彌補EDS的較差能量分辨率(一般差于120 eV)的不足,因此EELS成為材料科學、納米技術等領域中輕元素分析的強有力工具。
EDS在重元素檢測中更優,而EELS彌補了輕元素分析的短板。兩者結合可在寬元素范圍內提供全面分析。

▲表一
TEM中的EDS和EELS技術對比
2摻雜檢測
EELS分析系統中的電子探測器(相機)能顯著影響EELS譜圖質量如信背比和信號收集速率等。直接電子探測器(Direct Electron Detection,DED)是近年來發展起來的一種電子探測器,相比傳統的電荷耦合元件(CCD)和互補金屬氧化物半導體(CMOS)電子探測器
DED的核心優勢包括:
(1)單電子靈敏度:直接轉換電子為電信號,避免傳統CCD中光轉換導致的信號損失;
(2)高信噪比(SNR):在低電子劑量下仍保持低噪聲,適合輻照敏感樣品;
(3)高動態范圍與快速讀出:支持高劑量下的微弱信號檢測,并減少掃描時間,降低樣品漂移影響。
配備有DED的EELS可用于低濃度摻雜如As、P等的檢測,以及分析電子束敏感材料(采用非常低的電子劑量)。
3價態分析:化學環境與鍵合狀態解析
元素的近邊精細結構(ELNES)反映元素局域化學環境,例如過渡金屬如Co、Fe的L邊峰形和能量位移可表征其氧化態。高能入射電子電離過渡金屬元素時,內殼層電子(如2p電子)被激發,會躍遷到導帶中大量未占據的態(如d軌道),導致在電離邊處形成較強的尖峰,即所謂白線,同種元素不同價態的白線強度不同,且會存在化學位移,從而可以用于價態分析;

4EELS定量分析
材料中不同原子的EELS的芯損失峰強度與原子占比有關,可以用于較精確的成分定量。EELS定量原理可用下列公式表示[1]:

其中NA和NB分別是原子數目,IA和IB分別是電子強度(芯損失峰積分面積),Δ是窗口大小,Β散射角度,σ散射截面,η是探測器效率。
通過去卷積處理消除儀器點擴散函數產生的展寬效應,結合電離邊積分強度與散射截面可以計算元素占比,適用于輕元素定量,如3D NAND存儲器件的浮柵中N含量監控,功函數材料TiN中的Ti/N原子比,以及應變Si技術中常用GeSi材料的Ge/Si原子比。
5禁帶寬度測量
低能損失區中靠近零峰的平坦區域表示材料中不存在能使入射電子產生該能量損失值的電子態,也即對應材料能帶中的禁帶區域,從而根據低能損失區的電子躍遷特征(如帶間躍遷閾值)可推算材料禁帶寬度。
6能量過濾像(Energy filtered TEM)
利用能量過濾器篩選電子束中具有特定能量損失(如O 的K邊和Si的L邊)的電子進行TEM成像,快速獲取樣品中各個元素的獨立分布圖像,可實現對材料成分、化學態和元素分布的原子尺度分析。
利用零損失峰形成的HR-EFTEM相比普通HRTEM圖像,過濾掉相干性較差的非彈性散射電子,圖像信噪比更好,空間分辨率更高。
EFTEM相比EELS效率高很多,獲取一個STEM-EELS mapping需要的時間約為5分鐘,且需要更長的時間進行數據處理,而采集一張EFTEM圖像花費的時間為2-20s,非常適合大批量篩查芯片工藝過程中的異常成分和形貌。
季豐電子
季豐電子成立于2008年,是一家聚焦半導體領域,深耕集成電路檢測相關的軟硬件研發及技術服務的賦能型平臺科技公司。公司業務分為四大板塊,分別為基礎實驗室、軟硬件開發、測試封裝和儀器設備,可為芯片設計、晶圓制造、封裝測試、材料裝備等半導體產業鏈和新能源領域公司提供一站式的檢測分析解決方案。
季豐電子通過國家級專精特新“小巨人”、國家高新技術企業、上海市“科技小巨人”、上海市企業技術中心、研發機構、公共服務平臺等企業資質認定,通過了ISO9001、 ISO/IEC17025、CMA、CNAS、IATF16949、ISO/IEC27001、ISO14001、ISO45001、ANSI/ESD S20.20等認證。公司員工超1000人,總部位于上海,在浙江、北京、深圳、成都等地設有子公司。
-
半導體
+關注
關注
339文章
30977瀏覽量
265385 -
顯微鏡
+關注
關注
0文章
762瀏覽量
25535 -
電子束
+關注
關注
2文章
135瀏覽量
14054
原文標題:透射電子顯微鏡(TEM)中的EELS分析技術
文章出處:【微信號:zzz9970814,微信公眾號:上海季豐電子】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
PONY譜尼測試提供專業電子檢測服務
常見能量收集技術
射頻能量采集技術的全面介紹
如何利用仿真研究無線能量傳輸技術?
激光器系統能量損失的克服方法介紹
電鏡技術中四維電子能量損失譜
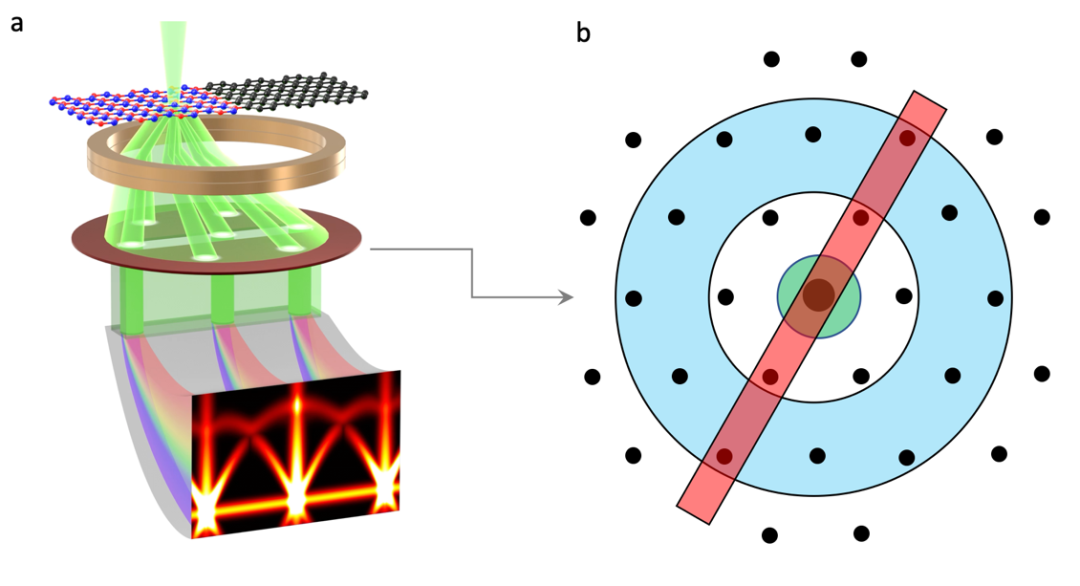
振動光譜的前景
透射電子顯微鏡(TEM)與聚焦離子束技術(FIB)在材料分析中的應用




 電子能量損失譜(EELS)技術解析
電子能量損失譜(EELS)技術解析

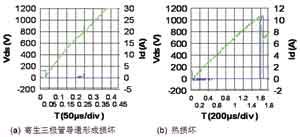




評論