掃描電子顯微鏡(SEM)與聚焦離子束(FIB)結合形成的雙束系統,是現代微納加工與材料分析領域中一種高度集成的多功能儀器平臺。該系統通過在同一真空腔體內集成電子束與離子束兩套獨立的成像與加工系統,實現了對樣品從微觀觀測到納米級加工的全流程操控。
SEM/FIB雙束系統不僅具備高分辨成像能力,還能進行精確的刻蝕、沉積、注入和截面制備,因此在半導體失效分析、材料科學研究、生物樣品制備及納米器件加工等方面具有不可替代的作用。
什么是SEM/FIB雙束系統
SEM/FIB雙束系統是一種集多種功能于一體的高端分析儀器。其中,FIB部分是將離子源產生的離子束經過離子槍聚焦、加速后作用于樣品表面,實現離子的成像、注入、刻蝕和沉積等功能。離子源的種類多樣,大多數FIB采用Ga源,但也有Xe、He等離子源可供選擇,不同的離子源在特定應用中各有優勢。
截面分析的應用與優勢
1. 截面分析的流程
針對材料領域,涵蓋各個環節,滿足客戶多元化的需求,如需專業檢測服務金鑒檢測顧問188-1409-6302。截面分析是SEM/FIB系統最典型的應用之一,其基本流程包括:
(1)定位與標記:在SEM模式下識別目標區域,必要時使用電子束或低束流FIB進行標記。
(2)保護層沉積:通常在待分析區域表面沉積一層Pt或W保護層,以防止離子束損傷表面結構。
(3)粗加工與精修:首先使用較高束流(如幾nA至幾十nA)快速刻蝕出截面輪廓,再逐步降低束流(至幾百pA甚至幾十pA)進行拋光,以獲得平整的觀測面。
(4)SEM成像與分析:將樣品傾轉至最佳觀測角度(通常為52°–54°),利用高分辨率SEM對截面形貌進行成像,并可結合EDS或EBSD進行成分與晶體結構分析。
2.技術優勢
(1)高定位精度:得益于SEM的高分辨成像能力,可在微米甚至納米尺度精確定位目標區域。(2)
低應力損傷:
FIB加工過程可控性強,對周圍材料影響小,尤其適用于脆性材料與多層結構。
(3)
截面完整性好:
能夠保持原始結構的形貌與界面信息,便于真實反映材料或器件的內部狀態。
3. 典型應用場景
(1)
半導體芯片檢測:
用于觀察晶體管柵極結構、金屬互聯層厚度、通孔形貌、介質層完整性等,是失效分析和工藝驗證的關鍵手段。
(2)
材料科學研究:
可用于分析涂層與基體界面、晶界結構、析出相分布、復合材料界面結合狀態等。為了方便大家對材料進行深入的失效分析及研究,金鑒實驗室具備Dual Beam FIB-SEM業務,包括透射電鏡(TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。
(3)
生物樣品制備:
如細胞、組織的截面制備,用于后續掃描電鏡或透射電鏡觀察。
總結
SEM/FIB雙束系統在微觀分析領域具有重要的地位,其截面分析功能為芯片檢測、材料分析等眾多領域提供了強大的技術支持。
-
SEM
+關注
關注
0文章
274瀏覽量
15678 -
fib
+關注
關注
1文章
128瀏覽量
11756 -
電子顯微鏡
+關注
關注
1文章
126瀏覽量
10655 -
離子束
+關注
關注
0文章
113瀏覽量
8100
發布評論請先 登錄
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構
SEM/FIB雙束系統截面加工:實現離子的成像、注入、刻蝕和沉積

納米加工技術的核心:聚焦離子束及其應用
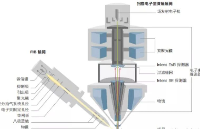



 SEM/FIB雙束系統及其截面加工技術
SEM/FIB雙束系統及其截面加工技術

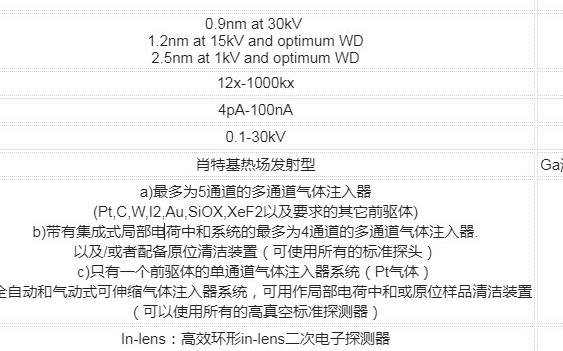
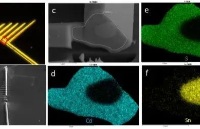
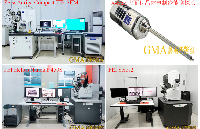
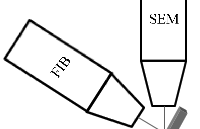
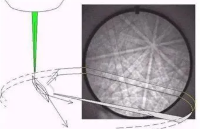
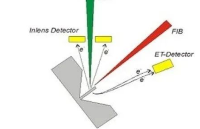





評論