聚焦離子束技術(shù)
聚焦離子束(Focused Ion Beam, FIB)技術(shù)作為現(xiàn)代半導(dǎo)體失效分析的核心手段之一,通常與掃描電子顯微鏡(Scanning Electron Microscope, SEM)集成,形成雙束系統(tǒng)。該系統(tǒng)能夠在微納米尺度上對(duì)芯片樣品進(jìn)行精確加工與高分辨率成像,是定位失效點(diǎn)、分析失效機(jī)理的重要工具。FIB的主要功能包括刻蝕、沉積和成像三個(gè)方面,下面將對(duì)各功能的技術(shù)原理進(jìn)行展開(kāi)說(shuō)明。
1. 刻蝕功能基于物理濺射原理。當(dāng)高能離子束聚焦并轟擊樣品表面時(shí),離子與材料原子發(fā)生碰撞,使表面原子被濺射脫離,從而實(shí)現(xiàn)材料的精準(zhǔn)去除。這一過(guò)程可用于剝離芯片表面的鈍化層或封裝外殼,暴露出下層金屬線(xiàn)路或介質(zhì)結(jié)構(gòu),便于后續(xù)觀(guān)察與分析。
2. 沉積功能則通過(guò)引入特殊氣體實(shí)現(xiàn)。在離子束照射區(qū)域,通入金屬有機(jī)氣體(如含鉑或鎢的前驅(qū)體氣體),高能離子誘發(fā)氣體分子分解,釋放出的金屬原子沉積在樣品表面,形成導(dǎo)電或絕緣薄膜。該技術(shù)常用于電路連接的修復(fù)或特定結(jié)構(gòu)的局部修飾。
3. 成像功能依賴(lài)于二次電子信號(hào)的采集。當(dāng)離子束掃描樣品表面時(shí),會(huì)激發(fā)出二次電子;通過(guò)探測(cè)器收集這些電子信號(hào),并轉(zhuǎn)化為灰度圖像,能夠清晰呈現(xiàn)樣品的表面形貌與微觀(guān)結(jié)構(gòu)。結(jié)合SEM的高分辨率電子成像,雙束系統(tǒng)可同時(shí)對(duì)同一區(qū)域進(jìn)行離子束加工與電子束成像,實(shí)現(xiàn)加工過(guò)程的實(shí)時(shí)監(jiān)控。
高精度定位與切割
在芯片失效分析中,快速準(zhǔn)確地定位缺陷位置是解決問(wèn)題的首要步驟。FIB憑借其納米級(jí)的加工精度,能夠針對(duì)芯片內(nèi)部的微觀(guān)缺陷——如金屬遷移、介質(zhì)裂紋、通孔異常等進(jìn)行精確定位。結(jié)合電壓對(duì)比成像技術(shù),可以通過(guò)對(duì)比電路中不同區(qū)域的電壓襯度差異,判斷金屬導(dǎo)線(xiàn)的連接狀態(tài),識(shí)別開(kāi)路或短路等故障。
同時(shí),F(xiàn)IB的刻蝕能力允許對(duì)芯片特定區(qū)域進(jìn)行定點(diǎn)切割,制備出垂直或傾斜的截面,從而暴露出內(nèi)部結(jié)構(gòu)。例如,當(dāng)芯片表面鈍化層出現(xiàn)裂紋時(shí),可通過(guò)FIB在裂紋區(qū)域進(jìn)行刻蝕,逐層去除材料,觀(guān)察裂紋是否延伸至下層金屬導(dǎo)線(xiàn),進(jìn)而判斷其對(duì)電路功能的影響。該方法也適用于分析因材料分布不均或局部過(guò)熱引起的結(jié)構(gòu)變形,以及晶體管中雜質(zhì)擴(kuò)散異常等工藝缺陷。
微觀(guān)結(jié)構(gòu)與成分分析
雙束系統(tǒng)中的SEM組件可對(duì)FIB制備的芯片截面進(jìn)行高清晰度成像,清晰展示金屬連線(xiàn)的形貌、層間介質(zhì)的完整性以及各層之間的界面狀態(tài)。這種實(shí)時(shí)成像與加工同步進(jìn)行的特點(diǎn),使得分析人員能夠在切割過(guò)程中直接觀(guān)察缺陷,如金屬線(xiàn)斷裂、通孔殘留、介質(zhì)孔洞等,提高分析效率。
除了形貌觀(guān)察,F(xiàn)IB還可與能譜儀(EDS)或電子能量損失譜(EELS)聯(lián)用,對(duì)微小區(qū)域進(jìn)行元素成分分析。通過(guò)測(cè)量特征X射線(xiàn)或電子能量損失,可以確定失效區(qū)域的元素種類(lèi)與分布,識(shí)別異常污染物、金屬遷移或成分偏離,為失效機(jī)理的判定提供關(guān)鍵信息。例如,在靜電放電(ESD)損傷分析中,結(jié)合形貌與成分分析,可以明確損傷區(qū)域的熔融痕跡與元素變化。
其他應(yīng)用
除上述應(yīng)用外,F(xiàn)IB技術(shù)還廣泛用于透射電子顯微鏡(TEM)樣品的制備。通過(guò)精細(xì)刻蝕與拋光,F(xiàn)IB可以制備出厚度僅為幾十納米的薄膜樣品,滿(mǎn)足TEM原子級(jí)分辨率觀(guān)察的要求。這使得研究人員能夠觀(guān)察器件內(nèi)部的晶格缺陷、位錯(cuò)分布以及柵極氧化層厚度等超微結(jié)構(gòu)信息。
FIB還可與多種分析技術(shù)聯(lián)用,如原子探針斷層掃描(APT)或拉曼光譜(Raman),從不同維度提供材料的結(jié)構(gòu)、成分與應(yīng)力信息,為復(fù)雜失效案例的綜合分析提供支持。
綜上所述,聚焦離子束技術(shù)通過(guò)其精密的加工與成像能力,在芯片失效分析中實(shí)現(xiàn)了從缺陷定位、結(jié)構(gòu)表征到成分分析乃至局部修復(fù)的全流程覆蓋。隨著半導(dǎo)體器件不斷向微小化、集成化發(fā)展,F(xiàn)IB技術(shù)將持續(xù)在失效分析、工藝調(diào)試與可靠性研究中扮演不可或缺的角色。
-
芯片
+關(guān)注
關(guān)注
463文章
54281瀏覽量
468321 -
失效分析
+關(guān)注
關(guān)注
18文章
251瀏覽量
67883 -
fib
+關(guān)注
關(guān)注
1文章
129瀏覽量
11798 -
離子束
+關(guān)注
關(guān)注
0文章
114瀏覽量
8137
發(fā)布評(píng)論請(qǐng)先 登錄
FIB聚焦離子束電路修改服務(wù)
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束顯微鏡(FIB-SEM)
聚焦離子束應(yīng)用介紹
聚焦離子束FIBSEM切片測(cè)試【博仕檢測(cè)】
聚焦離子束(FIB)技術(shù)的特點(diǎn)、優(yōu)勢(shì)以及應(yīng)用

聚焦離子束雙束系統(tǒng)在微機(jī)電系統(tǒng)失效分析中的應(yīng)用
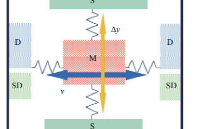
聚焦離子束顯微鏡(FIB):原理揭秘與應(yīng)用實(shí)例

聚焦離子束(FIB)技術(shù)原理和應(yīng)用




 聚焦離子束(FIB)技術(shù)在芯片失效分析中的應(yīng)用詳解
聚焦離子束(FIB)技術(shù)在芯片失效分析中的應(yīng)用詳解





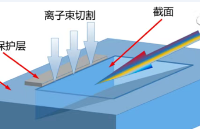
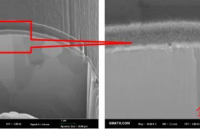



評(píng)論