FIB介紹
聚焦離子束(FIB)技術作為一種高精度的微觀加工和分析工具,在半導體失效分析與微納加工領域,雙束聚焦離子束(FIB)因其“穩、準、狠、短、平、快”的技術特征,被業內譽為“微創手術刀”。它通過聚焦離子束直接在材料上進行操作,無需掩模,能夠實現納米級精度的成像和修改,特別適合需要高精度的任務。
截面量測
以鎵離子源為核心,FIB 技術通過精確調控離子束與樣品表面的相互作用,實現納米級的精細操作。
缺陷分析
案例1:針對膜層內部缺陷通過FIB精細加工至缺陷根源處,同時結合前段生產工藝找出缺陷產生點,通過調整工藝解決產品缺陷。
案例2:產品工藝異常或調整后金鑒通過FIB獲取膜層剖面對各膜層檢查以及厚度的測量檢測工藝穩定性。
TEM制樣
透射電子顯微鏡(TEM)是研究材料微觀結構的重要手段,但需要制備超薄樣品。FIB 技術能夠精確地將樣品減薄到納米級厚度,同時保持樣品的結構完整性,為 TEM 分析提供高質量的樣品。通過 FIB 制備的樣品可以清晰地觀察到材料的晶體結構、界面特征和缺陷分布等信息。
1.FIB粗加工
2.納米手轉移
3.FIB精細加工完成制樣
氣相沉積(GIS)
FIB GIS系統搭載Pt氣體,其作用除了對樣品表面起到保護作用,還能根據其導電特性對樣品進行加工。FIB加工前為材料提供保護層,或用于材料精加工。
納米材料電阻無法直接進行測量,通過FIB GIS系統對其沉積Pt,將其連接到電極上進行四探針法測電阻。
結語
聚焦離子束(FIB)技術作為一種高精度的微觀加工和分析工具,在半導體量產中具有廣泛的應用前景。它能夠實現納米級精度的成像和修改,特別適合缺陷分析、電路修改、光掩模修復、TEM 樣品制備和故障分析等任務。
-
測試
+關注
關注
9文章
6308瀏覽量
131562 -
半導體
+關注
關注
339文章
31062瀏覽量
265728 -
fib
+關注
關注
1文章
129瀏覽量
11792
發布評論請先 登錄
半導體芯片結構分析
SPC在半導體在半導體晶圓廠的實際應用
Dual Beam FIB(雙束聚焦離子束)
4155C 半導體參數分析儀
半導體失效分析項目介紹
芯片漏電點FIB切片分析
FIB技術在印刷線路板PCB失效分析的應用
什么是FIB?FIB有哪些應用?如何修改線路做FIB?FIB怎么做失效分析?
半導體在熱測試中遇到的問題
聚焦離子束(FIB)技術在半導體中的應用與操作指導

FIB - SEM 技術在半導體芯片領域的實踐應用
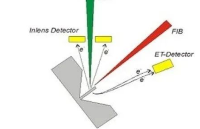
聚焦離子束(FIB)技術在芯片失效分析中的應用詳解




 FIB在半導體分析測試中的應用
FIB在半導體分析測試中的應用



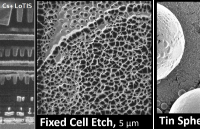



評論