在半導體芯片的研發與失效分析環節,聚焦離子束雙束系統(FIB - SEM)憑借其獨特的功能,逐漸成為該領域的核心技術工具。簡而言之,這一系統將聚焦離子束(FIB)的微加工優勢與掃描電子顯微鏡(SEM)的高分辨率成像能力相結合,實現了加工與觀測的高效協同,為芯片技術的持續進步提供了堅實保障。
技術原理與核心優勢
FIB - SEM 雙束系統由 FIB 模塊、SEM 模塊以及多軸樣品臺構成,形成了一個 “加工 - 觀測” 一體化的操作平臺。
1.FIB 模塊
利用液態金屬離子源(LMIS)產生的鎵離子束(Ga?),能夠進行納米級別的刻蝕、沉積以及樣品制備等精細加工操作。它可以在極小的芯片結構上實現材料的去除或添加。
2. SEM模塊
通過二次電子成像技術,實時監控加工過程,其定位精度可達到亞微米級別。這確保每一步操作都能精準地進行,無論是微小結構的尺寸測量,還是加工過程中位置的精準確認,SEM 模塊都能發揮重要作用。
3.FIB-SEM
雙束系統的協同優勢主要體現在以下幾個方面:首先,雙束同步工作支持三維重構技術。通過對芯片不同層面的連續切片與成像,再利用計算機算法進行數據處理,可以重建出芯片內部的三維結構模型,這有助于直觀地觀察芯片內部的復雜架構,對于芯片的設計驗證與失效分析都具有重要意義。其次,定點加工能力使得能夠在芯片的特定區域進行精準的材料去除或添加操作,為芯片的定制化修改和缺陷修復提供了技術手段。
核心應用場景
為方便客戶對材料進行深入的失效分析及研究。
(一)材料微觀截面截取與觀察
1. 芯片內部結構分析 :借助 FIB - SEM 系統,實現對芯片晶體管柵極、金屬互連層等關鍵部位的精準切割,獲得清晰無損的斷面,為后續分析提供高質量樣本,助力研究人員精準把握芯片設計與制造工藝細節,及時察覺潛在缺陷。
FIB切割芯片金道
(二)透射電鏡(TEM)樣品制備
1. 超薄樣品制備 :在透射電鏡樣品制備中,FIB-SEM 技術通過離子束逐層減薄,制備出厚度小于 100 納米且保留原子級晶格信息的超薄樣品。金鑒實驗室在進行試驗時,嚴格遵循相關標準操作,確保每一個測試環節都精準無誤地符合標準要求。
實驗室TEM制樣
2. 先進制程中的缺陷分析 :針對 3 納米以下制程芯片,FIB-SEM 技術精準剖析柵極氧化層缺陷與界面特性,為工藝改進和缺陷控制提供關鍵數據,推動芯片制造技術向更小尺寸、更高性能發展。
(三)芯片線路修改
1. 線路修復與優化 :FIB-SEM 系統可切斷短路線路并沉積導電材料修復斷路,提升良品率降低成本,還能快速修改多項目晶圓線路,加速研發進程。
2. 誘導沉積材料 :利用電子束或離子束將金屬有機氣體化合物分解,從而可在樣品的特定區域進行材料沉積。本系統沉積的材料為Pt,沉積的圖形有點陣,直線等,利用系統沉積金屬材料的功能,可對器件電路進行相應的修改,更改電路功能。
(四)封裝級失效分析
1. 深埋缺陷橫截面制備 :結合飛秒激光技術,FIB-SEM 系統高效制備深埋缺陷橫截面,清晰呈現缺陷形態與分布,為改進封裝工藝提供依據。
2. 漏電區域定位與失效機制分析 :電子束誘導電流成像技術助力精準定位漏電區域,結合 FIB-SEM 的觀察與分析功能,深入探究失效機制,提升封裝可靠性。
結論
總的來說,FIB - SEM 雙束系統憑借其微納加工與高分辨成像的協同優勢,在半導體芯片研發與失效分析領域發揮著不可替代的作用。隨著半導體技術的不斷演進,FIB - SEM 技術將持續助力半導體制造工藝的升級與創新。
-
SEM
+關注
關注
0文章
274瀏覽量
15678 -
fib
+關注
關注
1文章
128瀏覽量
11756 -
半導體芯片
+關注
關注
61文章
943瀏覽量
72626
發布評論請先 登錄
半導體芯片結構分析
聚焦離子束顯微鏡(FIB-SEM)
芯片漏電點FIB切片分析
FIB-SEM雙束技術及應用介紹
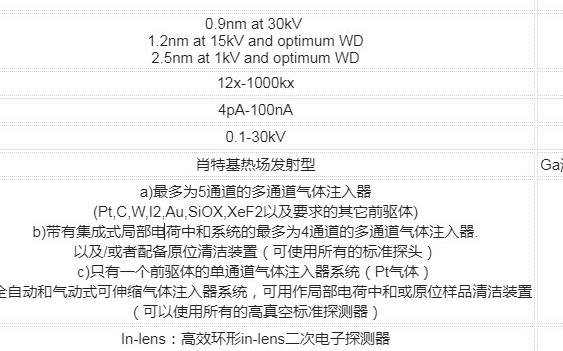
FIB-SEM雙束系統在材料科學領域的應用
聚焦離子束顯微鏡(FIB-SEM)材料分析

FIB-SEM技術全解析:原理與應用指南
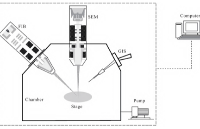
FIB-SEM 雙束技術簡介及其部分應用介紹
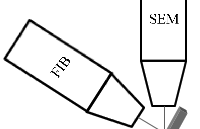
案例展示||FIB-SEM在材料科學領域的應用
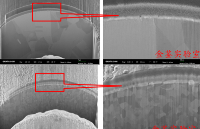
SEM/FIB雙束系統及其截面加工技術




 FIB - SEM 技術在半導體芯片領域的實踐應用
FIB - SEM 技術在半導體芯片領域的實踐應用

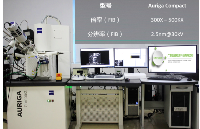
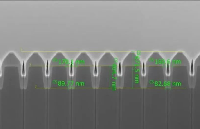





評論