在半導體和顯示器件制造中,薄膜與基底的厚度精度直接影響器件性能。現有的測量技術包括光譜橢偏儀(SE)和光譜反射儀(SR)用于薄膜厚度的測量,以及低相干干涉法(LCI)、彩色共焦顯微鏡(CCM)和光譜域干涉法(SDI)用于基板厚度的測量。本研究提出SR-SDI集成光學系統,通過可見光反射譜與近紅外干涉譜的協同處理,實現跨尺度同步厚度測量,并開發模型化干涉分析算法,將基底厚度測量誤差降至8 nm以下。
1
光譜反射儀(SR)
flexfilm
首先,通過擬合理論反射譜到實驗反射譜來確定薄膜的厚度。理論反射譜由薄膜層兩個界面處的多次反射和透射建模得出。公式如下: 其中,r01和 r12分別是空氣到薄膜和薄膜到基板的菲涅爾反射系數,λ 是波長,N~1 是薄膜材料的已知折射率。實驗反射譜通過測量參考基板和薄膜試樣的反射強度譜得出。
其中,r01和 r12分別是空氣到薄膜和薄膜到基板的菲涅爾反射系數,λ 是波長,N~1 是薄膜材料的已知折射率。實驗反射譜通過測量參考基板和薄膜試樣的反射強度譜得出。
2
光譜域干涉儀(SDI)
flexfilm
其次,通過分析干涉譜的周期來確定基板的厚度。干涉譜的周期取決于光程差,可以通過傅里葉變換后的峰值位置和光速計算得出。公式如下: 其中,I1,I2,I3和 I4分別是四個測量光束的干涉信號幅度。通過模型分析干涉譜,可以有效減小薄膜對基板厚度測量的影響。
其中,I1,I2,I3和 I4分別是四個測量光束的干涉信號幅度。通過模型分析干涉譜,可以有效減小薄膜對基板厚度測量的影響。
3
實驗驗證
flexfilm
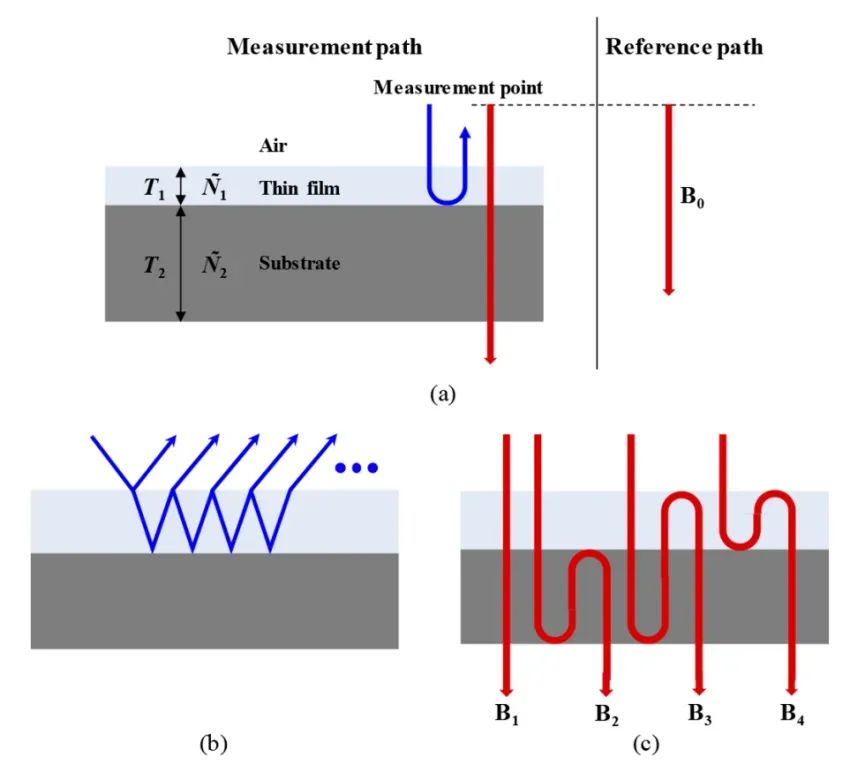
SR與SDI的光束傳播路徑:(a) SR(藍)和SDI(紅)的測量/參考光束;(b) SR詳細光路;(c) SDI詳細光路
實驗系統采用可見 - 近紅外雙波段光源:SR 使用鎢鹵素燈(300–2600 納米)與可見光譜儀,SDI 使用超輻射二極管(1550 納米中心波長)與近紅外光譜儀,通過二向色分束器實現光路集成。
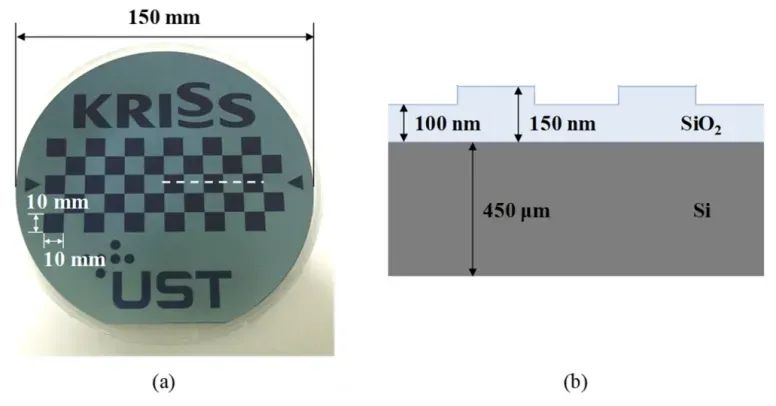
薄膜樣品示意圖:(a) 俯視圖(b) 圖(a)白虛線截面的剖面結構

厚度分布測量結果:(a) SR模式薄膜厚度分布;(b) SDI模式基底厚度分布;(c)–(d) 沿黑虛線的厚度剖面
對 450 微米硅基底上 100 納米與 150 納米的SiO?薄膜樣品進行掃描測量,薄膜厚度分布清晰地顯示了100nm和150nm的兩個不同厚度水平,而基板厚度分布顯示出逐漸變化的厚度,與薄膜厚度分布明顯不同。這證實了薄膜和基板的厚度可以在同一時間內測量,且互不干擾。
4
不確定度評估
flexfilm
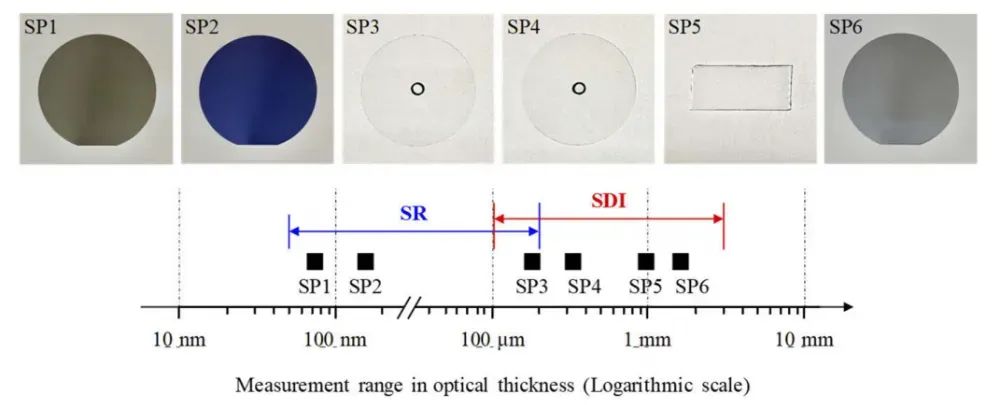
分布在寬厚度范圍內的厚度參考樣品

薄膜厚度測量不確定度為 0.12 納米k=2,薄膜樣品中基底為 0.094 微米k=2,單個基底為 0.076 微米k=2,驗證了方法的可靠性。六組參考樣品的對比測量顯示,測量值與認證值在擴展不確定度內一致,En 值均小于 1,證實了多尺度厚度測量的準確性。本文實現了一種基于光譜反射儀和光譜域干涉儀集成的光學測量系統,能夠同時測量薄膜和基板的厚度。通過模型分析干涉譜,有效減小了薄膜對基板厚度測量的影響。實驗結果驗證了該方法的有效性和可靠性,測量結果與標準測量設備一致。
FlexFilm自動膜厚儀
flexfilm
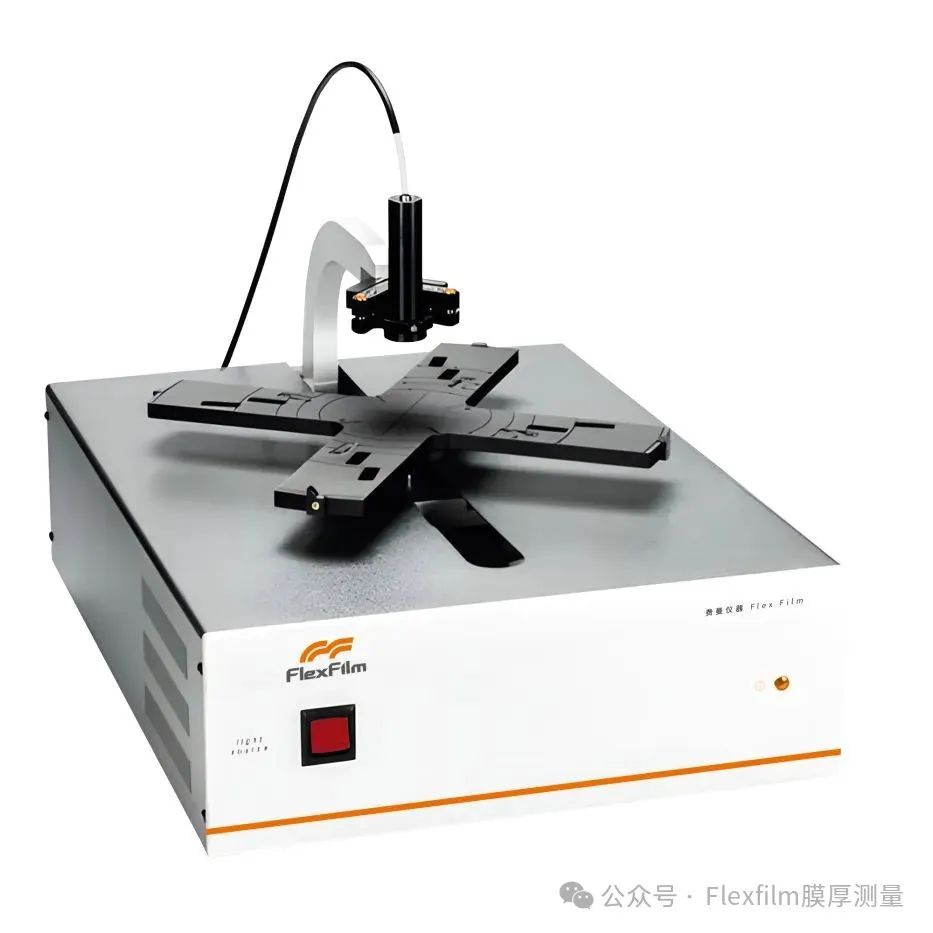
對樣品進行無損、快速、高精度測量,可用于反射率、透射率、膜厚等參數測量。廣泛應用于光學鍍膜、半導體薄膜、液晶顯示、薄膜層和生物醫學等厚度的測量方案中。
- 光學干涉方式,無損測量
- Mapping成像模式,輕松表征材料膜厚的均一性
- 多類解析算法,可精準和估算測量,滿足不同測量需要
- 軟件簡潔,測量一鍵操作,簡單易用
FlexFilm自動膜厚儀可以對半導體和顯示器件制造中的薄膜厚度進行精準測量,來實現器件的性能優化。原文出處:《Optical method for simultaneous thickness measurements of two layers with a significant thickness difference》
*特別聲明:本公眾號所發布的原創及轉載文章,僅用于學術分享和傳遞行業相關信息。未經授權,不得抄襲、篡改、引用、轉載等侵犯本公眾號相關權益的行為。內容僅供參考,如涉及版權問題,敬請聯系,我們將在第一時間核實并處理。
-
半導體
+關注
關注
339文章
30725瀏覽量
263997 -
測量
+關注
關注
10文章
5632瀏覽量
116716 -
顯示器件
+關注
關注
1文章
70瀏覽量
13325
發布評論請先 登錄
半導體薄膜厚度檢測設備設備出售
測厚儀 ZM100測透明薄膜的厚度
薄膜在線紅外測厚儀:精確測量薄膜厚度的利器
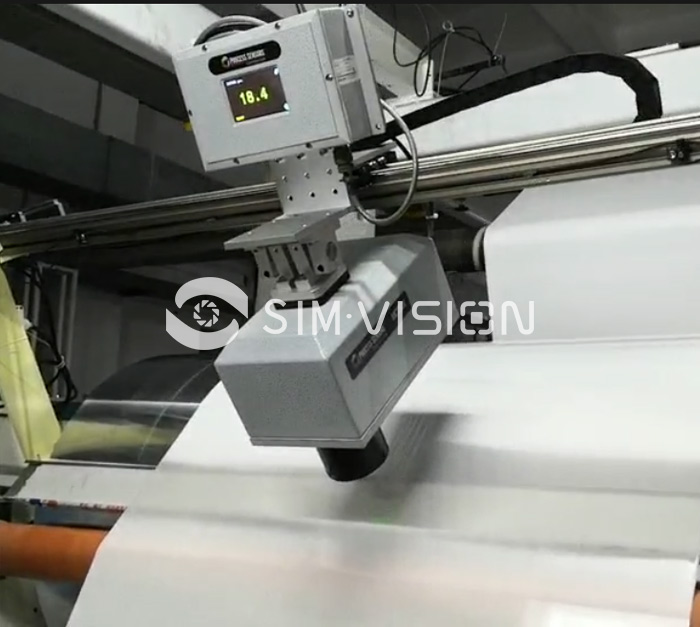



 薄膜質量關鍵 |?半導體/顯示器件制造中薄膜厚度測量新方案
薄膜質量關鍵 |?半導體/顯示器件制造中薄膜厚度測量新方案


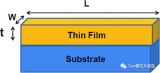






評論