文章來源:學習那些事
原文作者:前路漫漫
本文主要講述封裝缺陷。
概述
在電子器件封裝過程中,會出現多種類型的封裝缺陷,主要涵蓋引線變形、底座偏移、翹曲、芯片破裂、分層、空洞、不均封裝、毛邊、外來顆粒以及不完全固化等。
引線變形
引線變形現象,多發生于塑封料流動階段,表現為引線出現位移或形態改變。衡量這一缺陷程度,常采用引線最大橫向位移 x 與引線長度 L 的比值 x/L 作為量化指標。在高密度 I/O 器件封裝場景中,引線彎曲極易引發電器短路故障;同時,彎曲產生的應力還可能致使鍵合點開裂,削弱鍵合強度。而封裝設計、引線布局、引線材料與規格、模塑料特性、引線鍵合工藝以及封裝流程等,均會對引線鍵合產生影響;至于引線直徑、長度、斷裂載荷、密度等參數,更是與引線彎曲程度緊密相關。
底座偏移
底座偏移指的是芯片載體(即芯片底座)發生形變與位置偏離。塑封料的流動性能、引線框架的組裝設計方案,以及塑封料和引線框架的材料特性,均是導致底座偏移的關鍵因素。像薄型小尺寸封裝(TSOP)、薄型方形扁平封裝(TQFP)這類封裝器件,由于引線框架較薄,在封裝過程中更易出現底座偏移與弓腳變形問題,底座偏移情況可參考下圖。
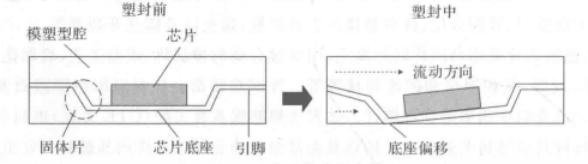
翹曲
封裝器件在平面之外發生的彎曲與形變,被稱為翹曲。塑封工藝引發的翹曲不僅會帶來分層、芯片開裂等可靠性隱患,還會在制造環節造成諸多問題。以塑封球柵陣列(PBGA)器件為例,翹曲會導致焊料球共面性不佳,使得器件在回流焊組裝至印刷電路板時出現故障。
在封裝工藝中,貼裝問題里的翹曲現象存在內凹、外凸以及組合模式這三種類型,具體形態如下圖所示。塑封料成分、模塑料濕氣含量、封裝幾何結構等,都是引發翹曲的潛在因素。通過精準把控塑封材料及其成分、優化工藝參數、調整封裝結構并管理封裝前環境條件,能夠最大程度減少封裝翹曲。在部分場景下,還可采用對電子組件封裝背面進行處理的方式來補償翹曲。例如,大陶瓷電路板或多層板的外部連接集中在同一側時,對其背面實施封裝操作,可有效降低翹曲程度。

芯片破裂
此外,封裝工藝過程中產生的應力會致使芯片破裂,而且往往會加劇前道組裝工序中已形成的微裂縫。晶圓或芯片減薄、背面研磨、芯片黏結等操作步驟,均可能促使芯片裂縫產生。值得注意的是,出現破裂、機械失效的芯片,并不一定會立即出現電氣失效情況。芯片破裂是否會引發器件瞬間電氣故障,與裂縫的延伸路徑密切相關。比如,若裂縫產生于芯片背面,或許不會對芯片內部敏感結構造成影響。由于硅晶圓質地薄且脆,晶圓級封裝更容易出現芯片破裂問題。因此,在轉移成型工藝中,需嚴格管控夾持壓力、成型轉換壓力等工藝參數,以此防范芯片破裂。而在 3D 堆疊封裝領域,疊層工藝的特性使得芯片破裂風險顯著增加,芯片疊層結構、基板厚度、模塑體積、模套厚度等設計因素,都會對 3D 封裝中芯片破裂情況產生影響 。
分層
分層或黏結不牢,本質上是塑封料與相鄰材料界面出現分離的現象。這類缺陷可能出現在塑封微電子器件的任意區域,無論是封裝過程、后封裝制造環節,還是器件使用階段,都有可能發生。其中,封裝工藝導致的界面黏結不良,是引發分層的關鍵因素。界面空洞、封裝時的表面污染以及固化不完全等情況,均會致使黏結效果不佳。此外,固化與冷卻過程中產生的收縮應力、翹曲,以及塑封料和相鄰材料間熱膨脹系數(CTE)不匹配引發的熱 - 機械應力,也都是分層問題的誘因。
空洞
在封裝工藝里,氣泡嵌入環氧材料形成空洞的情況,可能貫穿轉移成型、填充、灌封、塑封料印刷等各個階段。通過排空或抽真空等減少空氣量的手段,能夠有效降低空洞出現的概率。據相關研究,采用1--300Torr(1 個大氣壓760Torr,1Torr = 1.01325×10?Pa)的真空壓力范圍可取得較好效果。填模仿真分析顯示,底部熔體前沿與芯片接觸會阻礙流動性,部分熔體前沿向上經芯片外圍大開口區域填充半模頂部,新老熔體前沿在此交匯,進而產生起泡現象。
不均封裝
塑封體厚度不均會引發翹曲和分層問題。傳統的轉移成型、壓力成型、灌注封裝等技術,較少出現此類缺陷;而晶圓級封裝因其工藝特性,更容易導致塑封厚度不一致。為保障塑封層厚度均勻,需固定晶圓載體,盡量減小其傾斜度,以便刮刀安裝;同時,還需精準控制刮刀位置,維持刮刀壓力穩定。在塑封料硬化前,若填充粒子局部聚集、分布不均,或者塑封料混合不充分,都會造成材料組成不一致。
毛邊
毛邊是塑封成型時,模塑料通過分型線沉積在器件引腳上形成的。夾持壓力不足是產生毛邊的主因,若不及時清除引腳上的模料殘留,會在組裝階段引發諸多問題,如后續封裝過程中鍵合或黏附不充分。樹脂泄漏則屬于較為輕微的毛邊形態。
外來顆粒及不完全固化
當封裝材料接觸受污染的環境、設備或其他材料時,外來粒子會在封裝內部擴散,并附著在 IC 芯片、引線鍵合點等金屬部位,進而引發腐蝕及其他可靠性問題。固化時間不足、溫度偏低,或是兩種封裝料灌注時混合比例出現偏差,都會導致不完全固化。為充分發揮封裝材料性能,不僅要確保其完全固化,在許多封裝工藝中,還可采用后固化工藝輔助;同時,必須嚴格把控封裝料的配比精度。
-
芯片
+關注
關注
463文章
54305瀏覽量
468418 -
封裝
+關注
關注
128文章
9309瀏覽量
148963 -
工藝
+關注
關注
4文章
718瀏覽量
30378
原文標題:封裝缺陷分類
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
軟件代碼缺陷分類及其應用
一文詳解封裝互連技術
一文詳解封裝互連技術
基于FFmpeg解封裝WMV和M4V格式
一文詳解封裝基板的制備工藝
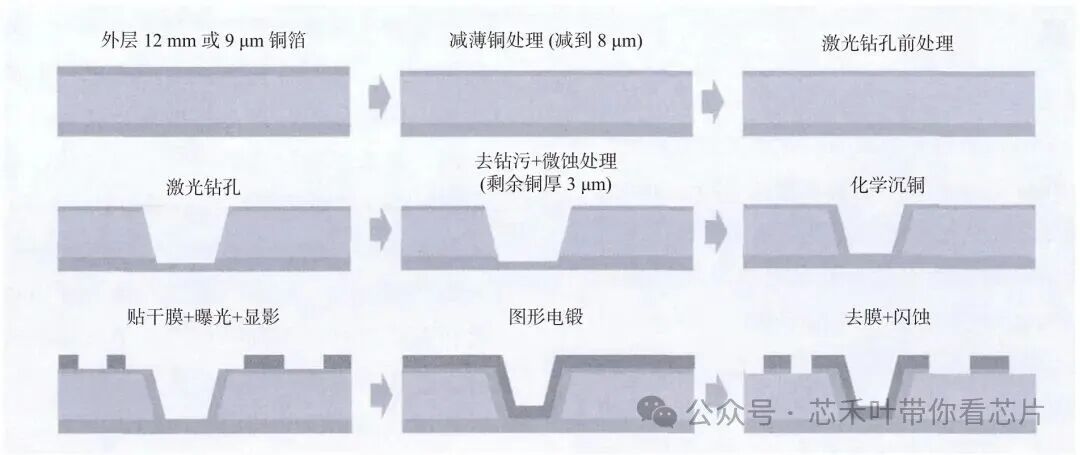



 一文詳解封裝缺陷分類
一文詳解封裝缺陷分類


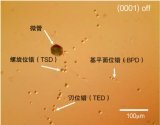



評論