IGBT的高溫漏電流與電壓阻斷能力固有缺陷是其被新一代電力電子設備加速淘汰的根本原因
一、IGBT的高溫漏電流與電壓阻斷能力固有缺陷的本質
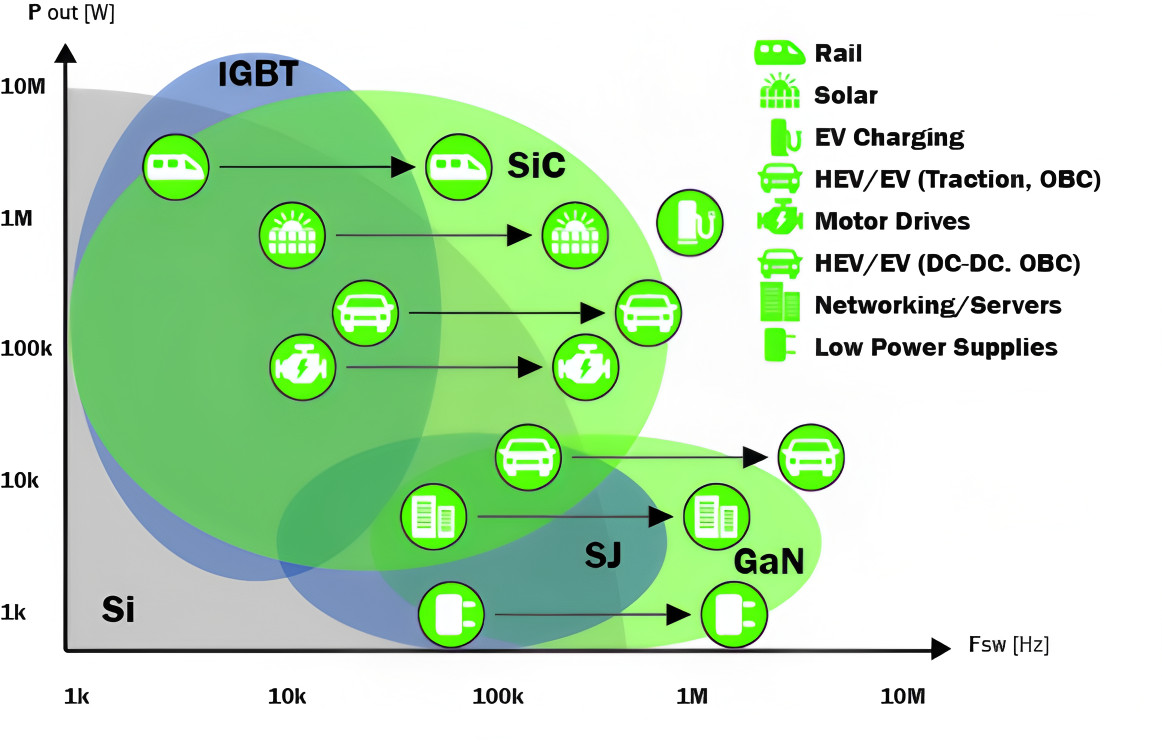
材料物理特性限制
IGBT基于硅(Si)材料,其帶隙較窄(1.1 eV),高溫下本征載流子濃度呈指數級增長。當溫度從25°C升至175°C時,漏電流(如ICES)可從微安級升至毫安級(例如某IGBT在1200V下的漏電流從20μA升至50mA)。漏電流增大會導致靜態功耗(Pleakage=VCE×ICES)顯著上升,引發局部溫升,形成熱失控循環,最終導致器件燒毀。
電壓阻斷能力的臨界性
IGBT的電壓阻斷能力(如1200V)由其PN結耗盡層寬度和摻雜濃度決定。當外加電壓超過VCE額定值時,耗盡層被擊穿,雪崩倍增效應觸發大電流(如某IGBT在過壓10%時,漏電流驟增100倍)。IGBT雪崩倍增效應會導致晶格損傷或金屬化層熔融,引發永久性失效。
失效不可逆性的機理
熱斑形成:局部電流集中產生高溫熱點(>300°C),導致硅材料熔化或焊層分層,結構完整性被破壞。
二、SiC MOSFET的對比優勢
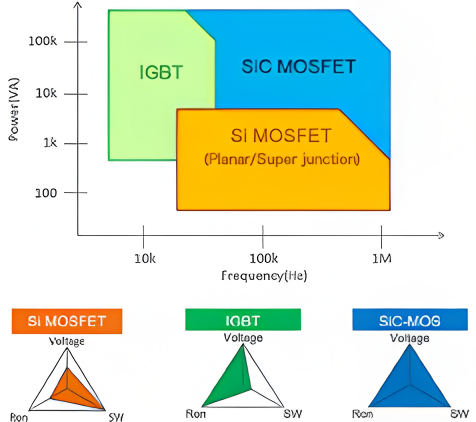
寬禁帶材料的根本性提升
SiC帶隙(3.3 eV)是硅的3倍,高溫下本征載流子濃度極低。例如,某SiC MOSFET在175°C、1200V下的漏電流(IDSS)僅5μA,比同電壓IGBT低3個數量級,顯著降低靜態損耗。
高臨界擊穿電場強度
SiC的擊穿場強(約3 MV/cm)是硅的10倍,阻斷同等電壓所需的器件厚度更薄(如1200V器件厚度僅需硅的1/10),導通電阻(RDS(on))更低(如13.5 mΩ@60A)。即使過壓至1500V,漏電流仍可控,雪崩能量耐受能力(遠高于IGBT。
熱穩定性與散熱優勢
熱導率高:SiC熱導率(3.7 W/cm·K)是硅的2.5倍,熱量分布更均勻,降低熱斑風險。
高溫可靠性:SiC MOSFET的結溫上限可達200°C(IGBT通常限制在175°C),且在高溫下閾值電壓漂移(ΔVth)更小(如從25°C到175°C僅下降0.4V),確保開關穩定性。
三、典型案例與數據支撐
IGBT失效案例
某光伏逆變器中,IGBT模塊因長期高溫運行導致漏電流累積,觸發熱失控,最終擊穿電壓阻斷層,造成設備停機,維修成本超百萬元。數據顯示,IGBT在175°C下的漏電流達50mA,而SiC MOSFET僅為5μA。
SiC MOSFET的可靠性驗證
通過HTRB(高溫反向偏置)測試,SiC模塊在1200V、175°C下持續1000小時無失效,漏電流穩定在μA級。而部分IGBT模塊在相同條件下,漏電流隨時間呈指數增長,500小時后即超出安全閾值。
四、結論
IGBT的高溫漏電流與電壓阻斷能力固有缺陷源于硅材料的物理極限,過壓或高溫導致的失效具有不可逆性。而SiC MOSFET憑借寬禁帶、高擊穿場強和優異熱特性,從根本上解決了這些問題,成為高壓高溫應用的更優選擇。隨著國產SiC碳化硅功率半導體成本持續下降,其在光伏逆變器、儲能變流器PCS、風電變流器、電能質量APF/SVG、軌道交通等領域的滲透率將加速提升。
審核編輯 黃宇
-
電壓
+關注
關注
45文章
5779瀏覽量
122160 -
IGBT
+關注
關注
1289文章
4351瀏覽量
263559
發布評論請先 登錄
SGM40677:具備過壓保護和真反向電流阻斷功能的電流限制開關
合科泰分析12V2A開關電源中TL431的故障原因

電機加速過程中突然出現過電流原因分析

貼片電容直流的漏電流標準值

怎樣去預防貼片電容漏電流的發生?

技術深解 | 永銘低漏電流固態電容如何實現待機功耗突破?數據與工藝全解析

數據說話|永銘VHE電容如何破解車規熱管理系統的高溫高紋波難題?
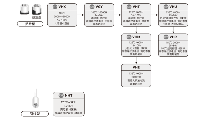
電解電容鼓包是什么原因造成的?
電解電容的漏電流過大會對電路造成哪些不良影響?
電解電容的漏電流問題如何解決?
硅基時代的黃昏:為何SiC MOSFET全面淘汰IGBT?

部分外資廠商IGBT模塊失效報告作假對中國功率模塊市場的深遠影響

IGBT的靜態參數有哪些?怎樣去精確測量這些參數呢?




 IGBT高溫漏電流和電壓阻斷能力固有缺陷是其被淘汰的根本原因
IGBT高溫漏電流和電壓阻斷能力固有缺陷是其被淘汰的根本原因

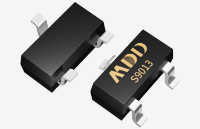



評論