原創 齊道長 未來半導體
12月5日早訊,根據供應鏈向未來半導體反饋 ,DNP 正在推進用于先進半導體封裝的玻璃通孔 (TGV) 玻璃芯基板和共封裝光學玻璃基板的樣品驗證。DNP將加快資本投資,在2026財年開始小規模生產玻璃基板,在2027財年開始全面投產,預計到2030年玻璃基板先進封裝業務投資發展到約20億美元的規模。
· 用于先進半導體封裝的玻璃通孔 (TGV) 玻璃芯基板
DNP 可替代傳統樹脂基板的TGV玻璃芯基板,可實現更高效率和更大面積化。高密度TGV技術可提供比現有產品更高性能的半導體封裝。DNP 大面積化的510x515mm的TGV玻璃芯基板,應用于下一代AI芯片——服務器中高性能設備(CPU /GPU s )的先進封裝基板市場,預計到2030年投資將達到20億美元。

· 共封裝光學玻璃基板
為解決數據中心耗電量增加這一全球社會問題,DNP 提供共封裝光學基板,其中的光波導可實現高速信息處理和節能。DNP 具有聚合物光波導的玻璃配線基板,這是需要節能和高性能的下一代數據中心所必需的。
· DNP 玻璃基板布局與目標
DNP以半導體相關事業為主要事業領域,利用微加工技術、精密涂布技術等自主研發的核心技術,提供用于制作半導體微細電路圖案的母版光掩模,并提供新一代半導體封裝材料。

在玻璃基板方向,2020年 JTB Planning Network 成為合并子公司(成立 DNP Planning Network, Co. Ltd.),并與2022年開發半導體封裝用TGV玻璃芯基板。DNP于2023年3月正式推出玻璃芯基板,并斬獲2023年半導體年度大獎(由San gyo Tim es ,Inc .組織)中獲得大獎。
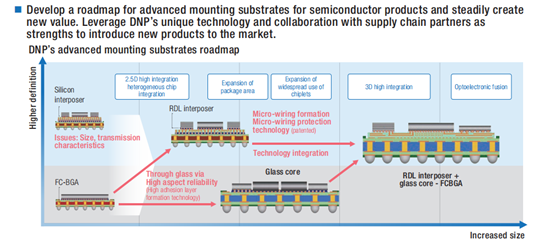
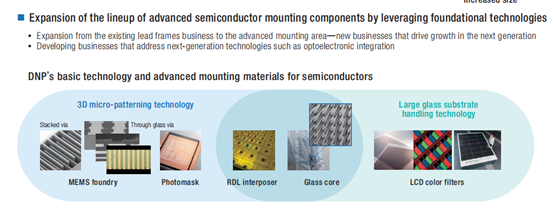
根據《半導體封裝玻璃基板技術與市場白皮書2024》調研,2024年DNP已于與多個客戶正在對接,對提高封裝良率和優化玻璃基制造過程和玻璃基板樣品進行驗證。同時,基于玻璃芯板并行開發重新分發層(RDL)中間件和其他相關技術,根據市場預期和各公司的需求,DNP將加快資本投資,在2026財年開始小規模生產玻璃基板,在2027財年開始全面投產,預計到2030年玻璃基板先進封裝業務投資發展到約20億美元的規模。DNP的目標是引領下一代AI芯片的CPU /GPUs的先進封裝基板產業化。
聲明:本網站部分文章轉載自網絡,轉發僅為更大范圍傳播。 轉載文章版權歸原作者所有,如有異議,請聯系我們修改或刪除。聯系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
半導體封裝
+關注
關注
4文章
316瀏覽量
15223 -
基板
+關注
關注
2文章
321瀏覽量
24017 -
DNP
+關注
關注
1文章
9瀏覽量
9421
發布評論請先 登錄
格陸博科技EMB電子機械制動已完成三年冬夏季標定驗證
iPhone 17已進入大規模量產階段 鄭州富士康高返費招工浪潮開啟
SoC芯片市場將超3200億美元!燦芯IP發力多端客戶,加速智能終端產品落地

Samtec前沿應用 | GCT玻璃芯技術要點

LG電子重兵布局混合鍵合設備研發,鎖定2028年大規模量產目標
超大規模芯片驗證:基于AMD VP1902的S8-100原型驗證系統實測性能翻倍




 DNP:推進玻璃芯板樣品驗證,到2030年投20億美元用于大規模量產
DNP:推進玻璃芯板樣品驗證,到2030年投20億美元用于大規模量產







評論