芯片制造可分為前段(FEOL)晶體管制造和后段(BEOL)金屬互連制造。后段工藝是制備導(dǎo)線將前段制造出的各個(gè)元器件串連起來連接各晶體管,并分配時(shí)鐘和其他信號(hào),也為各種電子系統(tǒng)組件提供電源和接地。
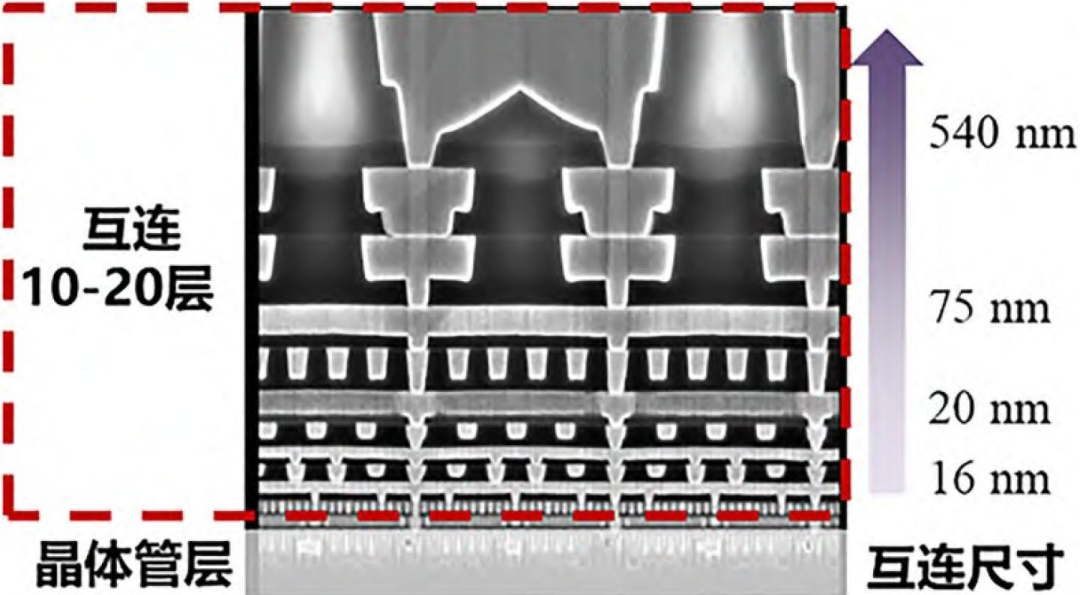
第一代互連技術(shù)通常采用鋁和鋁合金作為導(dǎo)體材料。鋁通常采用干法刻蝕中的反應(yīng)離子刻蝕工藝進(jìn)行布線。至0.18微米技術(shù)節(jié)點(diǎn)以下時(shí),鋁作為金屬材料的缺點(diǎn)逐漸顯示出來。銅因具有良好的導(dǎo)電性、較高的熔點(diǎn)以及較好的抗電遷移性能,成為鋁之后金屬互連材料首選。
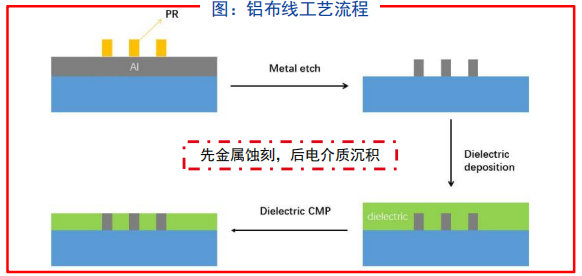
銅屬于穩(wěn)定金屬,反應(yīng)時(shí)不易產(chǎn)生揮發(fā)性物質(zhì),因此干法刻蝕不再適用于銅布線。1997年IBM公司提出大馬士革工藝,通過沉積銅實(shí)現(xiàn)布線,互連技術(shù)進(jìn)入銅互連時(shí)代。
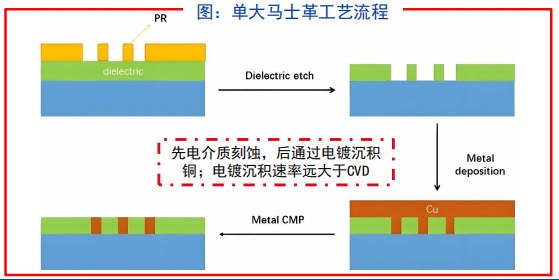
大馬士革工藝可分為單大馬士革工藝和雙大馬士革工藝,兩者的區(qū)別在于互連引線溝槽與互連通孔是否同時(shí)淀積填充銅金屬。單大馬士革工藝通過一次刻蝕和填充工藝來形成,即僅包含溝槽或僅包含通孔,具有更高的分辨率。通常第一金屬銅層(M1)用單大馬士革工藝,其他層用雙大馬士革工藝。雙大馬士革工藝可一次形成通孔和溝槽,較單大馬士革工藝可減少約20%的工藝流程,可分為先通孔-后溝槽和先溝槽-后通孔兩類。
先通孔-后溝槽:65nm及以上技術(shù)節(jié)點(diǎn)多采用基于光阻掩膜的先通孔工藝,原因是先形成溝槽會(huì)導(dǎo)致表面不平整,而通孔關(guān)鍵尺寸小于溝槽,為了在不平整的溝槽上光刻形成達(dá)到要求的通孔,對(duì)光刻膠的要求較高,要求光刻膠較厚且景深較大。
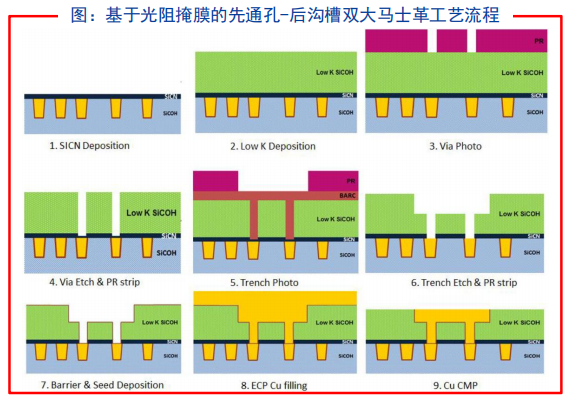
先溝槽-后通孔:金屬硬掩模一體化刻蝕(Metal Mard Mask All-in-One Etch)因更好的CD控制和更少的介質(zhì)損傷,成為45nm及以下技術(shù)節(jié)點(diǎn)后段金屬溝槽/通孔刻蝕的主流,采用的是先溝槽的雙大馬士革工藝。
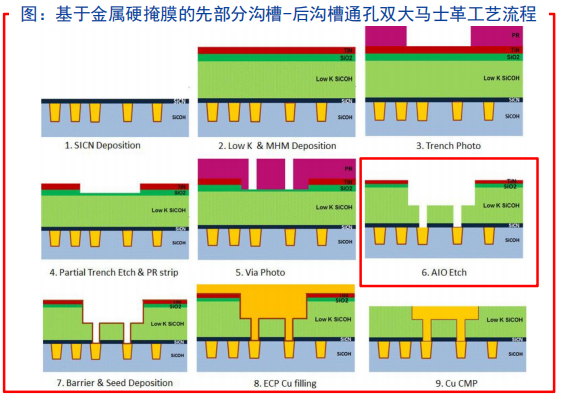
來源:半導(dǎo)體材料與工藝
-
元器件
+關(guān)注
關(guān)注
113文章
5003瀏覽量
99635 -
工藝
+關(guān)注
關(guān)注
4文章
713瀏覽量
30310 -
晶體管
+關(guān)注
關(guān)注
78文章
10395瀏覽量
147730 -
芯片制造
+關(guān)注
關(guān)注
11文章
719瀏覽量
30464 -
互連技術(shù)
+關(guān)注
關(guān)注
0文章
29瀏覽量
10629
原文標(biāo)題:大馬士革銅互連工藝
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
一文詳解銅大馬士革工藝


鐵匠鋪鍛打大馬士革花紋鋼酸洗之后花紋確實(shí)夠漂亮鍛打?鐵匠?大馬士革? #硬聲創(chuàng)作季
如何采用銅互連單大馬士革工藝制作超厚金屬銅集成電感的概述
12吋晶圓集成電路芯片制程工藝與工序后端BEOL的詳細(xì)資料說明
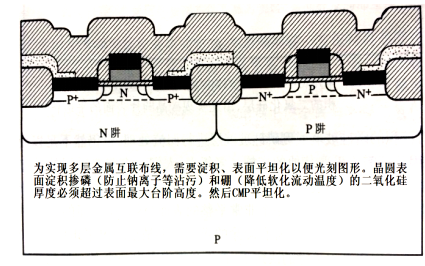
實(shí)現(xiàn)3nm技術(shù)節(jié)點(diǎn)需要突破哪些半導(dǎo)體關(guān)鍵技術(shù)
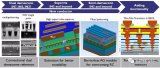
什么是銅互連?為什么銅互連非要用雙大馬士革工藝?

半大馬士革集成中引入空氣間隙結(jié)構(gòu)面臨的挑戰(zhàn)

通過工藝建模進(jìn)行后段制程金屬方案分析

降低半導(dǎo)體金屬線電阻的沉積和刻蝕技術(shù)
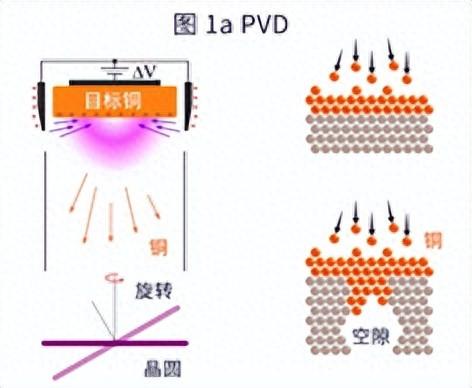
金屬層1工藝的制造流程
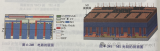
半大馬士革工藝:利用空氣隙減少寄生電容
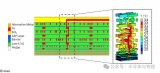
芯片制造過程中的布線技術(shù)




 大馬士革銅互連工藝詳解
大馬士革銅互連工藝詳解


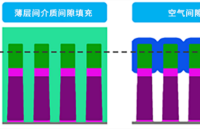
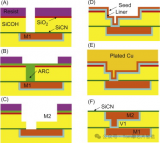



評(píng)論