共讀好書
張路非,閆軍政,劉理想,王芝兵,吳美麗,李毅
(貴州振華群英電器有限公司)
摘要:
在微組裝工藝應用領域,為保證印制電路板上裸芯片鍵合后的產品可靠性,采用化學鍍鎳鈀金工藝(ENEPIG),可在焊接時避免“金脆”問題、金絲鍵合時避免“黑焊盤”問題。針對化學鍍鎳鈀金電路板的金絲鍵合(球焊)可靠性進行了研究,從破壞性鍵合拉力測試、第一鍵合點剪切力測試以及通過加熱條件下的加速材料擴散試驗、鍵合點切片分析、鍵合點內部元素掃描等多方面分析,與常規應用的鍍鎳金基板鍵合強度進行了相關參數對比,最終確認了長期可靠性滿足產品生產要求。此外,對鎳鈀金電路板金絲鍵合應用過程中需要注意的相關事項進行了總結與說明。
0 引言
隨著微組裝工藝的發展,印制電路板上除常規元器件焊接外,也漸漸出現裸芯片的粘接、焊接和鍵合工藝,以滿足對產品的高集成度、小型化的要求。因此,印制電路板的焊盤表面處理工藝也從最基礎的“噴錫”演變到“鍍金”、“沉金”,但同時,也帶來了新的問題。常規采用含錫焊料的焊接工藝中,當焊點中金含量為3%~19%時,會形成AuSn 4合金,導致焊點變脆,存在質量隱患,這種現象稱為“金脆”現象。為了避免該問題,在有高可靠性要求的焊接工藝中,或者不采用金焊盤,或者將金焊盤的鍍金層厚度進行嚴格控制。
標準DOD-STD-2000-1B中規定,鍍金連接器和元件引線的焊接部位的鍍層在1.27~2.54 μm范圍內時,應進行搪錫,以避免“金脆”問題 [1] 。電路板焊接應用中,由于大部分元器件均采用貼裝形式,焊接部位錫量較少,一般情況下,應將焊盤中的鍍金層控制在0.3 μm以下,才可以有效避免“金脆”現象。
印制電路板常規的金焊盤鍍覆工藝為化學鍍鎳金工藝,即在電路板銅焊盤基材上先鍍鎳再鍍金,而該工藝經過高溫或長時間儲存后,鍍層中的鎳會向金層滲透、擴散,形成“黑焊盤” [2] 。常規的印制電路板進行微組裝工藝時,都是對元器件先焊接,再鍵合,焊接過程中的高溫可造成“黑焊盤”問題,影響后續的鍵合工藝。為避免“黑焊盤”的問題出現,一般會提高鍵合區域的焊盤鍍金層厚度,印制板廠家一般建議將該區域的鍍金層厚度做到1 μm以上。
1 化學鍍鎳金電路板解決方案
1.1 選擇性鍍金工藝
為了使印制電路板可以兼容焊接和鍵合工藝,電路板廠家開始應用選擇性鍍金工藝。
印制 電路 板焊 盤仍 采用 化學 沉鎳 金工 藝(ENIG),為防止“黑焊盤”對鍵合工藝的影響,且避免“金脆”現象出現,將電路板中的焊接區域、鍵合區域進行選擇性鍍金,即鍍金厚度不同,焊接區域鍍金厚度控制在0.3 μm以下,鍵合區域鍍金厚度控制在1 μm以上。
但是,選擇性鍍金工藝,需要至少兩次鍍金,且要對部分焊盤進行“保護”,工藝流程大大增加,導致電路板生產成本提高,某些焊盤較多的電路板在采用選擇性鍍金工藝后,價格可能是采用普通鍍金工藝的幾倍甚至十幾倍。
1.2 增加“過渡片”工藝
當某一型號的印制電路板需求量很低時,考慮生產成本,也不會對電路板焊盤進行選擇性鍍金,而是仍采用鍍金焊盤,但是鍍金層厚度控制在0.3 μm以下,印制電路板上需要進行鍵合的焊盤處,再焊接或者使用導電膠粘接一種上表面為純金或者鍍厚金的“過渡片”,形成高可靠性的鍵合區域,再完成芯片對“過渡片”間的鍵合,從而完成印制電路板上的電氣互聯。
但是,“過渡片”如果采用金-銅鑲嵌材料,即焊接部位為銅、鍵合部位為金,成本也會很高。若采用銅表面鍍金材料,則仍存在“金脆”隱患,而只能采用導電膠粘接工藝,這樣,不僅會增加生產工序,導電膠粘接應用在航空、航天產品中可靠性也較差。
為解決以上問題,印制電路板制造行業,開始研發并應用化學鍍鎳鈀金工藝(ENEPIG),該工藝在鎳層和金層之間加入薄的一層鈀(Pd),阻止鎳層向金層擴散,避免了“黑焊盤”問題。這種工藝制備的焊盤,金層很薄,一般厚度在0.3 μm以下,避免了焊接過程中,出現“金脆”現象。同時,由于金層厚度較薄,且鍍金工藝簡單,生產成本也大大降低。
近年來,化學鍍鎳鈀金工藝在國內具有高可靠要求的產品中應用增多,為驗證其鍵合應用的長期可靠性,進行了相關研究。
2 化學鍍鎳鈀金焊盤的鍵合強度
2.1 材料及工藝方案
在對化學鍍鎳鈀金焊盤的鍵合強度測試中,以常見的表面鍍鎳金基板作為對比,如圖1所示。
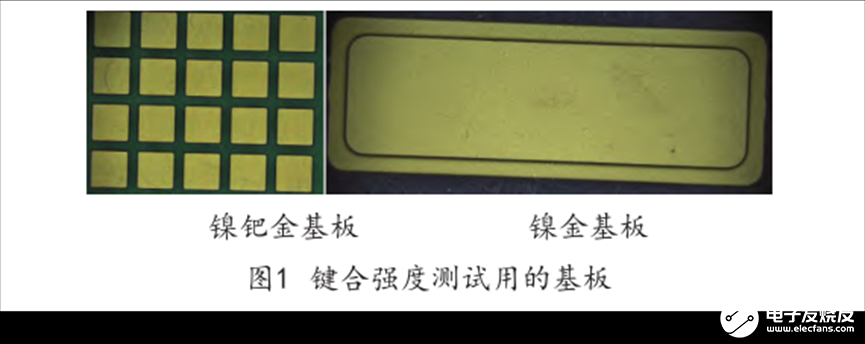
兩種材料的詳細情況見表1。
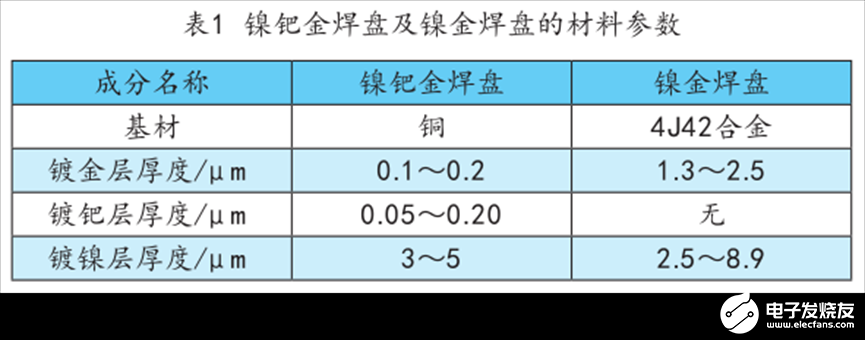
兩種基材均使用某型號設備進行全自動鍵合,在基板表面,采用相同的鍵合程序,分別鍵合50根直徑為25 μm的金絲,以確保鍵合絲長度、弧度、鍵合參數相同,詳細鍵合參數見表2。

2.2 破壞性鍵合拉力測試
鍵合完成后,對所有鍵合絲進行破壞性拉力測試,拉力測試位置均為弧高最高點,如圖2所示。

鎳鈀金基板鍵合金絲測試后,破壞性拉力均值為10.6 cN,數據分布如圖3所示。鎳金基板鍵合金絲測試后,破壞性拉力均值為10.3 cN,數據分布如圖4所示。測試過程中均無鍵合點脫落情況。通過破壞性拉力測試數據對比,兩種基板無明顯差別。


2.3 鍵合點剪切力測試
鍵合點剪切力測試,是將金絲鍵合的第一鍵合點進行破壞性剪切力測試,以更加直觀地檢測其第一鍵合點的鍵合強度。
經過測試,鎳鈀金基板的第一鍵合點剪切力測試均值為58.8 cN,數據分布如圖5所示。而鎳金基板的第一鍵合點剪切力測試均值為64.6 cN,數據分布如圖6所示。通過破壞性鍵合點剪切力測試數據可以看出,在相同鍵合參數下,鎳金基板的第一鍵合點強度要高于鎳鈀金基板的。


2.4 鍵合點剪切力測試后金殘留情況
進行破壞性鍵合點剪切力測試后,鍵合點的金殘留情況也可作為鍵合強度是否可靠的判斷依據。鎳鈀金基板進行鍵合點剪切力測試后,鍵合點金殘留情況明顯少于鎳金基板的,如圖7所示。
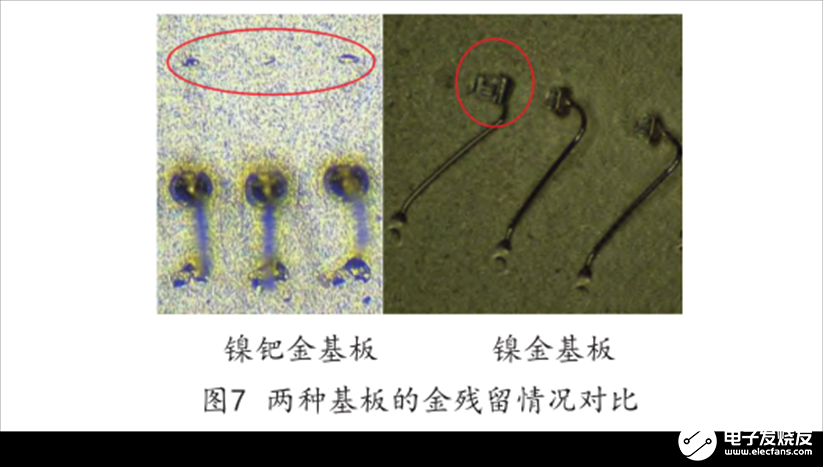
3 化學鍍鎳鈀金焊盤的鍵合可靠性
通過拉力、鍵合點剪切力測試分析,產品基本可以滿足使用要求,但是鍵合點剪切力測試后的金殘留情況與常規鎳金基板不同,因此,繼續進行了相關可靠性研究。
3.1 試驗條件(烘焙溫度300 ℃、烘焙時間1 h)
在金絲鍵合工藝應用過程中,為驗證鍵合材料與基板金屬間的擴散效應,經常采用在溫度300 ℃下烘焙1 h的試驗方式,來加快材料間的擴散,進而驗證長期應用可靠性。
本次將鍵合后的鎳鈀金電路板進行了300 ℃下1 h的烘焙,烘焙后,對第一鍵合點進行了破壞性剪切力測試。其鍵合點并未出現脫落情況。其剪切力測試均值為72.1 cN,對比烘焙前,有明顯提升,數據分布如圖8所示。此外,其第一鍵合點進行剪切力測試后,金殘留也逐漸變多,如圖9所示。


驗證其鍵合強度增強是否為鍵合點與材料間的擴散導致,對鍵合點進行了切片分析,證實了其焊盤鍍層中的鎳元素(Ni)確實擴散到了鍵合點內部,如圖10和圖11所示。
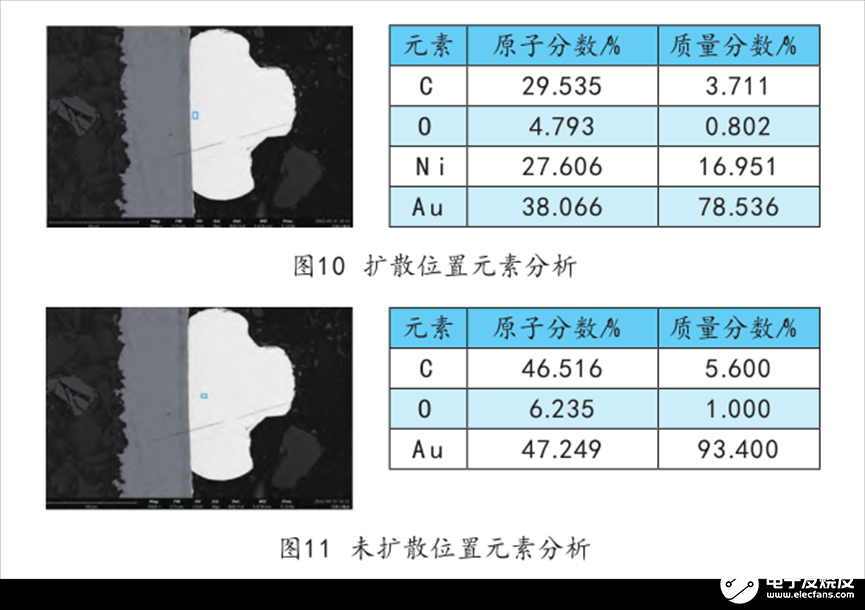
3.2 試驗條件(烘焙溫度300 ℃、烘焙時間8 h)
為驗證該擴散是否持續進行,再次試制樣品,并進行了溫度300 ℃下8 h的烘焙。烘焙后,其電路基板部分已經變形,但是銅鍍鎳鈀金焊盤部分得以保留,對其第一鍵合點再次進行剪切力測試,其鍵合點大部分已無法去除,鍵合點僅從頸縮處斷裂,因此,第一鍵合點的剪切力測試數據已無意義,如圖12所示。

對該鍵合點再次進行切片分析,Ni元素擴散位置更加深入,且焊盤底層的Cu元素也開始擴散,如圖13所示。
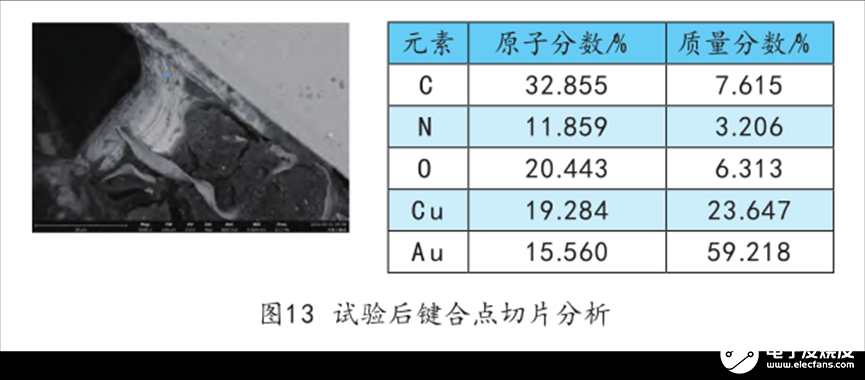
3.3 小結
通過以上驗證,可知鎳鈀金基板長期應用過程中,Ni元素仍然存在擴散問題,只是生產過程中,鍍層中的Pd成分可以有效阻止Ni元素短時間內擴散,以保證焊接后,鍵合工藝的穩定進行。
測量烘焙300 ℃/8 h后的Ni元素的擴散距離已大于10 μm(如圖14所示)。因此,通過該試驗也可以確定,常規的鎳金基板的鍍金層厚度大于1 μm仍然無法阻止長時間的Ni元素擴散。

常規鎳金基板在微組裝領域已應用多年,無可靠性隱患,因此,可以推斷,鎳鈀金基板的鎳層擴散問題不會影響長期應用可靠性。且其經過擴散后鍵合強度增加,無多層金屬分離問題,證明其長期應用可靠性能夠滿足高可靠性產品要求。
4 產品應用注意事項
4.1 避免表面劃傷
鎳鈀金焊盤在使用過程中,由于其表面金層、鈀層厚度均較薄,應注意避免表面劃傷,否則很容易破壞金、鈀鍍層,導致鍵合強度異常。
4.2 避免沾污
鍵合用的基板在少量沾污情況下,采用等離子清洗工藝,即可去除表面污染,該方式同樣適用于鎳鈀金基板。但是,若出現較為嚴重的污染時,常規的鎳金基板表面,可以采用打磨方式去除頑固污物,而鎳鈀金焊盤的打磨方式不易控制,無法確保鍍層不被破壞。
4.3 確保表面粗糙度
該問題主要對于印制電路板的制造商而言,因其鍍金層較薄,實際鍵合過程中,表面金層的形變量很小,因此,相對于鍍厚金的鎳金基板,鎳鈀金基板對表面粗糙度要求更高,有文獻表明,表面粗糙度至少要在 R a 0.6以下 [3] 。
5 結論
通過以上驗證,可知采用化學鍍鎳鈀金工藝的印制電路板焊盤可以滿足金絲鍵合的可靠性要求,但是,在實際生產中相對鎳金基板,應用鎳鈀金基板需要對其他生產工藝進行更加良好的控制,避免對鍍金、鈀層的破壞。
審核編輯 黃宇
-
電路板
+關注
關注
140文章
5317瀏覽量
108162 -
鍵合
+關注
關注
0文章
96瀏覽量
8275 -
微組裝工藝
+關注
關注
6文章
5瀏覽量
9021
發布評論請先 登錄
什么是高可靠性?
如何通過專業Layout設計賦能電路板生產,實現產品可靠性與效率雙贏?
半導體“金(Au)絲引線鍵合”失效機理分析、預防及改善的詳解;

深入解析與使用感受:Isograph、Medini與REANA可靠性分析軟件對比

如何提高電路板組件環境可靠性
芯片制造“鍍”金術:化學鍍技術的前沿突破與未來藍圖




 化學鍍鎳鈀金電路板金絲鍵合可靠性分析
化學鍍鎳鈀金電路板金絲鍵合可靠性分析











評論