1:制造先進的啟動晶片(SOI)的方法。
2:作為一種創建復雜三維結構和腔體的方法,以創造設備功能。(分庭,通道,噴嘴.)
3:作為一種創建封閉的包裝方法環境(用于諧振器、反射鏡和紅外器件的真空封裝)




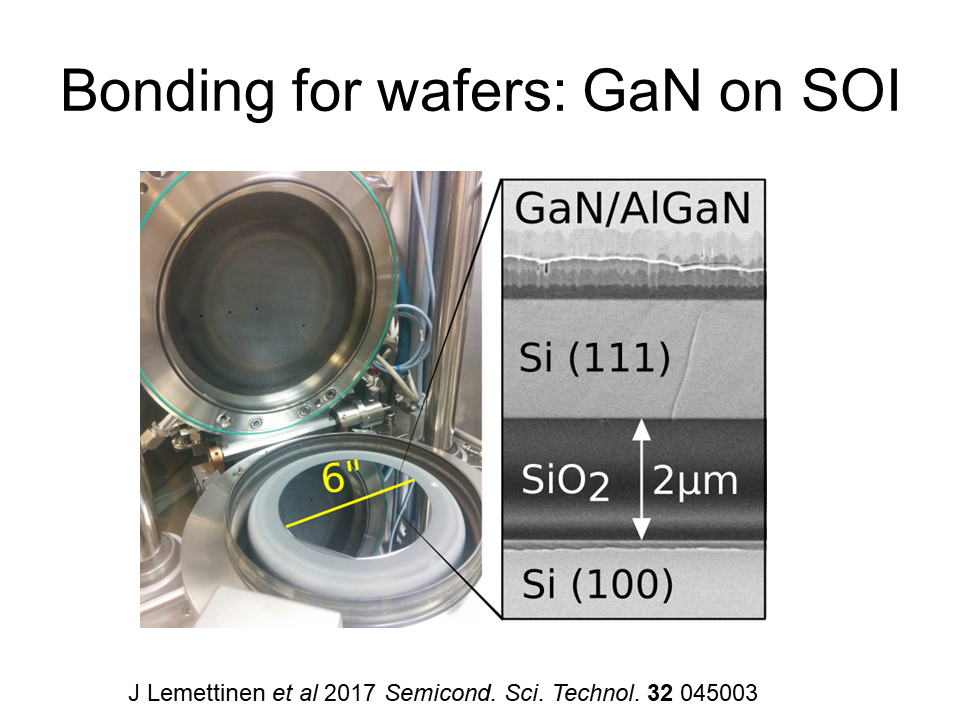
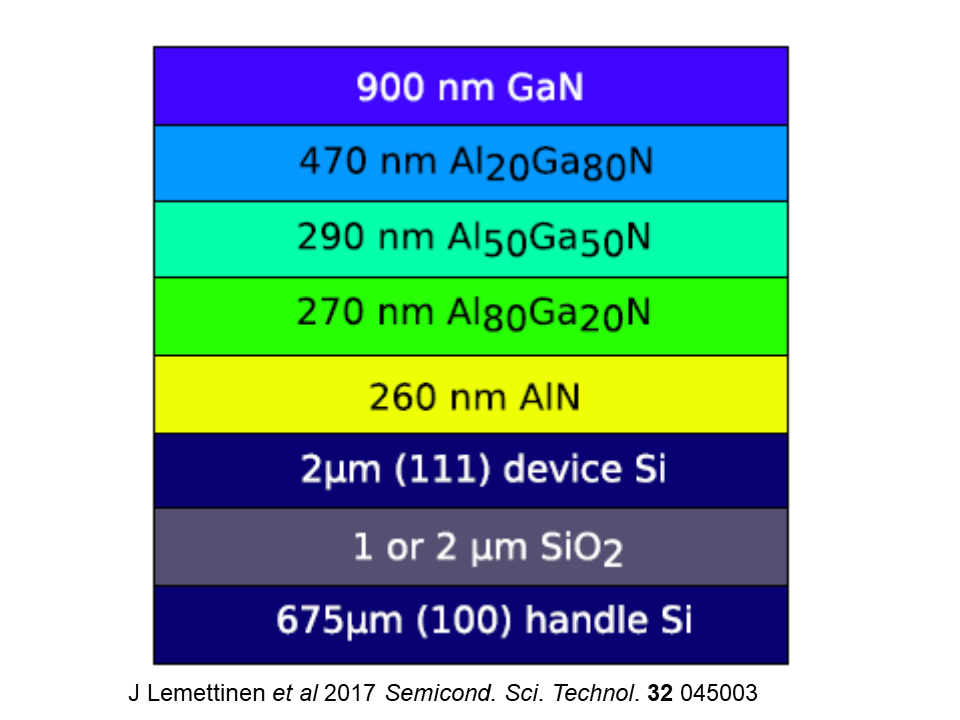
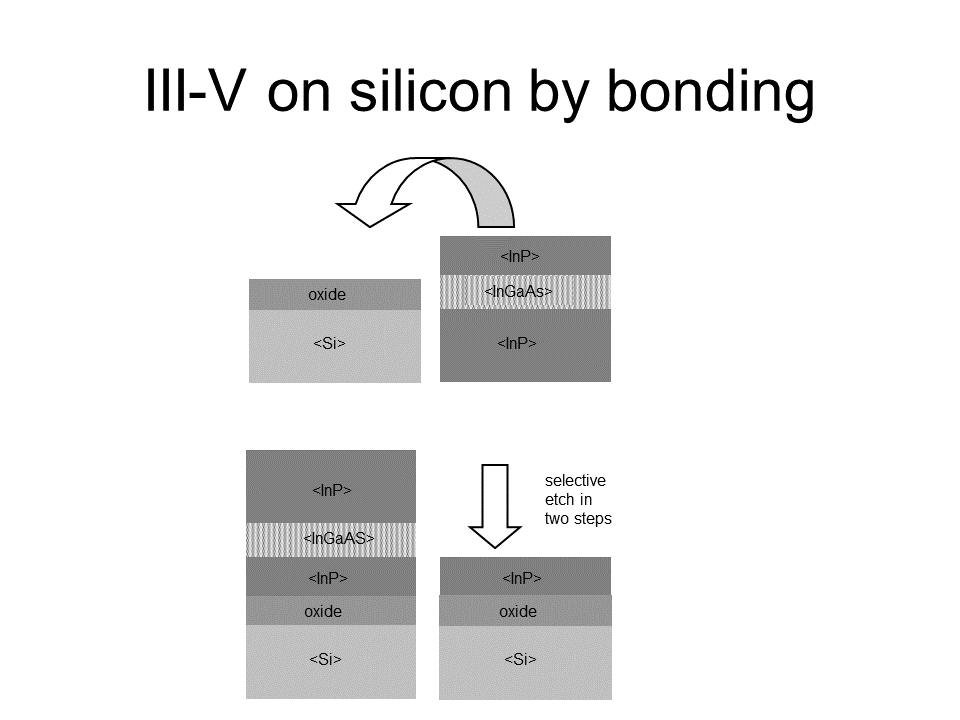

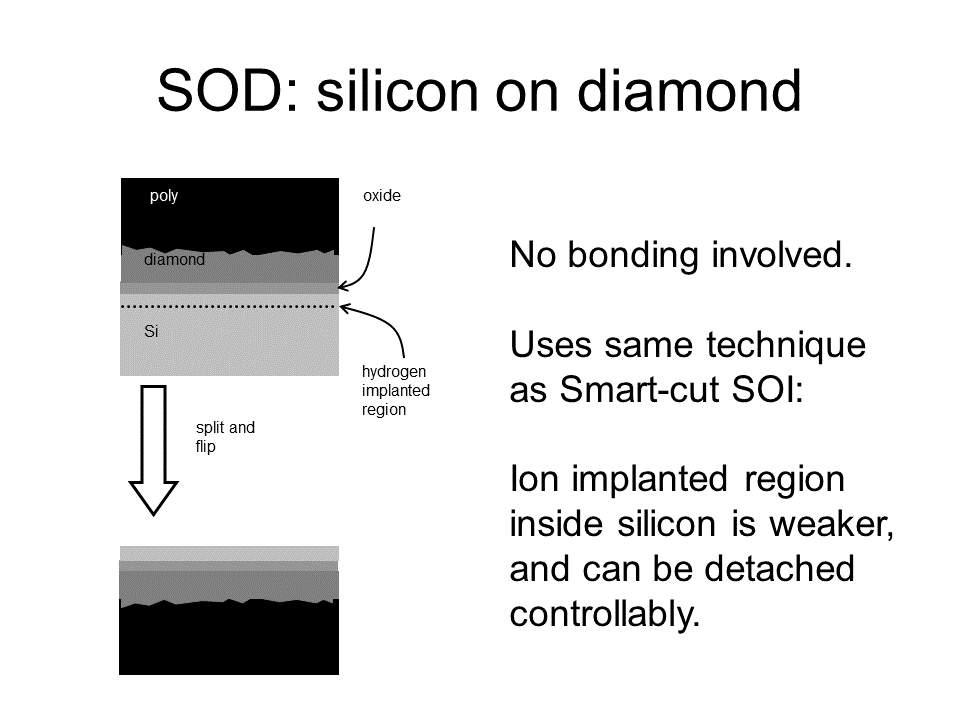
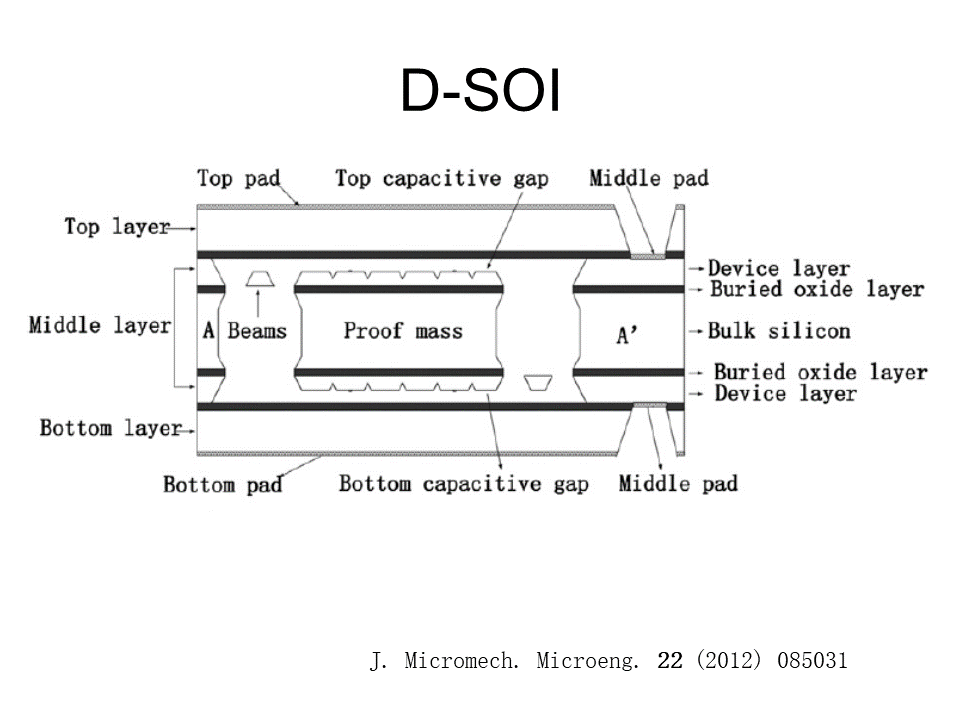
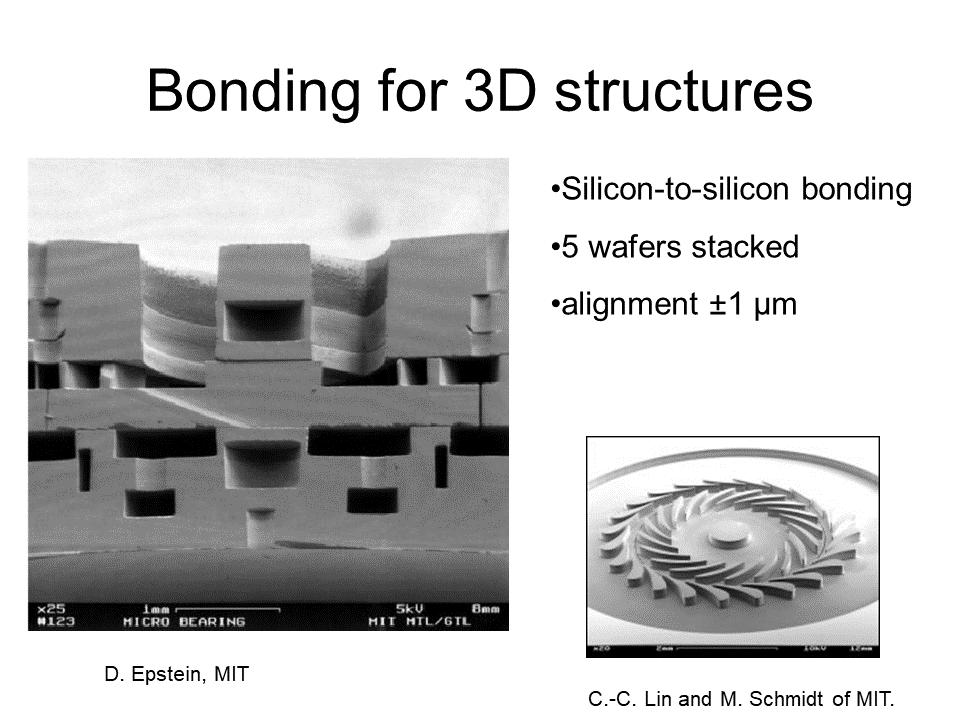
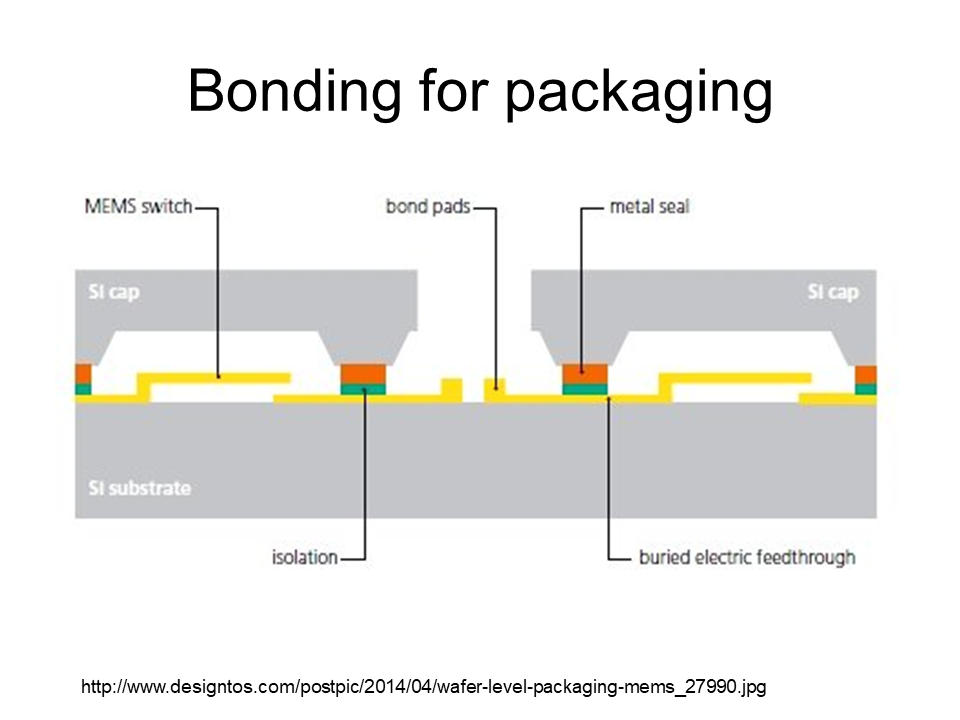
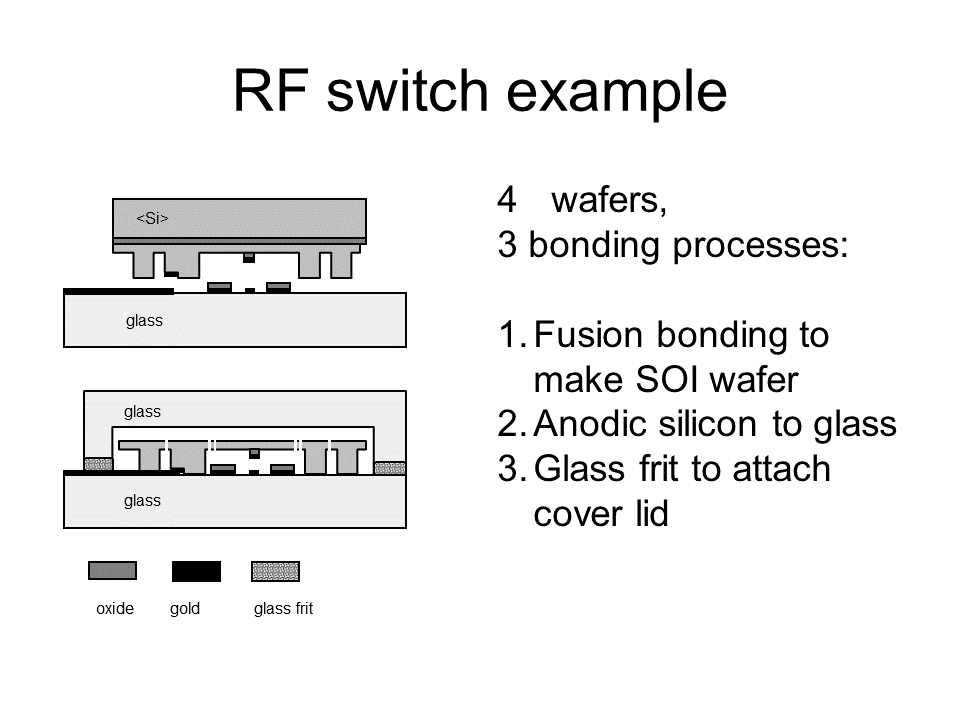
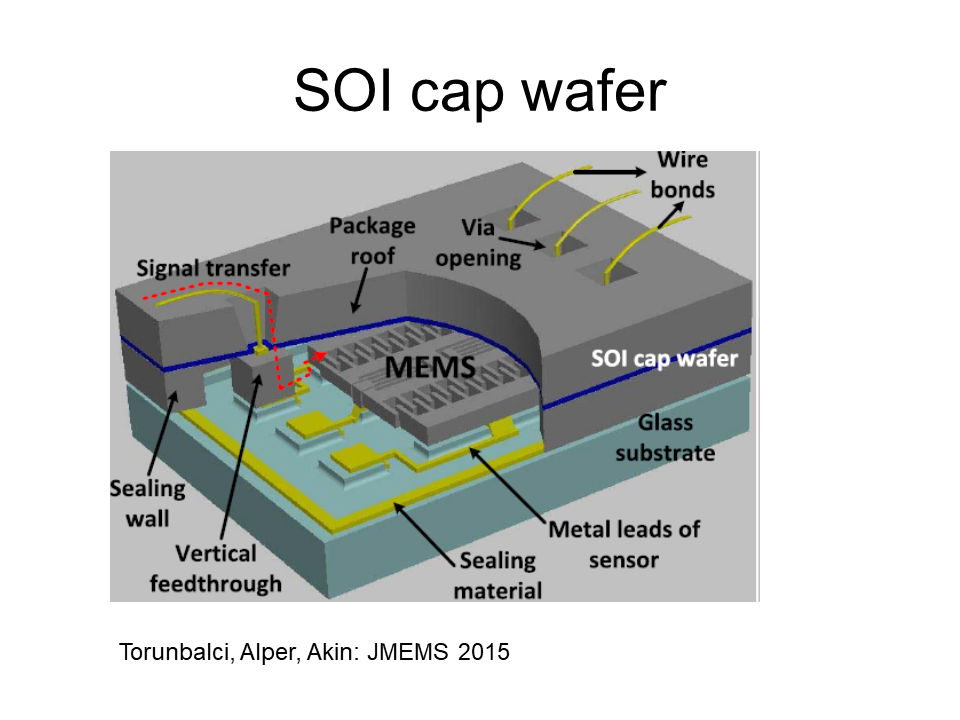
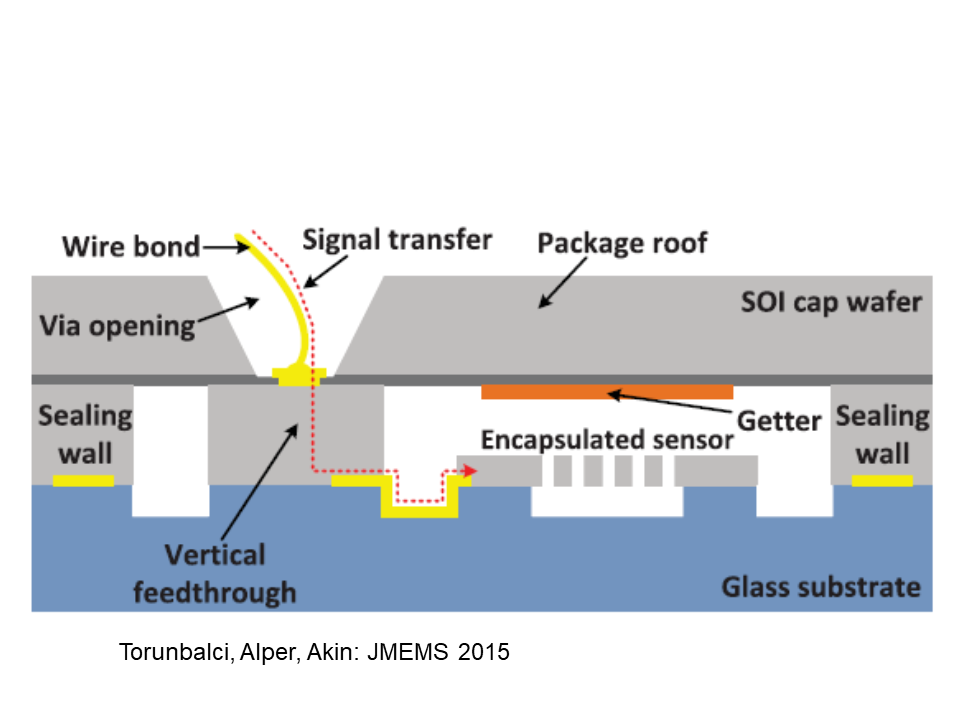
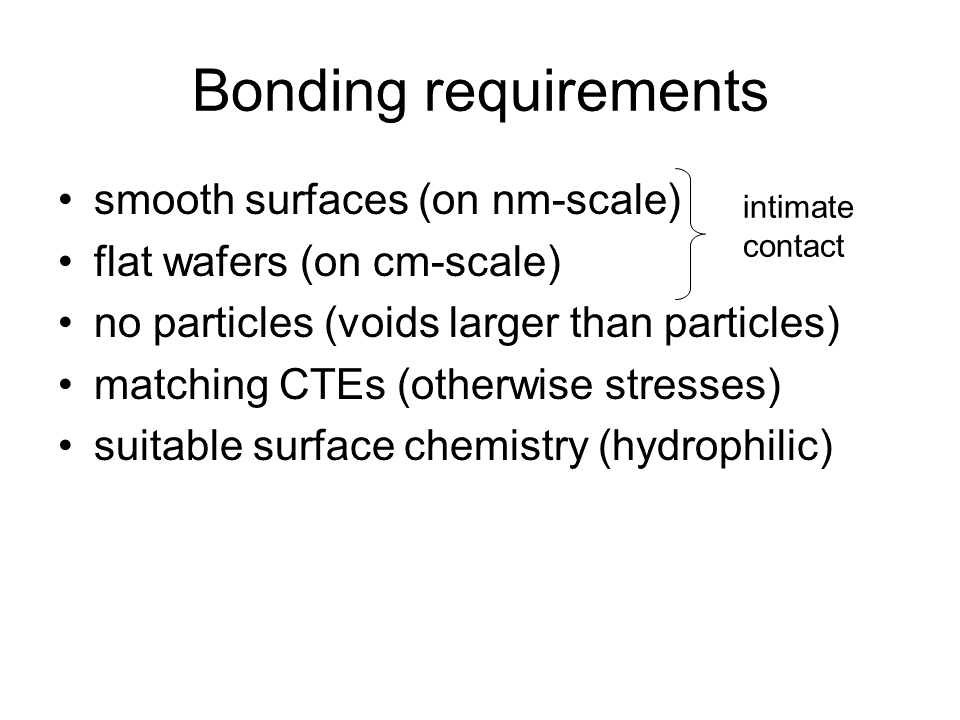

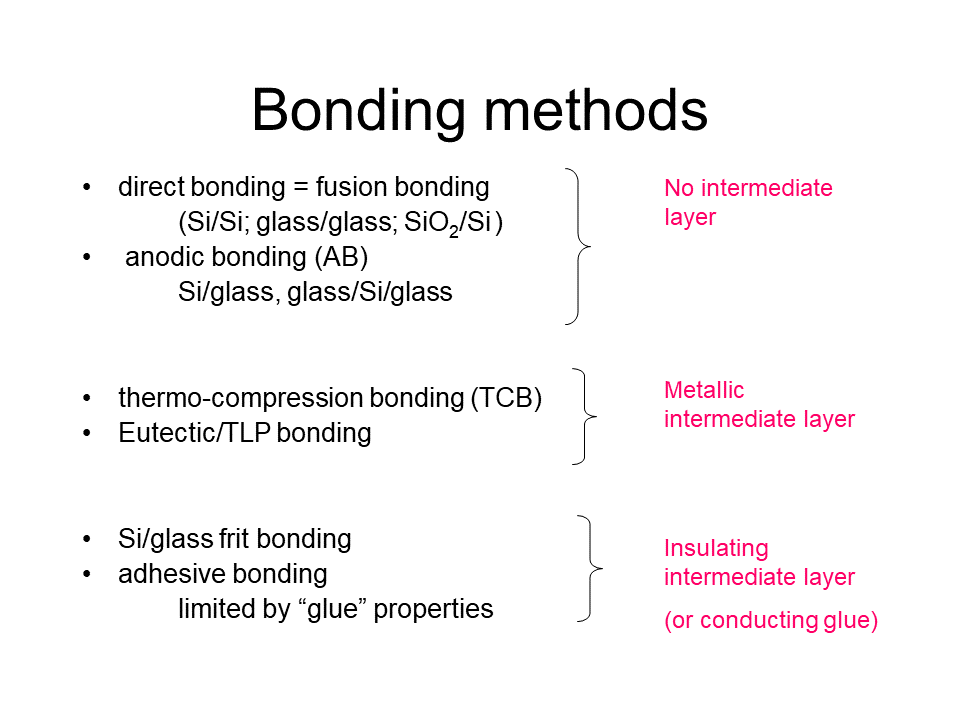





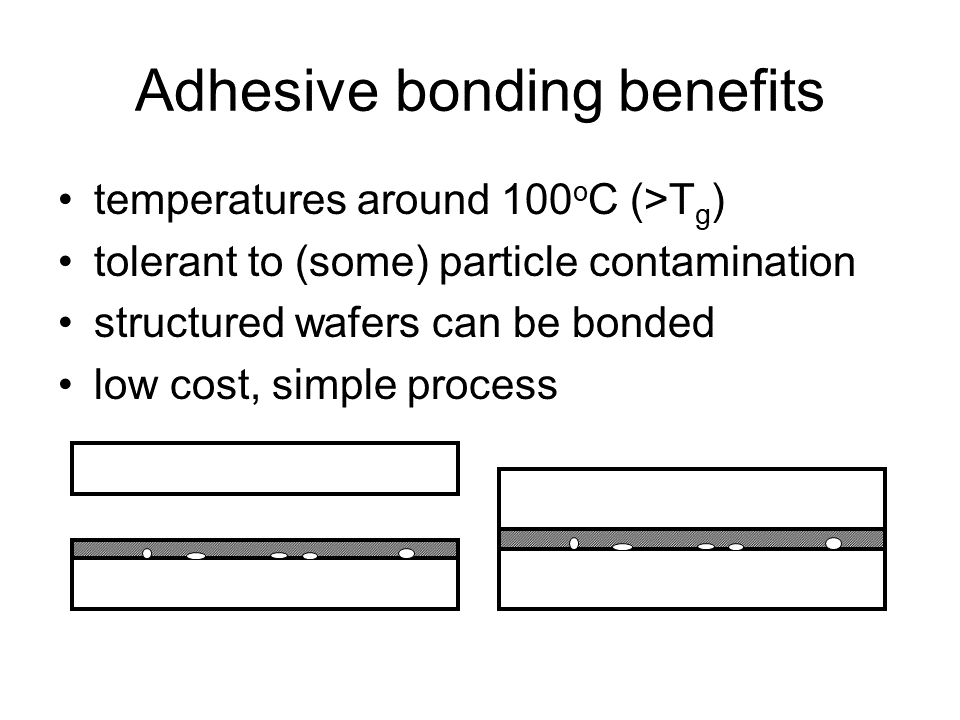



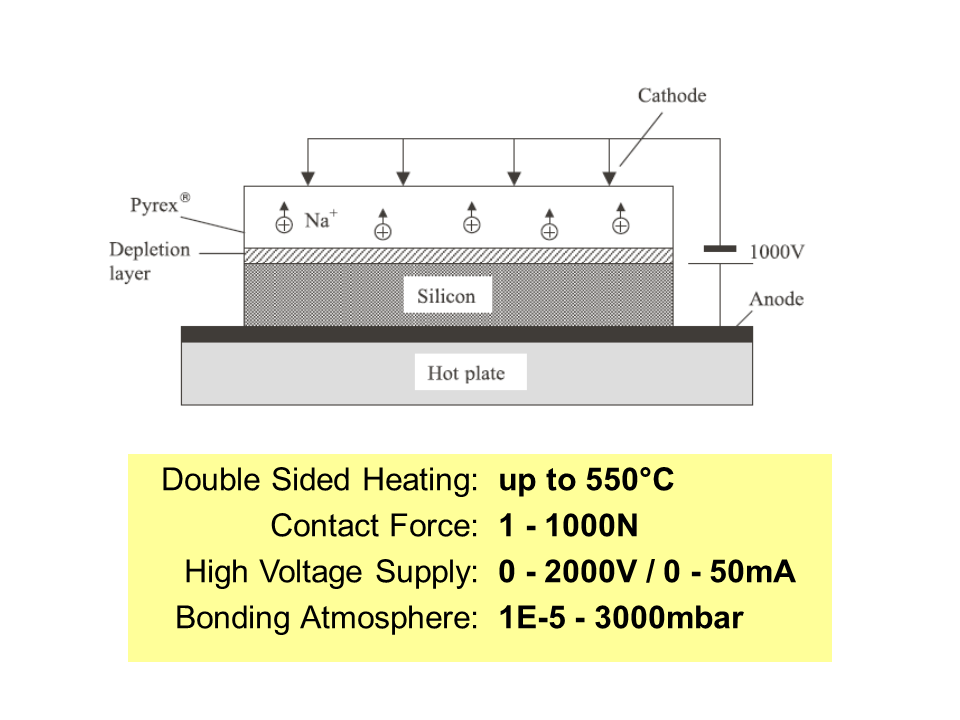








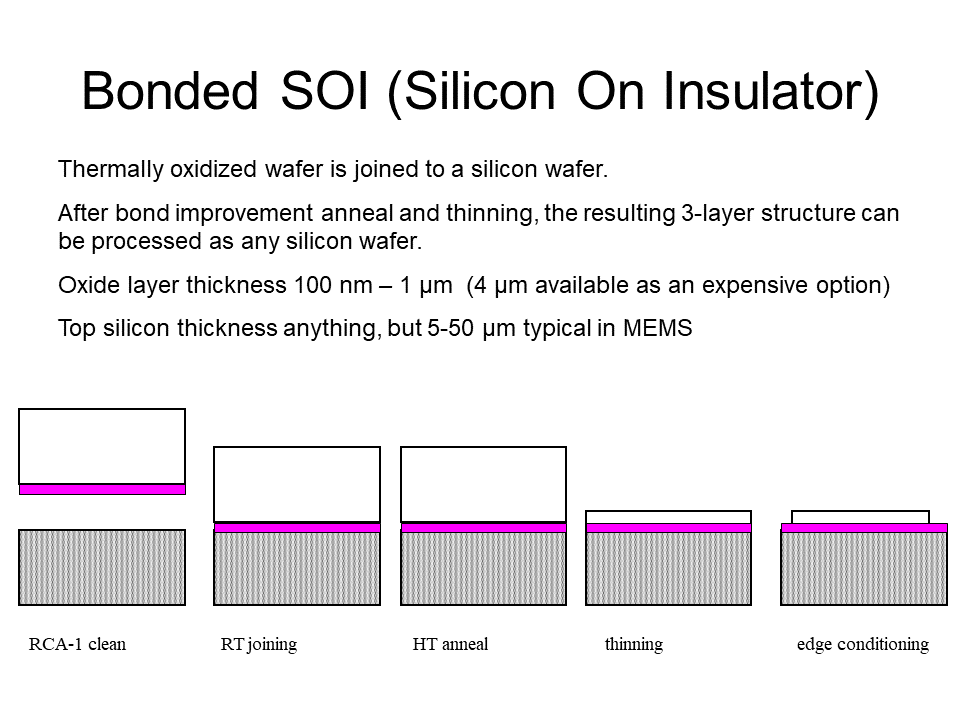
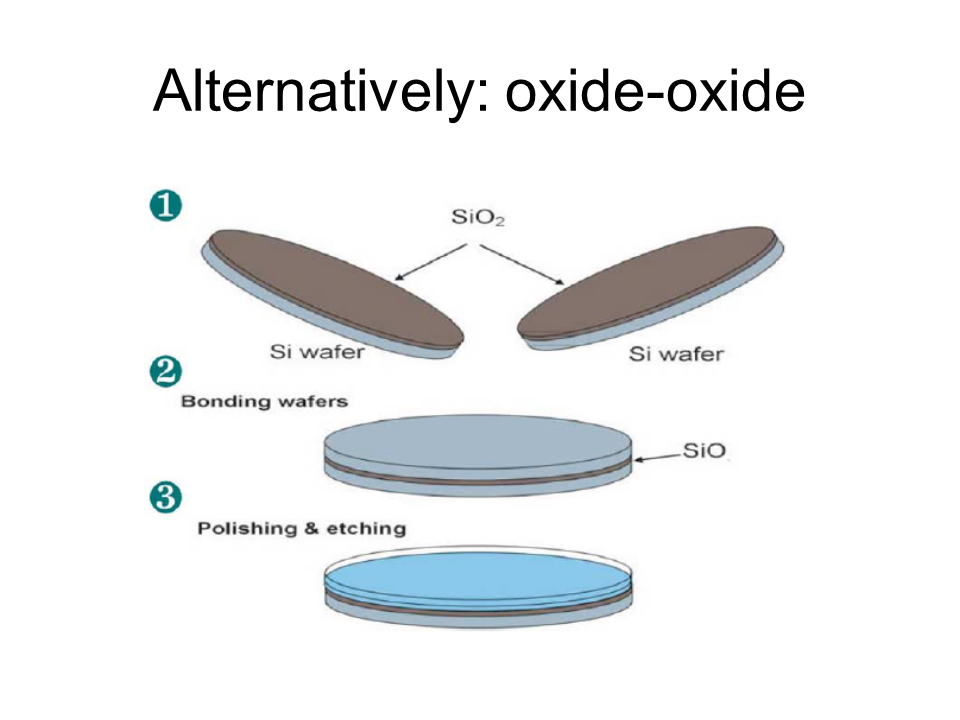



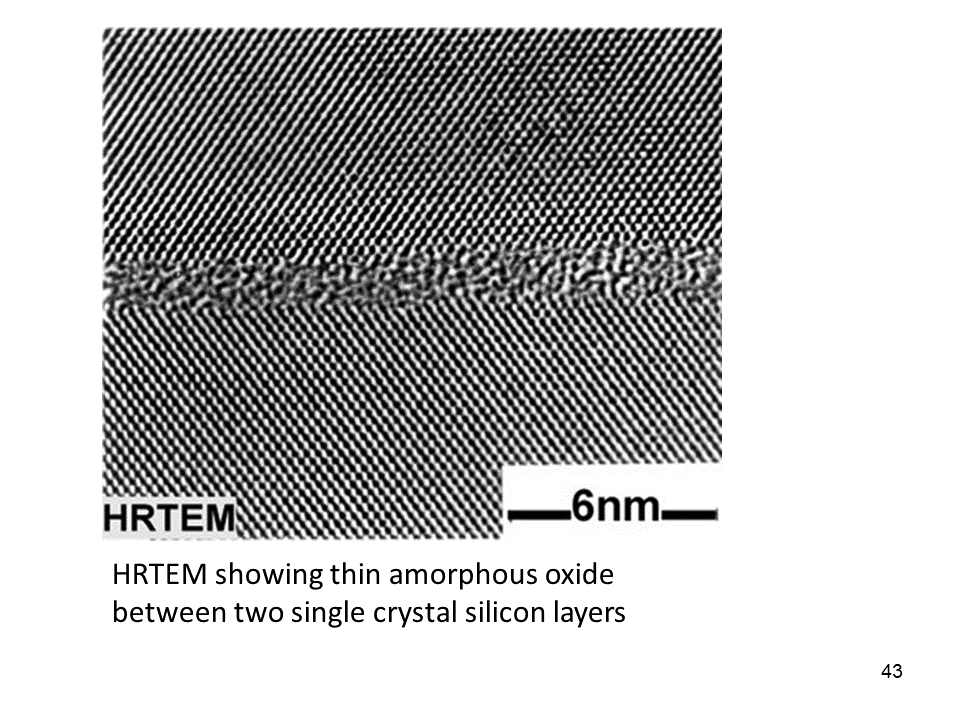



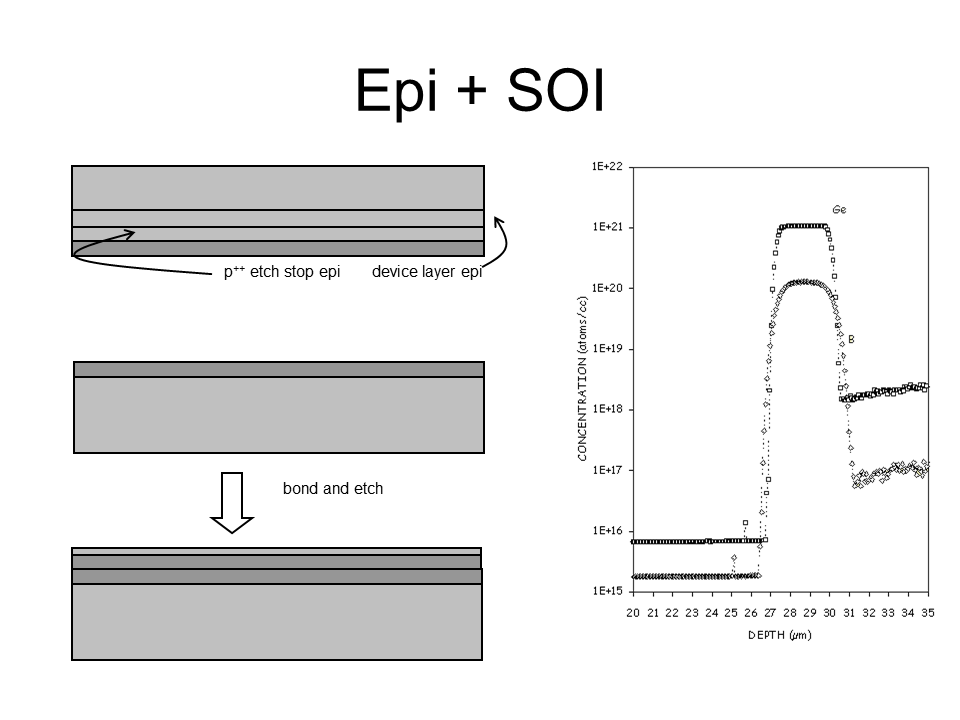
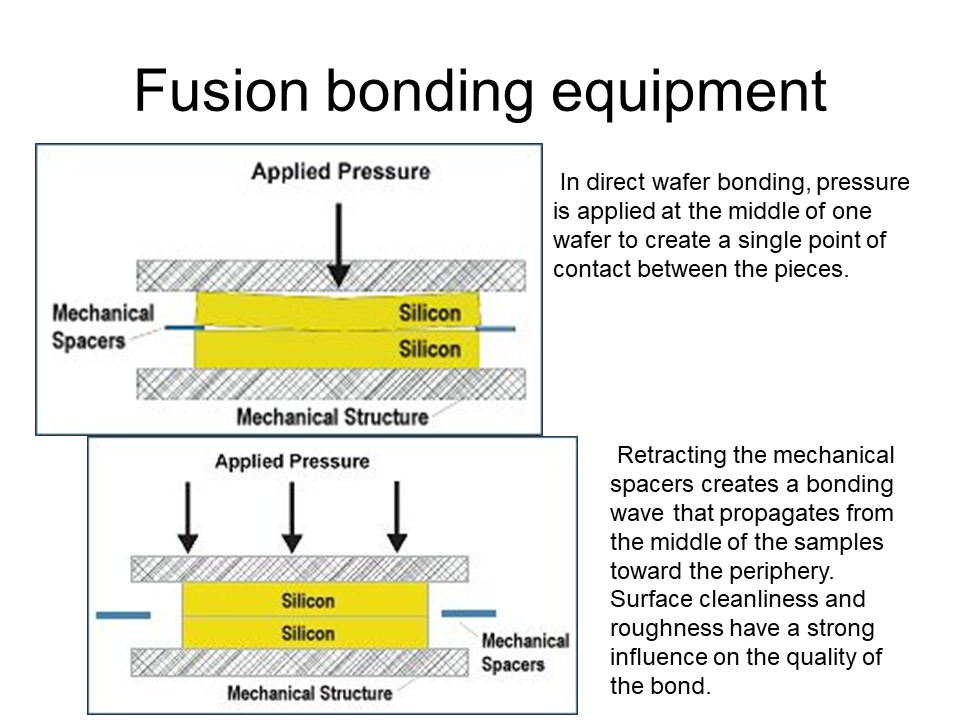







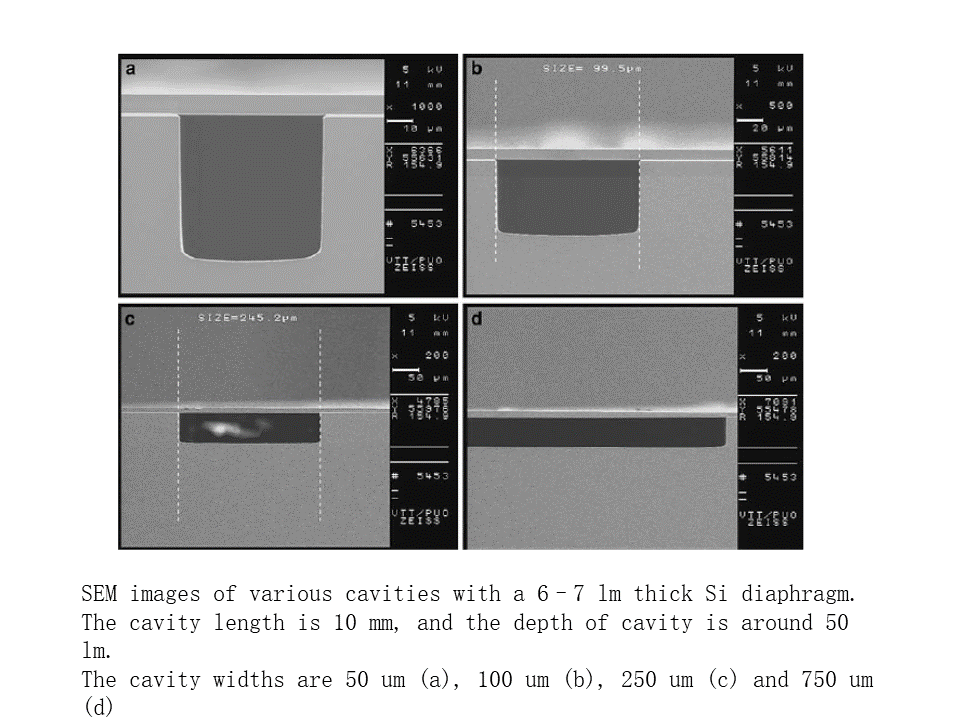
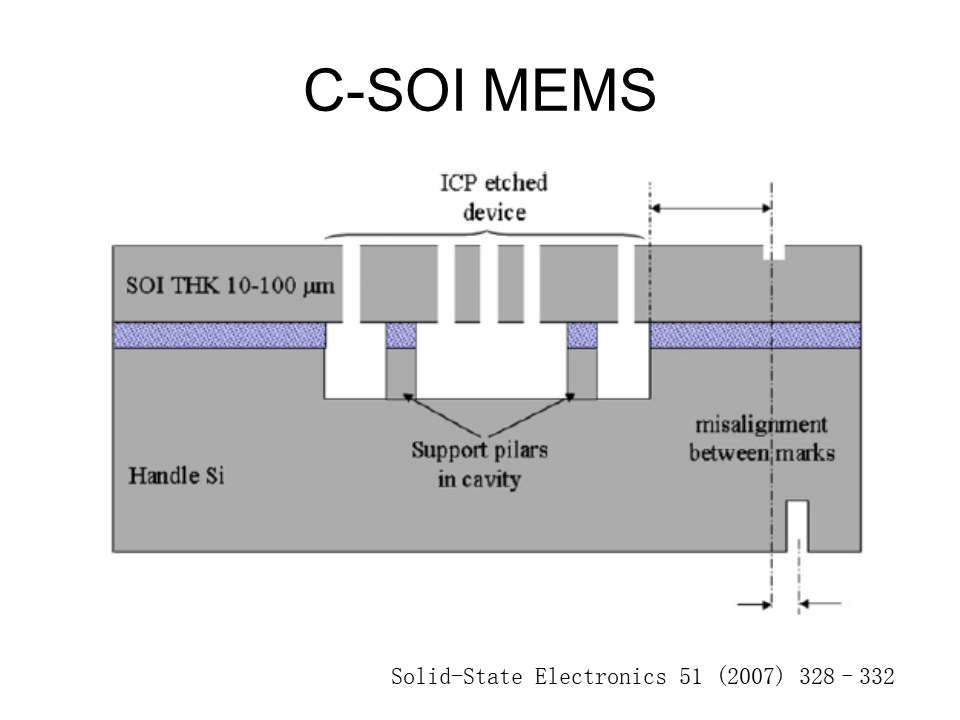

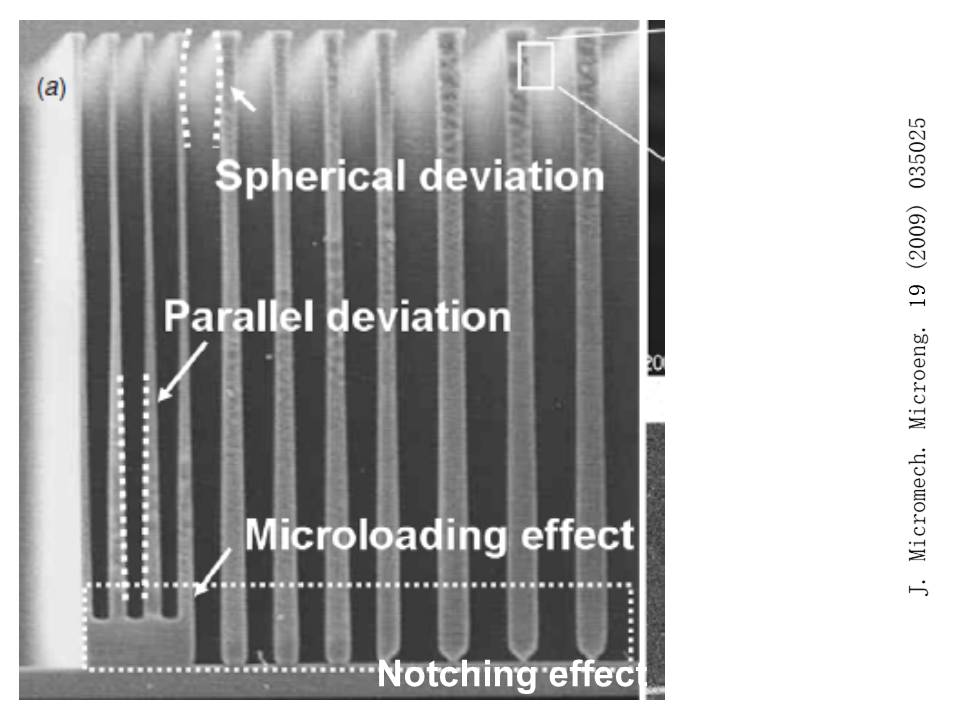

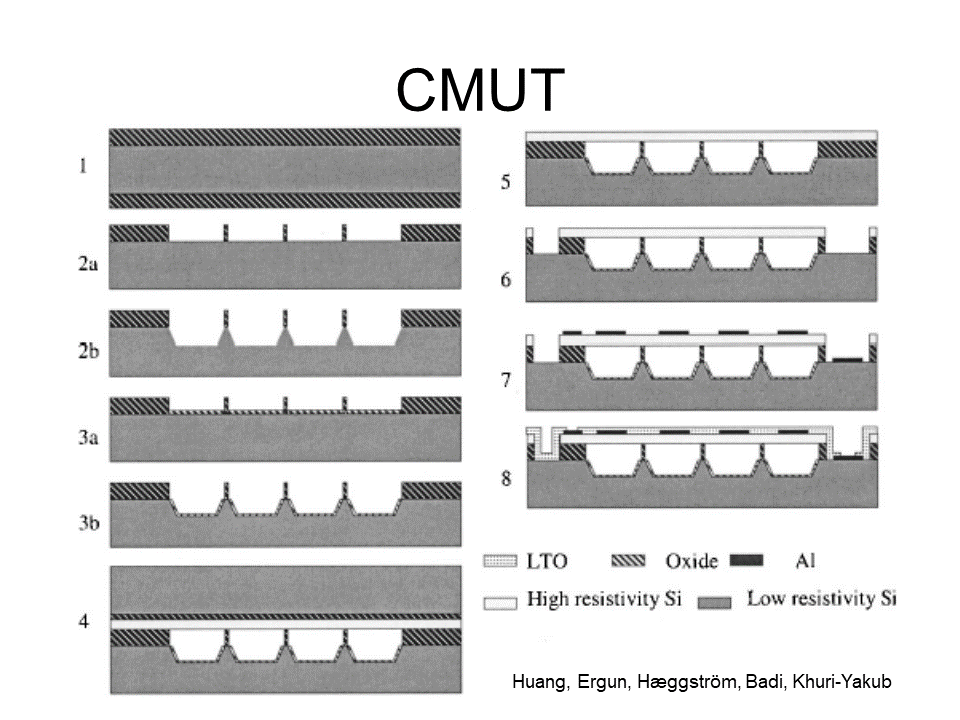
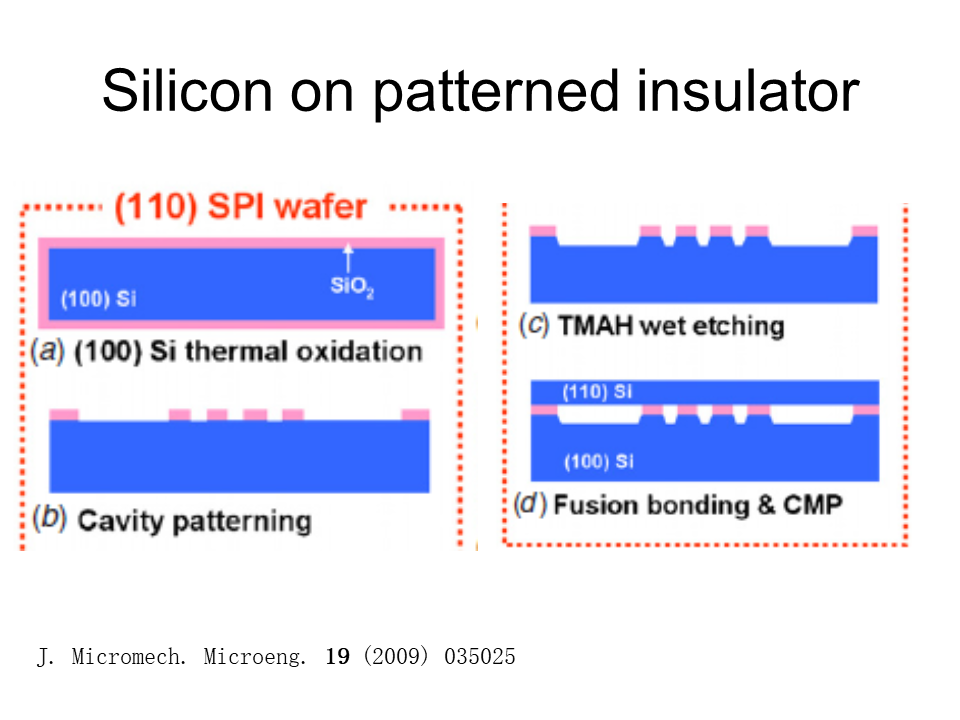
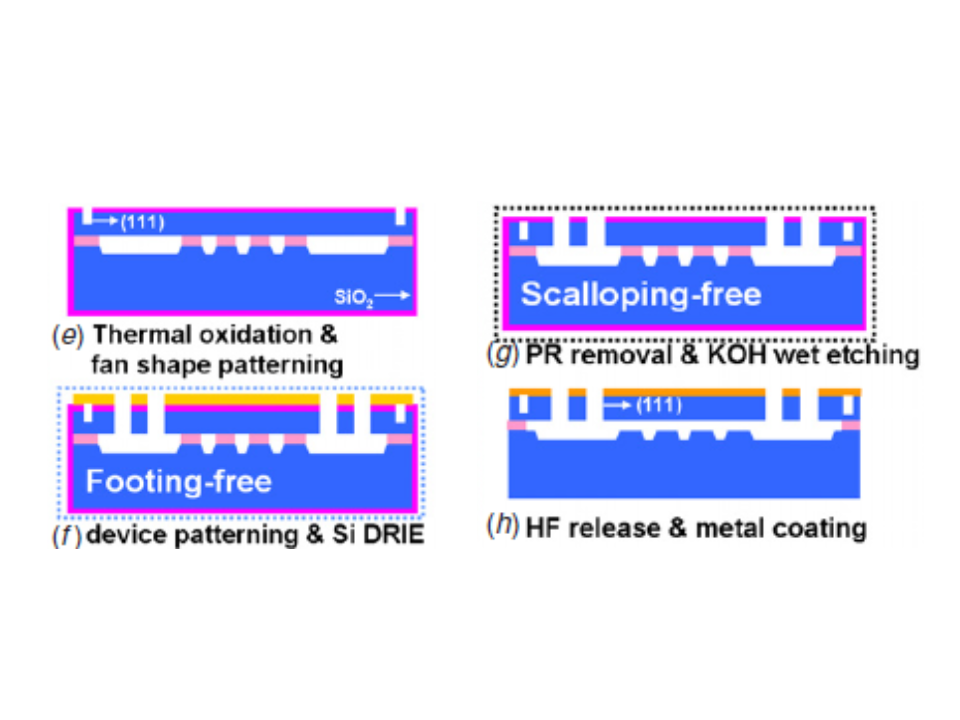
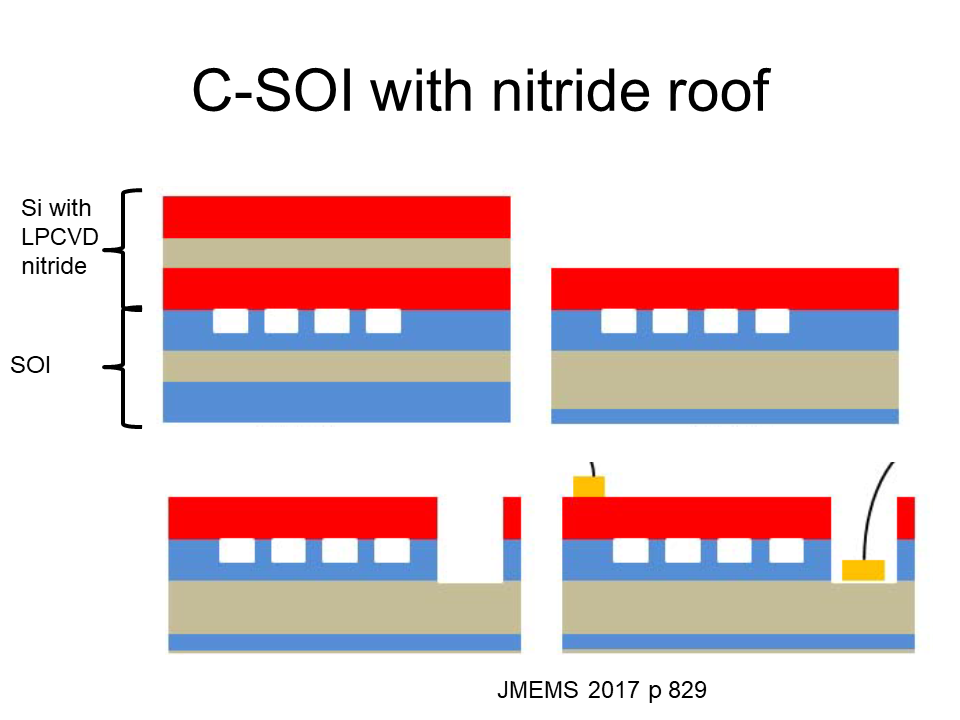




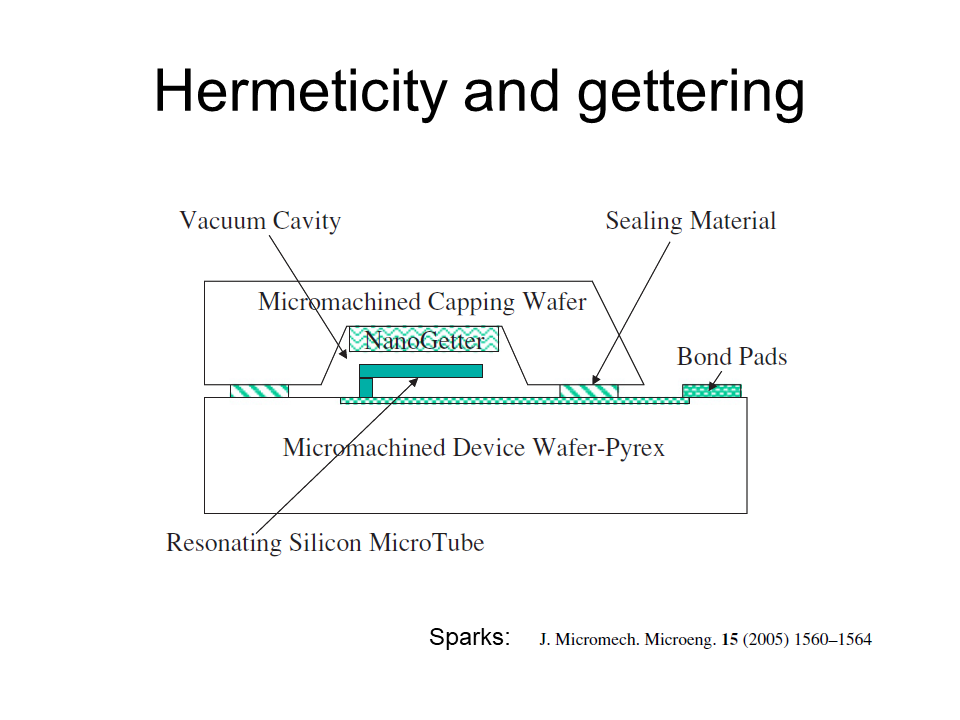
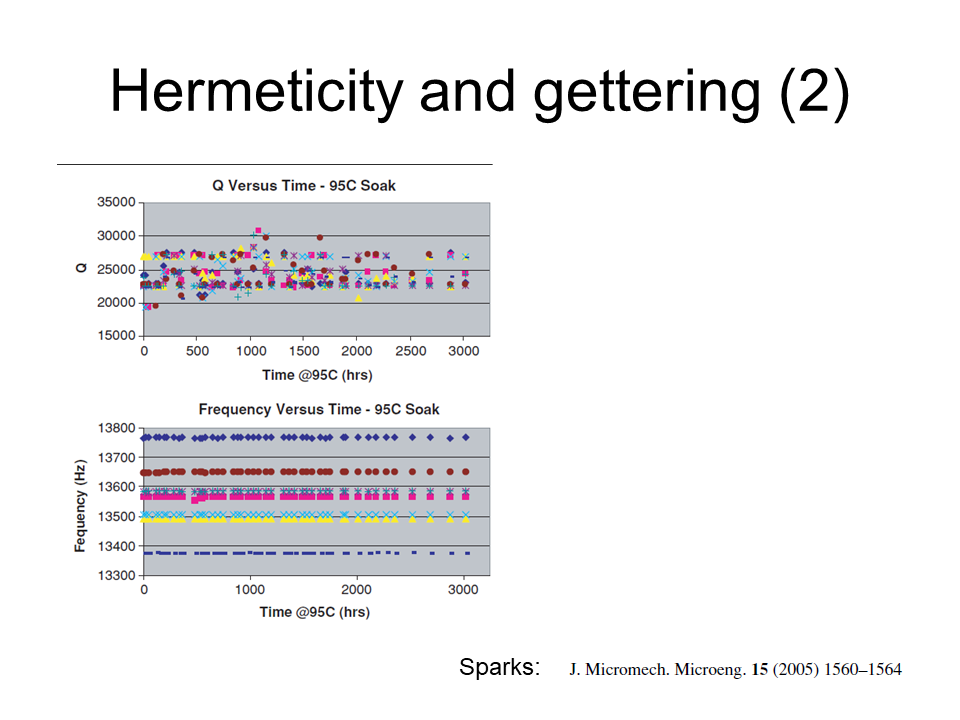






審核編輯:黃飛
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
晶圓
+關注
關注
53文章
5410瀏覽量
132296 -
諧振器
+關注
關注
4文章
1167瀏覽量
67503
原文標題:晶圓鍵合工藝技術詳解
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
熱點推薦
晶圓級CSP的裝配工藝流程
晶圓級CSP的裝配工藝流程
目前有兩種典型的工藝流程,一種是考慮與其他元件的SMT配,首先是錫膏印刷,然后貼裝CSP,回流焊接
發表于 11-20 15:44
?1634次閱讀
晶圓級扇出型封裝的三大核心工藝流程
塑封料(EMC) 擴展芯片面積,從而在芯片范圍之外提供額外的I/O連接空間。根據工藝流程的差異,FOWLP主要分為三大類:芯片先裝(Chip-First)面朝下、芯片先裝面朝上以及RDL先制。本文將深入剖析這三種工藝的具體流程、




 晶圓鍵合工藝流程與關鍵技術探討
晶圓鍵合工藝流程與關鍵技術探討














評論